退火工艺是晶圆制造中的关键步骤,通过控制加热和冷却过程,退火能够缓解应力、修复晶格缺陷、激活掺杂原子....

在无线通信中,接收器接收到的信号非常小,以至于系统中只能容忍有限的噪声。因此,对于电路设计人员来说,....
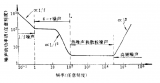
集成电路传统封装技术主要依据材料与管脚形态划分:材料上采用金属、塑料或陶瓷管壳实现基础封装;管脚结构....

键合技术是通过温度、压力等外部条件调控材料表面分子间作用力或化学键,实现不同材料(如硅-硅、硅-玻璃....

在TSV制造技术中,既包含TSV制造技术中通孔刻蚀与绝缘层的相关内容。

在芯片制造的最后环节,裸片(Die)需要穿上“防护铠甲”——既要抵抗物理损伤和化学腐蚀,又要连接外部....
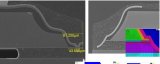
Gerber 文件是用于电子设计自动化(EDA)中,尤其是在印刷电路板(PCB)设计和制造过程中,传....
三维集成电路制造中,对准技术是确保多层芯片键合精度、实现高密度TSV与金属凸点正确互联的核心技术,直....

相较于传统CMOS工艺,TSV需应对高深宽比结构带来的技术挑战,从激光或深层离子反应刻蚀形成盲孔开始....
想象一下,你要为比沙粒还小的芯片建造“房屋”——既要保护其脆弱电路,又要连接外部世界,还要解决散热、....
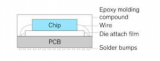
在半导体三维集成(3D IC)技术中,硅通孔(TSV)是实现芯片垂直堆叠的核心,但受深宽比限制,传统....

绝缘体上硅(SOI)技术作为硅基集成电路领域的重要分支,其核心特征在于通过埋氧层(BOX)实现有源层....
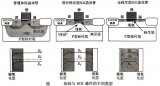
锁相放大器是一种用于提取微弱信号的高精度电子仪器,能够在强噪声背景下检测出微伏(μV)甚至纳伏(nV....
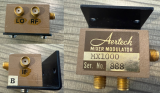
在智能终端轻薄化浪潮中,集成电路封装正面临"尺寸缩减"与"管脚扩容"的双重挤压——处理器芯片为处理海....
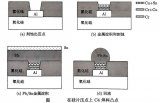
在多芯片封装趋势下,一个封装内集成的高性能芯片日益增多,热管理难题愈发凸显。空气冷却应对此类系统力不....
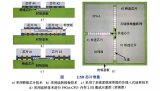
在柔性混合电子(FHE)系统中,柔性实现的难点在于异质材料的协同工作。硅基芯片、金属互连、聚合物基板....

在MEMS中,玻璃因具有良好的绝缘性、透光性、化学稳定性及可键合性(如与硅阳极键合),常被用作衬底、....
CMP是半导体制造中关键的平坦化工艺,它通过机械磨削和化学腐蚀相结合的方式,去除材料以实现平坦化。然....
Wafer Acceptance Test (WAT) 是晶圆制造中确保产品质量和可靠性的关键步骤。....
1997年,富士通公司研发出一种名为芯片上引线(Lead On Chip,LOC)的封装形式,称作L....

铝丝键合常借助超声楔焊技术,通过超声能量实现铝丝与焊盘的直接键合。由于键合所用劈刀工具头为楔形,使得....
在集成MEMS芯片的环境温度测量领域,热阻、热电堆和PN结原理是三种主流技术。热阻是利用热敏电阻,如....

这一篇文章介绍几种芯片加工工艺,在Fab里常见的加工工艺有四种类型,分别是图形化技术(光刻)?掺杂技....
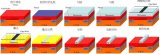
在电子器件封装过程中,会出现多种类型的封装缺陷,主要涵盖引线变形、底座偏移、翘曲、芯片破裂、分层、空....

LED发光二极管,一种半导体元件,当向其中注入电流时会发光。

ACC(Automatic Current Control)是恒电流驱动,通过电流采样反馈为电流驱动....
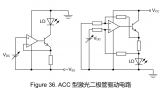
在集成电路生产过程中,晶圆背面二氧化硅边缘腐蚀现象是一个常见但复杂的问题。每个环节都有可能成为晶圆背....
在电子封装领域,各类材料因特性与应用场景不同,失效模式和分析检测方法也各有差异。
在指甲盖大小的芯片上,数百亿晶体管需要通过比头发丝细千倍的金属线连接。当制程进入130纳米节点时,传....

在指甲盖大小的硅片上建造包含数百亿晶体管的“纳米城市”,需要极其精密的工程规划。分层制造工艺如同建造....