传统塑料基板已经无法满足系统级封装信号传输速度、功率传输、设计规则和封装基板稳定性的复杂需求,玻璃基板需求暴涨,玻璃基板有比塑料基板更光滑的表面,同样面积下,开孔数量要比在有机材料上有明显优势。
此外,玻璃芯通孔之间的间隔能够小于 100 微米,这直接能让晶片之间的互连密度提升10倍。互连密度的提升能容纳更多数量的晶体管,从而实现更复杂的设计和更有效地空间利用。
与此同时,玻璃基板在热学性能、物理稳定度方面表现都更出色、更耐热,不容易因为温度高而产生翘曲或变形的问题。
全球巨头将玻璃基板聚焦于2.5D/3D封装、系统级以及CPO和下一代AI芯片
康宁中国区表示半导体先进封装是公司战略布局的重要一环,康宁玻璃晶圆/面板主要服务于包括先进封装和光电共封装(CPO)客户。以玻璃载板平整度以及热膨胀系数(CTE)于客户的晶圆相互匹配,康宁熔融下拉工艺可以提供非常完美的表面质量、平整度,以及大尺寸和可量产性。除了玻璃基板,还将它做成玻璃晶圆/面板成品给到客户,包括先进封装和光电共封装(CPO)客户。
康宁显著的合作案例有:他们通过将Ayar Labs的TeraPHY光学I/O小芯片与康宁的玻璃基波导模块相结合。另外爱立信正在与Ayar Labs和康宁合作开发这种人工智能驱动的解决方案,也融入了Intel的光电基板的光学和电学的实现技术路径。
基于玻璃基板的混合光子集成系统
特种玻璃巨头肖特发力半导体业务,新材料基板成为下一代芯片突破口。2024年8月肖特中国在苏州设立“半导体先进封装玻璃解决方案“部门,为中国半导体行业的合作伙伴提供定制化解决方案。已经在为头部半导体企业量身定制玻璃基板产品,以支持HD Fanout、2.5D/3D、PLP等先进封装工艺的实现,满足小芯片集成度的提高,支持更高的算力需求。
肖特玻璃
英特尔在玻璃基板开发方面处于领先地位,这是由于当前 RDL 中介层解决方案的限制以及对更精细凸点间距的需求所驱动的。然而,玻璃基板技术面临几个挑战,英特尔表示玻璃比传统基板材料更脆,难以加工。形成穿透玻璃导孔(TGV)需要先进的蚀刻和沉积技术。必须开发新的工具和流程来有效处理玻璃基板。
尽管困难重重,但英特尔正在向数据中心、人工智能和图形构建在2030年实现单个封装体内集成1万亿个晶体管的目标挺近。此外,英特尔研发的共同封装光学元件技术,CPO预计将于24年年底投入生产。
作为玻璃基板的最大潜在客户,台积电除维持 CoWoS扩张外,正在建立部署玻璃芯的扇出型面板级(515X510mm)封装。其攻坚动力来自英伟达的未来AI芯片需求。台积电强调了高集成良率的重要性,特别是对于在昂贵的先进逻辑节点上制造的顶层芯片。为解决集成水平的提高,分割和拾取放置的挑战性,台积电正在联合业界支持开发、新型热界面材料(TIMs)、有机模塑化合物、底填材料和先进的过程控制和计量工具。
台积电正在根据英伟达的需求为其未来的FOPLP开发玻璃基板,以领先于竞争者将,最早2025-2026年推出解决方案进入市场。台积电还和英特尔正在积极扩大研发力度。
为此,许多台湾制造商将一人得道鸡犬升天。台湾制造商成立了“玻璃基板供应商电子核心系统联盟”,以汇集专业知识。该联盟专注于通过玻璃通孔(TGV)等精炼工艺,这是大规模生产玻璃基板的瓶颈。2024年对台积电来说已经是一个重要的一年,该公司最近也启动了苹果的2纳米芯片组试生产。
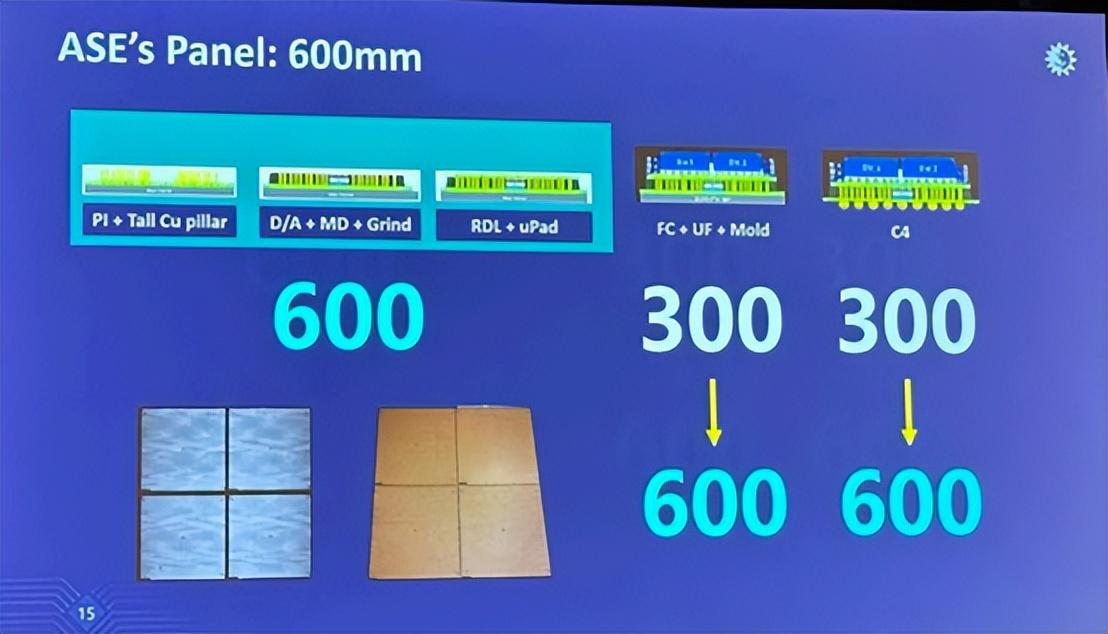
日月光作为半导体封装和测试领域的领导者,在 FOPLP 技术上取得了重大进展。基于玻璃芯,构建更大尺寸的板级封装成为日月光的探索目标。除了板级处理在大批量生产中可以带来显著的成本节约,还有更高的产出,如对于相同的中介层尺寸,600x600mm 的面板可以容纳 8 倍于 12 英寸晶圆的中介层数量。目前日月光能够控制 600x600mm 板级封装并实现有效的翘曲和断裂控制,5μm/5μm RDL 线宽/间距能力,还计划在 2025 年前开发 2μm/2μm 原型。
随着人工智能热潮进入下一步,玻璃基板将在未来发挥巨大作用。玻璃芯基板可能在 2027-2028 年左右进入大规模生产,紧随高性能应用中 FOPLP 的采用之后。激进者在2025年率先导入玻璃基产品。
更重要的是,看客们还在期待他们造出的玻璃基 AI、HPC 到底是什么样的。目前为止,没有一家大牛敢拿出他们的GPU展示给我们。
【近期会议】
10月30-31日,由宽禁带半导体国家工程研究中心主办的“化合物半导体先进技术及应用大会”将首次与大家在江苏·常州相见,邀您齐聚常州新城希尔顿酒店,解耦产业链市场布局!https://w.lwc.cn/s/uueAru
11月28-29日,“第二届半导体先进封测产业技术创新大会”将再次与各位相见于厦门,秉承“延续去年,创新今年”的思想,仍将由云天半导体与厦门大学联合主办,雅时国际商讯承办,邀您齐聚厦门·海沧融信华邑酒店共探行业发展!诚邀您报名参会:https://w.lwc.cn/s/n6FFne
声明:本网站部分文章转载自网络,转发仅为更大范围传播。 转载文章版权归原作者所有,如有异议,请联系我们修改或删除。联系邮箱:viviz@actintl.com.hk, 电话:0755-25988573
审核编辑 黄宇
-
封装
+关注
关注
128文章
8832浏览量
145934 -
玻璃基板
+关注
关注
1文章
100浏览量
10886 -
3D封装
+关注
关注
9文章
144浏览量
27917 -
AI芯片
+关注
关注
17文章
1994浏览量
36057
发布评论请先 登录
华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

3D封装与系统级封装的背景体系解析介绍






 玻璃基板全球制造商瞄准2.5D/3D封装、系统级、CPO和下一代AI芯片
玻璃基板全球制造商瞄准2.5D/3D封装、系统级、CPO和下一代AI芯片




















评论