智能门锁指纹模组焊点补强加固用底部填充胶由汉思新材料提供。
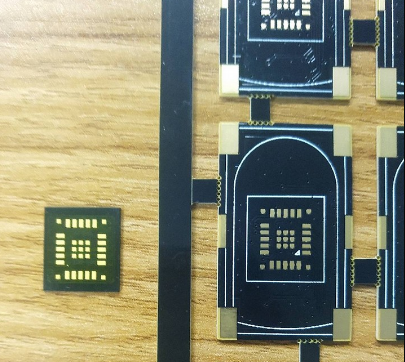

客户产品:智能门锁指纹模组,新产品工艺研发价段。
产品用胶点:
1, QFN芯片底部填充(无锡球,印刷锡膏导通),芯片规格11*13mm,共33个焊盘,焊盘最小间距0.4mm,
2, PCB板四边中间条状点胶(四角铜箔片中间),结构粘接,用到黑色热固胶水,粘接上盖板为不锈钢。
客户产品要求:
接受热固150摄氏度
热风枪返修移除芯片后看填充效果完整与否。
客户已有设备:
气动阀点胶,有烤箱,有低温冷冻条件。
汉思新材料推荐用胶:
通过我司技术人员到客户现场拜访,详细沟通确认,智能门锁指纹模组焊点补强加固用底部填充胶,最终推荐汉思底部填充胶HS700系列。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
焊点
+关注
关注
0文章
138浏览量
13123 -
智能门锁
+关注
关注
17文章
1898浏览量
44493
发布评论请先 登录
相关推荐
热点推荐
汉思新材料HS711板卡级芯片底部填充封装胶
汉思新材料HS711是一种专为板卡级芯片底部填充封装设计的胶水。HS711填充胶主要用于电子封装领域,特别是在半导体封装中,以提供机械支撑、应力缓冲和保护芯片与基板之间的连接免受环境因

先进封装Underfill工艺中的四种常用的填充胶CUF,NUF,WLUF和MUF介绍
今天我们再详细看看Underfill工艺中所用到的四种填充胶:CUF,NUF,WLUF和MUF。 倒装芯片的底部填充工艺一般分为三种:毛细填充

电路板元件保护用胶
电路板元件保护用胶在电子制造领域扮演着至关重要的角色,它们用于固定、保护和密封电路板上的元件,确保电子设备的稳定性和可靠性。以下是对电路板元件保护用胶的详细介绍:一、电路板元件保护

项目分享 | 小熊派DIY一款指纹门锁
于模组感应器上进行指纹录入。(录入一个指纹需要进行三次重复录入,即一个指纹录入四次)
录入完成后,输入任意数字作为录入指纹的编号存入
发表于 10-09 13:55
芯片封装胶underfill底部填充胶点胶工艺基本操作流程
一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致






 智能门锁指纹模组焊点补强加固用底部填充胶
智能门锁指纹模组焊点补强加固用底部填充胶




















评论