芯片底部填充胶(Underfill)在封装工艺中若出现填充不饱满或渗透困难的问题,可能导致芯片可靠性下降(如热应力失效、焊点开裂等)。以下是系统性原因分析与解决方案:

一、原因分析
1.材料特性问题
胶水黏度过高:黏度过大会阻碍流动性,导致渗透不足。
固化速度不匹配:固化时间过短(胶水提前固化)或过长(未充分填充时流动停滞)。
胶水储存不当:胶水过期或受潮/受热导致性能劣化。
2.工艺参数不当
点胶参数错误:点胶量不足、点胶路径不合理(未覆盖关键区域)或点胶速度过快。
温度控制不佳:基板或芯片未预热,胶水在低温下黏度升高;固化温度与时间偏离工艺窗口。
真空/压力不足:未使用真空辅助填充时,毛细作用不足以驱动胶水渗透。
3.结构设计缺陷
间隙过小:芯片与基板间隙(Standoff Height)过小(如<50μm),流动阻力增大。
结构阻挡:焊球阵列(BGA)密度过高、凸块(Bump)布局不合理,或存在物理障碍物(如密封胶圈)。
排气不畅:胶水流动路径中无排气通道,导致气阻(Air Entrapment)。
4.环境因素
温湿度失控:车间湿度过高导致胶水吸潮,或温度波动影响黏度。
洁净度不足:颗粒污染物堵塞流动路径。
二、解决方案
1.材料优化
选择低黏度或自流动(Self-flowing)胶水(例如黏度<2000 cP),必要时添加稀释剂(需验证兼容性)。
调整固化曲线:延长胶水在流动阶段的预热时间,避免过早固化;匹配温度梯度与胶水特性。
严格储存管理:胶水需避光冷藏(如2~8℃),使用前回温至室温并充分搅拌。
2.工艺改进
点胶参数优化:
采用多针头点胶或螺旋点胶(Spiral Dispensing)覆盖更广区域。
点胶量需通过实验确定(例如体积覆盖焊球高度的1.5倍)。
预热基板与芯片:预热温度通常为80~120℃(具体依胶水规格),降低胶水黏度。
真空辅助填充:在真空腔中加压或抽真空(5~50 kPa),增强毛细效应。
固化工艺调整:分阶段固化(如预固化+主固化),确保流动充分后再完全固化。
3.结构设计调整
增大间隙:通过调整焊球高度或基板设计,使间隙>50μm(需平衡机械强度)。
优化布局:避免密集焊球区域形成“死区”,必要时采用阶梯式焊球排布。
增加排气孔:在基板边缘设计微型排气通道,或通过临时开孔辅助排气。
4.环境与设备控制
环境温湿度控制:保持车间温度25±2℃、湿度40~60% RH。
点胶设备校准:定期维护点胶阀,避免堵塞或出胶不均。
洁净度管理:使用高精度过滤器(如5μm)净化胶水,避免颗粒污染。
三、验证与测试
1.流动测试:使用透明玻璃基板模拟实际封装,观察胶水流动路径与填充率。
2. X-Ray检测:检查填充胶在焊球间隙中的渗透均匀性。
3.可靠性测试:通过温度循环(-40~125℃)和机械振动测试验证填充效果。
四、典型案例
案例1:某BGA封装填充不饱满,原因为焊球间隙仅30μm。解决方案:改用低黏度胶水(1500 cP)并增加真空辅助,填充率提升至95%。
案例2:胶水提前固化导致渗透失败。调整固化曲线,将预固化温度从100℃降至80℃,延长流动时间至3分钟,问题解决。
通过系统性优化材料、工艺与设计,可显著提升填充胶的渗透效果,确保封装可靠性。
汉思新材料提供定制化解决方案,根据客户需求调整黏度、固化时间等参数,并支持免费样品测试和点胶代加工服务。 欢迎咨询!!
-
芯片
+关注
关注
460文章
52616浏览量
442663 -
封装工艺
+关注
关注
3文章
65浏览量
8164
发布评论请先 登录
电池保护板芯片封胶底部填充胶

underfill底部填充工艺用胶解决方案






 芯片底部填充胶填充不饱满或渗透困难原因分析及解决方案
芯片底部填充胶填充不饱满或渗透困难原因分析及解决方案




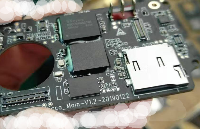
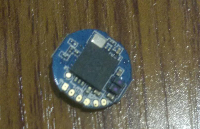

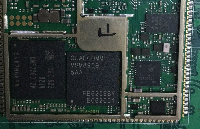














评论