随5G、物联网、电动车蓬勃发展,对于低功耗要求越来越高,功率半导体成为这些产业势不可挡的必备组件。宜特(TWSE: 3289)晶圆后端工艺厂的晶圆减薄能力也随之精进。宜特今(1/6)宣布,晶圆后端工艺厂(竹科二厂),通过客户肯定,成功开发晶圆减薄达1.5mil(38um)技术,技术门坎大突破。同时,为更专注服务国际客户,即日起成立宜锦股份有限公司(Prosperity Power Technology Inc)。
使用控片测得2mil、1.5 mil、1.5 mil优化条件后的损坏层厚度及TEM分析宜特指出,功率半导体进行“减薄”,一直都是改善工艺,使得功率组件实现“低功耗、低输入阻抗”最直接有效的方式。晶圆减薄除了有效减少后续封装材料体积外,还可因降低RDS(on)(导通阻抗)进而减少热能累积效应,以增加芯片的使用寿命。
但如何在减薄工艺中降低晶圆厚度,又同时兼顾晶圆强度,避免破片率居高不下之风险自晶圆减薄最大的风险。
为解决此风险,iST宜特领先业界,已完成2mil(50um)、1.5mil(38um),甚至到0.4mil(10um)减薄技术开发,iST宜特更藉由特殊的优化工艺,在降低晶圆厚度的同时,也兼顾晶圆强度,可将研磨损伤层(Damage layer)降到最低。
责任编辑:xj
-
半导体
+关注
关注
335文章
29027浏览量
239962 -
晶圆
+关注
关注
53文章
5181浏览量
130108 -
宜特科技
+关注
关注
0文章
5浏览量
8866
发布评论请先 登录

晶圆减薄工艺分为哪几步






 宜特晶圆:成功开发晶圆减薄达1.5mil(38um)技术
宜特晶圆:成功开发晶圆减薄达1.5mil(38um)技术





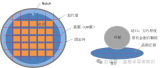










评论