据了解,现在很多电子产品都在使用底部填充胶水来保护PBC板BGA芯片和电子元件,让产品防摔,抗震,防跌落。汉思化学也进军BGA芯片用胶领域。
汉思化学是面向全球化战略服务的一家创新型化学新材料科技公司,集团总部位于东莞,并在中国香港、中国台湾、新加坡、马来西亚、印尼、泰国、印度、韩国、以色列、美国加州等12个国家及地区均设立了分支机构。十余栽兢兢业业,致力于推动绿色化学工业发展,凭借着强大的企业实力与卓越的产品优势,汉思为全球客户提供工业胶粘剂产品,定制相关应用方案与全面的技术支持。
芯片底部填充胶水如何使用:
把产品装到点胶设备上,很多类型点胶设备都适合,包括:手动点胶机/时间压力阀、螺旋阀、线性活塞泵和喷射阀。设备的选择应该根据使用的要求。
1.在设备的设定其间,确保没有空气传入产品中。
2.为了得到最好的效果,基板应该预热(一般40℃约20秒)以加快毛细流动和促进流平。
3.以适合速度(2.5~12.7mm/s)施胶。确保针嘴和基板及芯片的边缘的距离为0.025~0.076mm,这可确保底部填充胶的最佳流动。
4.施胶的方式一般为"I"型沿一条边或"L"型沿两条边在角交叉。施胶的起始点应该尽可能远离芯片的中心,以确保在芯片的填充没有空洞。施胶时"I"型或"L"型的每条胶的长度不要超过芯片的80%。
5.在一些情况下,也许需要在产品上第二或第三次施胶。
-
芯片
+关注
关注
460文章
52737浏览量
444229 -
胶粘剂
+关注
关注
1文章
93浏览量
11426 -
芯片封装
+关注
关注
12文章
582浏览量
31595
发布评论请先 登录
汉思新材料:环氧底部填充胶固化后有气泡产生原因分析及解决方案

汉思新材料:底部填充胶返修难题分析与解决方案

苹果手机应用到底部填充胶的关键部位有哪些?

BGA底部填充胶固化异常延迟或不固化原因分析及解决方案

汉思新材料:车规级芯片底部填充胶守护你的智能汽车

underfill胶水的作用是什么?
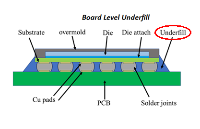
芯片封装胶underfill底部填充胶点胶工艺基本操作流程






 芯片底部填充胶水如何使用
芯片底部填充胶水如何使用



















评论