盲人听书机BGA芯片底部填充胶应用由汉思新材料提供

客户产品是盲人听书机。
盲人听书机是一款听读产品,符合人体工程学的外形设计,让盲人朋友触摸时手感舒适,能听各种影视语音文件,语音朗读效果可以多种选择,通过WIFI连接网络,给盲人朋友的生活带来更多的方便和乐趣.
产品用胶部位:用于主芯片底部填充,加固补强.
目前有在使用底部填充胶,一个月用量在500ML。
目前所用包装为250ML。50ML。
具体型号为其他
客户颜色要求:黄色,或是黑色。
固化方式:120℃30MIN.,
BGA芯片参数:
锡球参数三个。锡球
BGA芯片:中心距0.8MM,球直径0.45MM
BGA芯片:中心距是0.5MM,球的直径是0.3MM.
BGA芯片:中心距0.8MM,球直径0.45-0.55MM。
根据客户提供的相关信息,目前推荐汉思HS707底部填充胶.
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片封装
+关注
关注
12文章
582浏览量
31589 -
BGA芯片
+关注
关注
1文章
33浏览量
13858
发布评论请先 登录
相关推荐
热点推荐
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利
汉思新材料取得一种封装芯片高可靠底部填充胶及其制备方法的专利2025年4月30日消息,国家知识产权局信息显示,深圳市汉思新材料科技有限公司取得一项名为“封装

汉思新材料:车规级芯片底部填充胶守护你的智能汽车
看不见的"安全卫士":车规级芯片底部填充胶守护你的智能汽车当你驾驶着智能汽车穿越颠簸山路时,当车载大屏流畅播放着4K电影时,或许想不到有群"透明卫士"正默默

先进封装Underfill工艺中的四种常用的填充胶CUF,NUF,WLUF和MUF介绍
今天我们再详细看看Underfill工艺中所用到的四种填充胶:CUF,NUF,WLUF和MUF。 倒装芯片的底部填充工艺一般分为三种:毛细

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致






 盲人听书机BGA芯片底部填充胶应用
盲人听书机BGA芯片底部填充胶应用






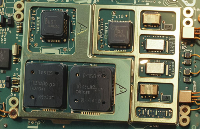















评论