电力设备电源控制板BGA芯片底部填充胶应用由汉思新材料提供

客户产品是电力设备电源控制板
需求原因:新产品开发.
用胶部位:FPC与BGA底部填充
施胶用途:填充胶保护BGA芯片
胶水颜色:黑
施胶工艺:半自动点胶
有烤箱设备.固化温度和时间:150度
芯片参数
芯片尺寸:10*10mm 锡球球距:0.3mm 锡球中心距:0.8mm
测试要求:
测试满足正常电子产品测试要求
环保要求:RoHS和REACH
通过我司工程人员和客户详细沟通确认,推荐汉思BGA底部填充胶HS709。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
460文章
52737浏览量
444213 -
芯片封装
+关注
关注
12文章
582浏览量
31595
发布评论请先 登录
相关推荐
热点推荐
汉思新材料:车规级芯片底部填充胶守护你的智能汽车
看不见的"安全卫士":车规级芯片底部填充胶守护你的智能汽车当你驾驶着智能汽车穿越颠簸山路时,当车载大屏流畅播放着4K电影时,或许想不到有群"透明卫士"正默默

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致






 电力设备电源控制板BGA芯片底部填充胶应用
电力设备电源控制板BGA芯片底部填充胶应用







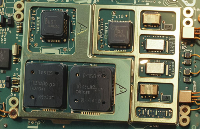
















评论