手机SIM卡和银行卡芯片封装和bga底部填充胶方案由汉思新材料提供
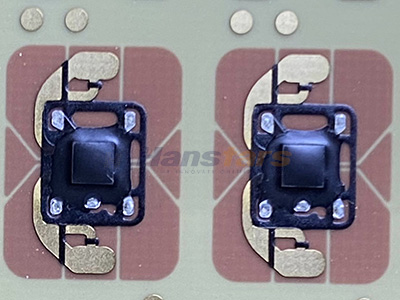
涉及部件:手机SIM卡和银行卡的CSP芯片封装和周边焊点保护
工艺难点:客户目前出现的问题 在做三轮实验时出现胶裂 ,在点胶时还有个难题就是胶固化后的厚度不能超过客户要求的两个厚度一个530微米和470微米,还有点胶不能益胶到胶圈外面
应用产品:用到我司底部填充胶产品
方案亮点:目前我司产品能够很好的满足客户工艺和测试要求
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
芯片
+关注
关注
460文章
52736浏览量
444137 -
SIM卡
+关注
关注
6文章
291浏览量
29753 -
芯片封装
+关注
关注
12文章
582浏览量
31594
发布评论请先 登录
相关推荐
热点推荐
搭载紫光同芯E450R芯片的银行卡试点首发
近日,为贯彻落实国家金融科技发展战略,邮储银行北京分行与国金认证联合发布“金鸿实验室”,并携手产业伙伴重磅发布了系列“基于RISC-V的金融IC卡产品”。其中,搭载全球首款开放式软硬件架构安全芯片E450R的
从原理到实操:SIM卡&银行卡芯片推力测试全解
在当今快速发展的电子产业中,芯片作为核心组件,其性能和质量直接决定了电子产品的整体表现和使用寿命。无论是日常通讯中不可或缺的SIM卡,还是金融交易中广泛使用的银行卡,

芯片封装胶underfill底部填充胶点胶工艺基本操作流程
一、烘烤烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致






 手机SIM卡和银行卡芯片封装和bga底部填充胶方案
手机SIM卡和银行卡芯片封装和bga底部填充胶方案





















评论