季丰MA实验室目前拥有Talos系列透射电镜和HF5000球差矫正透射电镜,具有纳米材料与结构的亚原子尺度分析能力,同时多位博士领衔的工程师团队具有丰富的半导体行业材料分析经验,能为客户提供非常全面的TEM解决方案。
EELS基本原理简介
电子能量损失谱(EELS)是一种通过分析高能入射电子与材料原子发生非弹性碰撞后能量损失特征的先进表征技术,可用于获取材料的成分、化学态及电子结构信息。其在芯片工艺研发和失效分析中具有独特优势,尤其在纳米尺度下可对芯片工艺结构中的材料成分如原子比和掺杂、元素种类和价态、材料禁带宽度和介电常数等进行精细分析。
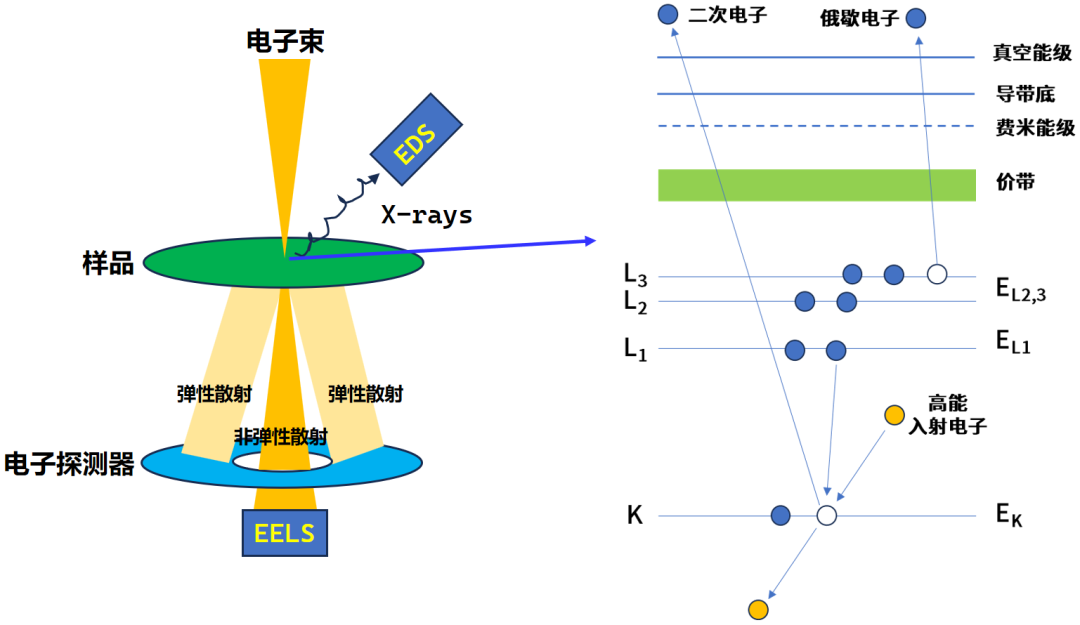
▲图一
电子束与样品原子作用过程
电子与样品相互作用时,能量损失主要分为:
低能损失区(0-50 eV):
对应入射电子诱导的等离子体激发、带间跃迁等,可反映材料的介电性质和载流子浓度。其中等离子体峰也叫指纹峰,因相同元素组成但价态不同的材料的等离子体峰有各自不同的峰形和峰位。
芯损失区(>50 eV):
对应内壳层电子的电离,形成元素特征电离边(如K、L边),这些电离边的形状和位置与元素的多少、种类和价态有关,可用于元素鉴别、成分定量和价态分析等。
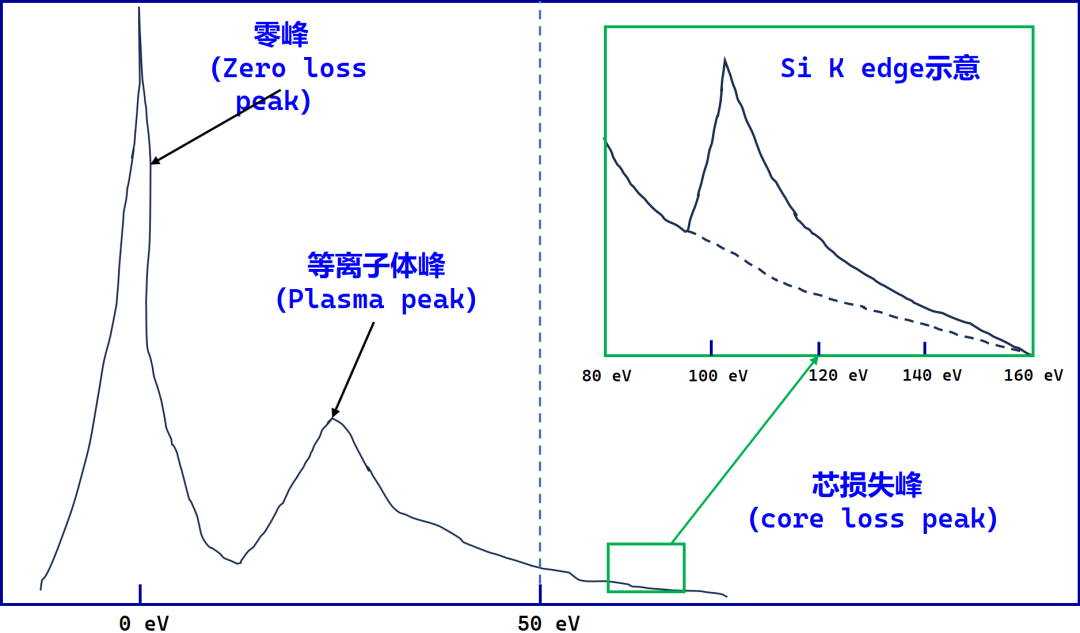
▲图二
EELS谱的构成:零峰、低损失峰(等离子体峰)和芯损失峰
EELS的主要应用
1元素鉴别
目前半导体工业界最常用的检测元素的电子显微镜技术是EDS分析,半导体工艺涉及的元素种类非常多,包含金属如W、Al、Cu、Au、Fe、Ti、Ta、Hf、Co、Ni、Ge、Ga、Ag、Pt等和非金属元素如B、C、N、O、F、Si、P、S、Cl、Ar等,其中很多小原子序数的非金属元素的特征X射线产额低,且易被探测器窗口(如铍窗)吸收,导致信号弱、背景噪声高,定性和定量分析均很困难。轻元素的K层或L层电离边通常出现在低能量范围(如碳的K边约280 eV)。
EELS在低能量损失区域(通常<2000 eV)具有非常高的能量分辨率(可优于1 eV)和灵敏度,能够清晰分辨这些电离边,弥补EDS的较差能量分辨率(一般差于120 eV)的不足,因此EELS成为材料科学、纳米技术等领域中轻元素分析的强有力工具。
EDS在重元素检测中更优,而EELS弥补了轻元素分析的短板。两者结合可在宽元素范围内提供全面分析。

▲表一
TEM中的EDS和EELS技术对比
2掺杂检测
EELS分析系统中的电子探测器(相机)能显著影响EELS谱图质量如信背比和信号收集速率等。直接电子探测器(Direct Electron Detection,DED)是近年来发展起来的一种电子探测器,相比传统的电荷耦合元件(CCD)和互补金属氧化物半导体(CMOS)电子探测器
DED的核心优势包括:
(1)单电子灵敏度:直接转换电子为电信号,避免传统CCD中光转换导致的信号损失;
(2)高信噪比(SNR):在低电子剂量下仍保持低噪声,适合辐照敏感样品;
(3)高动态范围与快速读出:支持高剂量下的微弱信号检测,并减少扫描时间,降低样品漂移影响。
配备有DED的EELS可用于低浓度掺杂如As、P等的检测,以及分析电子束敏感材料(采用非常低的电子剂量)。
3价态分析:化学环境与键合状态解析
元素的近边精细结构(ELNES)反映元素局域化学环境,例如过渡金属如Co、Fe的L边峰形和能量位移可表征其氧化态。高能入射电子电离过渡金属元素时,内壳层电子(如2p电子)被激发,会跃迁到导带中大量未占据的态(如d轨道),导致在电离边处形成较强的尖峰,即所谓白线,同种元素不同价态的白线强度不同,且会存在化学位移,从而可以用于价态分析;

4EELS定量分析
材料中不同原子的EELS的芯损失峰强度与原子占比有关,可以用于较精确的成分定量。EELS定量原理可用下列公式表示[1]:

其中NA和NB分别是原子数目,IA和IB分别是电子强度(芯损失峰积分面积),Δ是窗口大小,Β散射角度,σ散射截面,η是探测器效率。
通过去卷积处理消除仪器点扩散函数产生的展宽效应,结合电离边积分强度与散射截面可以计算元素占比,适用于轻元素定量,如3D NAND存储器件的浮栅中N含量监控,功函数材料TiN中的Ti/N原子比,以及应变Si技术中常用GeSi材料的Ge/Si原子比。
5禁带宽度测量
低能损失区中靠近零峰的平坦区域表示材料中不存在能使入射电子产生该能量损失值的电子态,也即对应材料能带中的禁带区域,从而根据低能损失区的电子跃迁特征(如带间跃迁阈值)可推算材料禁带宽度。
6能量过滤像(Energy filtered TEM)
利用能量过滤器筛选电子束中具有特定能量损失(如O 的K边和Si的L边)的电子进行TEM成像,快速获取样品中各个元素的独立分布图像,可实现对材料成分、化学态和元素分布的原子尺度分析。
利用零损失峰形成的HR-EFTEM相比普通HRTEM图像,过滤掉相干性较差的非弹性散射电子,图像信噪比更好,空间分辨率更高。
EFTEM相比EELS效率高很多,获取一个STEM-EELS mapping需要的时间约为5分钟,且需要更长的时间进行数据处理,而采集一张EFTEM图像花费的时间为2-20s,非常适合大批量筛查芯片工艺过程中的异常成分和形貌。
季丰电子
季丰电子成立于2008年,是一家聚焦半导体领域,深耕集成电路检测相关的软硬件研发及技术服务的赋能型平台科技公司。公司业务分为四大板块,分别为基础实验室、软硬件开发、测试封装和仪器设备,可为芯片设计、晶圆制造、封装测试、材料装备等半导体产业链和新能源领域公司提供一站式的检测分析解决方案。
季丰电子通过国家级专精特新“小巨人”、国家高新技术企业、上海市“科技小巨人”、上海市企业技术中心、研发机构、公共服务平台等企业资质认定,通过了ISO9001、 ISO/IEC17025、CMA、CNAS、IATF16949、ISO/IEC27001、ISO14001、ISO45001、ANSI/ESD S20.20等认证。公司员工超1000人,总部位于上海,在浙江、北京、深圳、成都等地设有子公司。
-
半导体
+关注
关注
335文章
29188浏览量
242619 -
显微镜
+关注
关注
0文章
661浏览量
24510 -
电子束
+关注
关注
2文章
122浏览量
13686
原文标题:透射电子显微镜(TEM)中的EELS分析技术
文章出处:【微信号:zzz9970814,微信公众号:上海季丰电子】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
PONY谱尼测试提供专业电子检测服务
常见能量收集技术
射频能量采集技术的全面介绍
如何利用仿真研究无线能量传输技术?
激光器系统能量损失的克服方法介绍
电镜技术中四维电子能量损失谱
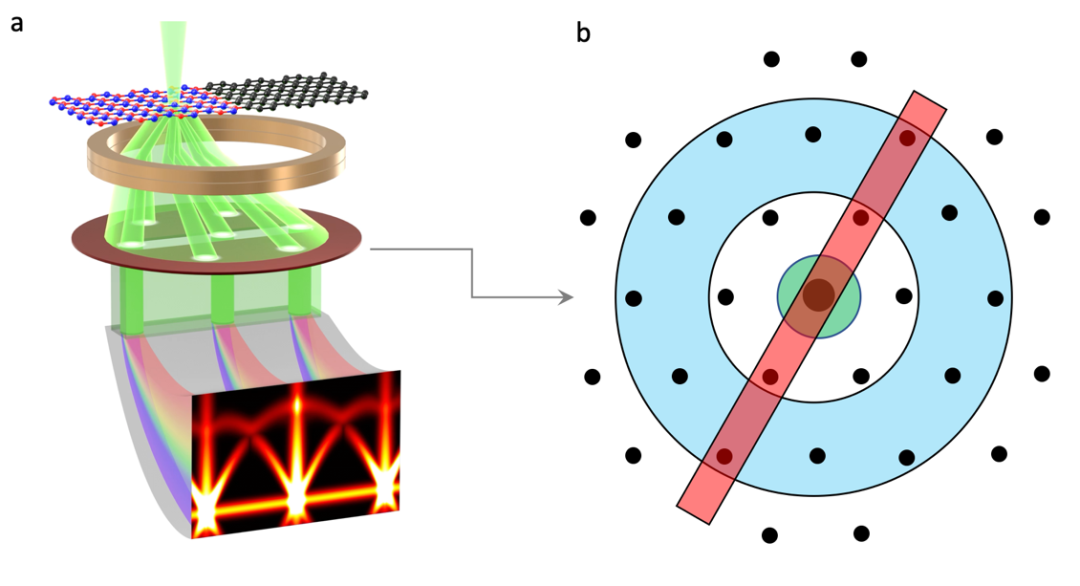
振动光谱的前景
透射电子显微镜(TEM)与聚焦离子束技术(FIB)在材料分析中的应用






 电子能量损失谱(EELS)技术解析
电子能量损失谱(EELS)技术解析

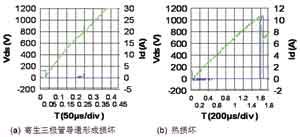











评论