在半导体芯片的研发与失效分析环节,聚焦离子束双束系统(FIB - SEM)凭借其独特的功能,逐渐成为该领域的核心技术工具。简而言之,这一系统将聚焦离子束(FIB)的微加工优势与扫描电子显微镜(SEM)的高分辨率成像能力相结合,实现了加工与观测的高效协同,为芯片技术的持续进步提供了坚实保障。
技术原理与核心优势
FIB - SEM 双束系统由 FIB 模块、SEM 模块以及多轴样品台构成,形成了一个 “加工 - 观测” 一体化的操作平台。
1.FIB 模块
利用液态金属离子源(LMIS)产生的镓离子束(Ga?),能够进行纳米级别的刻蚀、沉积以及样品制备等精细加工操作。它可以在极小的芯片结构上实现材料的去除或添加。
2. SEM模块
通过二次电子成像技术,实时监控加工过程,其定位精度可达到亚微米级别。这确保每一步操作都能精准地进行,无论是微小结构的尺寸测量,还是加工过程中位置的精准确认,SEM 模块都能发挥重要作用。
3.FIB-SEM
双束系统的协同优势主要体现在以下几个方面:首先,双束同步工作支持三维重构技术。通过对芯片不同层面的连续切片与成像,再利用计算机算法进行数据处理,可以重建出芯片内部的三维结构模型,这有助于直观地观察芯片内部的复杂架构,对于芯片的设计验证与失效分析都具有重要意义。其次,定点加工能力使得能够在芯片的特定区域进行精准的材料去除或添加操作,为芯片的定制化修改和缺陷修复提供了技术手段。
核心应用场景
为方便客户对材料进行深入的失效分析及研究。
(一)材料微观截面截取与观察
1. 芯片内部结构分析 :借助 FIB - SEM 系统,实现对芯片晶体管栅极、金属互连层等关键部位的精准切割,获得清晰无损的断面,为后续分析提供高质量样本,助力研究人员精准把握芯片设计与制造工艺细节,及时察觉潜在缺陷。
FIB切割芯片金道
(二)透射电镜(TEM)样品制备
1. 超薄样品制备 :在透射电镜样品制备中,FIB-SEM 技术通过离子束逐层减薄,制备出厚度小于 100 纳米且保留原子级晶格信息的超薄样品。金鉴实验室在进行试验时,严格遵循相关标准操作,确保每一个测试环节都精准无误地符合标准要求。
实验室TEM制样
2. 先进制程中的缺陷分析 :针对 3 纳米以下制程芯片,FIB-SEM 技术精准剖析栅极氧化层缺陷与界面特性,为工艺改进和缺陷控制提供关键数据,推动芯片制造技术向更小尺寸、更高性能发展。
(三)芯片线路修改
1. 线路修复与优化 :FIB-SEM 系统可切断短路线路并沉积导电材料修复断路,提升良品率降低成本,还能快速修改多项目晶圆线路,加速研发进程。
2. 诱导沉积材料 :利用电子束或离子束将金属有机气体化合物分解,从而可在样品的特定区域进行材料沉积。本系统沉积的材料为Pt,沉积的图形有点阵,直线等,利用系统沉积金属材料的功能,可对器件电路进行相应的修改,更改电路功能。
(四)封装级失效分析
1. 深埋缺陷横截面制备 :结合飞秒激光技术,FIB-SEM 系统高效制备深埋缺陷横截面,清晰呈现缺陷形态与分布,为改进封装工艺提供依据。
2. 漏电区域定位与失效机制分析 :电子束诱导电流成像技术助力精准定位漏电区域,结合 FIB-SEM 的观察与分析功能,深入探究失效机制,提升封装可靠性。
结论
总的来说,FIB - SEM 双束系统凭借其微纳加工与高分辨成像的协同优势,在半导体芯片研发与失效分析领域发挥着不可替代的作用。随着半导体技术的不断演进,FIB - SEM 技术将持续助力半导体制造工艺的升级与创新。
-
SEM
+关注
关注
0文章
264浏览量
15065 -
fib
+关注
关注
1文章
107浏览量
11475 -
半导体芯片
+关注
关注
61文章
936浏览量
71554
发布评论请先 登录
如何利用FIB和SEM中的有源和无源电位衬度进行失效定位呢?
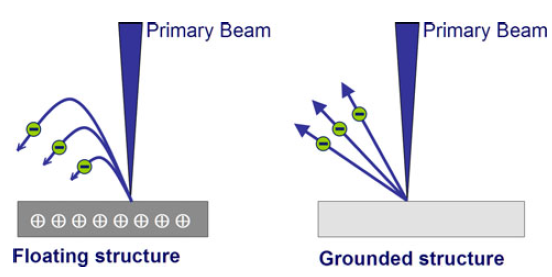
半导体芯片结构分析
聚焦离子束显微镜(FIB-SEM)
芯片漏电点FIB切片分析
FIB-SEM双束技术及应用介绍
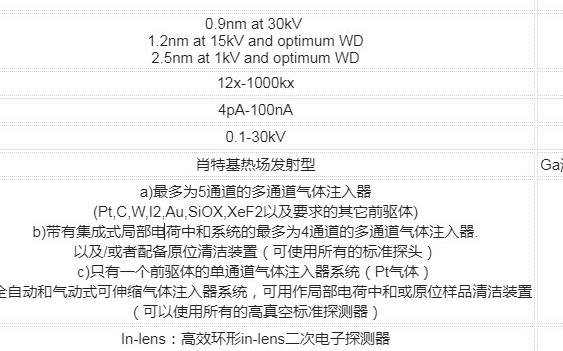
FIB-SEM双束系统在材料科学领域的应用
聚焦离子束显微镜(FIB-SEM)材料分析

聚焦离子束扫描电镜(FIB-SEM)技术原理、样品制备要点及常见问题解答

FIB-SEM技术全解析:原理与应用指南
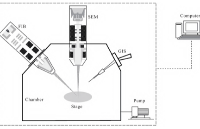
FIB-SEM 双束技术简介及其部分应用介绍
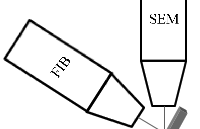
案例展示||FIB-SEM在材料科学领域的应用
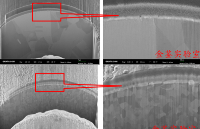





 FIB - SEM 技术在半导体芯片领域的实践应用
FIB - SEM 技术在半导体芯片领域的实践应用

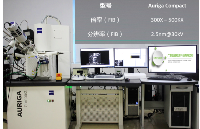
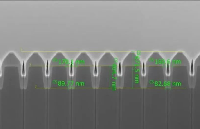











评论