在半导体材料领域,碳化硅(SiC)因其卓越的电导性、热稳定性和化学稳定性而成为制作高功率和高频电子器件的理想材料。然而,为了实现这些器件的高性能,必须对SiC进行精细的表面处理。化学机械抛光(CMP)技术作为实现这一目标的关键工艺,通过化学作用和机械摩擦的协同效应,能够去除材料表面的缺陷和不平整,从而获得光滑平整的表面。工艺完成后,利用美能光子湾共聚焦显微镜对SiC表面粗糙度进行精确测量,是评估CMP效果的重要手段。
Part.01
碳化硅SiC
碳化硅SiC,作为第三代半导体材料,是一种具有出色光电性能的宽禁带半导体,其优点在于物理化学稳定性高,如高硬度、高温耐受性和耐腐蚀性,在电力电子、航空航天、新能源汽车等领域中展现出巨大的应用潜力。
在单晶生长工艺中获得SiC晶碇之后,需要对SiC衬底进行精细制备,这一过程主要包含以下几个关键步骤:

碳化硅SiC加工流程
Part.02
化学机械抛光(CMP)
CMP,全称为Chemical Mechanical Polishing,即化学机械抛光,是借助超微离子研磨作用以及浆料的化学腐蚀作用在被研磨的介质表面上形成光洁的平面。
CMP工艺是一种在半导体制造中常用的关键工艺技术,主要用于实现晶圆表面平坦化。它通过结合机械削磨和化学腐蚀,去除半导体材料表面的凸起部分和凹陷部分,以提高晶片的平坦度。
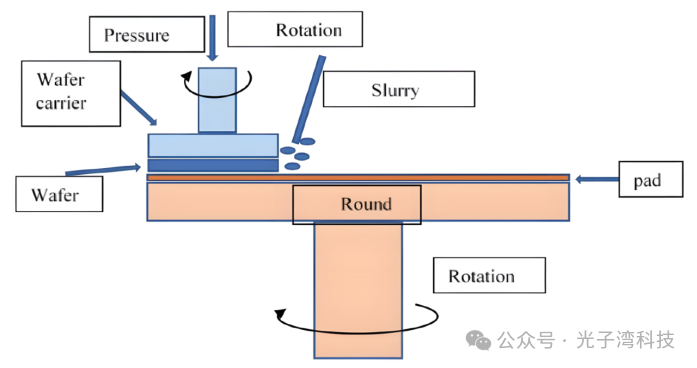
化学机械抛光工艺示意图
其中放置在晶圆和抛光垫之间的颗粒产生的界面摩擦会影响材料去除率(MRR)。CMP中的摩擦力受多种因素影响,例如晶圆的材料、抛光垫的特性、磨蚀颗粒的类型以及加工过程中的压力和速度。此外,CMP中的摩擦力还受到抛光液与晶圆之间化学反应的影响。
在碳化硅化学机械抛光(CMP)中,提高机械材料去除效率主要有两种方法:1)通过磨蚀颗粒提高材料去除效率;2)增强化学反应活性。
Part.03
多晶硅化学机械抛光(MAS CMP)
加入磨蚀颗粒使用是作为提高碳化硅化学机械抛光工艺中机械材料去除的一种有效方法。使用含有120nm胶体二氧化硅颗粒和30nm的TiO2颗粒的混合磨蚀浆液,并创建纳米压痕。
其中MAS中的硬磨料(TiO2)负责碳化硅的机械去除,而软磨料(胶体二氧化硅)则具有降低表面粗糙度的效果。
Part.04
光催化辅助化学机械抛光(PCMP)
光催化辅助化学机械抛光(PCMP)通过利用TiO2光催化剂进行光催化氧化,将其涂抹在抛光垫上,并控制CMP设备中的气体环境,用紫外线进行照射,来激活化学机械抛光过程中的化学反应。
当光能(紫外线;UV)照射到TiO2的带隙上时,会在其表面产生电子和空穴,导致光催化剂表面电子与氧气反应形成超氧离子,空穴与水(或湿气)反应产生羟基自由基。
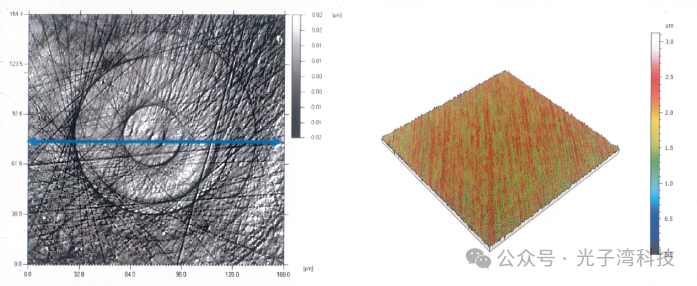
光学元件的表面质量是影响光学系统成像分辨率的重要因素,在经过减薄或研磨工艺后,SiC衬底表面损伤深度通常为2-5μm,这需要通过抛光工艺来提高表面质量,尽量降低表面粗糙度和亚表面损伤层深度。对工艺后的晶圆片进行表面粗糙度表征,可以判断抛光工艺是否达到理想效果,这一过程对于确保器件性能和可靠性至关重要。
ME-PT3000
美能光子湾3D共聚焦显微镜

美能光子湾3D共聚焦显微镜是一款用于对各种精密器件及材料表面,可应对多样化测量场景,能够快速高效完成亚微米级形貌和表面粗糙度的精准测量任务,提供值得信赖的高质量数据。
超宽视野范围,高精细彩色图像观察
提供粗糙度、几何轮廓、结构、频率、功能等五大分析功能
采用针孔共聚焦光学系统,高稳定性结构设计
- 提供调整位置、纠正、滤波、提取四大模块的数据处理功能
随着碳化硅(SiC)技术的不断进步,其在高功率和高频电子器件领域的应用前景愈发广阔。通过化学机械抛光(CMP)工艺的优化,我们不仅提升了SiC晶圆的表面质量,更确保了其在极端条件下的性能稳定性。美能光子湾3D共聚焦显微镜的应用,为SiC表面粗糙度的精确测量提供了强有力的技术支持,进一步推动了SiC材料在电力电子、航空航天、新能源汽车等关键领域的应用。
-
半导体
+关注
关注
335文章
29145浏览量
242032 -
SiC
+关注
关注
32文章
3259浏览量
65886 -
碳化硅
+关注
关注
25文章
3095浏览量
50749
发布评论请先 登录





 半导体碳化硅SiC制造工艺CMP后晶圆表面粗糙度检测
半导体碳化硅SiC制造工艺CMP后晶圆表面粗糙度检测

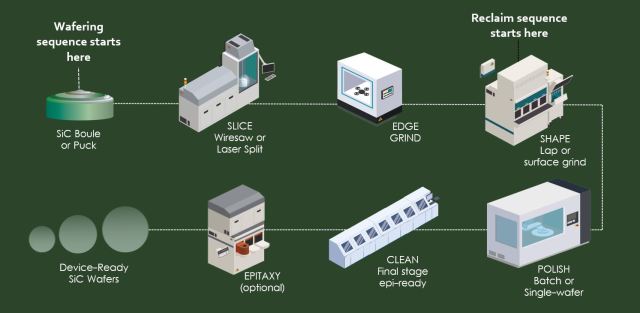

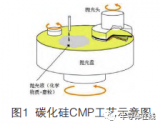










评论