采用氧化局限技术制作面射型雷射元件最关键的差异在于磊晶成长时就必须在活性层附近成长铝含量莫耳分率高于95%的砷化铝镓层,依据众多研究团队经验显示,最佳的铝含量比例为98%,主要原因在于这个比例的氧化速率适中,而且氧化后较不容易因为热应力造成上反射镜磊晶结构破裂剥离。砷化铝(AlAs)材料氧化机制普遍认为相对复杂,可能的化学反应过程可能包含下列几项:

通常在室温环境下铝金属表面自然形成的氧化铝是一层致密的薄膜,可以保护内部金属不会进一步被氧化,但是在较高温度条件下氧化的铝会形成y相的氧化铝(y-Al2O3),结构中会有许多细微孔洞可以让反应物(水气或氧气)输送到更深处与未氧化的铝原子继续进行反应。为何高铝含量的砷化铝镓材料中铝含量的些微波动会导致显著的氧化速率变化,研究人员从比较铝和镓的吉布斯自由能(Gibbs free energy)来推测部分可能原因,铝和镓金属的吉布斯自由能如下列公式5-8、5-9:

由上式可知铝氧化过程中比镓释放更多能量,同时考量到通水蒸气进行湿氧化过程中氢气也参与部分反应过程,因此下列自由能公式推论出砷化铝在425°C(698k)温度下进行湿氧化过程中的吉布斯自由能。

若将公式5-10的AlAs以GaAs取代,则△G698=+10 kJ/mol,这表示以镓原子取代部分铝原子形成AlGaAs会让氧化反应较不易进行(所需能量较高),而且镓含量愈高愈不容易氧化。但是尽管砷化铝有较高的氧化速率,氧化后的较大残留应力让元件结构较不稳定,因此后来大多数砷化镓系列材料氧化局限面射型雷射大多采用铝含量98%的Alo.98Gao.02As作为氧化层以获得最佳的氧化速率与元件结构强度。除了铝含量比例以外,氧化速率也与氧化温度和反应物浓度有关,通常采用的氧化温度在400°C到450°C之间,下图5-24为30nm厚的Alo.99Gao.01As在400°C、425°C和450°C温度下固定氮气流量与反应物水温所得到的氧化时间与氧化深度关系图。氧化层厚度也会影响氧化速率,一般越薄的氧化层因为水气要扩散到元件内部所需的时间较长,因此氧化速率较慢,但是当氧化层厚度超过50nm以后,氧化速率就几乎不再受厚度增加影响。

虽然较高温度下可以获得较快的氧化速率,但是一般来说稍慢的氧化速率有助于精确控制氧化深度,同时较低的氧化温度也可以避免在氧化反应终止样品冷却降温过程中可能遭受到温度剧烈变化以及残留热应力导致氧化层上方DBR破裂剥离的风险。选择性氧化制程时间控制非常严苛主要的原因在于氧化反应通常只能进行一次,一旦氧化时间太短导致氧化深度不足,原本较多孔隙可以供水气渗透进行氧化反应的y-Al2O3;在降温过程中可能会转换为较致密的a-Al2O3,因此如果发现氧化深度不足,再把样品放回氧化炉中也无法再一次对更内部尚未反应的材料进行氧化,即使再次增加氧化时间或提高温度,最有可能发生的是原本的氧化层产生不规则裂隙让水气扩散进入内部继续氧化,但是原本比照蚀刻mesa形状的氧化孔径(oxide aperture)也会因此变成不规则,同时也无法控制最终的电流孔径尺寸。另一方面,如果氧化时间太长,那么所有原本可导通电流的砷化铝镓层全部被转变成绝缘的氧化铝,完全没有留下可供载子流通的电流孔径,那么整批样品就报废无法使用了,因此精确控制氧化时间以期能一次达到最终所需的氧化孔径是氧化局限面射型雷射最关键的制程步骤。
选择性氧化制程所使用的湿式氧化炉管(wet oxidation furnace)如下图5-25所示,其基本构造主要包含一个可以均匀加热面射型雷射磊晶片的承载座或炉管加热腔体,并利用氮气作为输送气体将加热的纯水蒸发的水气吹送至氧化炉中,与蚀刻暴露出来的高铝含量氧化层进行化学反应。采用氮气吹送水蒸气而非直接通氧气主要原因在于氧气反而会抑制砷化铝镓氧化反应进行,推测其可能原因应该是氧气与砷化铝镓反应会在表面形成致密的氧化铝,反而会形成保护层让内部未被氧化的砷化铝镓不再反应。
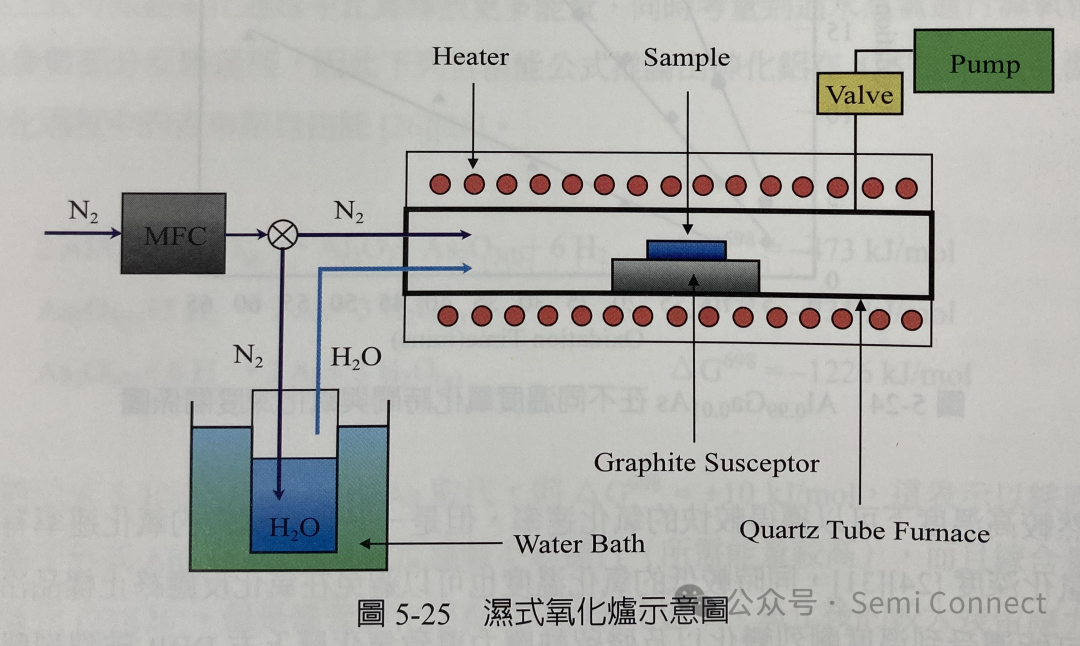
氧化炉温度分布均温区必须仔细校正,在晶片放置处温度变化率应控制在摄氏士0.1°C以内,以避免温度变化影响氧化速率,并且在样品处随时监测氧化温度。高铝含量砷化铝镓层氧化速率对温度变化相当敏感,因此精确控制氧化温度对于达成高再现性是必要的条件,同时水气加热温度关系到反应物浓度,因此也会影响氧化速率,图5-26显示三种不同水温条件下砷化铝镓层氧化速率关系。
完成选择性氧化制程后,必须观察氧化后的电流局限孔径大小符合元件制作需求,但是该氧化层却位在高反射率的DBR底下,通常难以借由一般的可见光光学显微镜直接观察,可能必须借助红外光电荷耦合元件(charge coupled device, CCD)或者SEM等间接方式来观察。但是长波长红外光CCD相对昂贵,通常解析度也比较低,因此也很难直接观察到1.3微米波长的面射型雷射动辄5~6微米深的氧化层结构,透过SEM观察劈开晶片剖面可以大致确认氧化深度,但是通常劈开面位置不会恰好是元件发光区的直径,有可能只是圆形mesa的任一弦,因此直接由光学影像观察仍然是最准确的方式。下图5-27即为光学显微镜观察完成选择性氧化制程的面射型雷射元件,较亮的同心圆即为氧化层,因为AlGaAs氧化成为AlxOy后,折射率由3减少为1.6左右,与相邻未被氧化的Al0.12Ga0.88As(n=3.5)之间折射率差异增加为△n=1.9,使得氧化层上方反射率增加,因此比周遭未被氧化的区域更能将光学显微镜光源反射回来,形成更明亮的影像区域。
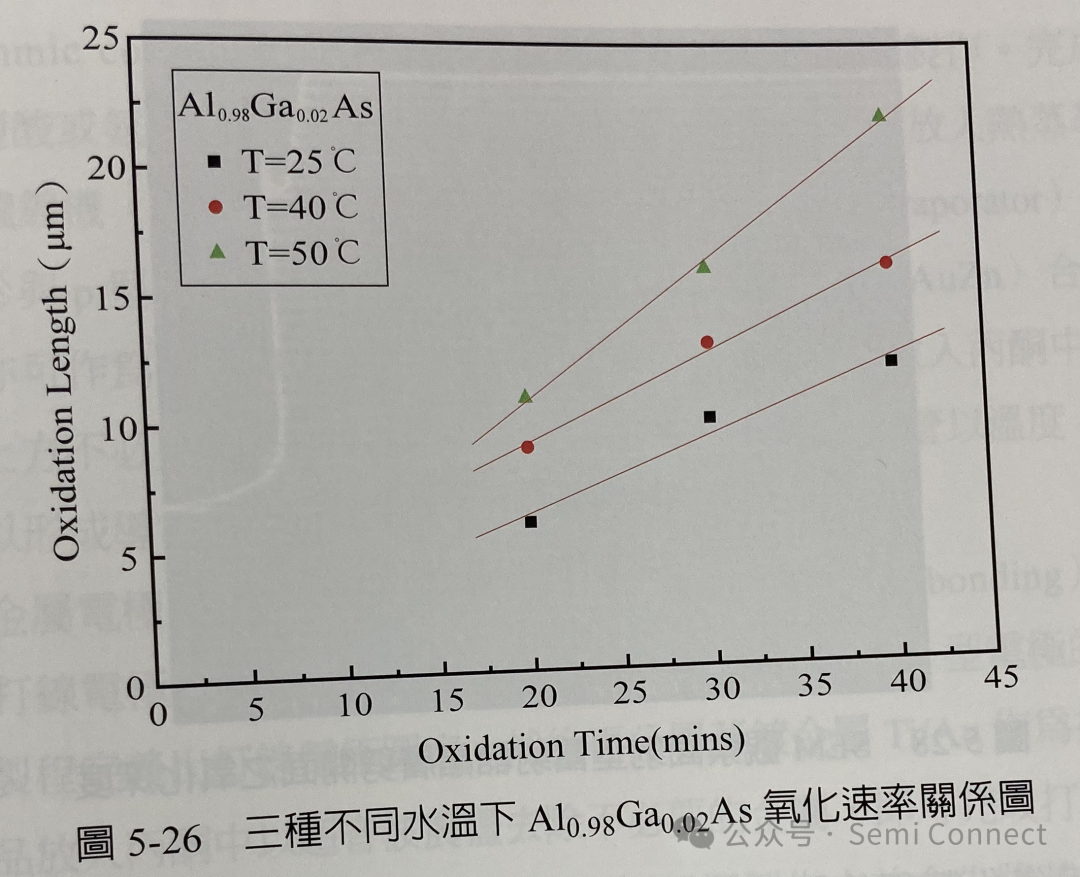

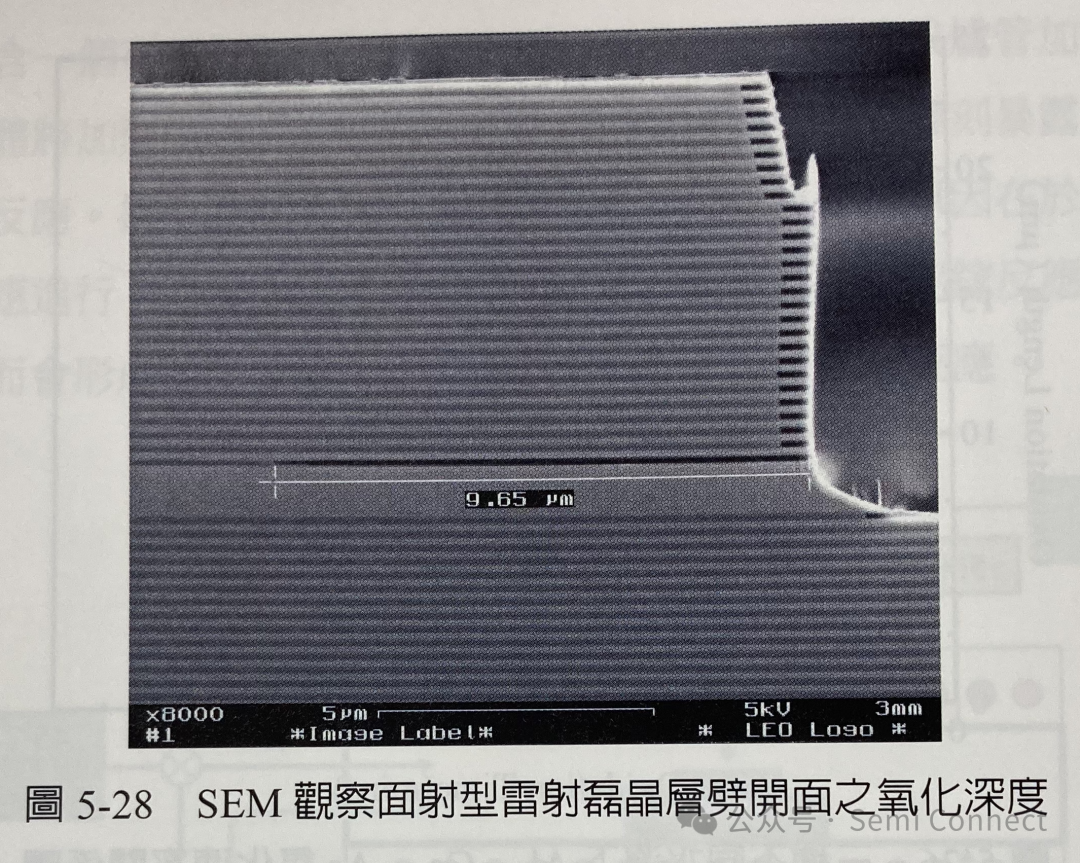
图5-28即为氧化制程后将元件劈开再透过SEM从劈开面观察氧化深度,由图中可以观察到,面射型雷射磊晶层结构中周期排列的交错线条即为DBR,颜色最淡的是Al0.12Ga0.88As,稍微深色的是Al0.92Ga0.08As,黑色线段就是被氧化形成的AlxOy,较长者就是Al0.98Ga0.02As氧化层,氧化层下方较厚的浅色结构就是等效1个波长的活性层增益区;较短的黑色线段就是Al0.92Ga0.08As被氧化形成的AlxOy,比较两者氧化深度差异就可以发现铝含量仅差异6%就可以造成氧化速率的显著变化。
-
氧化
+关注
关注
0文章
32浏览量
16159
原文标题:选择性氧化
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
AST埃斯特SEL-32D在线选择性焊接机:高效精密PCB焊接解决方案效精密PCB焊接
专为灵活生产而生!AST埃斯特 ASEL-450选择性波峰焊设备,省空间、省电、更省心!
小批量多品种生产困局破冰:选择性波峰焊如何重塑柔性电子制造竞争力
Keithley 6517B静电计在离子选择性电极和pH测量中的优势

PCBA 加工必备知识:选择性波峰焊和传统波峰焊区别大揭秘
半导体选择性外延生长技术的发展历史

什么是高选择性蚀刻
22.0%效率的突破:前硅多晶硅选择性发射极双面TOPCon电池的制备与优化

SiGe与Si选择性刻蚀技术
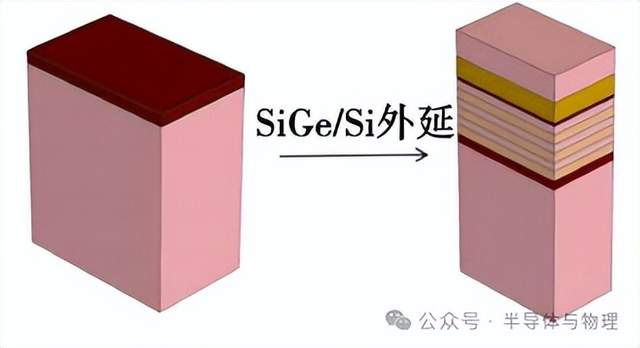
选择性沉积技术介绍
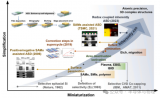
矿井电网选择性绝缘在线监测
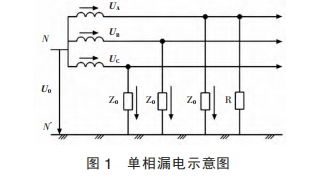





 选择性氧化知识介绍
选择性氧化知识介绍












评论