一、玻璃基板为何有望成为封装领域的新宠?
玻璃基板在先进封装领域备受关注,主要源于其相较于传统硅和有机物材料具有诸多显著优势。
从成本角度看,玻璃转接板的制作成本约为硅基转接板的 1/8 ,这得益于大尺寸超薄面板玻璃易于获取且无需沉积绝缘层。在电学性能方面,玻璃材料介电常数仅约为硅材料的 1/3,损耗因子比硅低 2 - 3 个数量级,可有效减小衬底损耗和寄生效应,提升信号传输完整性。同时,玻璃基板具备大尺寸超薄特性,康宁等厂商可量产大于 2m×2m 的超大尺寸和小于 50μm 的超薄面板玻璃。此外,其工艺流程简单,无需在衬底表面及 TGV 内壁沉积绝缘层,超薄转接板也无需二次减薄,且机械稳定性强,当转接板厚度小于 100μm 时翘曲较小 。
英特尔持续加码玻璃基板领域,早在十年前就开始探索,计划于 2030 年批量生产玻璃基板封装芯片,认为玻璃基板有望成为下一代主流基板材质,这也推动了玻璃基板在行业内的关注度提升。
二、TGV 在玻璃基板应用中起到什么关键作用?
TGV(Through Glass Via,玻璃通孔)技术是玻璃基板应用于先进封装的关键工艺。它是 TSV 技术的延续,主要区别在于基板种类,TGV 采用高品质硼硅玻璃、石英玻璃作为中介层基板,以获得比硅中介层更好的封装表现。
在 3D 封装中,以 HBM 工艺为例,TSV 是关键技术之一,而对于玻璃基板的 3D 封装,TGV、铜孔的填充及其 RDL 成为关键工艺。TGV 技术的优势在于可降低信号传输距离,增加带宽并实现封装小型化。同时,TGV 作为 TSV 的低成本替代方案,逐渐受到广泛关注,因为硅基转接板存在成本高和电学性能差的问题,而 TGV 省去了沉积隔离层、绝缘层的过程。然而,TGV 目前面临通孔成孔工艺以及高质量填充两方面的挑战。
三、玻璃通孔成孔技术有哪些?各有何特点?
喷砂法:加工前需在玻璃基板制作复合掩模,然后进行干粉喷砂蚀刻,需两侧蚀刻且保证中心点对称。该方法制作的通孔粗糙、孔径大且一致性差,只能制作孔径大于 200μm、间距较大的玻璃通孔,沙粒碰撞还会对玻璃表面及孔侧壁造成损伤,在先进封装工艺中应用较少。
聚焦放电法:将玻璃放在两电极间,通过放电熔融和内部应力形成通孔,可制备多种玻璃通孔,均匀性好、无裂纹,但单次单孔制作,生产效率低,通孔形状不垂直,可能影响后续填充。
等离子体刻蚀法:先在石英玻璃蒸发铝层作硬掩模,光刻后用氯气等腐蚀铝层,再用氧气等离子体去光刻胶,最后蚀刻石英形成 TGV。该方法可大面积刻蚀多个 TGV,生产效率较高,侧壁粗糙度小、无损伤,可靠性好,但工艺复杂、成本高且刻蚀速率慢。
激光烧蚀法:利用激光能量烧蚀玻璃形成通孔,如激光形成的 TGV 侧壁裂纹多,准分子激光形成的 TGV 孔壁粗糙度大且成孔效率低。
电化学放电加工法:结合电火花和电解加工,通过电解液的电化学放电和化学腐蚀去除材料。工艺简单、设备要求低,但只能加工孔径大于 300μm 的锥形玻璃通孔,应用范围受限。
光敏玻璃法:通过紫外曝光、热处理、湿法刻蚀等加工,可实现各向异性刻蚀,获得高密度、高深宽比通孔,但光敏玻璃材料和工艺成本高,不同尺寸图形刻蚀精度差别大,高温处理易导致结构偏移。
激光诱导刻蚀法:通过脉冲激光诱导玻璃产生变性区,再用氢氟酸刻蚀形成通孔。可形成孔径大于 20μm 的玻璃通孔,成孔质量均匀、一致性好、无裂纹,成孔速率快且形貌可调,但存在激光诱导速度慢、制备过程复杂等缺点,不过该方法具有低成本优势,有大规模应用前景。
四、玻璃通孔填孔技术如何实现高质量金属填充?
高质量的金属填充是玻璃通孔应用的另一技术难点。一方面,TGV 孔径大、形状多样(盲孔、垂直通孔、X 型通孔、V 型通孔),对铜沉积挑战大,易堵塞;另一方面,玻璃与常用金属粘附性差,易分层、卷曲、脱落。目前主要填充工艺如下:
Bottom-up 填充:用于 TGV 盲孔填充,通过在孔口侧壁及表面添加抑制剂,底部添加加速剂,使铜自下而上填充,确保盲孔无孔洞和缝隙。
蝶形填充:适用于垂直 TGV 通孔。先在通孔壁按 “两边多,中间少” 涂抹抑制剂,使铜在孔中心优先沉积形成蝶形,随后转变为 Bottom - up 填充实现完全填充。Dimitrov 课题组提出的改良方案,使用酒精预润湿、特定镀液和添加剂,可在一定时间内实现不同深宽比 TGV 的完整填充,但工艺复杂,工业化生产难度大。
Conformal 填充:通过添加剂使孔内铜沉积速率与孔侧壁及表面相当,适用于 X 和 V 型通孔。X 形、V 形通孔特殊形状可避免中央孔洞缺陷,相比垂直通孔的 BFT 电镀模式,可在更大电流密度下实现快速完整填充。
TGV 孔内电镀薄层:在保证电学性能前提下,可减小电镀时间和成本,孔深和孔径适用范围更大。通常需先沉积金属粘附层,近年来研发人员开发化镀 Cu 种子层低成本填充方案,如美国安美特公司通过形成金属氧化物黏附层,乔治亚理工学院采用环氧聚合物干膜增强 Cu 与玻璃的结合力。
五、玻璃基板产业链上有哪些重点公司?
玻璃基板供应商:
海外方面,美国康宁是全球龙头,可提供 4 - 12 英寸、厚度 100 - 700μm 的玻璃晶圆基板,TGV 孔径 20 - 100μm,深宽比可达 10:1。德国肖特公司的 Hermes 玻璃晶圆基板可用于多种器件封装;Mosaic Microsystems 公司能提供全流程玻璃晶圆加工服务;日本印刷株式会社开发出玻璃芯基板产品。
国内厂商也在快速发展,云天半导体突破 4 - 12 寸晶圆级系统封装能力,TGV 关键指标达国际领先;沃格光电掌握多项核心技术,玻璃基 Mini LED 背光产品量产,TGV 载板通过客户验证;森丸电子专注于无源互连特殊工艺,可提供多种尺寸玻璃晶圆;三叠纪突破亚 10 微米通孔和填充技术;赛微电子旗下瑞典代工厂掌握领先的 TGV 工艺;五方光电的玻璃基板用于光学垫片和车载领域;蓝特光学的 TGV 玻璃晶圆应用于多个领域。
TGV 设备厂商:
激光开孔设备厂商中,LPKF 的 Vitrion S 5000 系统适用于多种玻璃基板加工,TGV 孔径最小 10 微米,深宽比可达 10:1(部分材料 50:1);4JET Microtech 的 VLIS 工艺可高效制备高精度 TGV。国内帝尔激光推出 TGV 激光微孔设备,大族激光研制出激光诱导蚀刻快速成型技术设备,德龙激光研发出玻璃通孔等激光精细微加工设备。
电镀设备方面,美国泛林公司推出 Kallisto 和 Phoenix 两款 TGV 电镀解决方案;盛美上海是国内前道电镀设备领先企业,其电镀设备可应用于多通道先进封装关键电镀步骤。
-
封装
+关注
关注
128文章
8832浏览量
145934 -
玻璃基板
+关注
关注
1文章
100浏览量
10886
原文标题:玻璃基板:先进封装领域的变革力量与投资洞察
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
玻璃基板:半导体封装领域的“黑马”选手

3D封装玻璃通孔技术的开发

玻璃基板的技术优势有哪些
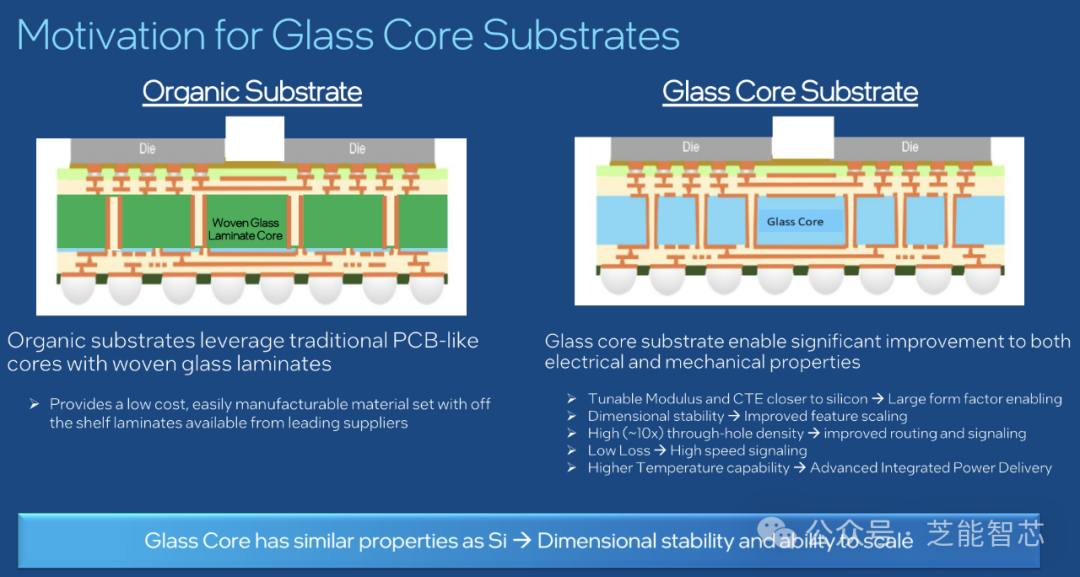





 玻璃基板为何有望成为封装领域的新宠
玻璃基板为何有望成为封装领域的新宠

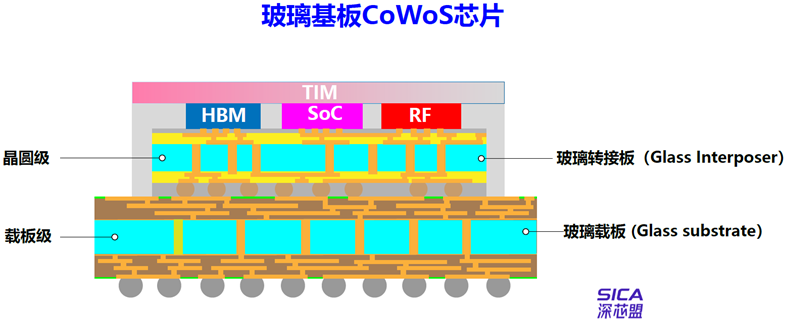

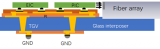





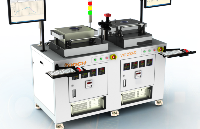










评论