近日,电科装备旗下北京中电科电子装备有限公司8-12寸系列减薄机发货突破百台,自主开发的减薄设备通过产业应用端的认可。
减薄设备是集成电路制造不可或缺的关键装备,主要用于集成电路材料段晶圆表面加工,以及在集成电路封装前对晶圆背面基体材料进行去除,以满足晶圆精确厚度和精细表面粗糙度的要求,同时该设备还可应用于化合物半导体、特种陶瓷等其他领域。
北京中电科电子装备有限公司坚持减薄与工艺技术自立自强,成功解决了系列关键技术,相继推出了多款8-12寸系列减薄设备,最新研制的碳化硅全自动减薄设备,重要技术指标和性能对标国际先进水平。目前,8-12寸系列减薄设备形成了多领域产品谱系,填补了国内材料、芯片装备行业在超精密减薄技术领域空白。
-
集成电路
+关注
关注
5433文章
12194浏览量
369508 -
晶圆
+关注
关注
53文章
5222浏览量
130344 -
封装
+关注
关注
128文章
8859浏览量
146041
原文标题:突破百台!电科装备8-12寸系列减薄机通过产业应用端认可
文章出处:【微信号:第三代半导体产业,微信公众号:第三代半导体产业】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
晶科储能检测中心获得CNAS认可资格
研磨机6-8-12寸研磨盘FNNS-510000-0 21H017CW是什么
精密传感技术驱动半导体未来:明治传感器在CMP/量测/减薄机的应用
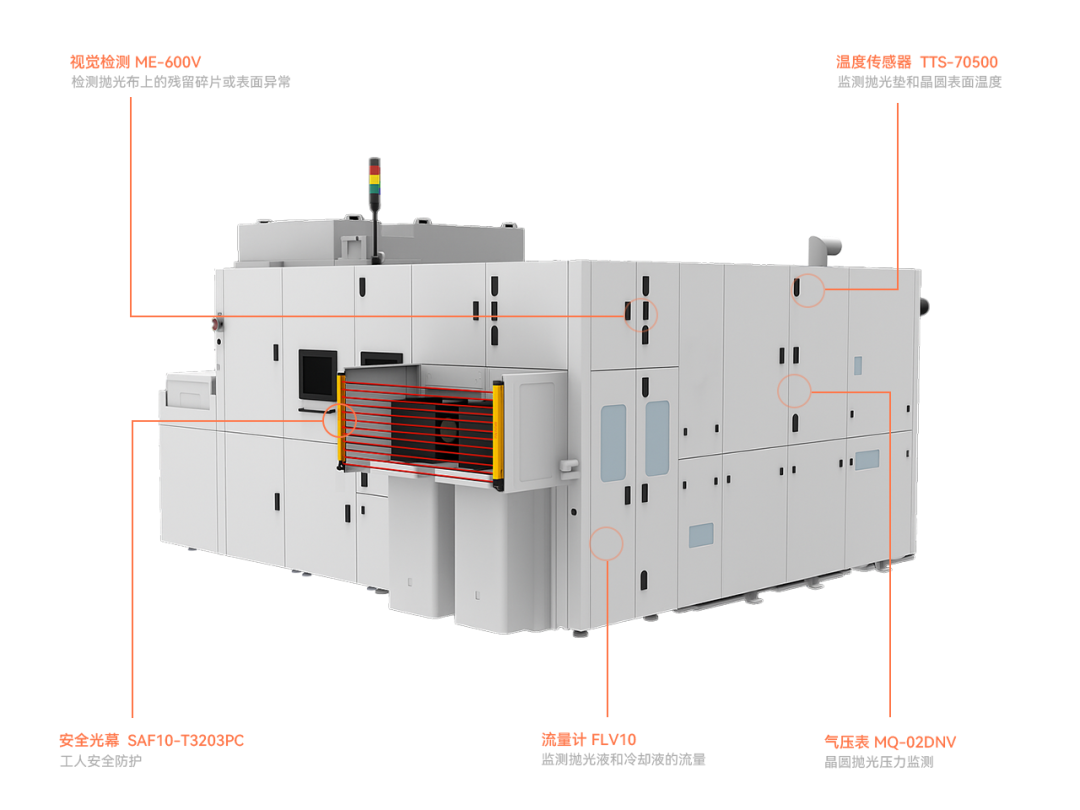
晶圆减薄工艺分为哪几步
12英寸SiC,再添新玩家
中软国际科创中心驱动AI产业未来发展
简单认识晶圆减薄技术
减少减薄碳化硅纹路的方法






 电科装备8-12寸系列减薄机通过产业应用端认可
电科装备8-12寸系列减薄机通过产业应用端认可














评论