华为技术有限公司最近增加了多项专利信息,其中一项专利名称为“一种芯片封装以及芯片封装的制备方法”,公开号码为cn116547791a。
根据专利摘要,这次申请有助于芯片性能的提高。芯片包包括基板、该裸芯片、第一保护结构及屏蔽结构;该裸芯片、第一保护结构和屏蔽结构都设置在基板的第一表面。该包裹第一保护结构,芯片侧面堵塞的包裹,不仅第一保护结构背离该裸芯片的半导体表面,还有芯片第一表面1,保护结构的第一表面及其结构阻挡的第一表面,其中该裸芯片的第一表面为该裸芯片背离该基板的表面,该第一保护结构的第一表面为该第一保护结构背离该基板的表面,该阻隔结构的第一表面为该阻隔结构背离该基板的表面。
据了解,截至2022年底,华为拥有有效授权专利超过12万项,主要分布在中国、欧洲、美洲、亚太、中东、非洲。华为在中国和欧洲分别拥有4万多项专利,在美国拥有22000多项专利。
-
芯片
+关注
关注
460文章
52799浏览量
445289 -
华为
+关注
关注
216文章
35309浏览量
257225 -
结构
+关注
关注
1文章
119浏览量
22053 -
基板
+关注
关注
2文章
312浏览量
23613
发布评论请先 登录
汉思新材料取得一种系统级封装用封装胶及其制备方法的专利

采用扇出晶圆级封装的柔性混合电子

突破!华为先进封装技术揭开神秘面纱
降压恒压芯片H6225L 输入8V-60V降压12V 60V降压5V 60V降压3.3V/1.3A
超声波焊接有利于解决固态电池的枝晶问题
顺络贴片电感的微型化封装是否会影响性能?


苹果公开新专利:可折叠设备铰链
BGA芯片在汽车电子中的应用

浅谈英特尔在先进封装领域的探索
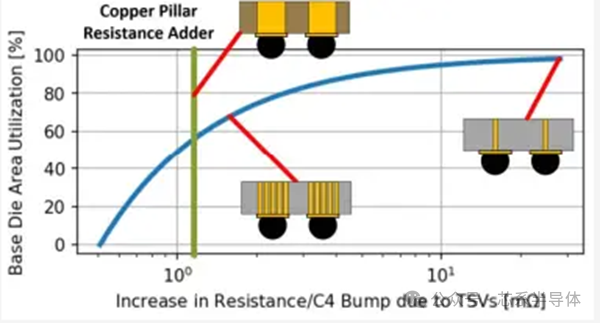






 华为公开封装专利:有利于提高芯片性能
华为公开封装专利:有利于提高芯片性能

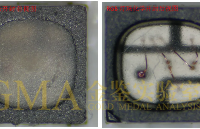











评论