传统刀片切割(划片)原理——撞击
机械切割(划片)是机械力直接作用于晶圆表面,在晶体内部产生应力操作,容易产生晶圆崩边及晶片破损。
由于刀片具有一定的厚度,由此刀具的切割(划片)线宽较大。钻石锯片切割(划片)能够达到的最小切割线宽度一般在25-35μm之间。
刀具切割(划片)采用的是机械力的作用方式,因而刀具切割(划片)具有一定的局限性。对于厚度在100μm以下的晶圆,用刀具进行切割(划片)极易导致晶圆破碎。
刀片切割(划片)速度为8-10mm/s,切割速度较慢。且切割不同的晶圆片,需要更换不同的刀具。
旋转砂轮式切割需要刀片冷却水和切割水,均为去离子水(DI纯水)
切割刀片需要频繁更换,后期运行成本较高。
新型激光切割
激光切割(切片)属于无接触式加工,不会对晶圆产生机械应力的作用,对晶圆操作较小。
由于激光在聚焦上的优点,聚焦点可小到亚微米级,从而对晶圆的微处理更具有优越性,可以进行小部件加工;即使在不高的脉冲能量水平下,也能得到较高的能量密度,有效地对材料进行加工。
大多数材料吸收激光直接将硅材料汽化,形成沟道,从而实现切割的目的。因为光斑小,能实现最低限度的碳化影响。
激光切割采用的高光束质量的光纤激光器对芯片的电性影响也较小,可提供更高的切割成品率。
激光切割速度更快。
激光可以切割厚度较薄的晶圆,可用于对不同厚度的晶圆进行切割。
激光可切割一些较复杂的晶圆芯片,如六边形管芯等。
激光切割也不需要用到去离子水,也不存在刀具磨损的问题,可以实现24小时不间断作业。
激光有很好的兼容性,用激光切割,对不同的晶圆片可以实现更好的兼容性和通用性。
P.S.:OFweek君不是技术出身,现学现卖的这种概括文章,对于产业中的各种基础概念无法做到非常准确的描述。若读者朋友们对于文章内容准确性有异议,欢迎添加OFweek君微信(hepinggui2010)告知。若相关内容能形成完整的文章,OFweek君也可以署名文章投稿的形式,将相应内容发表在OFweek旗下各个内容平台上。感谢大家的支持!
-
晶圆
+关注
关注
53文章
5194浏览量
130231 -
激光切割
+关注
关注
3文章
228浏览量
13342
发布评论请先 登录
基于纳米流体强化的切割液性能提升与晶圆 TTV 均匀性控制






 晶圆传统刀片切割与新型激光切割的对比
晶圆传统刀片切割与新型激光切割的对比




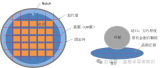











评论