来源:芯豆豆
Dicing(晶圆切割)
定义:
Dicing 是指将制造完成的晶圆(Wafer)切割成单个 Die 的工艺步骤,是从晶圆到独立芯片生产的重要环节之一。每个 Die 都是一个功能单元,Dicing 的精准性直接影响芯片的良率和性能。
Dicing 的主要功能
分离晶圆上的芯片:
将晶圆表面按设计的布局切割成一个个独立的 Die。
确保每个 Die 的物理尺寸和边缘完整性。
保证芯片质量:
避免切割过程中损伤芯片或引发裂纹。
最大限度减少应力和缺陷对芯片功能的影响。
为封装工艺做准备:
切割完成后,Die 将进入封装流程,因此 Dicing 是封装前的最后一步。
Dicing 的主要方法
切割产生的机械应力可能导致晶圆裂纹。
切口宽度(Kerf)较大,材料浪费较多。
成本较低。
切割速度较快。
方法:使用高速旋转的金刚石刀片对晶圆进行切割。
特点:常用于较大尺寸的晶圆(6英寸以下)。
优点:
缺点:
类比:像用精密锯片切割木板,虽然效率高,但切割线可能会有一定损耗。
激光切割(Laser Dicing):
对设备要求高,成本较高。
切口宽度小,减少材料损耗。
应力小,适合高性能芯片。
方法:使用高能激光束沿晶圆表面或内部进行精确切割。
特点:适用于更薄、更小的晶圆或高密度芯片设计。
优点:
缺点:
类比:类似激光雕刻,通过非接触方式完成精细切割,损伤小但设备昂贵。
隐形切割(Stealth Dicing):
工艺复杂,适合特定晶圆类型。
切割表面无损伤。
非常适合薄晶圆和密集电路设计。
方法:使用激光在晶圆内部创建隐形裂纹,随后通过外力分离 Die。
特点:无需切割表面,切割损耗极低。
优点:
缺点:
类比:像在玻璃内部划出裂纹后,通过轻微外力让玻璃分离成小块。
Dicing 的主要步骤
晶圆贴膜(Wafer Mounting):
在晶圆背面贴上一层支撑膜(Dicing Tape),固定晶圆并避免切割过程中移动。
类比:就像在木板上贴保护膜,既能固定又能防止损伤。
对准(Alignment):
根据晶圆上的切割标记(Scribe Line),对齐刀片或激光位置,确保切割精度。
类比:类似裁剪布料前对齐裁剪线。
切割(Dicing):
通过机械刀片、激光或隐形切割技术,沿 Scribe Line 切割晶圆。
类比:将大蛋糕按照预定切割线分成一块块小蛋糕。
清洗(Cleaning):
清除切割过程中产生的碎屑(如硅粉、胶渣),确保 Die 表面洁净。
类比:清理裁剪后的布料边角,避免影响成品。
取出(Die Pick-Up):
从支撑膜上取出独立的 Die,为封装工艺做准备。
类比:像从模具中取出已成型的零件。
Dicing 的关键参数
切割线宽度(Kerf Width):
指切割所占的宽度,越小越能减少材料损耗。
激光切割通常比机械切割的 Kerf 更小。
应力控制:
切割过程中避免对晶圆和芯片产生过多机械应力。
切割精度:
切割线的位置精度,直接影响芯片的外形质量和后续封装。
薄晶圆处理:
对于超薄晶圆(如 100?m 以下),需要更加精细的切割工艺和支撑技术。
Dicing 的重要性
直接影响芯片良率:
切割过程中的应力或裂纹会导致芯片失效,影响最终良品率。
支持高集成度工艺:
随着芯片设计密度提高,Dicing 工艺需要更高的精度以适应狭窄的 Scribe Line。
减少材料浪费:
更先进的 Dicing 工艺(如隐形切割)可降低材料浪费,优化成本。
类比:Dicing 是芯片制造的“精准裁缝”
晶圆是裁缝手中的大布料,Dicing 就是把它按照设计线裁剪成一块块适合使用的小布片(Die)。
不同的裁剪工具(机械刀片、激光、隐形切割)对应不同的布料类型(晶圆厚度、材质)。
Dicing 的精确性决定了成品的质量和美观,就像裁缝的技术决定了衣服的剪裁效果。
总结
Dicing 是从晶圆到独立芯片的重要过渡步骤,其核心目标是将晶圆上的 Die 精确切割为独立的最小功能单元,同时避免机械应力或裂纹对芯片性能的损伤。通过不断改进切割技术(如激光切割、隐形切割),Dicing 工艺已能够满足现代半导体制造对高精度、高密度和低成本的要求,是芯片制造中不可或缺的一环。
-
芯片
+关注
关注
460文章
52573浏览量
442097 -
晶圆
+关注
关注
53文章
5175浏览量
130025 -
工艺
+关注
关注
4文章
687浏览量
29494
原文标题:Fab厂常见工艺名词术语:Dicing(晶圆切割)
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
基于纳米流体强化的切割液性能提升与晶圆 TTV 均匀性控制






 晶圆切割的定义和功能
晶圆切割的定义和功能



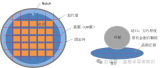











评论