文章来源:学习那些事
原文作者:前路漫漫
本文介绍了半导体器件中单粒子的概念、诱因和已知的效应。
概述
我们知道,带电离子穿透半导体材料的过程中,会与靶材原子发生交互作用,沿离子运动轨迹生成电子 - 空穴对,这一物理过程正是单粒子效应的诱发根源。从作用机理来看,半导体器件及集成电路中单粒子效应的产生需经历三个核心阶段,各阶段的物理行为存在显著差异:
其一为能量粒子的电荷沉积阶段。高能粒子轰击器件敏感区域时,通过两种路径实现电荷沉积:一是离子与器件基体材料直接碰撞引发的直接电离,使材料原子外层电子脱离束缚形成自由电荷;二是离子与被撞击原子发生核反应后,生成的二次粒子(如反冲核、γ 光子等)进一步与周围材料作用,诱发间接电离并产生额外电荷。
其二是电离电荷的内部传输阶段。沉积的自由电荷在器件内部的运动模式受区域电场特性调控:在高电场区域(如 PN 结耗尽层),单粒子触发的电荷受电场力驱动,以定向漂移的形式快速移动;在中性区域(如衬底本体),电荷因浓度梯度差异呈现无规则扩散运动;此外,在部分具有特殊结构的器件(如 CMOS 图像传感器、功率器件)中,电离电荷还会通过双极放大效应实现倍增式传输,显著增强电荷迁移总量。
其三是敏感区域的电荷收集与干扰阶段。当传输的电荷被器件敏感区域(如存储单元的电容结构、逻辑单元的沟道区域)捕获时,电荷的输运过程会激发瞬时脉冲电流,该电流会打破器件原有电荷平衡状态,对器件核心功能及关联单元(如读写电路、时钟模块)造成干扰,最终表现为逻辑翻转、功能失效等单粒子效应现象。
随着半导体工艺的持续迭代,器件特征尺寸从微米级向纳米级缩减,半导体存储器的电荷存储容量随之降低,导致其对单粒子电离效应的敏感度呈指数级提升。这一工艺演进不仅加剧了传统单粒子效应的影响,还催生出电荷共享、多位翻转等新型物理现象 —— 在超深亚微米工艺节点下,单个高能粒子撞击产生的电荷会跨越相邻存储单元的边界,引发多个单元同时发生逻辑翻转,此类现象的发生频率已大幅上升,成为当前单粒子效应机理研究中需重点突破的核心课题。
单粒子效应诱因
单个空间带电粒子穿越半导体材料时,单粒子效应的诱发依托三类核心物理过程:重离子在材料中的直接电离、质子的直接电离,或质子通过核反应生成反冲核后引发的电离。
电离过程源于具有特定有效电荷数的带电离子与半导体硅材料原子的库仑相互作用:在此过程中产生的二次高能电子(δ 射线),会在 1~100fs 的极短时间内,通过能量损失与光子激发进一步扩展电离路径,最终形成明确的电离径迹结构。在半导体硅材料中,生成一个电子 - 空穴对的平均能量为 3.6eV(1.0eV=10???J);而线性能量传输(LET)作为描述离子在传输材料中单位距离平均能量损失的关键参数,常用单位为 MeV?cm?/mg。在集成电路设计场景中,为对比器件物理尺寸与关键节点存储电荷量,LET 单位可通过计算转换为单位距离沉积电荷量(如 pC/μm 或 fC/μm)。例如,当带电离子的 LET 值为 98.0MeV?cm?/mg 时,其单位距离沉积电荷量约为 1.0 pC/μm。
电子器件与集成电路单粒子效应的产生机理,还与器件工艺、结构及电路响应密切相关,但其核心过程始终是电离 —— 高能带电粒子穿越半导体器件材料时,通过能量损失形成电离电荷沉积。需特别注意的是,物理层面的电荷产生机理不仅包含上述电离过程,还涵盖弹性与非弹性碰撞引发的核反应过程。此外,随着现代新型电子器件与集成电路在航天器电子设备系统中的广泛应用,空间带电粒子电离引发的电荷收集过程因兼具特殊性与复杂性,仍持续吸引科研人员深入探索。
不同单粒子现象的产生机理与核心过程存在差异,但所有单粒子效应的共性基础一致:要么是重离子在半导体材料中的直接电离,要么是质子通过核反应生成反冲核后的直接电离。在地面模拟实验研究中,还可利用半导体材料对特定能量光子的吸收实现类重离子电离过程 —— 例如通过脉冲激光照射,即可在实验室环境下模拟空间单粒子效应。
对电子器件与集成电路而言,单粒子效应的产生包含四个明确的基本过程:
第一个过程是电荷沉积(即电离过程):高能带电粒子撞击敏感区后,通过与半导体材料的库仑相互作用,使材料原子的电子脱离原子核束缚,形成微米空间尺度的电子 - 空穴对分布;
第二个过程是电荷输运:电离产生的电子 - 空穴对(载流子)在器件沟道区、耗尽层区等不同区域内,通过漂移与扩散运动实现电离电荷的分离;
第三个过程是敏感节点电荷收集:带电粒子的电离径迹可能穿越一个或多个 PN 结,该过程的核心是分析独立 PN 结(可能处于反偏或正偏状态)的电荷收集特性;
第四个过程是器件与电路响应:其关键特征为器件内部敏感节点单元状态改变所需的最小电荷,即临界电荷 Q?。临界电荷概念最初用于对比数字电路的单粒子效应敏感性,实际应用中可扩展至其他类型单粒子效应的敏感性分析。如图 1 所示,为单粒子效应产生的基本过程及对航天器电子设备系统影响的示意图。

重离子与高能质子通过电离过程在电子器件材料中实现能量沉积时,会在离子运动路径的 PN 结近区形成稠密的等离子体柱 —— 即电子 - 空穴对径迹。该径迹中,仅有小部分电离电荷会发生复合,大部分电荷则被 PN 结的接触节点捕获;除 PN 结近区的电荷收集外,电荷还可通过聚集与扩散过程,在 PN 结以外区域收集重离子、高能质子电离产生的电荷,例如通过扩散方式在 PN 结耗尽层区完成电荷收集。上述电荷收集过程的最终结果,是在离子撞击路径所经过的内部电路敏感节点上,产生持续时间较短的脉冲电流或脉冲电压。
从单粒子效应产生的角度来看,带电离子通过电离形成的沉积电荷量,主要受三方面因素调控:首先体现在带电离子的特性参数,包括离子能量、离子类型及电荷态;其次关联于电子器件或集成电路的物理结构与工艺特性,具体涵盖电荷沉积的有效路径深度与电荷收集的有效路径长度;最后取决于电子器件或集成电路的电路响应特性,例如电路对电流脉冲的敏感性 —— 这一特性与电路状态改变所需的电压电容、电路响应时间等参数密切相关。
通常情况下,在硅基电子器件或集成电路中,带电离子形成沉积电荷的时间处于 200ps 范围内。在此时间段内,带电离子沉积的大部分电荷会被集成电路敏感节点收集,在电路层面表现为瞬态电流脉冲或瞬态电压脉冲。值得注意的是,这类脉冲中还存在由电荷扩散引发的延迟成分,该延迟成分的持续时间可延长至 1μs 甚至更久,而这一延迟成分正是慢速响应单粒子效应(SEE)的重要诱因之一,例如动态存储器中的单粒子翻转、CMOS 电路的锁定等单粒子现象,主要便是由该延迟成分诱发。
在单粒子效应产生的电路响应过程中,临界电荷 Q?是表述单粒子现象特征的核心概念,其定义为数字电路或集成电路内部敏感节点单元发生单粒子效应状态变化所需的最小电荷量,主要用于表征单粒子效应敏感性的电路特性。对 MOS 器件而言,临界电荷的大小由电路分布参数决定:可先根据器件结构参数,计算灵敏区 PN 结的势垒电容、栅电容,并估算寄生电容大小,再依据电容串并联关系得到总电容,总电容与高低电平差的乘积即为临界电荷 —— 在此情况下,临界电荷与带电粒子电离沉积电荷的数值差异较小。而对双极性器件而言,临界电荷与带电粒子电离沉积电荷的数值差异则较为悬殊。在实际应用中,由于部分器件参数无法精准获取,仅能估算临界电荷的分布范围;此外,从电路工艺水平来看,同一批次器件的灵敏结寄生电容本身存在变化区间,这也导致临界电荷会在一定范围内波动。
从电子器件与集成电路响应的角度出发,单粒子效应可划分为两大类,即单粒子诱发软错误(Single-event Soft Error,SSE)与单粒子诱发硬错误(Single-event Hard Error,SHE)。以 MOS 晶体管为例,图 2 给出了电子器件和集成电路单粒子效应产生的基本物理过程示意图。

其中,单粒子诱发软错误主要包括单粒子翻转(SEU)、单粒子瞬态(SET)等;单粒子诱发硬错误则涵盖单粒子锁定(SEL)、单粒子烧毁(SEB)、单粒子栅击穿(SEGR)等。随着半导体器件与集成电路制造工艺的持续发展,单粒子效应的类型逐渐增多,目前在传统电子器件与集成电路中已发现的单粒子效应主要有:存储器件的单粒子翻转、模拟及数字器件的单粒子瞬态脉冲、CMOS 器件的单粒子锁定、功率器件的单粒子烧毁与单粒子栅击穿等。
已知的单粒子效应
在电子器件与集成电路中,若单个带电粒子入射导致一个锁存器或存储单元的输出信号出现错误,且该错误输出可通过操作器件的一个或多个相关功能模块纠正,则判定为发生单粒子诱发软错误,除上述单粒子翻转、单粒子瞬态脉冲外,还包括单粒子功能中断等类型。若单个带电粒子入射导致器件性能产生不可逆变化,且该变化通常造成器件一个或多个模块、甚至整个器件的永久性损伤,则判定为发生单粒子诱发硬错误,具体包含单粒子锁定、单粒子栅击穿、单粒子烧毁等类型。以下将对已被认知的主要单粒子效应进行概念化介绍。
1. 单粒子翻转(Single Event Upset,SEU)
单粒子翻转是单个高能带电粒子(质子或重离子)通过诱发瞬态信号变化,导致电子器件与集成电路产生软错误的现象。其物理过程表现为:当宇宙空间高能带电粒子穿越电荷存储单元时,会在耗尽层及近区沉积能量,形成由电子 - 空穴对构成的等离子体径迹柱;该径迹柱内的电荷在电场作用下向敏感节点聚集并被收集,若收集电荷量超过节点临界电荷值,存储单元状态即发生翻转。若入射粒子为高能质子,其会通过核非弹性相互作用生成二次粒子,当二次粒子沿传播路径沉积的电荷量满足节点收集需求时,同样会改变邻近存储单元状态,引发翻转。
SEU 作为软错误,仅改变存储单元状态而不损坏器件,可通过刷新数据纠正。从器件应用来看,SRAM 的 SEU 多发生于存储单元内部,NAND Flash 的 SEU 则常见于存储单元浮栅与页缓冲器。随着器件工艺迭代,存储单元结构愈发致密,相邻敏感节点间距缩小,临界电荷值随之降低,此时单个粒子入射可能导致两个及以上相邻存储单元同时翻转,即单粒子多位翻转。目前已观测到先进工艺下的两类多位翻转:一是单个字节内多 bit 翻转,二是相邻物理地址的多个存储单元同步翻转,此类现象的防护设计已成为纳米器件空间应用的核心技术挑战。
2. 单粒子瞬态(Single Event Transient,SET)
单粒子瞬态是单个高能带电粒子(质子或重离子)诱发的电压 / 电流扰动信号,在电子器件与集成电路内传播时引发错误的现象。其诱发机制为:宇宙空间高能带电粒子穿越 PN 结(单个或多个)时,在耗尽层及近区沉积能量并形成电子 - 空穴对等离子体径迹柱,柱内电荷在电场作用下被节点收集,进而产生瞬态电流脉冲;该脉冲沿电路单元链路传播时,会导致电路单元状态错误。若入射粒子为高能质子,其生成的二次粒子若在传播路径中沉积足够电荷并被 PN 结单元收集,同样会形成瞬态电流脉冲,最终引发电路状态变化。
SET 属于软错误,仅改变电路逻辑单元状态而不损伤器件,可通过刷新逻辑数据恢复。不同工艺器件的 SET 发生区域存在差异:双极性工艺制作的运算放大器、电压比较器中,SET 多源于内部敏感晶体管,扰动信号经晶体管链路传播后,会在器件输出端形成瞬态脉冲电流以改变电路状态;MOS 数字器件的 SET 电流则主要产生于内部晶体管的体区与漏极区。随着器件工艺精细化,存储单元临界电荷降低,SET 的诱发概率上升,其防护设计已成为逻辑器件与数字器件空间应用的关键挑战。
3. 单粒子锁定(Single Event Latchup,SEL)
单粒子锁定是单个高能带电粒子(质子或重离子)穿越器件敏感区域时,触发寄生结构导通,进而诱发反常高电流状态的现象,会导致器件功能失常。SEL 本质是寄生 PNPN 半导体结构中出现的低阻高电流效应,在 CMOS 器件中最为常见。器件进入锁定状态后,仅需较低电压即可维持该状态,同时产生的大电流会使器件内部温度急剧升高,若未及时干预,可能导致器件因过热损毁;仅当切断供电电压至低于锁定临界电压时,器件才可恢复正常状态。
4. 单粒子烧毁(Single Event Burnout,SEB)
单粒子烧毁是单个高能带电粒子(质子或重离子)穿越功率器件敏感区域时,使寄生晶体管导通并引发雪崩过程,最终形成反常大电流的现象,会导致器件内部 MOSFET 单管功能失常及永久性损坏,属于硬错误。SEB 主要发生于功率 MOSFET 器件中,近年来在 SiC 二极管等新型高功率器件中,也观测到重离子诱发的类 SEB 现象。其核心机制是雪崩过程产生的大电流突破器件耐受极限,造成不可逆的结构损伤。
5. 单粒子栅击穿(Single Event Gate Rupture,SEGR)
单粒子栅击穿是单个高能带电粒子(质子或重离子)穿越器件敏感区域时,导致 MOSFET 栅极介质击穿,使栅 - 漏两极永久短路、栅极漏电流增大,最终造成器件永久性损伤的硬错误。SEGR 与 SEB 同属功率器件常见故障,除功率 MOSFET 外,在 NAND Flash 器件中也可观测到此类现象 —— 尤其当重离子垂直入射时,NAND Flash 对 SEGR 的敏感性显著提升,这对先进工艺 NAND Flash 在空间或强辐射环境中的应用构成严重制约。
6. 单粒子功能中断(Single Event Functional Interrupt,SEFI)
单粒子功能中断是单个高能带电粒子(质子或重离子)入射引发器件部分模块重启、锁定或其他可检测功能性失常的现象,无需通过电源反复开关恢复功能(与 SEL 存在差异),且不造成永久性损伤,属于软错误。SEFI 多出现于微处理器(CPU)、信号处理器(DSP)等复杂器件中:当此类器件工作时,粒子诱发的翻转若发生在内部寄存器或锁存器,会导致控制功能失常,进而引发功能中断。例如,CPU 内部寄存器翻转可能导致程序执行路径紊乱,造成系统死机;NAND Flash 内部微控制器若出现此类错误,会使其控制的编程、擦除等操作失效。
除上述 6 类主要单粒子效应外,在地面模拟试验与空间飞行试验中,还观测到其他单粒子现象,如单粒子扰动(Single Event Disturb,SED)。SED 与单粒子瞬态脉冲类似,核心表现为数字电路存储单元逻辑状态出现瞬时改变,其对电路功能的影响需结合具体应用场景进一步分析。
-
集成电路
+关注
关注
5435文章
12234浏览量
369969 -
半导体
+关注
关注
336文章
29335浏览量
245715 -
电荷
+关注
关注
1文章
656浏览量
36949
原文标题:半导体器件中的单粒子效应
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
特征工艺尺寸对CMOS SRAM抗单粒子翻转性能的影响
半导体的导电特性
高速ADC的单粒子闩锁和瞬态
泰克 TSP-2000-HALL 半导体器件测试方案
数字源表应用方案的半导体霍尔效应测试
霍尔效应在半导体性能测试中的作用
皮秒脉冲激光技术在AS32S601单粒子效应评估中的应用
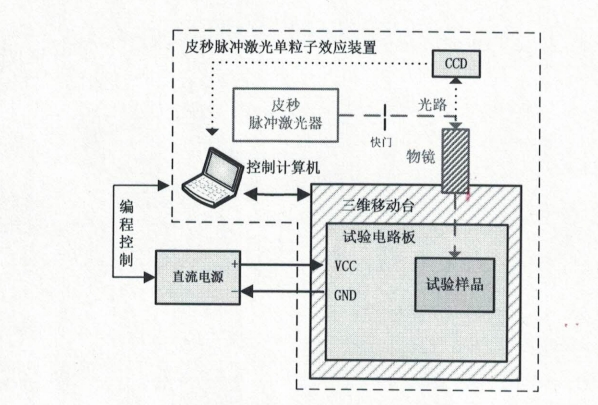





 一文详解半导体器件中的单粒子效应
一文详解半导体器件中的单粒子效应


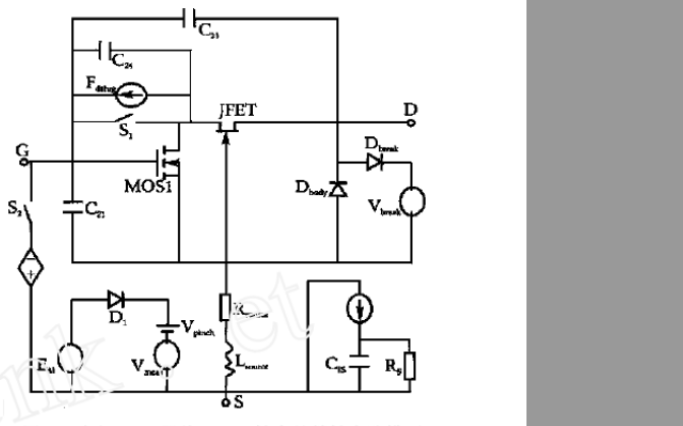












评论