光刻工艺是芯片制造的关键步骤,其精度直接决定集成电路的性能与良率。随着制程迈向3nm 及以下,光刻胶图案三维结构和层间对准精度的控制要求达纳米级,传统检测手段难满足需求。光子湾3D 共聚焦显微镜凭借非接触式三维成像、亚微米级分辨率和快速定量分析能力,成为光刻工艺全流程质量控制的关键工具,本文将阐述其在光刻胶涂层检测、图案结构分析、层间对准验证等核心环节的应用。
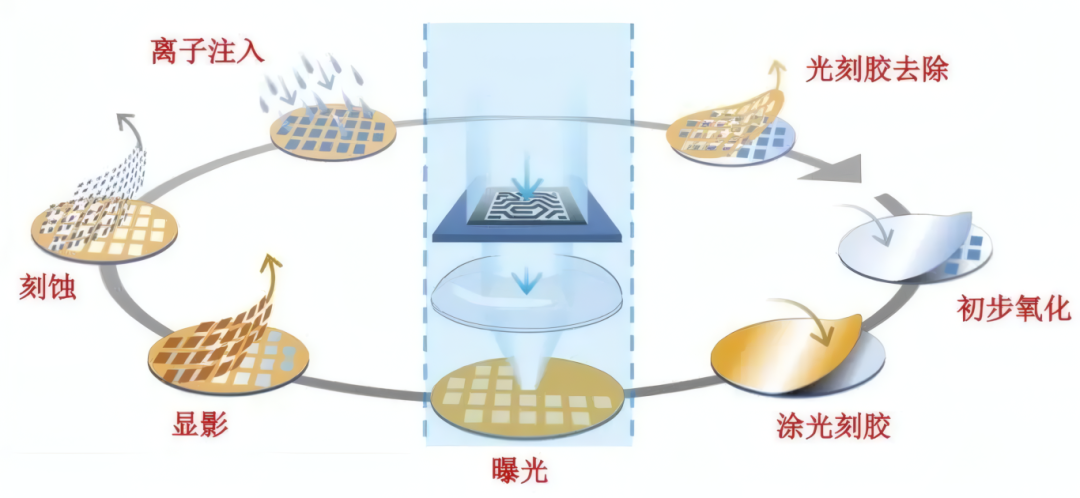
芯片制造之光刻工艺详细流程图
#Photonixbay.
光刻胶涂层质量的三维量化分析
光刻胶涂层的均匀性与表面状态是光刻基础。3D 共聚焦显微镜通过逐层扫描,实现涂层厚度、粗糙度及缺陷的高精度检测。
厚度与均匀性测量:先进制程中,光刻胶厚度需控制在100-1000nm,整片晶圆厚度偏差小于 5%。共聚焦显微镜通过垂直扫描(Z 轴分辨率 1nm)生成三维高度图,量化厚度分布。
表面缺陷与粗糙度检测:可识别低至0.5μm 的微观缺陷,通过三维粗糙度参数(Ra/Rq)评估表面质量,如检测亚纳米级表面波纹,指导抛光参数调整。
#Photonixbay.
光刻图案的三维结构精准表征
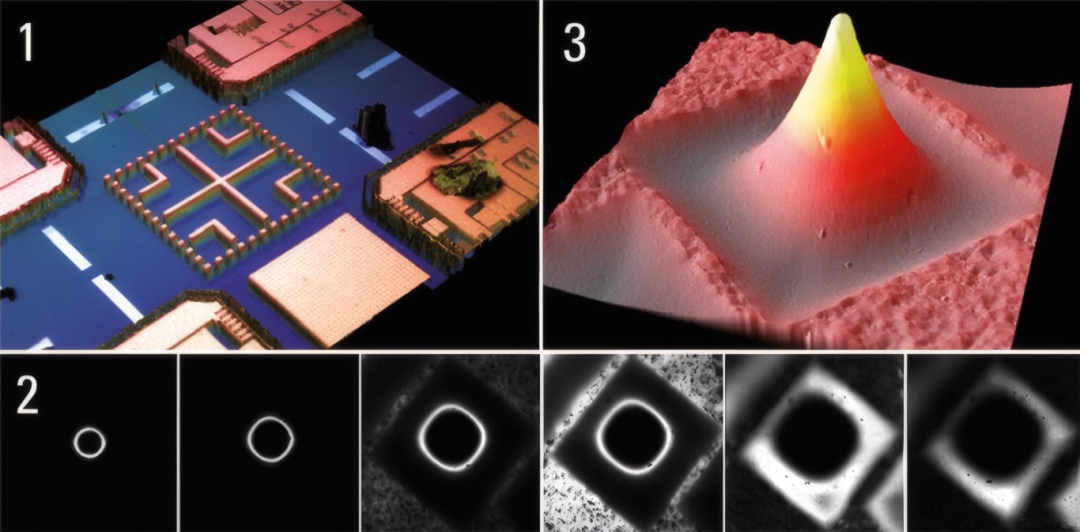
通过共聚焦显微镜三维成像晶圆表面上的缺陷(1):表面有凸块的晶圆(2):共聚焦显微镜扫描凸块的各个步骤(秒)(3):最终图像
光刻的核心是将掩模图案转移至光刻胶,形成三维结构。共聚焦显微镜通过三维成像实现对关键尺寸(CD)、轮廓及缺陷的全面分析。
关键尺寸与轮廓测量:可测量导线、栅极等结构的顶部/ 底部线宽、线间距及线宽粗糙度(LWR),7nm 制程中线宽控制在 ±0.5nm 内;对沟槽、通孔可测深度及宽深比,避免图形失真。
三维缺陷检测:通过三维重建识别桥连、断线等缺陷,如在3D NAND 制造中检测高深宽比通孔的侧壁垂直度,保障刻蚀保真度。
#Photonixbay.
层间对准精度的实时验证
芯片制造需数十层光刻堆叠,层间对准精度是关键。共聚焦显微镜通过对准标记分析与三维重合度评估量化误差。
对准标记定位与偏移量计算:识别十字线、网格等标记,定位中心并计算相邻层的平移、旋转或缩放偏差,先进制程中对准精度控制在1-2nm。
多层结构重合度分析:观察上下层图形重合度,如在GAA 晶体管制造中检测栅极与源漏极对准情况,避免接触不良。
#Photonixbay.
显影后表面状态的高效评估

3D 共聚焦显微镜检测分析芯片表面图
显影效果直接影响光刻胶图形的稳定性。共聚焦显微镜通过三维分析实现对显影残留与表面均匀性的快速检测。
显影残留量化:通过高度分析量化未去除光刻胶的残留厚度和面积,指导显影液浓度优化与工艺参数调整。
表面形貌均匀性评估:通过三维粗糙度(Ra/Rq)评估显影后表面质量,如在 EUV 光刻中检测曝光不均导致的局部溶胀,确保符合要求。
3D 共聚焦显微镜通过对光刻胶涂层、图案结构、层间对准及显影后状态的三维量化分析,为芯片制造的光刻工艺提供了关键的可视化与数据支持。随着AI 技术与多模态成像的发展,光子湾3D 共聚焦显微镜将进一步提升检测效率与精度,成为半导体制造质量控制的关键工具。
#Photonixbay.
光子湾3D共聚焦显微镜
光子湾3D共聚焦显微镜是一款用于对各种精密器件及材料表面,可应对多样化测量场景,能够快速高效完成亚微米级形貌和表面粗糙度的精准测量任务,提供值得信赖的高质量数据。

超宽视野范围,高精细彩色图像观察
提供粗糙度、几何轮廓、结构、频率、功能等五大分析功能
采用针孔共聚焦光学系统,高稳定性结构设计
提供调整位置、纠正、滤波、提取四大模块的数据处理功能
从半导体材料的微观表征到芯片制造光刻工艺的精准检测,光子湾共聚焦显微镜以原位观察与三维量化能力,为光刻胶涂覆、曝光显影等核心环节提供关键数据支撑。在半导体晶圆缺陷分析、锂电电极界面研究等前沿领域,它持续助力从“试错研发” 到 “精准设计” 的跨越,尤其在光刻工艺的质量控制中,成为提升制程稳定性的重要技术支撑。
感谢您本次的阅读光子湾将持续为您奉上更多优质内容,与您共同进步。
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
芯片制造
+关注
关注
11文章
697浏览量
29853 -
显微镜
+关注
关注
0文章
655浏览量
24471 -
光刻工艺
+关注
关注
1文章
37浏览量
1999
发布评论请先 登录
科学领域新技术,打造高品质共聚焦显微镜
结构深、角度大、反射差?用共聚焦显微镜就对啦!
为什么激光共聚焦显微镜成像质量更好?
什么是共聚焦显微镜?

共聚焦显微镜的作用






 3D 共聚焦显微镜 | 芯片制造光刻工艺的表征应用
3D 共聚焦显微镜 | 芯片制造光刻工艺的表征应用

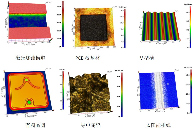















评论