本文介绍了铜互连双大马士革工艺的步骤。
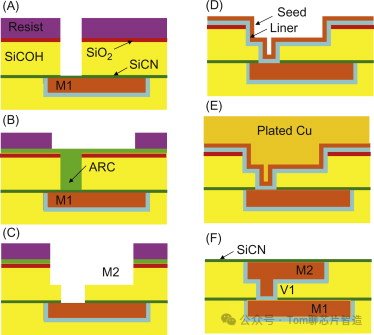
如上图,是双大马士革工艺的一种流程图。双大马士革所用的介质层,阻挡层材质,以及制作方法略有差别,本文以图中的方法为例。
(A) 通孔的形成 在介质层(如SiCOH)上沉积光刻胶(Resist),并使用光刻工艺做出掩模图形。通过干法刻蚀手段,得到通孔。
(B)制作沟槽所需的图形 完成通孔的刻蚀后,通常会去除原来的光刻胶。旋涂抗反射层,并将通孔填满,之后会再次涂布光刻胶,做出开槽所需的光刻胶图形。
(C) 开沟槽 干法刻蚀除去多余的抗反射层,介质层等,并去除晶圆表面光刻胶。
(D) 沉积种子层 在刻蚀好的沟槽和通孔内,使用PVD或CVD沉积Cu种子层和阻挡层。Cu种子层用于电镀的导电材料。阻挡层主要是Ta或TaN,用于防止铜扩散。
(E) 电镀铜 使用电镀工艺,将铜填充到通孔和沟槽中。铜完全填满后,表面会有过量的铜。使用CMP工艺去除多余的铜和种子层,只保留通孔和沟槽中的铜。
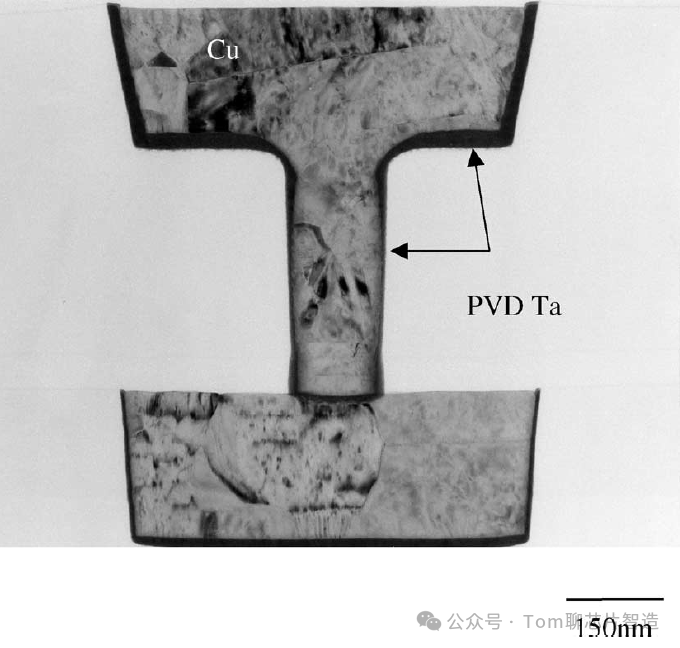
(F)cmp抛光 cmp抛光后,在表面覆盖阻挡层。
-
电镀铜
+关注
关注
0文章
27浏览量
9302 -
光刻工艺
+关注
关注
1文章
36浏览量
1991 -
铜
+关注
关注
0文章
3浏览量
1788
原文标题:铜互连双大马士革工艺步骤
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
一文详解铜大马士革工艺


如何采用铜互连单大马士革工艺制作超厚金属铜集成电感的概述
12吋晶圆集成电路芯片制程工艺与工序后端BEOL的详细资料说明
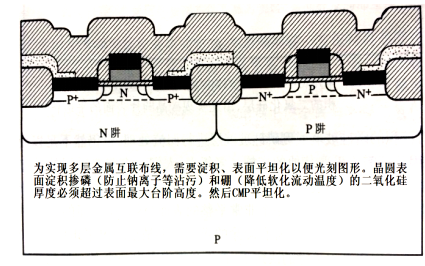
铝/铜互连工艺与双镶嵌法(AL/Cu Interconnect and Dual Damascenes)
半大马士革集成中引入空气间隙结构面临的挑战

通过工艺建模进行后段制程金属方案分析

降低半导体金属线电阻的沉积和刻蚀技术
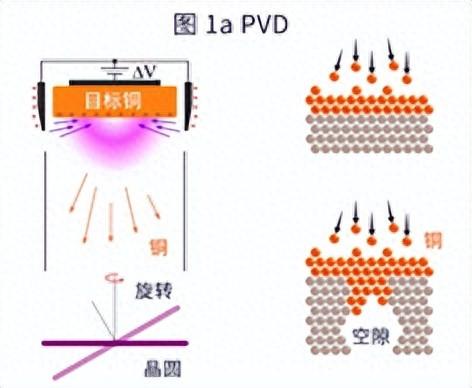
半大马士革工艺:利用空气隙减少寄生电容
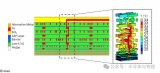
大马士革铜互连工艺详解






 铜互连双大马士革工艺的步骤
铜互连双大马士革工艺的步骤


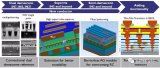
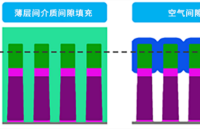

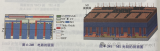










评论