在芯片制程中,很多金属都能用等离子的方法进行刻蚀,例如金属Al,W等。但是唯独没有听说过干法刻铜工艺,听的最多的铜互连工艺要数双大马士革工艺,为什么?
什么是铜互连?
芯片的金属互连是指在芯片内部,用于连接晶体管、电容、电阻等之间的金属导线,确保芯片电信号传输。早期的集成电路中,铝是制作金属互连的主要材料,但由于铜具有更好的导电性和抗电迁移特性,现在一般用铜作为集成电路的互联金属。
芯片互连指的是集成电路上,不同的部件之间进行电连接的金属连接。这些导线使得芯片内部的成千上万乃至上亿的晶体管之间可以进行信号传输。简单来说,就像几个水库,相互独立。通过挖沟渠的方式,将水库之间导通,来实现水流(电流)的流动。如果没有互连,芯片内部就像一个断路。 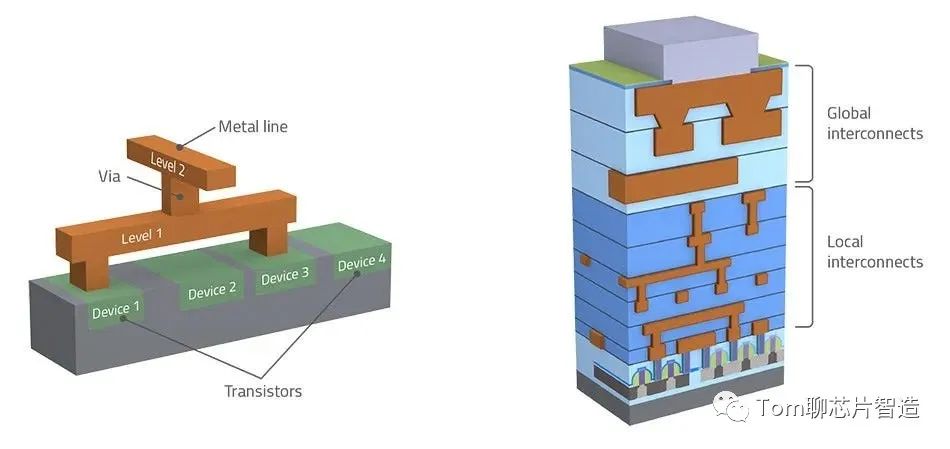 ?
?
什么是大马士革工艺?
熟悉历史和地理的朋友都知道叙利亚首都大马士革(Damascene)这座城市,而大马士革刀剑以其锋利,纹理的精美而著称。其中需要用到一种镶嵌工艺:首先,在大马士革钢的表面上雕刻出所需的图案,将预先准备好的材料紧密地镶嵌到雕刻出的凹槽中,完成镶嵌后,表面可能会有些不平整。工匠会仔细打磨,确保整体的光滑。
了解芯片工艺的朋友不禁惊呼,这不就是芯片的双大马士革工艺的雏形嘛。先在介电层中刻出凹槽或孔,然后在其中填充金属。填充后,多余的金属会被cmp去除。简直如出一辙。
为什么铜互连非要用双大马士革工艺?
铜不容易被刻蚀!与某些材料不同,铜在等离子体刻蚀过程中不容易形成挥发性化合物。对于许多材料,干法刻蚀会形成容易从表面蒸发的反应产物,这些产物会迅速扩散出去而不会再次沉积在晶圆表面。但是,铜与常见的刻蚀气体反应生成的化合物往往是非挥发性的,这使得其难以被有效地从表面去除。
干法不行,那用湿法?芯片制程新线宽在几十纳米,湿法精度根本达不到。 因此弃用干湿法刻蚀的方案,改用双大马士革工艺。
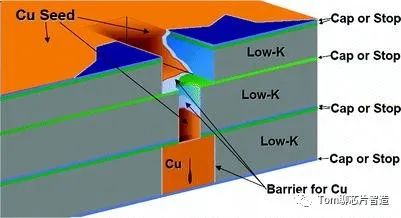 ? ?
? ?
双大马士革工艺步骤:
介电层沉积:在已有的金属层上沉积一层介电材料。通常是一个低介电常数的材料,以减少电容和信号延迟。
孔与槽的光刻与蚀刻:首先通过光刻技术在介电层上形成图案,定义出导通孔和互连槽的位置。然后,使用蚀刻技术,将这些图案转移到介电层中,形成实际的孔和槽。
铜沉积:在孔和槽中沉积铜。通常是通过电镀技术完成的。
化学机械抛光:去除多余的铜,使铜与介电层的表面齐平。这样,只有孔和槽内部的铜仍然保留。 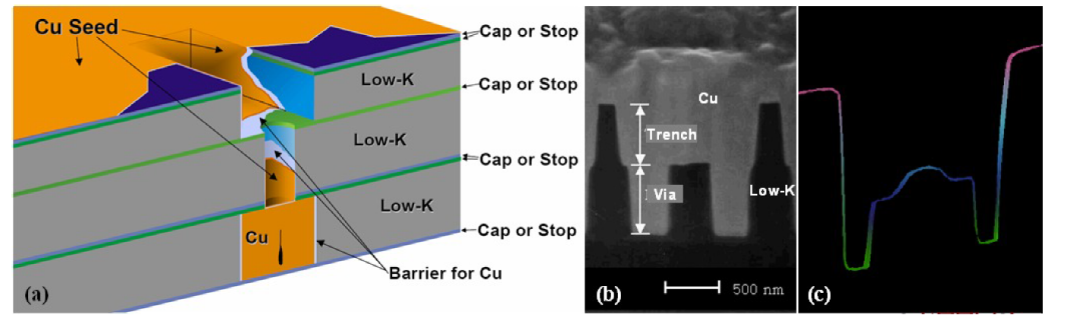
为什么没有干法刻蚀铜工艺?
铜的刻蚀难以生成易挥发物质,生成物会附在晶圆表面,生成物的再沉积了影响下方Cu的刻蚀速率和均匀性,甚至导致Cu刻蚀的停止。
一般金属的干法刻蚀通常需要目标材料与刻蚀气体反应生成易挥发的化合物。例如: 铝刻蚀:
2Al+3Cl2→2AlCl3 钨刻蚀:
W+Cl2→WCl6 钛刻蚀:
Ti+2Cl2→TiCl4 AlCl3,WCl6,TiCl4均是可挥发的物质,可以通过真空系统从刻蚀腔室中抽出。
Cu与Cl2或F自由基的反应式为:
Cu+Cl2→CuCl2或CuCl
Cu+F*→CuF2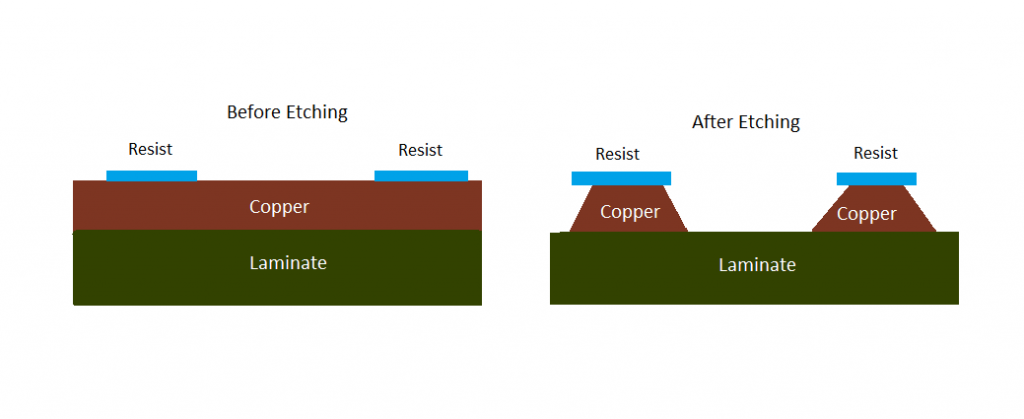
CuF2,CuCl,CuCl2的物化性质?
外观:CuF2,白色或绿色晶体;CuCl,白色或浅绿色的粉末;CuCl2,棕黄色至绿色的粉末。
相态:在常温下,CuF?,CuCl,CuCl2均是固态物质。
密度:CuF?,4.23 g/cm?;CuCl2,3.386 g/cm?;CuCl,4.14 g/cm?。
熔点:CuF?,785°C;CuCl,约为430°C;CuCl2,993°C。
铜刻蚀有哪些方法?
1,在线宽很小的芯片制程中,无法用干法刻蚀,也无法用湿法刻蚀,因为湿法刻蚀铜在纳米尺度上难以实现高度均匀和精确的控制,一般湿法刻蚀在线宽为3um以上比较适用。因此,在大多数芯片制程中只能使用双大马士革工艺进行Cu互连。
2,当线宽较大时,可以用湿法刻蚀来除去Cu。湿法刻蚀是使用液体化学品来去除材料的过程,对于铜这样的金属,需要使用特定的化学溶液进行去除。对于大面积的铜层,如电镀铜的种子层或较粗的铜线路,湿法刻蚀是一个有效且经济的选择。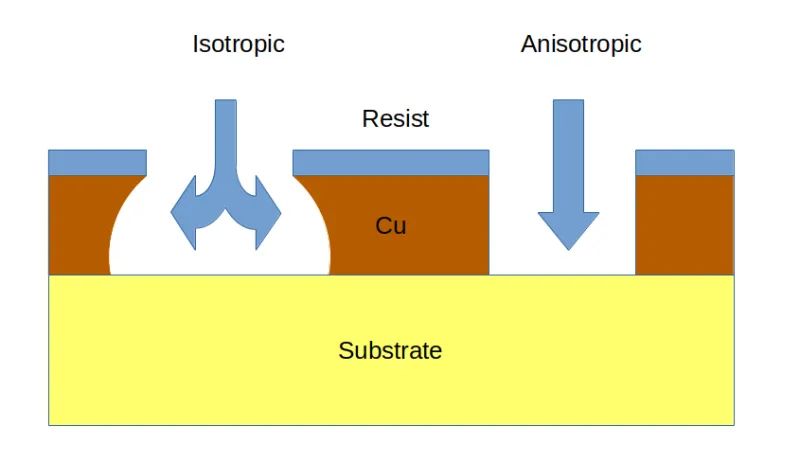
3,Cu层较薄时,可以考虑用IBE(离子束刻蚀)去除。但是IBE不是主流的除铜方式,因为它的速率较慢+Cu容易再沉积。IBE使用Ar离子轰击晶圆表面,Ar离子与晶圆表面的碰撞使Cu发生物理剥离,但是IBE设备的成本相对较高,且处理速率比化学刻蚀方法慢很多。
审核编辑:刘清
-
集成电路
+关注
关注
5430文章
12139浏览量
368970 -
晶体管
+关注
关注
77文章
10029浏览量
142196 -
CMP
+关注
关注
6文章
157浏览量
26803
原文标题:铜互连为什么不用干法刻蚀的方法?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
从微米到纳米,铜-铜混合键合重塑3D封装技术格局
一文详解铜大马士革工艺

无氧铜网线和纯铜网线哪个好
PCB设计中填充铜和网格铜有什么区别?

PCB设计中填充铜和网格铜有什么区别?

大马士革铜互连工艺详解

半大马士革工艺:利用空气隙减少寄生电容
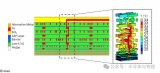
集成电路的互连线材料及其发展
降低半导体金属线电阻的沉积和刻蚀技术
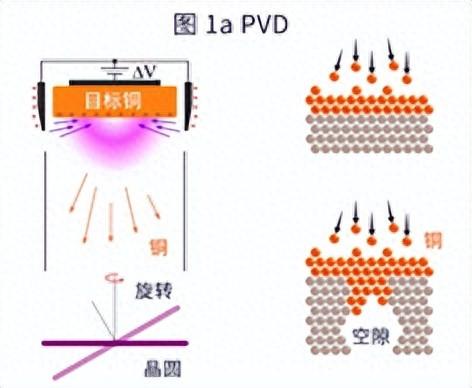





 什么是铜互连?为什么铜互连非要用双大马士革工艺?
什么是铜互连?为什么铜互连非要用双大马士革工艺?



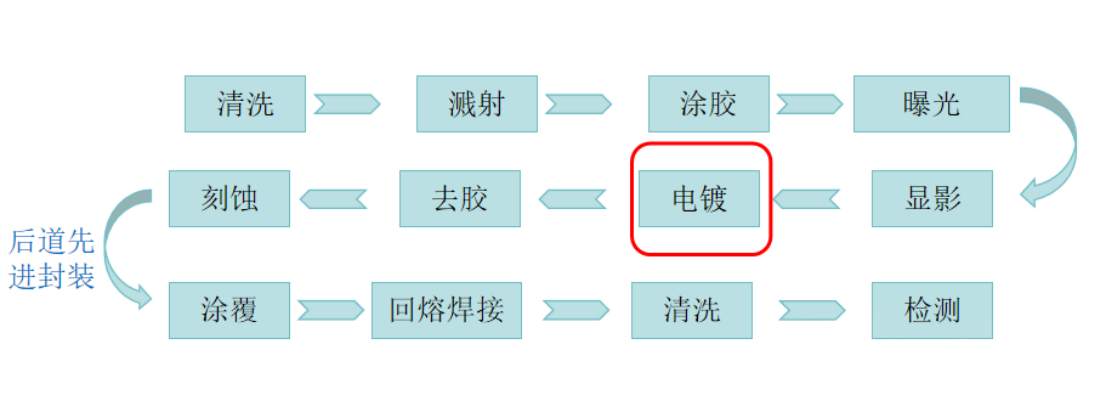
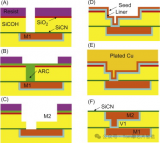
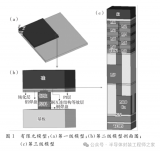
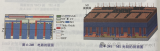










评论