华宇电子Flip Chip封装技术实现量产
Flip Chip是一种倒装工艺,利用凸点技术在晶圆内部重新排布线路层(RDL),然后电镀上bump。bump的结构一般为Cu+solder或Cu+Ni+solder。通过倒装装片机将芯片翻转正面朝下,无需引线健合,通过回流焊炉热熔芯片上的锡凸点(Bump)与引线框架或者基板进行焊接,使得芯片与载体焊接起来,直接替代了传统的上芯与压焊的工艺。电信号通过载体实现与封装外壳互联的技术无需引线键合。形成更短的电路,降低电阻;缩小了封装尺寸,相比传统引线键合产品,提高了电性能,热性能。有更高的可靠性保障。
主要应用领域:无源滤波器、存储器、CPU、GPU及芯片组等产品。
◆FCOL◆
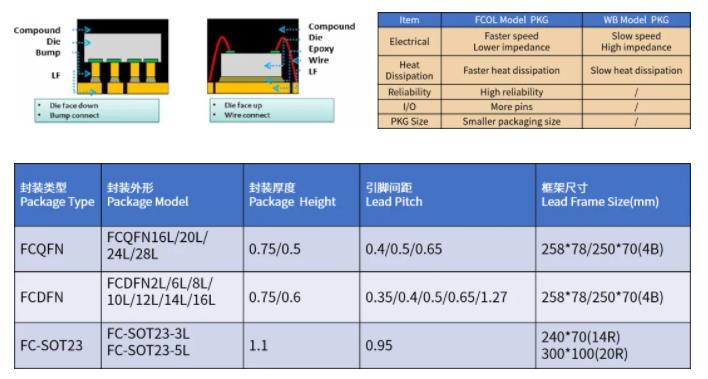
◆FCBGA◆
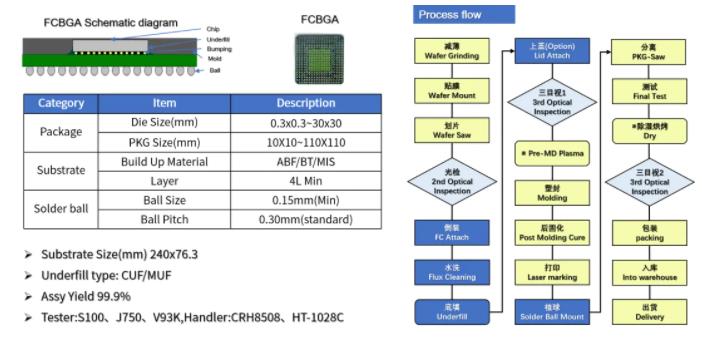
◆WBBGA◆
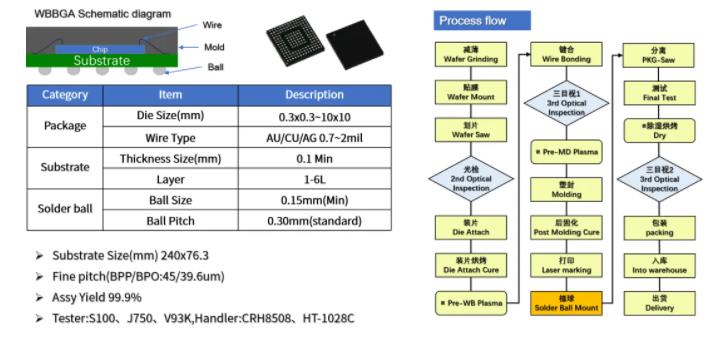
关于华宇电子
华宇电子是一家专注于集成电路封装和测试业务,包括集成电路封装、晶圆测试服务、芯片成品测试服务的高端电子信息制造业企业。在封装领域具有多芯片组件(MCM)封装、三维(3D)叠芯封装、微型化扁平无引脚(QFN/DFN)封装、高密度微间距集成电路封装、倒装技术(Flip Chip)、球栅阵列(WBBGA/FCBGA)封装技术等核心技术。在测试领域形成了多项自主核心技术,测试晶圆的尺寸覆盖12吋、8吋、6吋、5吋、4吋等多种尺寸,包含22nm、28nm及以上晶圆制程;芯片成品测试方面,公司已累计研发出MCU芯片、ADC芯片、FPGA芯片、GPU芯片、视频芯片、射频芯片、SoC芯片、数字信号处理芯片等累计超过30种芯片测试方案;公司自主研发的3D编带机、指纹识别分选设备、重力式测编一体机等设备,已在实际生产实践中成熟使用。产品广泛应用于5G通讯、汽车电子、工业控制和消费类产品、智能家居、智能定位、信息安全、消防安全、智能穿戴等各行业。
-
封装
+关注
关注
128文章
8832浏览量
145947 -
Flip Chip
+关注
关注
0文章
6浏览量
6394 -
封测
+关注
关注
4文章
366浏览量
35603
原文标题:华宇电子FCOL、FCBGA、WBBGA技术发布和量产
文章出处:【微信号:池州华宇电子科技股份有限公司,微信公众号:池州华宇电子科技股份有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
华宇电子亮相2025东南亚半导体展
rPGA Sandy Bridge + FCBGA PCH Cougar Point-M+MXM IIl ×2
华宇电子加速先进封装测试数字化转型
华邦电子存储芯片驱动智能汽车升级
武汉镭宇科技激光焊锡技术推动汽车电子行业高精度焊接新标准
宇树科技在物联网方面
宇阳科技荣获电子元件领军品牌
华秋电子 | 电子发烧友亮相OpenHarmony人才生态大会2024
感谢星宇电子对我司差示扫描量热仪认可






 华宇电子FCOL、FCBGA、WBBGA技术发布和量产
华宇电子FCOL、FCBGA、WBBGA技术发布和量产



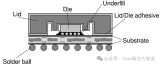










评论