·高电镀铜均匀性及电流密度,提高产能与良率,助力车用半导体芯片生产
·协同制程开发、设备制造、生产调试到售后服务规划,实现具可靠性的板级封装FOPLP整厂解决方案
作为一家活跃于全球并具有广泛技术组合的高科技设备制造商Manz 集团,继打造业界最大700 x 700 mm生产面积的FOPLP封装技术 RDL生产线,为芯片制造商提供产能与成本优势后,持续投入开发关键电镀设备,并于近日在两大重点技术的攻关上取得重大突破:
一是镀铜厚度达100 μm以上,让芯片封装朝着体积轻薄化的演进下仍能使组件具有良好的导电性、电性功能与散热性;
二是开发大于5 ASD的高电镀电流密度规格,快速增加镀铜的速度,有效提升整体产能。
此次技术突破为需求激增的高电性、高散热性车载芯片提供了最佳生产解决方案,并助力芯片制造商攫取高速成长的车用半导体商机。这也是Manz 集团继打造业界最大700 x 700 mm生产面积的FOPLP封装技术 RDL生产线,为芯片制造商提供产能与成本优势后,在关键技术领域取得的又一新突破。
根据Prismark的报告,2022年全球半导体市场虽然遭遇市场乱流,但是车用半导体无畏于COVID疫情肆虐、高通胀与能源价格高涨的现实,强势展现了2022到2027期间的复合年均增长率(CAGR)的预估,自动辅助驾驶(ADAS)增长高达13%,而电力系统增长则更高到18%,双双创下2位数的高增长率,成为半导体产业强力的增长引擎。为了掌握车用芯片市场的高成长良机,车用IDM大厂、OSAT、IC载板与PCB大厂积极寻求具备成本效益的高功能互连(Interconnect) 技术,以满足兼顾细线化导线与高散热薄形化封装需求的创新设计,FOPLP技术可免除IC载板的使用,成为车用芯片商与供应链的首选。
Manz亚智科技亚洲区总经理林峻生表示:“「车用芯片制造商在应用FOPLP封装技术面对电源芯片与模块的铜导线制程挑战时,较高电流密度电镀铜的高均匀性可进一步将产能及良率推升,也可提升电动车系统功率组件效能,强化电动车续航能力并降低环境污染,履行企业社会责任。”」而国内新能源车市场近期面对「降本增效」,车用芯片制造商正面临利润下降与设计周期压缩的挑战。林峻生指出:“「Manz FOPLP封装技术已达700 x 700 mm生产面积,将生产面积使用率提升到95 % ,可望为车用芯片制造商提高生产效率同时降低成本。除了制程技术开发及设备制造外,Manz亚智科技全方位的服务还涵盖以自动化整合上下游设备整厂生产设备线,协助客户生产设备调试乃至量产后的售后服务规划,一站式完整服务,帮助国内芯片制造商以高速建造生产线, 同时有效降低成本。”」
打造700 x 700 mm业界最大生产面积的面板级封装RDL生产线
Manz凭借长久在湿法化学制程、电镀、自动化、量测与检测等制程解决方案应用于不同领域所累绩的核心技术,以自动化技术串联整线设备,打造业界第一条700 x 700 mm最大生产面积的FOPLP封装RDL生产线,并已进入量产验证阶段,由于RDL制程占整体FOPLP封装超过三分之一的成本,其中至关重要的设备即为电镀设备,Manz的解决方案在RDL导线层良率与整体面积利用率,显现强大的竞争优势,大幅降低封装制程的成本,目前已经与国际IDM大厂合作组装一条验证生产线,积极进入生产验证与机台参数调校流程,紧锣密鼓准备迎接接续的量产订单。
全方位服务打造整厂解决方案,建立高获利FOPLP封裝的商业模式
除了设备建造外,Manz与客户合作密切,协同开发制程,并打造整合上下游设备整厂生产设备线,形成整厂解决方案(Total Fab Solution);以最佳制程参数调校的能力,协助IDM、OSAT与半导体代工厂建立完整芯片封装生产线,打造有利的FOPLP商业模式,并进而提升客户在半导体产业链的地位,增加半导体产品的竞争力。
FOPLP封装大举提升制程精细度,助长电源管理组件效能
FOPLP封裝的RDL技术满足高密度互连所构成的复杂布线规格,解决多芯片与越来越小的组件紧密整合时所需要的更多互连层,透过精密金属连接降低电阻值以提高电气性能。由于电动车市场高速起飞,SiC与IGBT等第三类半导体与高功率、大电流应用的车用芯片大行其道。为了满足大量的电源控制芯片的畅旺需求,Manz的RDL制程解决方案实现精细的图形线路与复杂的薄膜层的制造与管控,提供最小5μm /5μm的线宽与线距的制程规格,让半导体供应链从容面对高密度封装的技术挑战。
高电镀铜均匀性,提高产能与良率,协助客户达成节能减废的ESG目标
电镀设备是RDL制程中至关重要的环节,Manz电镀设备除了结合自有前、后段湿制程提供优异的整合方案之外,还能实现整面电镀铜之均匀性达92%的高标准,镀铜厚度可以做到100 μm以上的规格,让组件密度提升与封装架构薄型化,以具有优良的电性与散热性,使用大于5 ASD的高电镀电流密度规格,快速增加镀铜的速度与提升整体产能,采用无治具垂直电镀系统及自动移载系统,驾驭700 x 700 mm基板的行进与移动,有效搭配化学物分析、铜粉添加及化学液添加等模块,有效掌握化学品管理与维持节能减废的优化安排,协助客户达成ESG目标。
Manz亚智科技瞄准全球车用芯片近年激增需求,期望在板级封装FOPLP制程设备的突破,满足客戶進行RDL制程研发与产能最佳化规划,保持阶段性的技术发展与产能扩张所需的弹性配置,成为半导体市场不可或缺的竞争优势。同时,扩大规模量产与成本的优势,凝聚成为一个重要的技术领域,加速FOPLP市场化与商品化的快速成长,以此打造半导体新应用的发展契机
我们欢迎您于SEMICON China 2023展会期间莅临Manz展位,了解Manz创新板級封裝 RDL生产设备解决方案。
Manz与您相约SEMICON China 2023,上海新国际博览中心
│ 日期:06.29 ~ 07.01
│ 参观时间:09:00~17:00
│ 展位位置:E1馆 #1477
关于Manz集团
创新设备成就明日生产力 —— ENGINEERING TOMORROW'S PRODUCTION
Manz 集团是一家活跃于全球的高科技生产设备制造商。超过三十年的生产设备制造经验,集团核心技术涵盖自动化、湿法化学制程、检测系统、激光加工和喷墨打印;凭借着核心技术,专注于开发和设计创新且高效的半导体面板级封装、显示器、IC载板、锂电池以及电池CCS组件等生产设备,从用于实验室生产或试生产和小量生产的定制单机、标准化模块设备和系统生产线,甚至到量产线的整厂生产设备解决方案——应用于电子产品、汽车和电动车和医疗等市场的生产设备解决方案。
Manz集团成立于 1987 年,自 2006 年起在法兰克福证券交易所上市。全球约 1,500 名员工位于德国、斯洛伐克、匈牙利、意大利、中国大陆和台湾进行开发和生产;美国和印度也设有销售和客户服务子公司。2022财年集团的收入约为 2.50 亿欧元。
审核编辑 黄宇
-
芯片
+关注
关注
460文章
52624浏览量
442793 -
半导体
+关注
关注
335文章
29039浏览量
240327 -
封装
+关注
关注
128文章
8743浏览量
145752
发布评论请先 登录
突破!华为先进封装技术揭开神秘面纱
扇出型封装材料:技术突破与市场扩张的双重奏
英特尔先进封装,新突破
签约顶级封装厂,普莱信巨量转移技术掀起晶圆级封装和板级封装的技术革命

芯片封装中的FOPLP工艺介绍
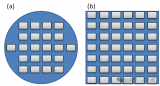
下一代FOPLP基板,三星续用塑料,台积青睐玻璃
三星与台积电在FOPLP材料上产生分歧
Manz集团成功交付多尺寸板级封装RDL量产线
Manz亚智科技RDL制程打造CoPoS板级封装路线,满足FOPLP/TGV应用于下一代AI需求

Manz亚智科技RDL制程打造CoPoS板级封装路线, 满足FOPLP/TGV应用于下一代AI需求

整合为王,先进封装「面板化」!台积电、日月光、群创抢攻FOPLP,如何重塑封装新格局?






 Manz亚智科技FOPLP封装技术再突破
Manz亚智科技FOPLP封装技术再突破













评论