硅基转接板2.5 D集成技术作为先进的系统集成技术,近年来得到迅猛的发展。但硅基转接板存在两个的主要问题:
1)成本高,硅通孔(TSV)制作采用硅刻蚀工艺,随后硅通孔需要氧化绝缘层、薄晶圆的拿持等技术;
2) 电学性能差,硅材料属于半导体材料,传输线在传输信号时,信号与衬底材料有较强的电磁耦合效应,衬底中产生涡流现象,造成信号完整度较差(插损、串扰等)。
作为另一种可能的替代硅基转接板材料,玻璃通孔(TGV)转接板正在成为半导体企业和科研院所的研究热点。
和TSV相对应的是,作为一种可能替代硅基转接板的材料,玻璃通孔(TGV)三维互连技术因众多优势正在成为当前的研究热点,与硅基板相比,TGV的优势主要体现在:
1)优良的高频电学特性。玻璃材料是一种绝缘体材料,介电常数只有硅材料的1/3左右,损耗因子比硅材料低2-3个数量级,使得衬底损耗和寄生效应大大减小,保证了传输信号的完整性;
2)大尺寸超薄玻璃衬底易于获取。Corning、Asahi以及SCHOTT等玻璃厂商可以提供超大尺寸(>2m × 2m)和超薄(<50?m)的面板玻璃以及超薄柔性玻璃材料;
3)低成本。受益于大尺寸超薄面板玻璃易于获取,以及不需要沉积绝缘层,玻璃转接板的制作成本大约只有硅基转接板的1/8;
4)工艺流程简单。不需要在衬底表面及TGV内壁沉积绝缘层,且超薄转接板中不需要减薄;
5)机械稳定性强。即便当转接板厚度小于100?m时,翘曲依然较小;
6)应用领域广泛。除了在高频领域有良好应用前景,作为一种透明材料,还可应用于光电系统集成领域,气密性和耐腐蚀性优势使得玻璃衬底在MEMS封装领域有巨大的潜力。
近年来,国内外许多研究者致力于研发低成本、小尺寸、细间距、无损快速玻璃成孔技术的开发,如喷砂法、光敏玻璃、等离子体刻蚀、聚焦放电、激光烧蚀等。但是由于玻璃材料的易碎性和化学惰性,当前已有的方法都还存在许多问题,距离实际应用和大规模的量产,还有很长的路要走。截止目前,玻璃通孔三维互连技术发展的主要困难包括:
1)现有的方法虽然可以实现TGV,但有些方法会损伤玻璃,造成表面不光滑;有些方法的加工效率低,没法大规模量产;
2)TGV的高质量填充技术,与TSV不同,TGV孔径相对比较大且多为通孔,电镀时间和成本将增加;
3)与硅材料相比,由于玻璃表面平滑,与常用金属(如Cu)的黏附性较差,容易造成玻璃衬底与金属层之间的分层现象,导致金属层卷曲,甚至脱落等现象。
1、 玻璃穿孔主要技术
1.1玻璃穿孔成孔技术
制约玻璃通孔技术发展的主要困难之一就是玻璃通孔成孔技术,需要满足高速、高精度、窄节距、侧壁光滑、垂直度好以及低成本等一系列要求。玻璃通孔成孔技术可以分为喷砂法、光敏玻璃法、聚焦发电法、等离子体刻蚀法、激光烧蚀法、电化学放电加工法、激光诱导刻蚀法。

其中,玻璃诱导刻蚀法如下:
1)使用皮秒激光在玻璃上产生变性区域;
2)将激光处理过的玻璃放在氢氟酸溶液中进行刻蚀。
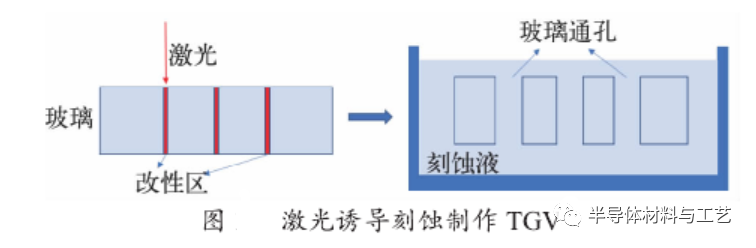
1.2玻璃穿孔填孔技术
类似硅通孔的金属填充方案也可以应用在TGV上。
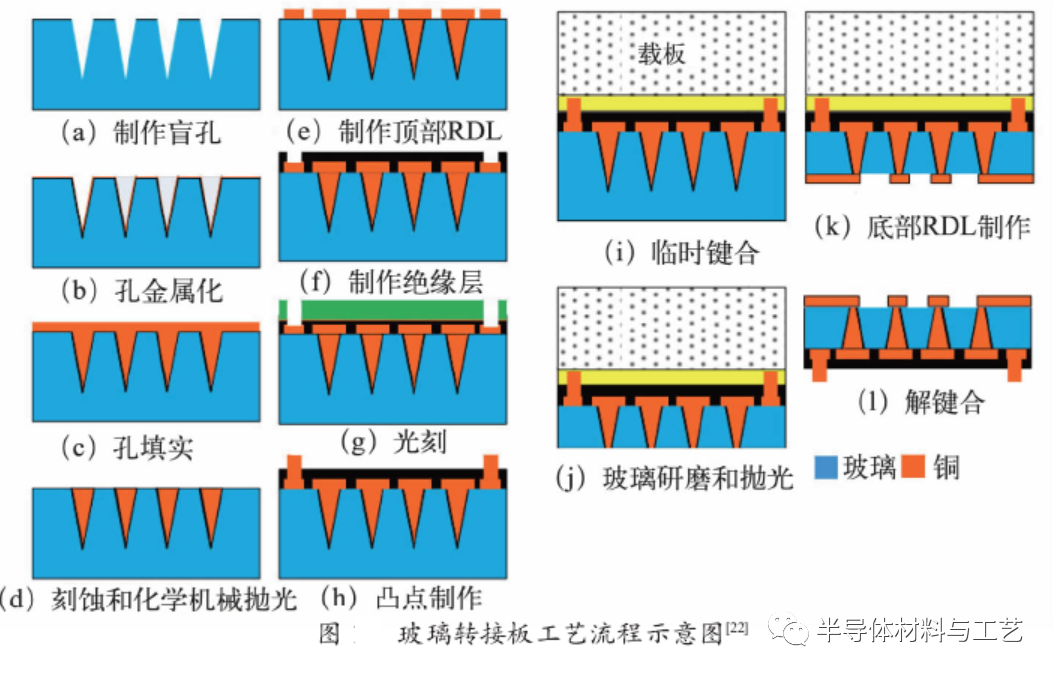
另外一个将TGV填实的方案是将金属导电胶进行TGV填实。利用金属导电胶的优点是固化后导电通孔的热膨胀系数可以调节,使其接近基材,避免了因CTE不匹配造成的失效。
除了TGV电镀填实外,TGV也可以采用通孔内电镀薄层方案实现电学连接。
1.3玻璃通孔高密度布线
线路转移(CTT)和光敏介质嵌入法,是比较常用的方式。CTT主要包括两个过程。一是精细RDL线预制,每一RDL层可以在可移动载体上单独制造一层薄导电层,并在转移到基板上之前测试或检查细线成品率。精细线路的形成采用细线光刻和电解镀铜的方法,并且以薄铜箔作为镀层的种子层。工艺流程如下:
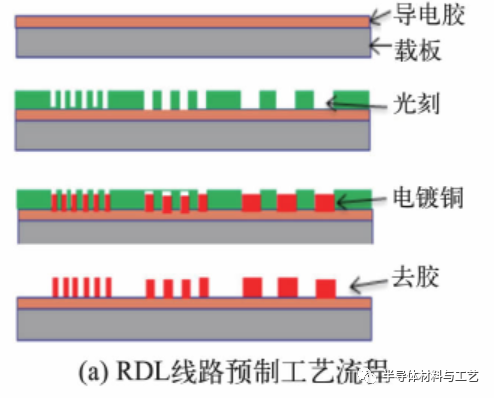
第二步就是将RDL层集成到基板上。RDL层被制造出来后,他们再使用热压合的同时被转移到核心层的两边。步骤如下:
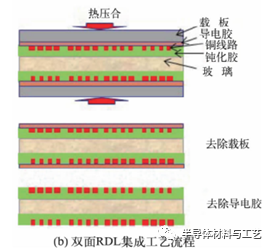
PTE工艺可分为两个不同的步骤,一是在光敏介质层总形成精细的沟槽;二是金属化,包括种子层沉积、电镀和表面除铜。工艺流程如下:
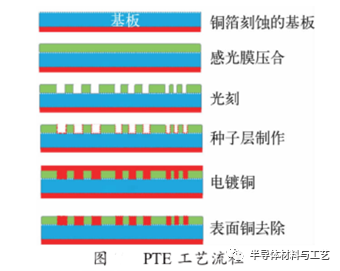
2、国内外研究现状
2011年,瑞士的微纳系统研究部提出了如下图所示的基于TSV技术圆片级真空封装方案。该方案由TSV封帽与器件层两部分构成,TSV封帽垂直导通柱是填充在硅通孔中的铜柱。器件层上制作有金锡电极与铜柱相连,从而把电信号从空腔内部的引到空腔外部,最后通过硅-硅直接键合实现密封。该方案气密性很好,但是TSV封帽制作工艺复杂,热应力大(铜柱与硅热失配大),且硅硅键合对键合表面要求质量很高,一般加工过的硅片很难达到此要求。
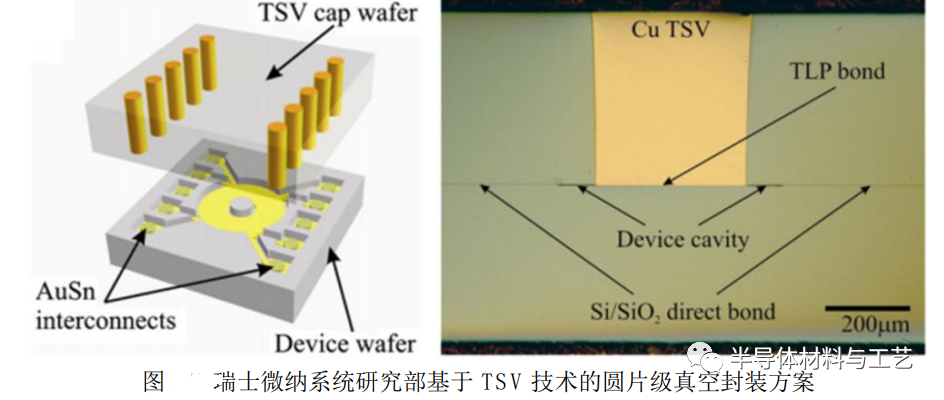
2013年,新加坡微电子学院提出如下图所示基于TSV技术的圆片级真空封装方案。该方案由TSV封帽、硅器件层组成,TSV封帽也是由硅通孔里的铜柱做垂直导通柱,硅器件层上制作有射频结构及金属电极,最后使用AuSn焊料键合实现气密封装。此方案虽然也存在TSV封帽制作工艺复杂,热应力大的问题,但采用焊料键合方式封装,尽管牺牲一定的密封性,但大大降低对TSV键合表面质量的要求,其工业应用范围更广。

从以上两个TSV例子可以看出,TSV存在工艺复杂,热应力过大的缺点。为解决这些问题,更好实现真空封装,又提出了TGV技术。2008年,美国Michigan大学提出了的一种基于常规工艺TGV技术的圆片级真空封装方案,如下图所示。该方案由封帽,器件层以及基于常规工艺TGV技术衬底三部分构成。封帽可以为硅或玻璃,制作有空腔;器件层是硅结构层。基于常规工艺TGV技术衬底是在玻璃片上制作电极和通孔,通孔表面沉积有金属层,有的通孔填充焊锡球,用以形成垂直导通柱,把电信号由密封腔中引出。最后通过阳极键合把器件层与TGV衬底键合在一起,形成密封。该方案优点是通过阳极键合形成密封,阳极键合密封性好、热失配小、污染小且一般硅片能达到阳极键合对表面质量的要求。
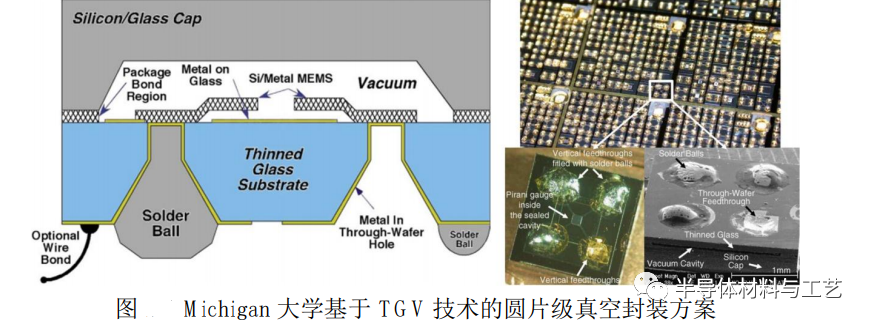
2010年,挪威的Sensonor Technologies AS提出了结构如下图所示的一种基于玻璃回流TGV技术圆片级真空封装方案封装蝶翼式硅微陀螺。为减少结构应力,提高陀螺仪灵敏度,采用三层对称结构设计,上下两层均为TGV衬底,中间夹硅结构层。基于玻璃回流TGV衬底,是通过高温玻璃回流,然后双面CMP加工制成的。TGV衬底垂直导通柱即为由回流玻璃隔离出来的硅柱,衬底上不制作金属电极,直接用硅做电极。硅结构层采用Silicon-on-Insulator (SOI)材料和干法刻蚀制作而成,空腔制作在硅可动结构层上,通过硅-玻璃将三者阳极键合在一起,分别有两次,形成密封环境。该封装方案优势凸出,不仅封装应力低,而且TGV衬底工艺简单,密封性好,热适配小,寄生电容小。
2013年,韩国Dankook大学开发出结构如图所示的TGV技术圆片级真空封装方案。该方案包括玻璃封帽、CPW器件层以及TGV衬底,腔体制作在玻璃封帽上。其TGV衬底与众不同,先后采用玻璃回流工艺与电镀铜工艺制作。简而言之,为先利用玻璃回流工艺制作硅导通柱,然后去除硅导通柱,用电镀铜作导通柱。CPW器件层制作在衬底密封环范围内,最后封帽与衬底通过硅-玻璃阳极键合形成密封腔,并制作外部的金属焊盘完成引线及封装。该方案电学性能优良,但工艺复杂。
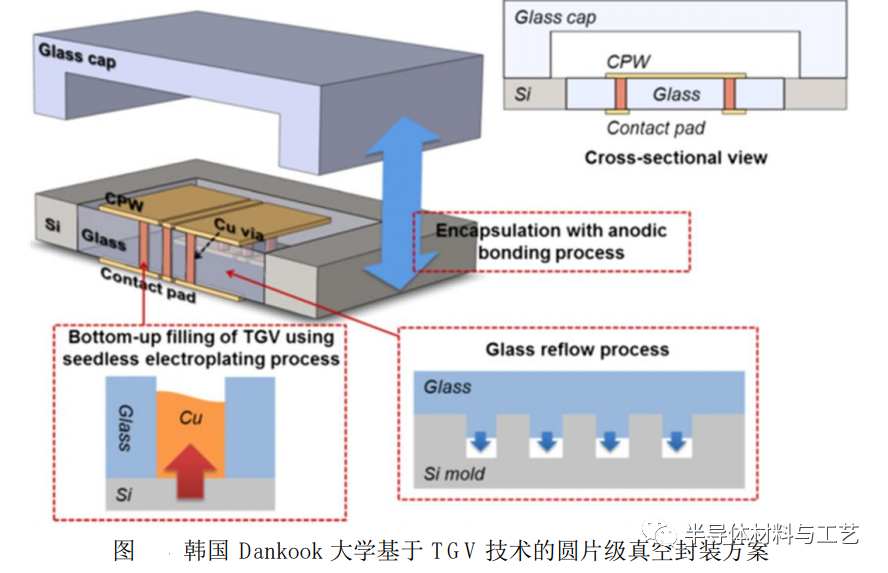
2009年,上海微系统所提出了一种结构如图所示基于TSV技术的圆片级真空封装方案。该方案由TSV封帽与硅衬底两部分组成:TSV封帽采用湿法和干法刻蚀出通孔,通孔中填充铜作为导通柱,导通柱与硅通过隔离层隔离,腔体制作在TSV封帽上。硅衬底上制作有结构,通过Cu-Sn焊料键合与TSV封帽实现密封封装。该方案简单易行,但焊料键合用在圆片级真空封装上会显得键合密封性不够,污染过大。
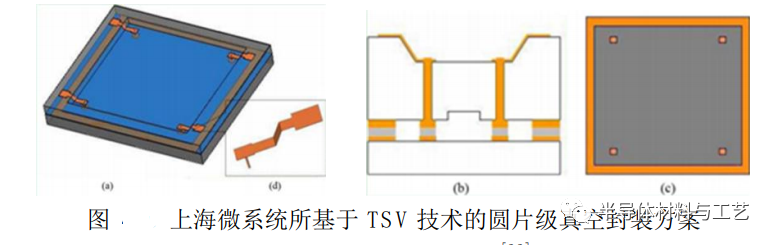
2012年,北京大学提出了结构如图所示一种基于常规工艺TGV技术的圆片级真空封装方案。该方案是典型的三明治式架构,由玻璃封帽、硅可动结构层、TGV衬底三层组成。硅可动结构采用干法刻蚀出可动结构;基于常规工艺TGV衬底采用湿法腐蚀出通孔与金属沉积导通柱等工艺制作而成;空腔制作在封帽上,空腔顶部沉积有吸气剂,保持腔体真空度。最后玻璃封帽、硅可动结构层、TGV衬底通过两次硅-玻璃阳极键合封装在一起。
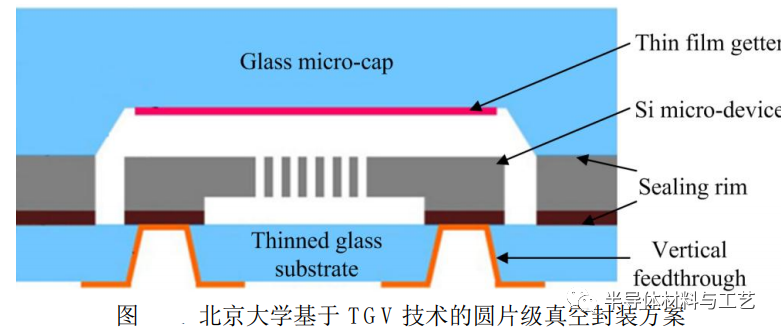
3、TGV技术的应用
3.1玻璃基板的三维集成无源元件
玻璃基板具有优异的高频电学性能,因此被广泛的应用于集成无源器件(IPD)之中。2010年,乔治亚理工的封装中心率先完成了基于TGV的滤波器设计与制造,并与相同的硅基电感对比,展现了更好的电学特性。2017年,日月光集团在玻璃基板上实现了面板级的IPD制作工艺。该方案板材翘曲可控制在1mm以内,并且无明显结构剥落分层现象。
玻璃通孔还可以在玻璃上制作空腔,进而为芯片的封装提供一种嵌入式玻璃扇出(eGFO)的新方案。2017年乔治亚理工率先实现了用于高I/O密度和高频多芯片集成的玻璃面板扇出封装。该技术在70um厚、大小为300mm*300mm的玻璃面板上完成了26个芯片的扇出封装,并有效的控制芯片的偏移和翘曲。2020年云天半导体采用嵌入式玻璃扇出技术开了77GHz汽车雷达芯片的封装,并在此基础上提出了一种高性能的天线封装(AiP)方案。工艺流程如图所示:
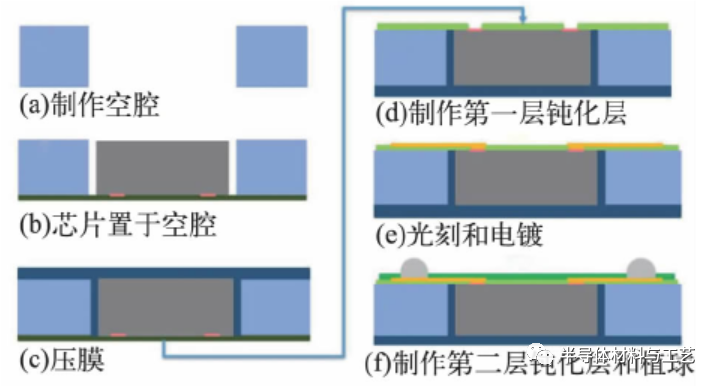
在厚度为180um的玻璃晶片中,先采用激光诱导玻璃变性和化学腐蚀工艺形成玻璃空腔,然后将175um高的芯片放入玻璃空腔总。通过复合材料将芯片和玻璃之间的缝隙填压而不产生空隙,同时保护芯片的背面。对晶圆的顶面进行剥离,形成铜RDL,最后进行后续线路制作、球栅阵列(BGA)制作以及晶圆切片。
3.3基于玻璃通孔的MEMS封装
2013年,LEE等利用玻璃穿孔技术实现射频MEMS器件的晶圆级封装,采用电镀方案实现通孔的完全填充,通过该方案制作的射频MEMS器件在20GHz时具有0.197dB的低插入损耗和20.032dB的高返回损耗。2018年,LAAKSO等创造性地使用磁辅助组装的方式来填充玻璃通孔,并用于MEMS器件的封装中。
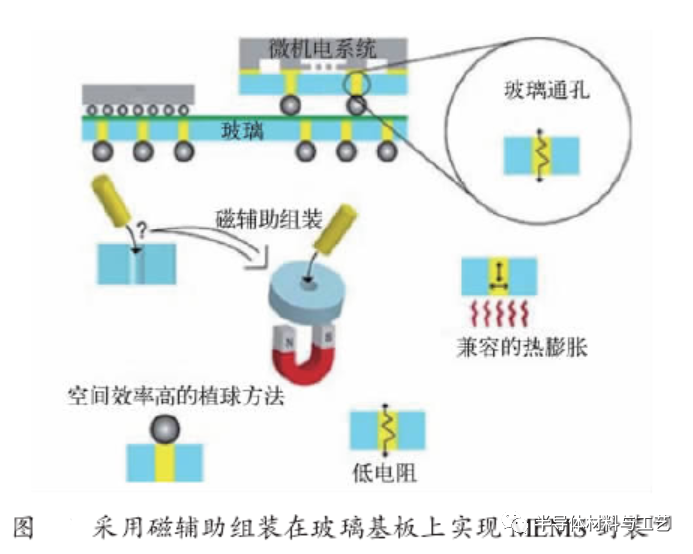
3.4基于TGV的集成天线
厦门大学的张淼创造性的引入TGV加工波导缝隙天线。首先采用激光诱导刻蚀制备波导缝隙阵列天线玻璃衬底,通过激光在玻璃上诱导产生连续性的变性区,后将变性后的玻璃在稀释氢氟酸总进行刻蚀,由于激光作用处的玻璃氢氟酸中刻蚀速率较快,所以玻璃会成块脱落从而形成目标通孔结构。最终刻蚀后的玻璃穿孔精度为±5μm,远远高于传统机加工的精度。其次,采用物理气相沉积对每层波导缝隙阵列天线玻璃衬底溅射铜层,经过氧等离子体清洗以彻底清除焊盘表面的有机物等颗粒,并使晶圆表面产生一定的粗糙度,为种子层的良好附着创造条件。清洗后的晶圆在烤箱150℃下烘烤60min彻底去除水汽。然后在磁控溅射设备中,晶圆表面溅射一层厚度约为5μm的铜层。最后,采用技术焊料键合技术将5片晶圆键合。用刮刀以及丝网将10μm厚度的锡焊料印刷到晶圆表面,然后在键合机的真空腔室中以240℃的温度加热,以40N的压力压合5min使焊料融化或相互扩散以达到键合的目的。工艺流程度如图:
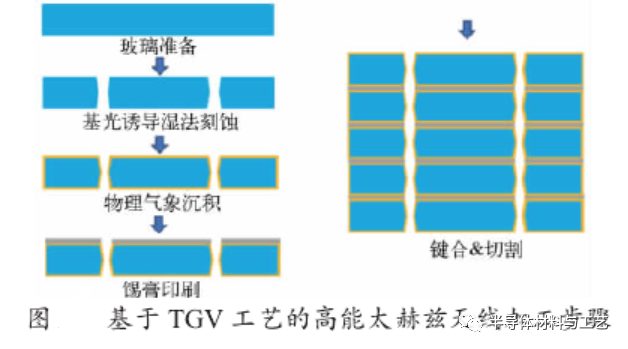
3.5多层玻璃基板
2018年IWAI等使用导电胶填充玻璃通孔,从而实现多层玻璃基板堆叠,在回流过程中,通过该方案制作的多层玻璃基板的翘曲比传统有机基板要小,通过该技术可以实现高密度布线,同时具有较高的可靠性。2019年,IWAI等在多层玻璃基板的技术基础上,完成了一个多芯片封装的结构。其工艺流程如图:
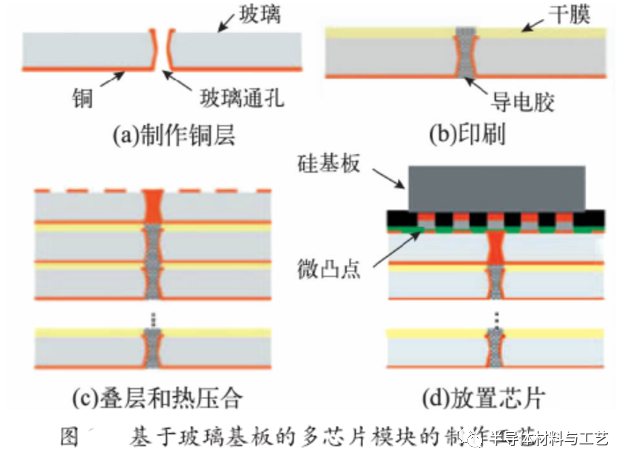
审核编辑:汤梓红
-
半导体
+关注
关注
335文章
29169浏览量
242520 -
嵌入式
+关注
关注
5161文章
19792浏览量
319863 -
滤波器
+关注
关注
162文章
8167浏览量
182715 -
封装
+关注
关注
128文章
8852浏览量
145970 -
刻蚀工艺
+关注
关注
2文章
40浏览量
8634
原文标题:玻璃通孔工艺(TGV)简介
文章出处:【微信号:半导体封装工程师之家,微信公众号:半导体封装工程师之家】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
玻璃基板时代,TGV技术引领基板封装
Plan Optik和4JET联合开发TGV金属化新工艺
玻璃通孔(TGV)工艺技术的应用

TGV玻璃基板主流工艺详解
一文了解玻璃通孔(TGV)技术
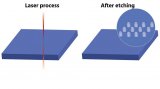
玻璃通孔(TGV)技术原理、应用优势及对芯片封装未来走向的影响

自动对焦技术助力TGV检测 半导体检测精度大突破






 玻璃通孔工艺(TGV)简介
玻璃通孔工艺(TGV)简介

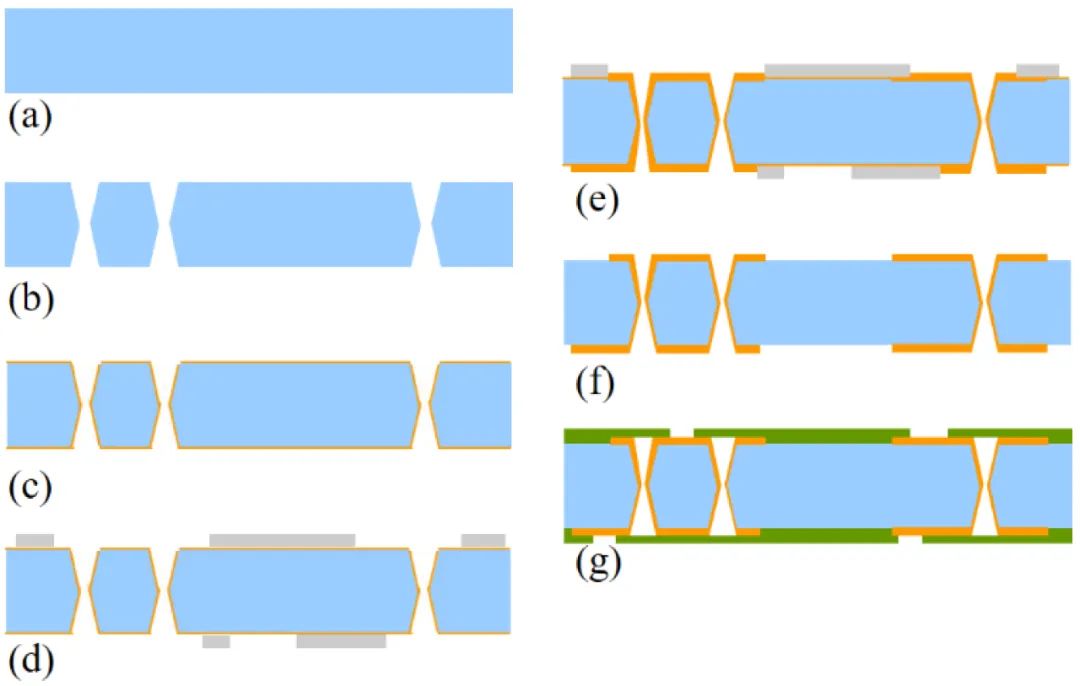


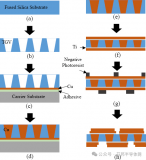

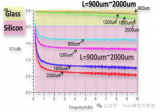











评论