的相互作用,而反应速度直接受温度影响。例如:高温加速反应(如硫酸+双氧水混合液在80℃下快速剥离光刻胶);低温导致反应滞后或不彻底,造成残留物污染后续工序。温度波动±1
![的头像]() 发表于
发表于 08-12 11:23
?109次阅读

氧化硅薄膜和氮化硅薄膜是两种在CMOS工艺中广泛使用的介电层薄膜。
![的头像]() 发表于
发表于 06-24 09:15
?586次阅读

在集成电路制造工艺中,氧化工艺也是很关键的一环。通过在硅晶圆表面形成二氧化硅(SiO?)薄膜,不仅可以实现对硅表面的保护和钝化,还能为后续的掺杂、绝缘、隔离等工艺提供基础支撑。本文将对
![的头像]() 发表于
发表于 06-12 10:23
?909次阅读

ISSG(In-Situ Steam Generation,原位水蒸汽生成)是半导体制造中的一种高温氧化工艺,核心原理是利用氢气(H?)与氧气(O?)在反应腔内直接合成高活性水蒸气,并解离生成原子氧(O*),实现对硅表面的精准氧化。
![的头像]() 发表于
发表于 06-07 09:23
?1247次阅读

),避免引入二次污染。 适用场景:用于RCA标准清洗(SC1/SC2配方)、去除硅片表面金属离子和颗粒。 典型应用: SC1溶液(H?SO?/H?O?):去除有机物和金属污染; SC2溶液(HCl/H?O?):去除重金属残留。 技术限制: 传统SPM(硫酸+过氧化氢)清洗中,过氧
![的头像]() 发表于
发表于 06-04 15:15
?464次阅读
半导体清洗SC1是一种基于氨水(NH?OH)、过氧化氢(H?O?)和去离子水(H?O)的化学清洗工艺,主要用于去除硅片表面的有机物、颗粒污染物及部分金属杂质。以下是其技术原理、配方配比、工艺特点
![的头像]() 发表于
发表于 04-28 17:22
?1953次阅读
的潜在影响。 SPM清洗的化学特性 SPM成分:硫酸(H?SO?)与过氧化氢(H?O?)的混合液,通常比例为2:1至4:1(体积比),温度控制在80-120℃35。 主要作用: 强氧化性:分解有机物(如光刻胶残留)、氧化金属污染
![的头像]() 发表于
发表于 04-27 11:31
?422次阅读
法) RCA清洗是晶圆清洗的经典工艺,分为两个核心步骤(SC-1和SC-2),通过化学溶液去除有机物、金属污染物和颗粒124: SC-1(APM溶液) 化学配比:氢氧化铵(NH?OH,28%)、过氧化氢(H?O?,30%)与去离
![的头像]() 发表于
发表于 04-22 09:01
?488次阅读
AEC-Q102标准作为汽车电子委员会制定的重要规范,为汽车级集成电路的可靠性测试提供了明确的指导。其中,硫化氢(H?S)试验是AEC-Q102标准中极具代表性的测试项目之一,它专注于评估集成电路在
![的头像]() 发表于
发表于 04-18 12:01
?254次阅读

资料介绍
此文档是最详尽最完整介绍半导体前端工艺和后端制程的书籍,作者是美国人Michael Quirk。看完相信你对整个芯片制造流程会非常清晰地了解。从硅片制造,到晶圆厂芯片工艺的四大基本类
发表于 04-15 13:52
在半导体制造过程中,SPM(Sulfuric Peroxide Mixture,硫酸过氧化氢混合液)清洗和HF(Hydrofluoric Acid,氢氟酸)清洗都是重要的湿法清洗步骤。但是很多人有点
![的头像]() 发表于
发表于 04-07 09:47
?681次阅读
可能来源于前道工序或环境。通常采用超声波清洗、机械刷洗等物理方法,结合化学溶液(如酸性过氧化氢溶液)进行清洗。 刻蚀后清洗 目的与方法:在晶圆经过刻蚀工艺后,表面会残留刻蚀剂和其他杂质,需要通过清洗去除。此步骤通常
![的头像]() 发表于
发表于 01-07 16:12
?502次阅读
一应用原理当产品在大气中使用时,大气环境会导致产品金属表面形成水膜,而大气中存在的硫化氢、二氧化硫、二氧化氮、氯气等有害气体会溶入金属表面的水膜中,产生腐蚀性离子加速腐蚀的发生。近年来,环境的不断
![的头像]() 发表于
发表于 11-18 17:56
?1035次阅读
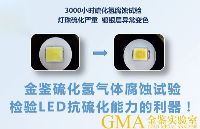
本文简单介去除晶圆表面颗粒的原因及方法。
在12寸(300毫米)晶圆厂中,清洗是一个至关重要的工序。晶圆厂会购买大量的高纯度湿化学品如硫酸,盐酸,双氧水,氨水,氢氟酸等用于清洗。
![的头像]() 发表于
发表于 11-11 09:40
?1388次阅读
与亚微米工艺类似,栅氧化层工艺是通过热氧化形成高质量的栅氧化层,它的热稳定性和界面态都非常好。
![的头像]() 发表于
发表于 11-05 15:37
?1598次阅读
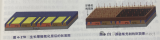






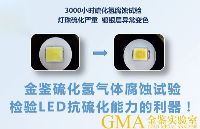





 过氧化氢(双氧水)工艺资料(下)
过氧化氢(双氧水)工艺资料(下)


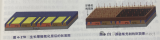










评论