ћ®їэµз“їћхЅъ≤ЉЊ÷‘ўЌї∆∆£ђЌк≥…»Ђ«т „њ≈3D ICЈв„∞ЉЉ х£ђ‘§Љ∆2021ƒкЅњ≤ъ°£“µљз»ѕќ™£ђћ®їэµз3D ICЈв„∞ЉЉ х÷ч“™ќ™ќіјі∆їєы–¬ јіъі¶јн∆чµЉ»л5ƒ…√„“‘ѕ¬ѕ»љш÷∆≥ћ£ђ’ыЇѕ»Ћє§÷«ƒ№(AI)”л–¬–ЌіжіҐ∆чµƒ“м÷ –Њ∆ђ‘§„ч„Љ±Є£ђ”–Ќы≥÷–шґјјњ∆їєыіуµ•°£
ћ®їэµзѕтјі≤ї∆ј¬џљ”µ•”лњЌїІ„іњц°£“µљз»ѕќ™£ђћ®їэµз’э љљ“¬ґ3D ICЈв„∞¬х»лЅњ≤ъ ±≥ћ£ђ“вќґ»Ђ«т–Њ∆ђЇуґќЈв„∞љш»л’ж’эµƒ3D–¬ЉЌ‘™£ђћ®їэµз’∆ќ’ѕ»љш÷∆≥ћ”≈ ∆Їу£ђљбЇѕѕ»љшЇуґќЈв„∞ЉЉ х£ђґ‘ќіјіљ”µ•ЄьЊя”≈ ∆£ђљЂ≥÷–шќђ≥÷“µљзЅмѕ»µЎќї°£
ѕ»љшЈв„∞љьјі±ї ”ќ™—”…мƒ¶ґыґ®¬…µƒјы∆ч£ђЌЄєэ–Њ∆ђґ—µю£ђіуЈщћб…э–Њ∆ђє¶ƒ№°£ћ®їэµз’вЉЄƒкЌ∆≥цµƒCoWoSЉ∞’ыЇѕ…»≥ц–ЌЈв„∞(InFO)£ђЊЌ «“т”¶њЌїІѕ£Ќы“їіќµљќї£ђћбє©і”–Њ∆ђ÷∆‘мµљЇуґќЈв„∞µƒ’ыЇѕЈюќс°£
ћ®їэµз«њµч£ђCoWoSЉ∞’ыЇѕ…»≥ц–ЌЈв„∞(InFO)»‘ «2.5D ICЈв„∞£ђќ™ЅЋ»√–Њ∆ђ–Іƒ№Єь«њ£ђ–Њ∆ђ“µї®ЅЋѕаµ±µƒ ±Љд£ђњ™ЈҐћеїэ–°°Ґє¶ƒ№ЄьЄі‘”µƒ3D IC£ђ’вѕоЉЉ х–иіо≈дƒ—ґ»ЄьЄяµƒќщ„књ„(TSV)ЉЉ х£ђ“‘Љ∞ЊІ‘≤±°їѓ°ҐµЉµз≤ƒ÷ ћоњ„°ҐЊІ‘≤Ѕђљ”Љ∞…Ґ»»÷І≥÷°£
Њ°є№ћ®їэµзќіЌЄ¬ґЇѕ„чњ™ЈҐґ‘ѕу£ђ“µљз»ѕќ™£ђ3D ICЈв„∞ЉЉ х≤гіќЈ«≥£Єя£ђ÷ч“™”√јі’ыЇѕ„оѕ»љшµƒі¶јн∆ч°Ґ эЊЁ–Њ∆ђ°ҐЄя∆µіжіҐ∆ч°ҐCMOS”∞ѕсЄ–”¶∆ч”띥їъµзѕµЌ≥(MEMS)£ђ“ї∞г–и“™’в÷÷ЉЉ хµƒєЂЋЊ£ђґа «єъЉ ÷™√ыѕµЌ≥≥І°£“‘ћ®їэµзЉЉ хњ™ЈҐјґЌЉ—–≈–£ђ∆їєы”¶Є√ « „Љ“µЉ»л3D ICЈв„∞ЉЉ хµƒњЌїІ°£
-
ћ®їэµз
+єЎ„Ґ
єЎ„Ґ
44ќƒ’¬
5760дѓјјЅњ
170151 -
∆їєы
+єЎ„Ґ
єЎ„Ґ
61ќƒ’¬
24551дѓјјЅњ
204425
‘≠ќƒ±кћв£Їћ®їэµзЌк≥…»Ђ«т „њ≈3D ICЈв„∞ЉЉ х
ќƒ’¬≥ці¶£Ї°ЊќҐ–≈Ї≈£ЇSEMI2025£ђќҐ–≈єЂ÷ЏЇ≈£Ї∞лµЉће«∞—Ў°њїґ”≠ћнЉ”єЎ„Ґ£°ќƒ’¬„™‘Ў«л„Ґ√ч≥ці¶°£
ЈҐ≤Љ∆ј¬џ«лѕ» µ«¬Љ
њіµг£Їћ®їэµз‘Џ√јљ®Ѕљ„щѕ»љшЈв„∞≥І ≤©Ќ® Ѓ“Џ√ј‘™∞лµЉћеє§≥ІћЄ≈–∆∆Ѕ—
ќч√≈„””лћ®їэµзЇѕ„чЌ∆ґѓ∞лµЉће…иЉ∆”лЉѓ≥…іі–¬ ∞ьј®ћ®їэµзN3P N3C A14ЉЉ х
ћ®їэµз„оіуѕ»љшЈв„∞≥ІAP8љшїъ
ќч√≈„” э„÷їѓє§“µ»нЉю”лћ®їэµзњ™’єљш“ї≤љЇѕ„ч
AMDїт „≤…ћ®їэµзCOUPEЈв„∞ЉЉ х
ћ®їэµзј©іуѕ»љшЈв„∞…и ©£ђƒѕњ∆µ»µЎљЂ‘цљ®–¬≥І
ѕыѕҐ≥∆ћ®їэµзЌк≥…CPO”лѕ»љшЈв„∞ЉЉ х’ыЇѕ£ђ‘§Љ∆√чƒк”–ЌыЋЌ—щ
ћ®їэµзCoWoSЈв„∞A1ЉЉ хљй…№

ЉЉ х„ —ґ | 2.5D ”л 3D Јв„∞

ќч√≈„”ј©іу”лћ®їэµзЇѕ„чЌ∆ґѓICЇЌѕµЌ≥…иЉ∆
ћ®їэµзѕ»љшЈв„∞≤ъƒ№Љ”Ћўј©’≈
ћ®їэµзЈв„∞£ђ–¬єжїЃ
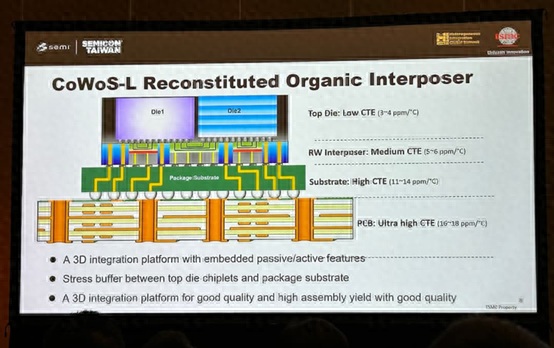





 ћ®їэµзЌк≥…»Ђ«т „њ≈3D ICЈв„∞ЉЉ х
ћ®їэµзЌк≥…»Ђ«т „њ≈3D ICЈв„∞ЉЉ х












∆ј¬џ