随着汽车行业快速增长,全球芯片市场对高性能芯片的需求大幅上涨。这一增长主要源于高级驾驶辅助系统 (ADAS)、电动汽车 (EV) 和智能网联汽车的普及。这些技术需要快速数据处理、增强传感器融合以及更优的通信能力的支持,以提升车辆性能、舒适性和安全性。芯片行业的关键进展之一是芯粒(小晶片)技术的横空出世。芯粒(小晶片)具有灵活、可扩展且经济高效的特点,能将多种技术集成到一块芯片上。这种集成显著提升了汽车的性能,同时降低了复杂度。例如,瑞萨电子已在其新一代汽车 SoC 中使用芯粒(小晶片),这表明该技术在汽车领域日益普及。
芯粒(小晶片)技术的一大显著优势在于其出色的适应性。与传统单片式设计不同,芯粒(小晶片)采用模块化方案,使制造商能够无缝集成各类专用功能。这种覆盖车辆全生命周期的适应性让 OEM 能够构建稳健而灵活的电子架构。传统定制芯片的设计和制造需要耗费大量时间与成本,单次流片就需要耗费数月时间及数百万美元的投入。通过紧密集成芯粒(小晶片),无需进一步缩小晶体管尺寸即可构建性能强大的系统;在成本与功耗对利基市场服务商构成严峻挑战的行业中,芯粒(小晶片)平台提供了一种突破性的解决方案。
汽车行业的企业正在想方设法通过提供差异化功能(如增强的安全性和高级娱乐选项与技术)在竞争中脱颖而出,从而满足市场需求,并最大限度缩短产品上市时间。我们正在迎来一个更加互联、以先进技术为主导的世界,汽车行业正顺应这一趋势,而芯粒(小晶片)技术在这一进程中发挥着重要作用。
1
集成化设计与分析解决方案
芯粒(小晶片)设计在一个封装中集成了多个裸片,这种高效的分区逻辑完美契合当前最先进的封装制造工艺。构建封装解决方案需要将所有硅片与外界隔离保护,并实现电源与信号的高效连接。高级封装与芯粒(小晶片)设计的进步主要由 PCB 领域的传统外包封装测试 (OSAT) 厂商推动。晶圆代工厂也在开发自有的品牌和先进封装技术,以满足市场不断变化的需求。
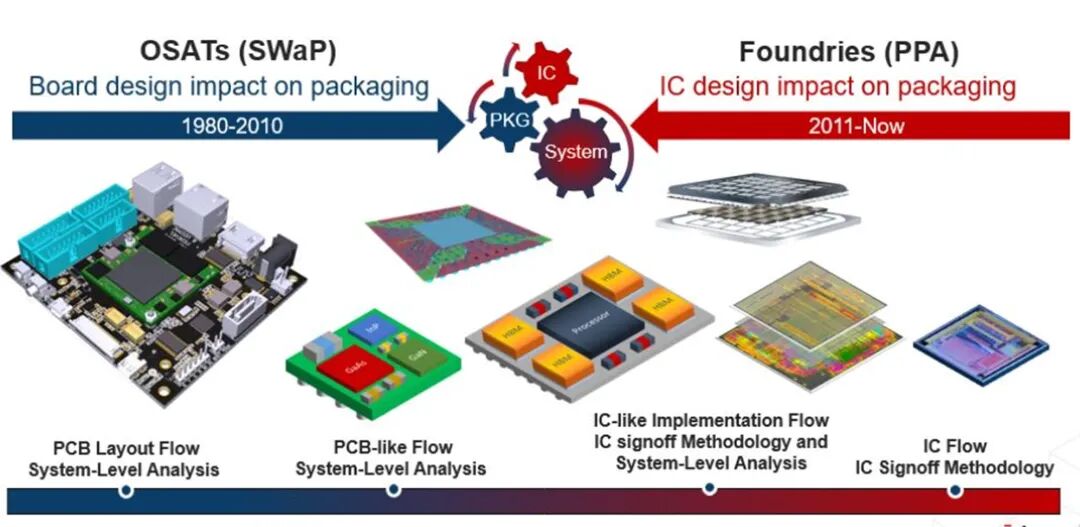
在谈及3D 封装与芯粒(小晶片)设计时,理解二者的区别至关重要。3D 封装采用独立设计的架构,具有清晰的接口和抽象的轮廓,通过凸块及与这些凸块的连接来实现封装。相比之下,硅片的 3D 堆叠需将单个 RTL 分割到两个独立晶圆上,这对门级分区与工艺仿真提出了严峻挑战。
封装技术已成为半导体设计不可或缺的组成部分,而不再是事后才考虑的环节。采用不同技术的先进多芯粒(小晶片)与多裸片封装趋势,正在为产品创造附加价值。这使得企业能够构建具有市场竞争力的卓越解决方案,通过先进封装技术提供更多卖点。但封装生态系统面临的挑战与硅片领域截然不同。在硅片领域,5 纳米制程设计套件 (PDK) 已明确可用。但在封装环节,与晶圆厂合作开发组装设计套件至关重要。
下一个挑战是现成的芯粒(小晶片)。目前尚未形成可购买特定功能芯粒(小晶片)的规模化市场。业界正积极联合多家 IP 供应商与企业,推进可公开销售的芯粒(小晶片)设计。其核心理念是:从供应商 A 与 B 处采购芯粒(小晶片)后,只需通过 UCIe 等标准化接口或线束连接,即可实现一致的互联通信。标准化进程正在进行中,当前面临的挑战是如何协调不同技术与标准,以构建如此复杂的系统。
2
芯粒(小晶片) 3D 集成技术
挑战与全方位解决方案
基于芯粒(小晶片)的系统设计带来了超越单一结构考量的复杂性。处理系统级任务需要运用电子设计自动化 (EDA) 工具进行热分析、信号完整性、电源完整性分析以及物理连接对准。

Cadence 是提供 IC、SiP/MCM、PCB 及系统分析工具的全方位解决方案供应商。

Integrity 3D-IC 平台
Cadence Integrity 3D-IC 平台将不同的设计平台与工具整合到一个解决?案之中,该平台有效促进了 IC 与封装设计?员跨?具、跨平台的协同?作。支持大容量的设计,可以帮助系统设计师规划、实现和分析具有各种封装风格(2.5D 或 3D)的任何类型的堆叠芯片系统。提供业界首个集成化系统和 SoC 级解决方案,利用系统分析技术与 Cadence 的 Virtuoso 和 Allegro X 模拟和封装实现环境进行协同设计。
-
晶片
+关注
关注
1文章
409浏览量
32377 -
汽车设计
+关注
关注
1文章
32浏览量
10473 -
驾驶辅助
+关注
关注
0文章
38浏览量
10103
发布评论请先 登录
高品质抗硫化汽车级晶片电阻器NS系列-阻容1号
多点悬浮触控技术将掀起一场新革命
行业资讯 I 芯粒峰会:基于芯粒的设计面临哪些挑战






 技术资讯 I 基于芯粒(小晶片)的架构掀起汽车设计革命
技术资讯 I 基于芯粒(小晶片)的架构掀起汽车设计革命


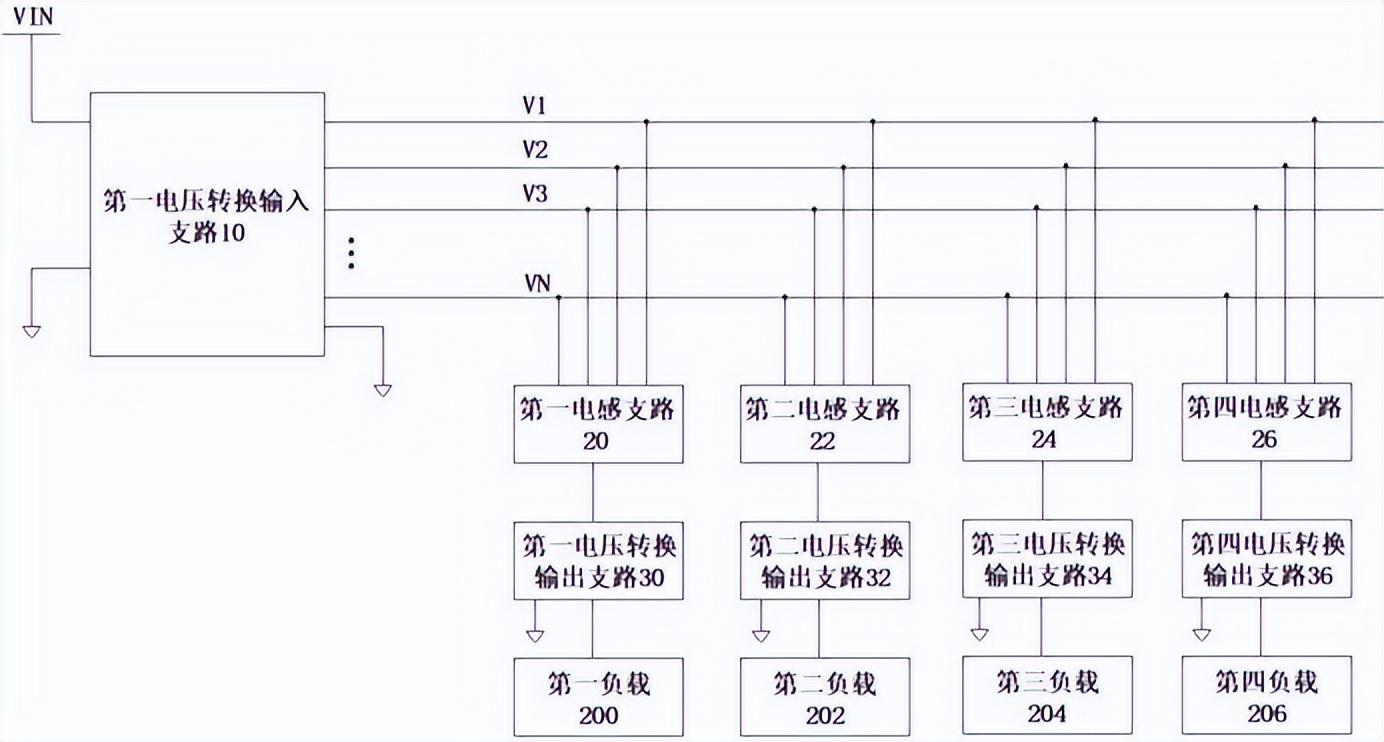












评论