半导体RCA清洗工艺中使用的主要药液包括以下几种,每种均针对特定类型的污染物设计,并通过化学反应实现高效清洁:
SC-1(碱性清洗液)
成分组成:由氢氧化铵(NH?OH)、过氧化氢(H?O?)和去离子水按比例混合而成,常见配比为1:1:5至1:2:7(体积比)。
核心作用:作为碱性溶液,主要用于去除颗粒、有机污染物及部分金属杂质。其机理在于双氧水的强氧化性分解有机物,同时氨水的碱性环境使硅片表面形成增厚的氧化层并携带负电荷,通过静电排斥力剥离附着的颗粒;此外,该过程还能络合金属离子,防止重新沉积。
工艺参数:通常在70–80°C下处理5–10分钟,后续需用大量去离子水彻底冲洗以避免残留。
SC-2(酸性清洗液)
成分组成:含盐酸(HCl)、过氧化氢(H?O?)和去离子水,典型配比为1:1:6至1:2:8(体积比)。
核心作用:针对金属污染进行深度清除。盐酸溶解金属氧化物生成可溶性氯化物,而双氧水进一步氧化残留的金属或有机物,尤其对碱性步骤后遗留的杂质有效。此步骤还能中和前序反应的碱性环境,确保表面电中性。
工艺参数:同样在70–80°C条件下运行5–10分钟,完成后必须充分水洗以终止反应并去除溶解产物。
稀释氢氟酸(DHF)
成分组成:氢氟酸与水的稀释混合物,常用比例为H?O:HF=100:1~20:1(体积比)。
核心作用:专门用于蚀刻去除SC-1/SC-2过程中形成的氧化层(如SiO?),同时释放被吸附的金属离子和微颗粒。由于其各向同性腐蚀特性,可均匀剥离表层而不损伤底层硅基体。
工艺要点:因HF的高腐蚀性和毒性,操作时间极短(通常1–2分钟),且需严格监控浓度与温度,避免过蚀风险。
硫酸-双氧水混合液(SPM)
成分组成:浓硫酸(H?SO?)与双氧水按3:1至5:1的比例调配。
核心作用:预处理阶段的强力清洗剂,适用于去除顽固有机物及重金属(如金、铜)。高温下硫酸提供强酸性环境促使有机物脱水碳化,双氧水则将这些碳化物氧化为气体逸出,实现深度净化。
工艺参数:需在100–120°C高温下维持10–30分钟,常用于晶圆初始脱脂或光刻胶去除前的准备工作。
缓冲氧化物蚀刻液(BOE)
成分组成:氢氟酸与氟化铵按1:6体积比配制。
核心作用:相较于纯DHF,BOE通过缓冲体系实现更可控的二氧化硅蚀刻速率,减少对底层材料的损伤,常用于精细图案转移后的氧化层修整。
这些药液通过分步反应协同作用,依次去除有机物、金属离子、氧化层及颗粒污染物。实际生产中会根据污染物类型调整配方比例、温度与处理时间,并结合兆声波辅助提升清洗效率。
-
半导体
+关注
关注
336文章
29363浏览量
246231 -
RCA
+关注
关注
0文章
43浏览量
9105 -
清洗工艺
+关注
关注
0文章
16浏览量
6749
发布评论请先 登录
苏州芯矽科技:半导体清洗机的坚实力量
半导体及光伏太阳能领域湿法清洗
苏州晶淼半导体 非标清洗设备
超声波清洗机,苏州晶淼半导体设备有限公司
半导体清洗工艺全集
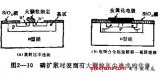
工业泵在半导体湿法腐蚀清洗设备中的应用

基于RCA清洗的湿式清洗工艺
半导体器件制造过程中的清洗技术

探秘半导体制造中单片式清洗设备
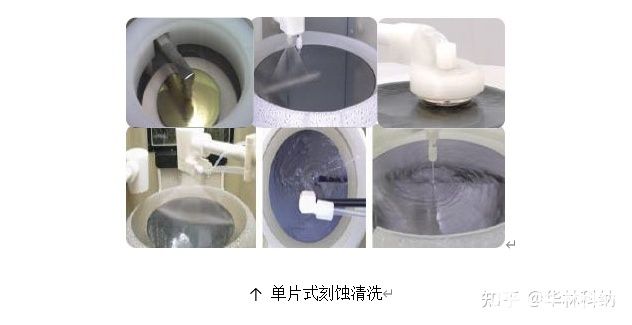





 半导体rca清洗都有什么药液
半导体rca清洗都有什么药液

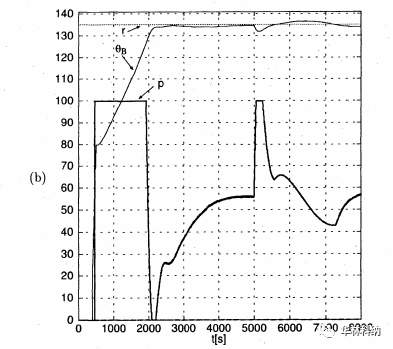













评论