电子发烧友网报道(文 / 吴子鹏)在半导体产业向 “超越摩尔定律” 迈进的关键阶段,键合技术作为实现芯片多维集成的核心支撑,正从后端封装环节走向产业创新前沿。在第十三届半导体设备与核心部件及材料展(CSEAC 2025)主论坛暨第十三届中国电子专用设备工业协会半导体设备年会上,拓荆科技股份有限公司董事长吕光泉与青禾晶元半导体科技(集团)有限责任公司创始人兼董事长母凤文,分别从原子级制造与键合集成两大核心维度,分享了半导体技术突破路径与产业应用实践,为中国半导体设备产业向多维创新发展提供了关键思路。
破解集成电路 “密度与带宽” 双重瓶颈的核心路径
在集成电路产业发展历程中,“摩尔定律” 驱动的制程微缩已逐步接近物理极限,而芯片性能提升与应用需求之间的差距却在持续扩大。吕光泉董事长指出,当前半导体产业面临的核心矛盾,在于器件密度提升与 I/O 带宽不足的错配:逻辑芯片算力 20 年增长 9 万倍,存储密度同步提升,但芯片间通讯带宽仅增长 30 倍,“存储墙” 已成为制约人工智能(AI)、高性能计算等场景的关键瓶颈。
要突破这一困境,需从 “平面集成” 转向 “多维集成”—— 前道制造通过原子级精度工艺提升器件密度,后道封装通过键合技术突破互联带宽限制,二者共同构成集成电路多维创新的核心框架。原子层沉积(ALD)技术凭借其精准的薄膜控制能力,成为前道工艺中实现复杂三维结构的核心支撑。吕光泉介绍,ALD 具有三大关键优势:一是沉积速率可控性极强,可实现原子级精度的薄膜生长;二是均匀性与保形性优异,对高深宽比结构(如 3D NAND 的存储孔洞)的覆盖能力远超传统工艺;三是材料兼容性广,可适配高介电常数(High-K)材料、金属栅极等新型材料体系。
在具体应用中,ALD 已成为先进器件结构的 “刚需技术”。以全环绕栅极(GAA)与互补场效应晶体管(CFET)为例,其立体栅极结构需通过 ALD 依次沉积 High-K 层、金属功函数层、钨层等关键薄膜,每层厚度控制需精准到纳米级,且需保证不同区域的一致性,若缺少 ALD 技术,此类复杂结构的量产将无从谈起。而在动态随机存取存储器(DRAM)领域,垂直结构(V-DRAM)的制备更是依赖 ALD 与原子层刻蚀(ALE)的协同 —— 通过 ALD 实现各向同性薄膜沉积,再借助 ALE 的自控性刻蚀能力,解决高深宽比结构的刻蚀难题,同时避免表面损伤,最终形成高密度存储单元。
与 ALD 相辅相成的 ALE 技术,是原子级制造的另一核心支柱。吕光泉强调,ALE 的 “自控性” 特性颠覆了传统刻蚀逻辑:其通过 “沉积 - 刻蚀” 的循环过程,可实现原子级别的刻蚀深度控制,尤其适用于 3D NAND、高带宽存储器(HBM)等需要超高精度的场景。例如,在 3D NAND 的通道孔刻蚀中,ALE 能有效解决传统干法刻蚀易导致的孔壁粗糙、尺寸不均问题,将刻蚀均匀性控制在纳米级,直接提升存储芯片的良率与可靠性。
键合集成:打通集成电路后道工艺的带宽瓶颈
青禾晶元母凤文董事长则聚焦后道工艺,提出键合技术是解决芯片互联带宽、突破平面集成限制的关键平台性技术。当前半导体产业正从 “平面集成” 向 “三维异构集成” 转型,键合技术不仅能实现不同芯片、不同材料的融合,更能将芯片间互联密度从传统封装的数百个节点提升至百万级,为 AI、高性能计算等场景提供核心支撑。
永久性键合:从材料融合到系统性能跃升
永久性键合技术主要包括超高真空室温键合、亲水性键合与混合键合,分别适用于不同应用场景:
·超高真空室温键合:作为青禾晶元的特色技术,其核心优势在于 “无热应力” 与 “原子级界面”。该技术在超高真空环境下,通过离子束轰击去除材料表面氧化层与污染物,获得高活性表面,随后在室温下实现原子间直接键合。在碳化硅(SiC)复合衬底制造中,通过该技术可将高质量 SiC 薄膜转移至低质量 SiC 衬底上,使高质量衬底重复利用,大幅降低 SiC 器件成本;在高端声表面波(SAW)器件的压电 - on - 绝缘体(POI)衬底制造中,可实现铌酸锂(LT)与硅、蓝宝石等材料的无应力键合,避免传统高温键合导致的材料翘曲、性能衰减问题。
·亲水性键合:通过等离子体处理使材料表面形成羟基,借助羟基间的范德华力实现预键合,再经热处理形成共价键。该技术是绝缘体上硅(SOI)衬底制造的核心工艺,广泛应用于国防、航空、汽车电子等对器件稳定性要求极高的领域,可有效提升芯片的抗辐射、耐高温性能。
·混合键合:融合介质层亲水性键合与金属热扩散键合,是先进封装的 “核心引擎”。母凤文指出,混合键合主要分为晶圆到晶圆(W2W)与芯片到晶圆(C2W)两种模式:W2W 适合小芯片批量键合,颗粒控制难度低;C2W 支持已知良好芯片(KGD)筛选,可实现不同工艺节点、不同材料芯片的异构集成,是 HBM、芯粒(Chiplet)技术的关键支撑。例如,在 HBM 封装中,混合键合无需凸点(Bump),可将 DRAM 堆叠高度降低 30% 以上,同时提升热排放效率;在 Chiplet 架构中,通过 C2W 混合键合可将 3nm 逻辑芯片与 28nm I/O 芯片、射频芯片等异构集成,兼顾性能与成本。
临时键合:支撑先进制程的 “过渡性核心技术”
临时键合技术主要用于晶圆减薄、背面处理等工艺,分为有机物与无机物两类。其中,无机物临时键合是新兴技术方向,相较于传统有机物临时键合,其优势显著:无需有机物涂层,材料成本降低 50% 以上;无机物层厚度仅数十纳米,可实现低应力;兼容高温制程(部分技术可耐受 1000℃),与先进晶圆厂(Fab)工艺适配性更高。目前,该技术已应用于存储器、图像传感器(CIS)、功率器件等领域,为晶圆背面电路制备、超薄晶圆加工提供关键支撑。
国产设备迈向 “全球竞争” 新征程
从先进制程的刻蚀、薄膜沉积设备突破,到先进封装的键合、量测设备领跑,国产设备已不再是 “低端替代” 的代名词,而是在 “高端局” 中逐步掌握话语权。当前,全球半导体产业正经历 “技术重构、生态重塑” 的关键阶段,国产设备企业需持续深化技术创新,强化产业链协同,抓住 AI、汽车电子、高性能计算等新兴需求机遇,从 “突破高端” 向 “引领标准” 迈进,为中国半导体产业实现高水平科技自立自强提供核心支撑。正如无锡市人民政府副市长孙玮所言:“半导体装备是集成电路产业的‘基石’,国产设备的高端突破,将为我国构建开放协同的产业生态、实现自主可控作出更大贡献。”
-
半导体设备
+关注
关注
4文章
406浏览量
16216
发布评论请先 登录
CSEAC 2025:从原子级制造到键合集成,国产设备的 “高端局”
从光固化到半导体材料:久日新材的光刻胶国产替代之路
从原理到应用,一文读懂半导体温控技术的奥秘
突破"卡脖子"困境:国产工业电源加速半导体设备国产替代潮

国产SiC碳化硅功率半导体企业引领全球市场格局重构
半导体制造AI大脑:从CIM1.0到CIM 3.0的中国式跃迁

最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测
打破海外垄断,青禾晶元:引领半导体键合新纪元






 从原子级制造到键合集成,国产半导体设备的 “高端局”
从原子级制造到键合集成,国产半导体设备的 “高端局”



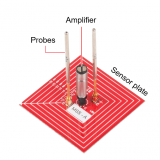










评论