随着电子行业向更小节点迈进,现代应用要求更高的时钟速率和性能。2014 年,斯坦福大学教授 Mark Horowitz 发表了一篇开创性的论文,描述半导体行业面临相关登纳德缩放及摩尔定律失效的挑战。尽管摩尔定律可能还没有定论,但登纳德缩放已经放缓,更高的性能是以更大漏电为代价的。如果我们缩小芯片面积,而部件功耗没有相应降低,则热密度将会增加,这会促进对更高效热管理解决方案的需求。
产品创新需要新功能以及支持更高计算密度的能力。与此同时,市场正在推动新产品在更具挑战性的环境中部署,通常具有高环境温度。为这些器件散热是一项非比寻常的工作,特别是在无线( 55°C )及汽车( 85°C )系统等常见应用的极端环境中。更具挑战性的是太空应用中的极端环境,其环境温度波动可能超过 300°C。在这里,主动热控制系统可调节电子器件所处的温度,并通过流体循环及外部红外辐射器散热,提高对热效率的要求。在具有挑战性的环境中,即使适度的热阻抗改善,也能带来显著的优势。
AMD 不断通过硬化重要功能及接口创新 Versal 自适应 SoC,例如,多速率 MAC( MRMAC )、600G 通道化多速率以太网( DCMAC )、AI 引擎以及低密度奇偶校验( LDPC )。所有 Versal 器件的一项重要创新是可编程片上网络( NoC ),它在芯片上提供硬化的高带宽、确定性连接基础架构。总而言之,这些进步可减少所需的可编程逻辑量,为更低动态功耗、按键时序收敛以及使用更小、更高效的器件完成给定任务铺平了道路。有关 Versal NoC 优势的更多详情,请参阅:《利用 Versal 自适应 SoC 可编程片上网络优化设计效率》。
本白皮书介绍的特定创新是 AMD 无顶盖封装技术,这项可改变市场格局的技术提供卓越的系统级优势。带加强环的无顶盖封装不应与裸片无顶盖封装混淆。AMD 带加强环的无顶盖封装可提供更高效的散热解决方案,使我们的客户能够在几乎任何环境中部署产品,无论是在地球之上还是地球之外!
-
半导体
+关注
关注
335文章
29196浏览量
242717 -
封装技术
+关注
关注
12文章
586浏览量
68728 -
散热
+关注
关注
3文章
556浏览量
32596
原文标题:白皮书 | 采用创新封装解决方案应对散热挑战
文章出处:【微信号:赛灵思,微信公众号:Xilinx赛灵思官微】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
LitePoint如应对UWB测试挑战

MUN12AD03-SEC的封装设计对散热有何影响?
动力电池测试中的直流负载挑战与应对策略
电脑的散热设计
DOH技术工艺方案解决陶瓷基板DBC散热挑战问题

软件定义汽车(SDV)开发有哪些挑战?SDV开发策略分享:福特汽车采用Jama Connect提升开发效率与质量

软件定义汽车(SDV)开发有哪些挑战?SDV开发策略分享:福特汽车采用Jama Connect提升开发效率与质量
塑封、切筋打弯及封装散热工艺设计
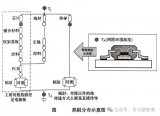
BGA封装对散热性能的影响
华润微持续发力MOSFET先进封装,三款顶部散热封装产品实现量产






 借助AMD无顶盖封装技术应对散热挑战
借助AMD无顶盖封装技术应对散热挑战


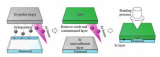












评论