透明薄膜在光学器件、微电子封装及光电子领域中具有关键作用,其厚度均匀性直接影响产品性能。然而,工业级微米级薄膜的快速测量面临挑战:传统干涉法设备庞大、成本高,分光光度法易受噪声干扰且依赖校准样品。本文本文基于FlexFilm单点膜厚仪的光学干涉技术框架,提出一种基于共焦光谱成像与薄膜干涉原理的微型化测量系统,结合相位功率谱(PPS)算法,实现了无需校准的高效厚度测量,为工业现场检测提供了新方案。
1
测量系统设计
flexfilm

薄膜厚度测量原理示意图本文设计的测量系统基于共聚焦光谱成像与薄膜干涉原理,其核心在于通过分析反射干涉光谱提取薄膜厚度信息。系统采用发光二极管(LED)、微型光谱仪以及自设计的共聚焦消色差探头,实现测量系统的微型化。在该系统中,干涉信号的产生源于薄膜上下表面反射光的相干叠加,其光程差与薄膜厚度紧密相关。LED 光源发出的光经探头聚焦到薄膜表面,反射光再通过光谱仪进行探测与分析。此设计不仅降低了系统成本,还提升了测量灵活性,使其更易集成于工业生产线上。
2
薄膜厚度计算算法
flexfilm
- 相位功率谱分析(PPS)
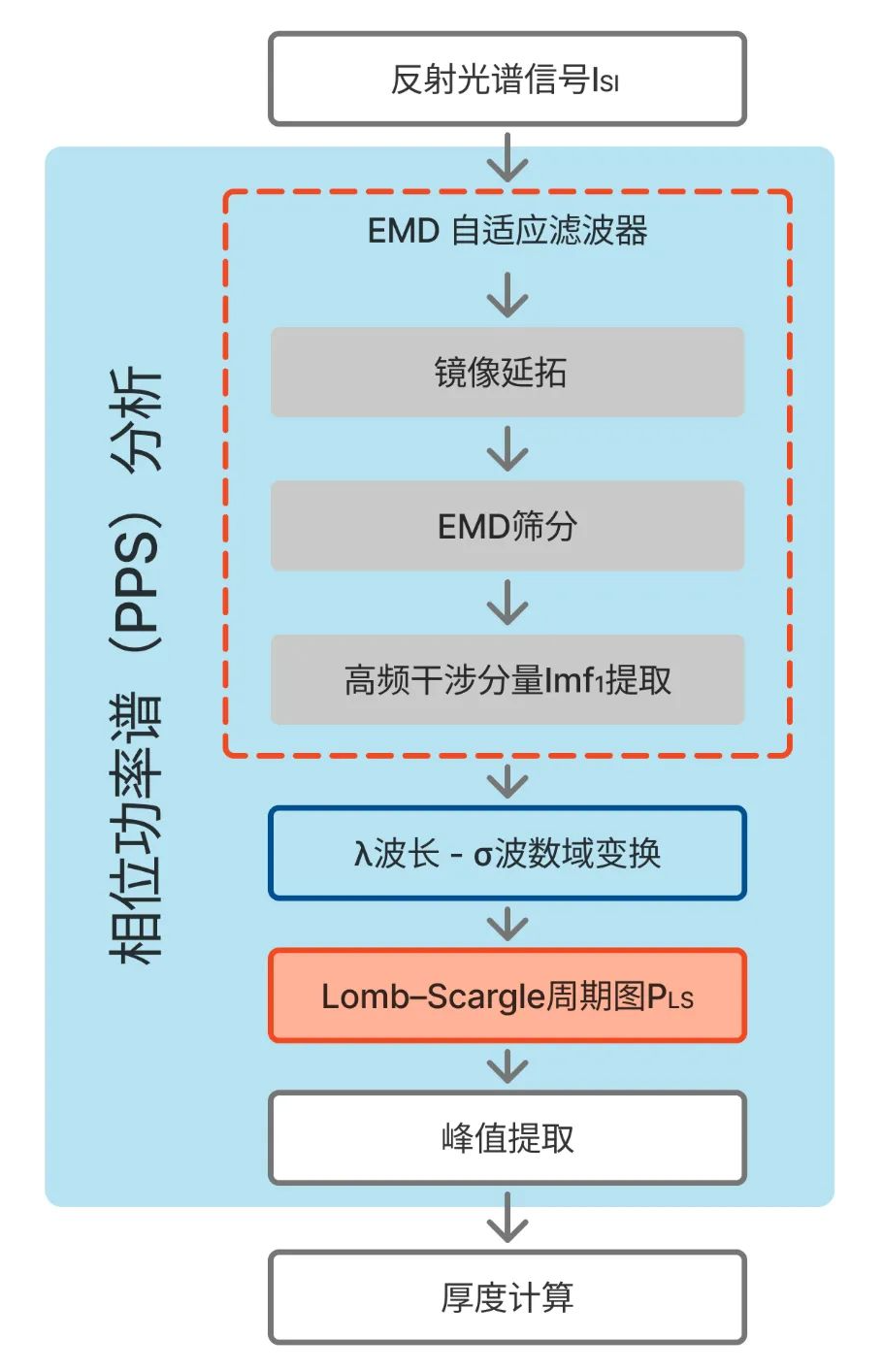
相位功率谱(PPS)算法流程图
- EMD滤波:利用经验模态分解自适应提取高频干涉分量,消除LED光源非均匀性影响。
- 波数域转换:将反射光谱从波长λλ转换至波数σ,增强相位项敏感性。
- LSP分析:通过改进的Lomb-Scargle周期图计算相位功率谱密度,抑制局部噪声。
- 厚度解算:定位功率谱峰值z????,结合折射率n?计算厚度 d=z????/2n?。
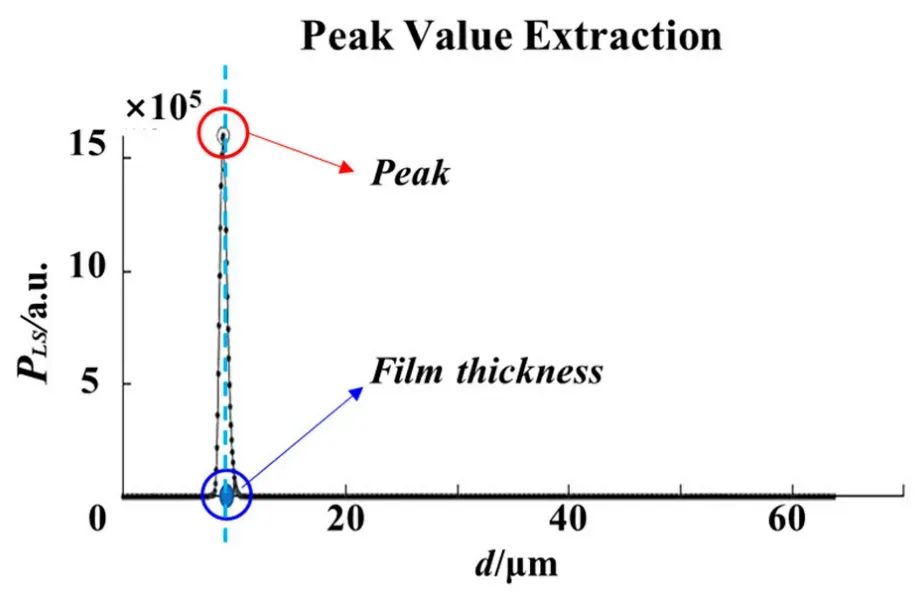
峰值提取和薄膜厚度计算
3
薄膜干涉模型验证
flexfilm

9 μm 厚度薄膜干涉仿真图(a)高斯光源下的反射光谱仿真图;(b)反射光谱仿真与测量信号对比

薄膜厚度对计算误差的影响
在高斯光源(中心波长660 nm,带宽80 nm)下,对1–100 ?m薄膜进行仿真。结果显示,1–75 ?m范围内固有误差≤±50 nm,超过75 ?m后因光谱仪分辨率限制误差增大。

干涉条纹对比度对计算厚度偏差的影响
信号对比度(K=0.1–1.0)变化对厚度计算偏差影响小于20 nm,证明算法对材料特性不敏感。 局部高斯噪声对计算厚度偏差的影响
局部高斯噪声对计算厚度偏差的影响
引入局部高斯噪声后,LSP算法误差(16 nm)仅为CIFFT算法(114 nm)的14%,抗噪鲁棒性显著。
4
薄膜厚度测量
flexfilm
- 标准薄膜样品测量

标准薄膜的 CIFFT 和 LSP 算法结果对比(a)单点重复性测量;(b)4×4 网格点测量
使用厚度范围 2 – 50 μm 的聚氯乙烯(PVC)标准薄膜样品进行测量。单点重复性测量实验表明,PPS 算法的标准差仅为 0.076 μm,远优于立方样条插值结合快速傅里叶变换(CIFFT)方法。区域测量稳定性验证中,最大绝对误差控制在0.9202 μm 以内,重复性不超过 2.5%,证明了系统在工业重复性要求下的可靠性。
- 锗基 SiO?标准薄膜测量
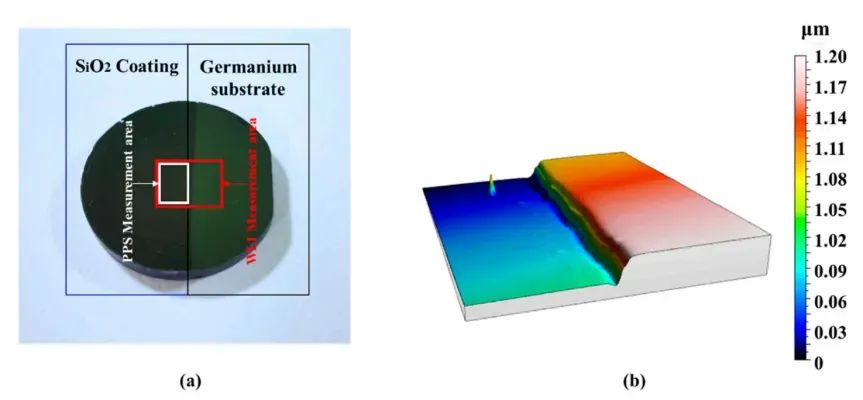
(a)锗基底上具有 1 μm 台阶的 SiO? 薄膜(b)白光干涉仪测量的台阶三维形貌
针对锗基底上1 μm 厚度的 SiO? 薄膜台阶结构进行测量,与白光干涉测量结果对比发现,PPS 方法的平均厚度测量值仅比白光干涉结果小约 50 nm,但测量速度更快,满足快速测量需求。
- PCB 芯片薄膜厚度测量
对PCB 板上不同区域1 – 30 μm 厚度的透明薄膜进行测量,结果显示测量值与工厂提供的参考值高度吻合,绝对厚度误差均在100 nm 以内。这验证了该测量系统在实际工业场景中对不同类型薄膜厚度测量的准确性和适用性。本文构建的微型化薄膜厚度测量系统实现了1–75 ?m范围、0.1 ?m不确定度的高精度测量,单次测量仅需10 ms,且无需校准样品,显著提升工业检测效率。EMD与LSP的协同作用有效抑制光源波动、噪声及非均匀采样的影响,为微米级薄膜测量提供了高效方案。
FlexFilm单点膜厚仪
flexfilm

FlexFilm单点膜厚仪是一款专为纳米级薄膜测量设计的国产高精度设备,采用光学干涉技术实现无损检测,测量精度达±0.1nm,1秒内即可完成测试,显著提升产线效率。
高精度测量:光学干涉技术,精度±0.1nm,1秒完成测量,提升产线效率。
智能灵活适配:波长覆盖380-3000nm,内置多算法,一键切换材料模型。
稳定耐用:光强均匀稳定(CV<1%)年均维护成本降低60%。
便携易用:整机<3kg,软件一键操作,无需专业培训。
本文研究技术已应用于FlexFilm单点膜厚仪,未来通过高分辨率光谱仪(如0.1 nm级)可扩展至亚微米级测量,结合多波长融合算法动态补偿折射率,进一步提升FlexFilm单点膜厚仪等在半导体、光学镀膜领域的在线检测精度。原文出处:《A Miniaturized and Fast System for Thin Film Thickness Measurement》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
pcb
+关注
关注
4371文章
23526浏览量
410836 -
半导体
+关注
关注
335文章
29026浏览量
240066 -
高精度测量
+关注
关注
0文章
12浏览量
4352
发布评论请先 登录
一种基于梳状滤波器的固体腔厚度测量方法
应用于光学测量的高性能薄膜厚度检测设备

美能Poly在线膜厚测试仪?:光伏行业中的微纳米薄膜光学测量创新

芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量






 薄膜厚度高精度测量 | 光学干涉+PPS算法实现PCB/光学镀膜/半导体膜厚高效测量
薄膜厚度高精度测量 | 光学干涉+PPS算法实现PCB/光学镀膜/半导体膜厚高效测量















评论