在先进光学、微电子和材料科学等领域,透明薄膜作为关键工业组件,其亚微米级厚度的快速稳定测量至关重要。芯片制造中,薄膜衬底的厚度直接影响芯片的性能、可靠性及功能实现,而传统红外干涉测量方法受机械振动、环境光干扰及薄膜倾斜等因素限制,测量精度难以满足高精度工业需求。为此,本研究提出一种融合红外干涉与激光校准的薄膜厚度测量新方法,旨在突破传统技术瓶颈,实现更精准、鲁棒的厚度检测。FlexFilm单点膜厚仪凭借其卓越的光学干涉技术,在薄膜厚度测量中展现出高精度、快速检测的优势,为本文研究提供了有力的数据支撑。
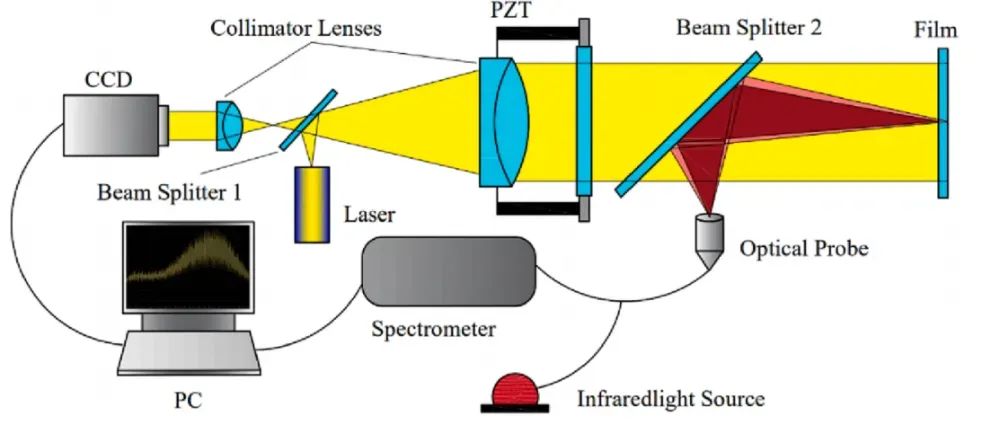
整体光路设计:包含红外测厚系统(左)和激光校正系统(右)
1
传统测量方法局限
flexfilm
薄膜基板(如蓝宝石、硅片)是芯片制造的核心部件,其厚度均匀性直接影响器件性能。现有测量技术存在显著局限:
- 扫描电镜(SEM):精度达纳米级,但破坏样本且无法在线检测;
- 椭偏仪:对厚膜(>500μm)测量失效,多层反射导致相变复杂化;
- 红外干涉法:虽适于工业环境,但受限于两大痛点:
- 环境噪声(振动/杂散光)使原始频谱最大频率提取误差达±1.5μm;
- 薄膜倾角仅1°即可引入0.3μm误差(以500μm膜为例),难以满足高精度产线需求。

红外测厚原理
2
厚度测量原理
flexfilm

方案流程图
- EMD-LSP算法(ELA)

ELA算法流程
基于光的干涉原理,红外干涉测量通过分析薄膜上下表面反射光的干涉光谱计算厚度。理论模型中,干涉光强 I(λ) 与波长 λ 的关系可表示为: 其中,n 为薄膜折射率,d 为厚度。为解决传统 FFT 算法在非平稳信号处理中的局限性,本研究提出EMD-LSP 算法(ELA),通过经验模态分解(EMD)过滤原始光谱噪声,再利用 Lomb-Scargle 周期图提取最大频率fj_peak,最终厚度公式为:
其中,n 为薄膜折射率,d 为厚度。为解决传统 FFT 算法在非平稳信号处理中的局限性,本研究提出EMD-LSP 算法(ELA),通过经验模态分解(EMD)过滤原始光谱噪声,再利用 Lomb-Scargle 周期图提取最大频率fj_peak,最终厚度公式为: 该算法有效提升了频率提取精度,为厚度计算奠定基础。
该算法有效提升了频率提取精度,为厚度计算奠定基础。
- 激光干涉倾角校准系统

厚度校正方案
针对工业生产中薄膜放置倾斜问题,构建基于激光干涉的厚度校正系统。通过斐索干涉光路检测薄膜前表面形状,利用泽尼克多项式拟合波前相位,获取 x 和 y 方向的倾斜分量 βx、βy,并通过几何关系推导校正公式: 其中,dm为红外干涉测量值,dr为校正后的实际厚度。该系统实现了对机械振动或操作误差引起的倾斜误差的自适应校正。
其中,dm为红外干涉测量值,dr为校正后的实际厚度。该系统实现了对机械振动或操作误差引起的倾斜误差的自适应校正。
- 系统集成设计
双光路架构:红外测量光路:960–1080nm波段获取厚度原始光谱;激光校准光路:632.8nm激光监测薄膜倾角;两通路光谱分离避免干扰,计算机统一控制实现实时反馈。
3
工业级精度验证
flexfilm
测量精度对比实验
 蓝宝石基底AFM图像(a)二维;(b,c)三维使用 6 组不同厚度的蓝宝石衬底(82.03μm 至 751.88μm)进行实验,分别采用 FFT、LSP 和 ELA 算法处理原始光谱。
蓝宝石基底AFM图像(a)二维;(b,c)三维使用 6 组不同厚度的蓝宝石衬底(82.03μm 至 751.88μm)进行实验,分别采用 FFT、LSP 和 ELA 算法处理原始光谱。 不同厚度薄膜的测量结果
不同厚度薄膜的测量结果 测厚实验数据分析:(a)平均误差;(b)方差
测厚实验数据分析:(a)平均误差;(b)方差
结果表明,ELA 算法较 LSP 提升测量精度约87.92%,较 FFT 提升约95.6%;测量稳定性较 LSP 和 FFT 分别提升67.96%和93.86%。这得益于 EMD 对环境噪声的有效过滤及 LSP 对非平稳信号的适应性。
- 倾角校正效果
 倾斜薄膜厚度校正结果
倾斜薄膜厚度校正结果
- 未校准时:倾角3°时751μm膜误差达4.7μm;
- 校正后:误差降至0.07μm(修正率97.87%),证实系统对≤3.75°倾角耐受性。
实验数据证明,该方法在复杂工业环境中具有可靠的抗干扰能力。本研究提出的红外干涉与激光校准融合方法,通过EMD-LSP 算法提升了光谱分析精度,结合激光干涉实现了倾斜误差的自适应校正。实验结果显示,该方法较传统技术测量精度提升约 90%,稳定性提升约 70%,且对倾斜薄膜的测量误差校正效果显著。其高精度、紧凑低成本的系统特性,满足了工业生产中高效快速的测量需求。
FlexFilm单点膜厚仪
flexfilm
FlexFilm单点膜厚仪是一款专为纳米级薄膜测量设计的国产高精度设备,采用光学干涉技术实现无损检测,测量精度达±0.1nm,1秒内即可完成测试,显著提升产线效率。
高精度测量:光学干涉技术,精度±0.1nm,1秒完成测量,提升产线效率。
智能灵活适配:波长覆盖380-3000nm,内置多算法,一键切换材料模型。
稳定耐用:光强均匀稳定(CV<1%)年均维护成本降低60%。
便携易用:整机<3kg,软件一键操作,无需专业培训。
本研究通过算法-光路协同创新借助FlexFilm 单点膜厚仪的先进技术,实现了工业薄膜厚度的“测量-校准”一体化。ELA算法解决了噪声敏感痛点,激光干涉倾角校正攻克了机械振动下的精度退化难题,为国产芯片制造装备的膜厚监测模块提供了新范式。原文出处:《A method for measuring and calibrating the thickness of thin films based on infrared interference technology》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
芯片制造
+关注
关注
11文章
695浏览量
29817 -
测量
+关注
关注
10文章
5286浏览量
113818
发布评论请先 登录
功率型LED热阻测量的新方法
激光干涉仪检测应用——重复定位精度测量
高精度非接触测量转速新方法研究
膜厚测试仪的使用方法 膜厚测试仪的校准步骤
芯片制造中的膜厚检测 | 多层膜厚及表面轮廓的高精度测量






 芯片制造中高精度膜厚测量与校准:基于红外干涉技术的新方法
芯片制造中高精度膜厚测量与校准:基于红外干涉技术的新方法

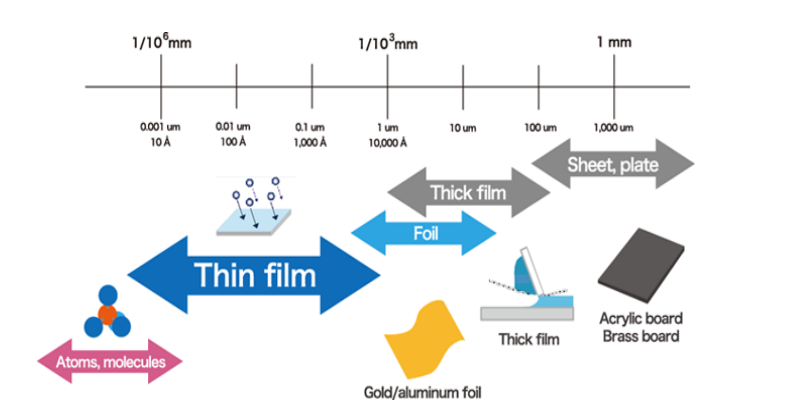
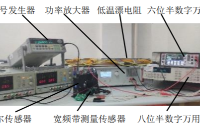
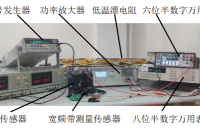












评论