来源:半导体小马;作者:小马
前面分享了先进封装的四要素一分钟让你明白什么是先进封装,今天分享一下先进封装四要素中的再布线(RDL)。
RDL(Redistribution Layer)即重分布层,是先进封装中实现芯片水平方向电气延伸和互连的关键技术,在 3D/2.5D 封装集成以及 FOWLP(扇出型晶圆级封装)中应用广泛。
一、工作原理
通过在芯片表面沉积金属层和相应的介电层,形成金属导线,将 IO 端口重新设计到更宽敞的区域,构建出表面阵列布局。简单来说,就是把芯片原本位于边缘或四周的 I/O 触点,通过半导体工艺延伸到芯片表面其他位置,扩展布局到占位更宽松的区域,实现 I/O 触点的重新布线。
二、优势
降低设备成本:打破了传统封装中昂贵且耗时的引线键合和倒装芯片键合工艺的束缚,通过减少设备所需的元件数量,有效降低设备成本。
减少占地面积:可将多个芯片集成到单个封装中,极大地减少器件的整体占地面积,满足智能手机、可穿戴设备等对空间要求极高的产品需求。
改善电气性能:RDL 中介层信号通孔尺寸极小,可大幅改善 SerDes 信号完整性,其金属厚度优势也能提升内存 SI,同时低损耗介电材料可降低介电损耗,优化整个封装的电气性能。
提高设计灵活性:RDL介质层利用精细的线路宽度和间距,减少路由干扰,支持更多引脚数量,使 I/O 触点间距更灵活,凸点面积更大,为芯片设计提供更大自由度。
三、工艺流程
在重新分配层工艺中,首先通过溅射工艺创建一层金属薄膜,之后在金属薄膜上涂覆厚层光刻胶。随后利用光刻工艺绘制电路图案,在电路图案的曝光区域电镀金层,以形成金属引线。由于重新分配工艺本身就是重建焊盘的工艺,因此确保引线键合强度是十分重要的。这也正是被广泛用于引线键合的材料—金,被用于电镀的原因。

四、应用领域
RDL 技术已广泛应用于MEMS器件、传感器、功率器件、存储器、微处理器和图形处理器等众多领域的封装,为实现更小、更快、更高效的芯片设计提供技术支撑。
在WLP中:在FIWLP/FOWLP中,RDL是最为关键的技术,通过RDL将IOPad进行扇入Fan-In或扇出Fan-Out,形成不同类型的晶圆级封装。
在2.5D中:除了硅基板上的TSV,RDL同样不可或缺,通过RDL将网络互联并分布到不同的位置,从而将硅基板上方芯片的Bump和基板下方的Bump连接。
在3D中:对于上下堆叠是同一种芯片,通常TSV就可以直接完成电气互联功能了,而堆叠上下如果是不同类型芯片,则需要通过RDL重新布线层将上下层芯片的IO进行对准,从而完成电气互联。
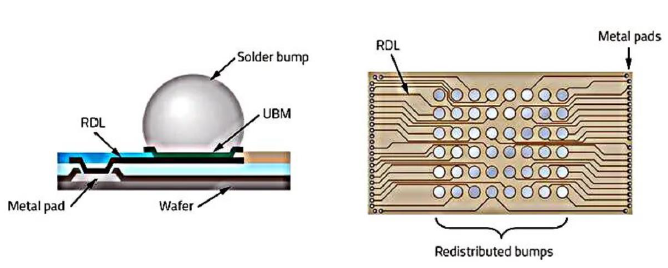
五、技术发展
目前 4 层 RDL 技术已经成熟,良率可达 99%,能满足约 85% 的封装需求。未来,RDL 工艺将朝着提高粘附力,减少热循环过程中的机械应力和热应力的方向发展,同时对布线检测等设备也提出了更高要求。
-
芯片
+关注
关注
460文章
52616浏览量
442691 -
晶圆
+关注
关注
53文章
5181浏览量
130122 -
先进封装
+关注
关注
2文章
479浏览量
665
原文标题:先进封装四要素中再布线(RDL)是什么?
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
芯片设计中再分布层(RDL)技术的优势
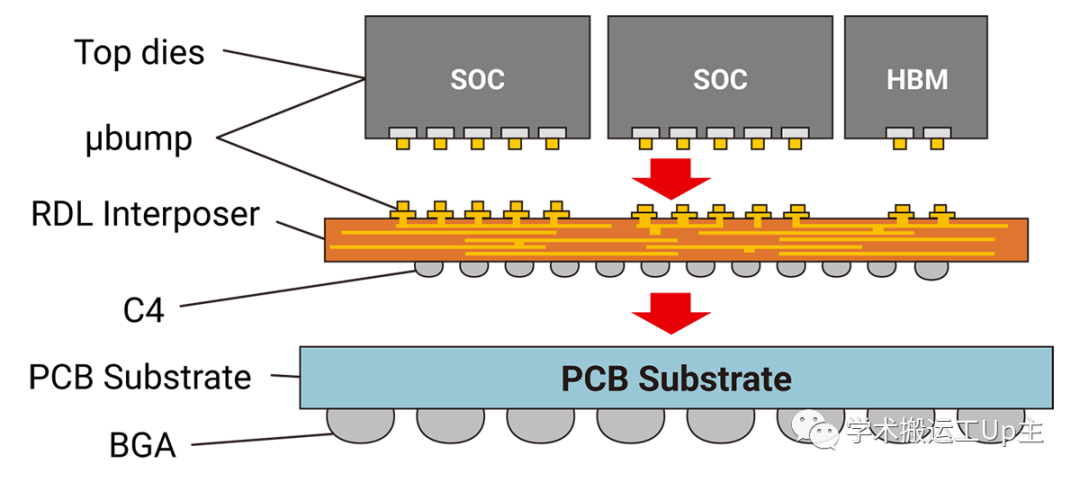
什么是先进封装?先进封装技术包括哪些技术

Manz亚智科技 RDL先进制程加速全球板级封装部署和生产

芯片先进封装里的RDL






 先进封装中的RDL技术是什么
先进封装中的RDL技术是什么











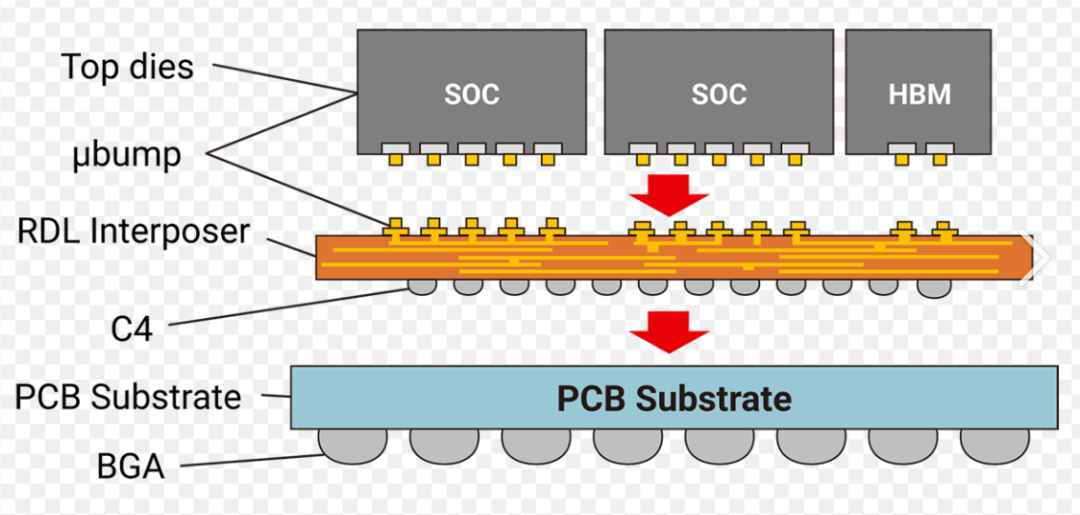










评论