在先进封装车间里,业内常把凸点比作芯片间的“微型桥梁”——直径小到20微米(比头发丝还细),却要扛起每秒数十亿次的信号传输重任。作为焊料厂家的研发工程师,今天就用“车间白话”聊聊先进封装凸点制作的材料选择、工艺门道和避坑指南。?
一、给“桥梁”选建材:凸点焊料怎么挑??
就像盖桥要选钢筋还是钢索,凸点焊料也得按“承载需求”定材料。
1. 锡基焊料:性价比之王,90% 场景都用它?
SAC 系列(锡银铜):我们车间最常用的“万金油”。比如 SAC305(含3% 银、0.5%铜)熔点217℃,焊点剪切强度能到45MPa,汽车芯片、手机处理器都爱用。但要注意,银含量越高成本越贵,普通消费电子用SAC105(1%银)就够了。?
SnBi低温焊料(锡铋):熔点只有138℃,适合3D堆叠时“低温焊接”——比如已经焊好一层芯片,再叠第二层时用它,不会把下层焊点烤化。缺点是有点脆,摔一下容易裂,所以穿戴设备里会搭配柔性基板用。?
2. 铜基凸点:高频高速场景的“硬核选择”?
纯铜柱加锡帽的组合,就像“钢筋混凝土桥”。铜的导电性比锡好5倍,熔点高达1083℃,在5G基站芯片、GPU这类高频(>10GHz)设备里,信号传输损耗能降30%。但铜容易氧化,我们会在表面镀一层镍金“防护衣”,过85℃/85% RH 测试1000小时都不生锈。?
3. 特殊场景的“贵价材料”?
金锡合金:熔点280℃,抗氧化能力极强,航天、军工芯片用得多。但金价摆在那儿,一颗芯片光凸点材料成本就比锡基贵10倍,一般场景真用不起。?
金属间化合物:比如铜锡反应生成的Cu?Sn,熔点676℃,焊点强度是锡基的2倍。现在我们在Chiplet封装里试产,缺点是焊接时得精确控制温度和压力,差 3℃就可能“焊不牢”。?
二、“桥梁”质量过关的硬指标:这些参数必须盯死?
做了封装焊接材料,我总结出凸点合格的“三板斧”。
1. 电气性能:信号不能“堵车”?
电阻得小:铜基凸点电阻<5mΩ,锡基< 10mΩ,不然高频信号跑着跑着就 “减速” 了。?
接触要稳:焊盘和凸点的接触面积得占95%以上,空洞(气泡)不能超 5%——就像桥基不能有空洞,不然容易塌。?
2. 机械强度:抗造才是王道?
剪切力测试:拿探针推凸点,至少要30MPa才合格(相当于指甲盖大小的面积能承受3公斤力)。我们车间用SAC305做的凸点,经常能到45MPa。?
耐疲劳:-40℃到125℃反复冷热冲击1000次,焊点不能裂。汽车芯片要求更严,得扛2000次,这时候铜柱凸点的优势就显出来了。?
3. 工艺适配性:机器“好干活”才量产快?
锡膏印刷时,触变性要刚好:太稀了会“塌边”(像摊烂的煎饼),太稠了印不饱满。我们调试了上百次配方,把触变指数定在3.5,印刷0.1mm间距的凸点也不桥连。?
焊料熔化后得“听话”:润湿性要好,能均匀铺满焊盘(铺展面积≥80%)。秘诀是助焊剂,低卤素配方(<500ppm)既能除氧化,又不会腐蚀芯片。?
三、凸点制作的3种工艺,各有各的“坑”?
1. 电镀工艺:精度高但“娇气”?
适合做细间距(<50μm)凸点,比如手机芯片的0.3mm pitch。流程是先在焊盘上盖层光刻胶,刻出凸点形状,再用电镀把焊料“填”进去。?
避坑点:电镀液里的杂质不能超过0.001%,上次车间不小心混进一点铁,结果做出来的铜柱脆得像饼干,一掰就断。?
设备要求:电镀机的电流得稳,波动超过1%,凸点就会长歪(垂直度偏差 > 2°),后续焊接准桥连。
?
2. 印刷 - 回流工艺:量产快但细节多?
把锡膏用钢网印到焊盘上,过回流炉一烤就成凸点,适合消费电子量产。?
钢网是关键:电铸钢网的开孔内壁要光滑(Ra<0.1μm),不然锡膏粘在上面,印出来的凸点就缺个角。我们试过激光切割钢网,效果差远了,还是电铸的靠谱。?
回流曲线别乱设:SAC305得加热到 240℃(熔点 + 20℃),但升温不能太快(≤3℃/秒),不然助焊剂挥发太猛,焊点会冒泡。氮气氛围里焊(氧含量 < 50ppm),焊点亮得像镜面,润湿性直接提升30%。?
3. 固态焊接:新方向但门槛高?
不用把焊料熔化成液态,靠金属扩散形成焊点。我们在3D堆叠里试这个工艺:?
温度控制要“抠”:铜锡反应最佳温度260℃,高3℃就会生成脆化相,低3℃又焊不牢。?
压力得均匀:整个晶圆上的压力差不能超过5%,不然有的地方焊紧了,有的地方还是松的。?
凸点虽小,却是先进封装的“咽喉要道”。选材料时别盲目追高端,手机芯片用 SAC305 就够了;做工艺时多盯细节——钢网精度差2μm、回流温度差5℃,良率可能就掉20%。我们焊料厂家天天跟这些“小家伙” 打交道,最明白:靠谱的凸点,都是材料、设备、工艺磨出来的。
-
汽车电子
+关注
关注
3037文章
8372浏览量
170365 -
锡膏
+关注
关注
1文章
950浏览量
17521 -
助焊剂
+关注
关注
3文章
138浏览量
11646 -
chiplet
+关注
关注
6文章
461浏览量
13035 -
先进封装
+关注
关注
2文章
479浏览量
663
发布评论请先 登录
说说电子工程师最在意的那些事儿
招聘LED封装工程师
招聘封装工程师
招聘LED封装工程师
电子工程师最在意的那些事
倒装芯片凸点制作方法
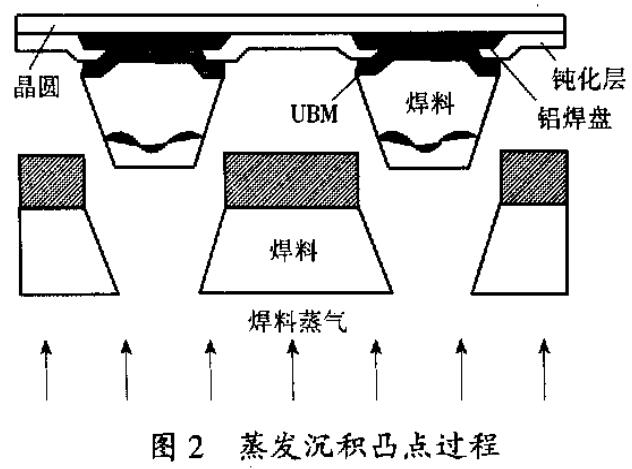





 从焊料工程师视角揭秘先进封装里凸点制作那些事儿?
从焊料工程师视角揭秘先进封装里凸点制作那些事儿?

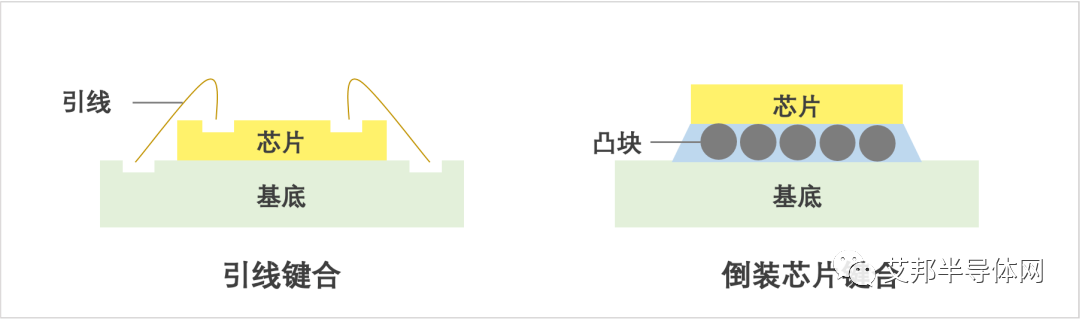

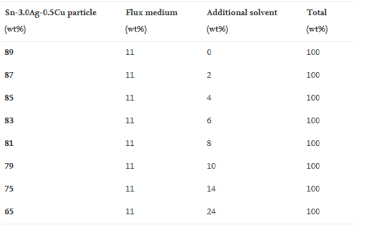












评论