一、什么是贴片(Die Attach)?
贴片,又叫Die Attach,是半导体封装流程中的一个关键步骤。它的作用是:
将切割下来的芯片(裸晶粒)牢固地粘贴在封装基底上,例如引线框架(leadframe)、陶瓷基板或芯片载板(substrate)上。
这个步骤是后续如打线键合(Wire Bonding)、**封装成型(Molding)**等工艺的基础。
二、贴片的目的和技术要求
核心目的:
固定芯片位置:确保芯片在整个封装流程中不会移动或倾斜。
热、电传导通道:部分贴片材料同时承担散热和电性连接功能(特别是功率器件)。
承受热应力和机械应力:贴片方式必须适应后续封装中的热膨胀、冷却等过程,防止芯片开裂或脱落。
技术要求:
贴合位置精度高(特别是大芯片或多芯片封装,误差需控制在 ±50μm)。
胶层或焊层厚度均匀,避免出现气泡或空洞(voids)。
芯片下方有足够的接触面积,有助于热传导和稳固性。
对于超薄芯片,要控制吸取力量,防止芯片破裂或微裂纹。
三、常见的贴片方法(按材料分类)
1.银胶(Ag Epoxy)粘贴方式
这是最普遍的方式之一:
使用含银颗粒的导电胶将芯片粘在引线框架上。
银的加入提升了导热和导电性能。
胶层通常控制在约5μm 厚。
工艺要求芯片边缘周围要有明显的银胶溢出痕迹(≥90%的边缘有溢胶),这样能确保贴合牢靠、传热良好。
应用:适用于多数常规封装产品。
2.共晶焊接(Eutectic Bonding)方式
使用**金-硅(Au-Si)**等共晶材料,通过加热使其熔融并形成金属焊接。
熔点一般为370°C左右,需控制好温度和时间。
具有很高的可靠性、导电性和导热性。
应用:多用于高功率、高可靠性芯片,如射频器件、汽车芯片。
3.焊锡熔焊(Solder Attach)方式
使用焊锡丝或锡膏加热熔融来进行贴片。
工艺温度略低于共晶焊(如SnAgCu合金约 220°C)。
速度较快,适用于芯片面积较小的产品。
应用:适合大批量、成本敏感型产品。
四、贴片过程控制要点
| 控制项目 | 关键要求 |
|---|---|
| 胶量或焊料量 | 需精准控制,防止过多(溢出过大)或过少(粘接不牢) |
| 芯片定位精度 | 对于大芯片要求高,误差需 ≤50μm |
| 贴合压力与时间 | 太大可能破坏芯片,太小可能导致虚贴 |
| 温度控制 | 特别是在加热固化或熔焊过程中,需要精准控温 |
| 溢胶观察 | 应有 ≥90% 周边出现银胶溢出现象,用于判定良好贴合 |
五、特殊贴片注意事项
对于超大芯片:
尺寸大意味着更高的定位精度要求。
易受热胀冷缩影响,需优化胶层或焊层应力分布。
对于超薄芯片:
非常脆弱,容易碎裂或产生微裂纹。
贴片机必须使用软吸头或带缓冲的真空吸盘,并降低动作速度。
六、贴片完成后的检测方式
贴片工艺完成后,通常会进行以下检测:
X光检查:查看是否有空洞、气泡、偏移。
截面SEM检查:验证胶层厚度、溢胶状态。
肉眼显微镜观察:确认银胶溢出、芯片中心对位。
热阻测试(尤其是功率器件):评估热传导性能。
七、总结
贴片(Die Attach)是连接芯片和封装载体的重要桥梁,是整个封装工艺的基础之一。它不仅关系到芯片能否“坐稳”,还能影响整个器件的热性能、电性能和可靠性。
一句话总结:贴片不只是“把芯片粘上去”,而是一门关于粘接材料、热力学、电性接触和机械应力管理的精密工程。
声明:
本号对所有原创、转载文章的陈述与观点均保持中立,推送文章仅供读者学习和交流。文章、图片等版权归原作者享有,如有侵权,联系删除。
-
芯片
+关注
关注
460文章
52616浏览量
442711 -
贴片
+关注
关注
10文章
929浏览量
37910 -
半导体封装
+关注
关注
4文章
296浏览量
14538
发布评论请先 登录
选择合适的 IP 实现 Die-to-Die 连接
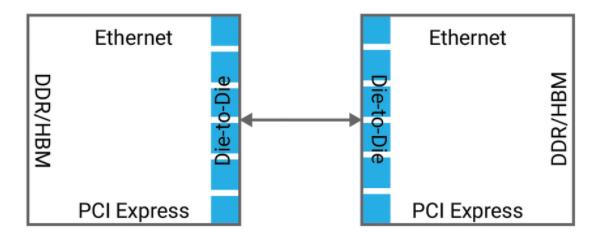
PAD贴片电阻的封装规格介绍
如何使用Die-to-Die PHY IP 对系统级封装 (SiP) 进行高效的量产测试?
UC1825-DIE 高速 PWM 控制器,UC1825-DIE
TLC555-DIE DIE LinCMOS 定时器
TPS40007-DIE 低输入、高效同步降压控制器,TPS40007-DIE
传输丢包问题导致Attach成功率低案例分析
粘片工艺介绍及选型指南
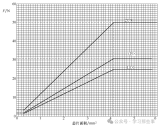





 贴片(Die Attach)介绍
贴片(Die Attach)介绍












评论