E
Environmental test(环境测试):一个或一系列的测试,用于决定外部对于给定的元件包装或装配的结构、机械和功能完整性的总影响。
Eutectic solders(共晶焊锡):两种或更多的金属合金,具有最低的熔化点,当加热时,共晶合金直接从固态变到液态,而不经过塑性阶段。
F
Fabrication():设计之后装配之前的空板制造工艺,单独的工艺包括叠层、金属加成/减去、钻孔、电镀、布线和清洁。
Fiducial(基准点):和电路布线图合成一体的专用标记,用于机器视觉,以找出布线图的方向和位置。
Fillet(焊角):在焊盘与元件引脚之间由焊锡形成的连接。即焊点。
Fine-pitch technology (FPT密脚距技术):表面贴片元件包装的引脚中心间隔距离为 0.025"(0.635mm)或更少。
Fixture(夹具):连接PCB到处理机器中心的装置。
Flip chip(倒装芯片):一种无引脚结构,一般含有电路单元。 设计用于通过适当数量的位于其面上的锡球(导电性粘合剂所覆盖),在电气上和机械上连接于电路。
Full liquidus temperature(完全液化温度):焊锡达到最大液体状态的温度水平,最适合于良好湿润。
Functional test(功能测试):模拟其预期的操作环境,对整个装配的电器测试。
G
Golden boy(金样):一个元件或电路装配,已经测试并知道功能达到技术规格,用来通过比较测试其它单元。
H
Halides(卤化物):含有氟、氯、溴、碘或砹的化合物。是助焊剂中催化剂部分,由于其腐蚀性,必须清除。
Hard water(硬水):水中含有碳酸钙和其它离子,可能聚集在干净设备的内表面并引起阻塞。
Hardener(硬化剂):加入树脂中的化学品,使得提前固化,即固化剂。
I
In-circuit test(在线测试):一种逐个元件的测试,以检验元件的放置位置和方向。
J
Just-in-time (JIT刚好准时):通过直接在投入生产前供应材料和元件到生产线,以把库存降到最少。
L
Lead configuration(引脚外形):从元件延伸出的导体,起机械与电气两种连接点的作用。
Line certification(生产线确认):确认生产线顺序受控,可以按照要求生产出可靠的PCB。
M
Machine vision(机器视觉):一个或多个相机,用来帮助找元件中心或提高系统的元件贴装精度。
Mean time between failure (MTBF平均故障间隔时间):预料可能的运转单元失效的平均统计时间间隔,通常以每小时计算,结果应该表明实际的、预计的或计算的。
N
Nonwetting(不熔湿的):焊锡不粘附金属表面的一种情况。由于待焊表面的污染,不熔湿的特征是可见基底金属的裸露。
O
Omegameter(奥米加表):一种仪表,用来测量PCB表面离子残留量,通过把装配浸入已知高电阻率的酒精和水的混合物,其后,测得和记录由于离子残留而引起的电阻率下降。
Open(开路):两个电气连接的点(引脚和焊盘)变成分开,原因要不是焊锡不足,要不是连接点引脚共面性差。
Organic activated (OA有机活性的):有机酸作为活性剂的一种助焊系统,水溶性的。
P
Packaging density(装配密度):PCB上放置元件(有源/无源元件、连接器等)的数量;表达为低、中或高。
Photoploter(相片绘图仪):基本的布线图处理设备,用于在照相底片上生产原版PCB布线图(通常为实际尺寸)。
Pick-and-place(拾取-贴装设备):一种可编程机器,有一个机械手臂,从自动供料器拾取元件,移动到PCB上的一个定点,以正确的方向贴放于正确的位置。
Placement equipment(贴装设备):结合高速和准确定位地将元件贴放于PCB的机器,分为三种类型:SMD的大量转移、X/Y定位和在线转移系统,可以组合以使元件适应电路板设计。
R
Reflow soldering(回流焊接):通过各个阶段,包括:预热、稳定/干燥、回流峰值和冷却,把表面贴装元件放入锡膏中以达到永久连接的工艺过程。
Repair(修理):恢复缺陷装配的功能的行动。
Repeatability(可重复性):精确重返特性目标的过程能力。一个评估处理设备及其连续性的指标。
Rework(返工):把不正确装配带回到符合规格或合约要求的一个重复过程。
Rheology(流变学):描述液体的流动、或其粘性和表面张力特性,如,锡膏。
S
Saponifier(皂化剂):一种有机或无机主要成份和添加剂的水溶液,用来通过诸如可分散清洁剂,促进松香和水溶性助焊剂的清除。
Schematic(原理图):使用符号代表电路布置的图,包括电气连接、元件和功能。
Semi-aqueous cleaning(不完全水清洗):涉及溶剂清洗、热水冲刷和烘干循环的技术。
Shadowing(阴影):在红外回流焊接中,元件身体阻隔来自某些区域的能量,造成温度不足以完全熔化锡膏的现象。
Silver chromate test(铬酸银测试):一种定性的、卤化离子在RMA助焊剂中存在的检查。(RMA可靠性、可维护性和可用性)
Slump(坍落):在模板丝印后固化前,锡膏、胶剂等材料的扩散。
Solder bump(焊锡球):球状的焊锡材料粘合在无源或有源元件的接触区,起到与电路焊盘连接的作用。
Solderability(可焊性):为了形成很强的连接,导体(引脚、焊盘或迹线)熔湿的(变成可焊接的)能力。
Soldermask(阻焊):印刷电路板的处理技术,除了要焊接的连接点之外的所有表面由塑料涂层覆盖住。
Solids(固体):助焊剂配方中,松香的重量百分比,(固体含量)
Solidus(固相线):一些元件的焊锡合金开始熔化(液化)的温度。
Statistical process control (SPC统计过程控制):用统计技术分析过程输出,以其结果来指导行动,调整和/或保持品质控制状态。
Storage life(储存寿命):胶剂的储存和保持有用性的时间。
Subtractive process(负过程):通过去掉导电金属箔或覆盖层的选择部分,得到电路布线。
Surfactant(表面活性剂):加入水中降低表面张力、改进湿润的化学品。
Syringe(注射器):通过其狭小开口滴出的胶剂容器。
T
Tape-and-reel(带和盘):贴片用的元件包装,在连续的条带上,把元件装入凹坑内,凹坑由塑料带盖住,以便卷到盘上,供元件贴片机用。
Thermocouple(热电偶):由两种不同金属制成的传感器,受热时,在温度测量中产生一个小的直流电压。
Type I, II, III assembly(第一、二、三类装配):板的一面或两面有表面贴装元件的PCB(I);有引脚元件安装在主面、有SMD元件贴装在一面或两面的混合技术(II);以无源SMD元件安装在第二面、引脚(通孔)元件安装在主面为特征的混合技术(III)。
Tombstoning(元件立起):一种焊接缺陷,片状元件被拉到垂直位置,使另一端不焊。
U
Ultra-fine-pitch(超密脚距):引脚的中心对中心距离和导体间距为0.010”(0.25mm)或更小。
V
Vapor degreaser(汽相去油器):一种清洗系统,将物体悬挂在箱内,受热的溶剂汽体凝结于物体表面。
Void(空隙):锡点内部的空穴,在回流时气体释放或固化前夹住的助焊剂残留所形成。
Y
Yield(产出率):制造过程结束时使用的元件和提交生产的元件数量比率。
 电子发烧友App
电子发烧友App











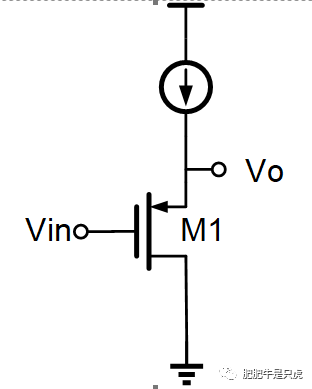


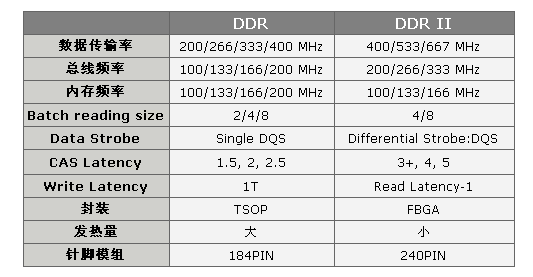










评论