上周台积电发布了2018年报,全年营收342亿美元,占到了全球晶圆代工市场份额的56%,可谓一家独大。在先进工艺上,台积电去年量产7nm工艺,进度领先友商一年以上,今年量产7nm EUV工艺,明年还有5nm EUV工艺,3nm工艺工厂也在建设中了。
作为全球最大的晶圆代工公司,台积电在半导体制造上的技术没啥可说的了,但很多人不知道的是台积电近年来加大了半导体封装技术的研发,过去几年能够独家代工苹果A系列处理器也是跟他们的封装技术进步有关。
日前在台积电说法会上,联席CEO魏哲家又透露了台积电已经完成了全球首个3D IC封装,预计在2021年量产,据悉该技术主要面向未来的5nm工艺,最可能首发3D封装技术的还是其最大客户苹果公司。
在苹果A系列处理器代工中,三星曾经在A9处理器分到一杯羹,与台积电分享了苹果订单,不过从A10处理器开始都是台积电独家代工了,而台积电能够赢得苹果青睐也不只是因为半导体制造工艺,还跟台积电能够整合先进封装工艺有关。
在半导体制造黄金定律摩尔定律逐渐失效的情况下,单纯指望制造工艺来提高芯片集成度、降低成本不太容易了,所以先进封装技术这几年发展很快。此前台积电推出了扇出型晶圆级封装(InFO WLP)以及CoWoS封装工艺,使得芯片有更好的电气特性,能实现更高的内存带宽和低功耗运行能力,能使到移动设备有更好性能和更低功耗。
不过InFO WLP、CoWoS本质上还是2.5D封装,业界追求的一直是真3D封装,去年台积电宣布推出Wafer-on-Wafer(WoW) 封装技术,通过TSV硅穿孔技术实现了真正的3D封装,而这个封装技术主要用于未来的7nm及5nm换工艺。
虽然台积电在上周的说法会上没有明确提及他们首发的3D IC工艺是否为Wafer-on-Wafer(WoW)封装技术,但猜测起来就是这个新技术了,毕竟3D封装是2019年的热门新技术,英特尔之前推出的Foreros封装也是3D芯片封装的一种。
根据台积电的说法,他们的3D IC封装技术已经完成了技术开发,不过2021年才会量产,这个时候他们的主力工艺还是5nm EUV级别的。至于哪家客户都成为第一个吃螃蟹的,预计苹果还是最先采用台积电3D封装的公司,以往也是苹果率先使用台积电2.5D封装的,他们有这个需求,也有这个资本。
-
处理器
+关注
关注
68文章
19935浏览量
236278 -
台积电
+关注
关注
44文章
5760浏览量
170150 -
晶圆
+关注
关注
53文章
5181浏览量
130121
原文标题:台积电:已完成全球首个3D IC封装,预计2021年量产!
文章出处:【微信号:icsmart,微信公众号:芯智讯】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录





 台积电:已完成全球首个3D IC封装,预计2021年量产
台积电:已完成全球首个3D IC封装,预计2021年量产




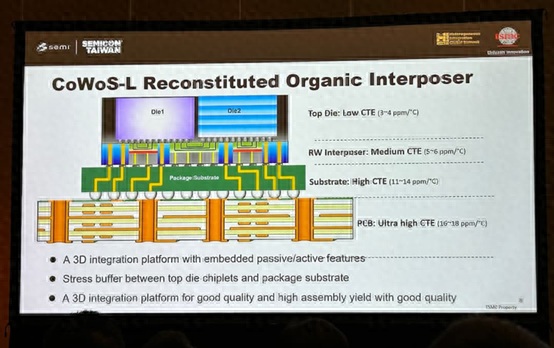










评论