8随着半导体器件特征尺寸不断缩小,三维(3D)封装技术已成为延续摩尔定律的重要途径。铜-介质混合键合(Hybrid Bonding)通过直接连接铜互连与介电层,实现了高密度、低功耗的异质集成。然而,化学机械抛光(CMP)工艺引入的纳米级表面形貌变化(如铜凹陷/凸起)会显著影响键合质量。传统测量方法如原子力显微镜(AFM)虽然具有埃级分辨率,但其接触式测量方式存在效率低、易损伤样品等缺点。本研究借助光子湾白光干涉轮廓仪重点开发基于白光扫描干涉法(WSI)的新型测量方案,通过系统优化和相位补偿,实现了非接触、高精度、高效率的表面形貌表征。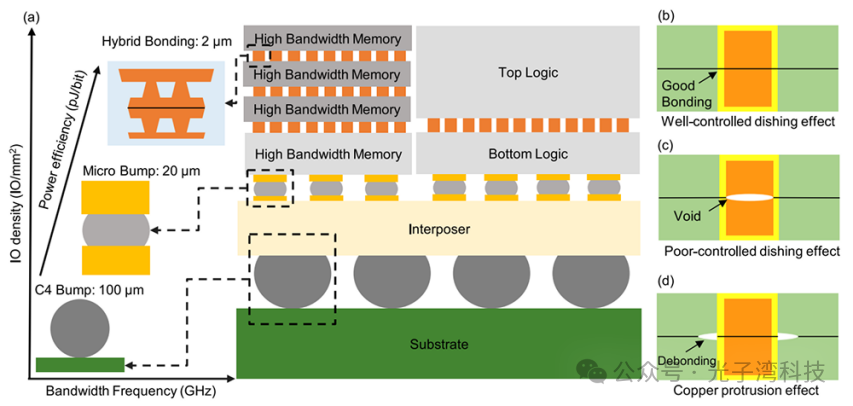 半导体封装异质集成的混合键合技术
半导体封装异质集成的混合键合技术
#Photonixbay.01
混合键合测试样品制备
本研究制备了两组具有典型特征的混合键合测试样品: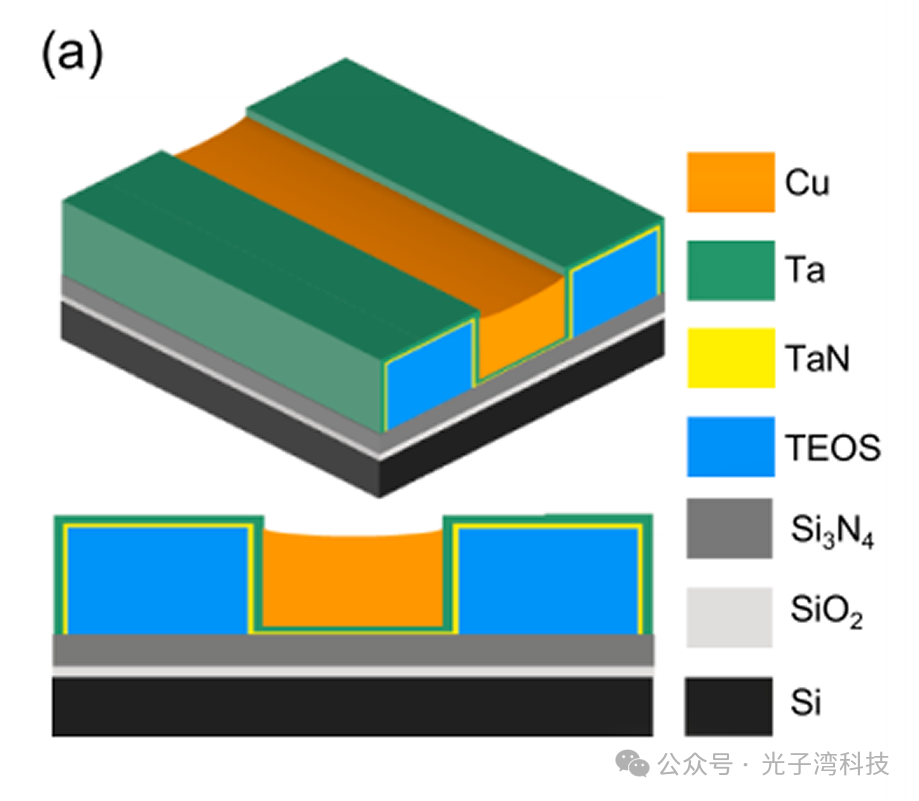 样品#1结构:TEOS图案表面覆盖Ta/TaN薄膜样品#1(标准CMP工艺):
样品#1结构:TEOS图案表面覆盖Ta/TaN薄膜样品#1(标准CMP工艺):
- 薄膜堆叠:Si 衬底 / 800nm Cu / 220 nm TEOS / 10nm Ta / 5nm TaN
- 关键工艺参数:
○ 抛光压力:24.1 kPa○ 抛光盘转速:80 rpm○ 抛光时间:90 s
- 目标形貌:100±5 nm铜凹陷(TEOS高于Cu)
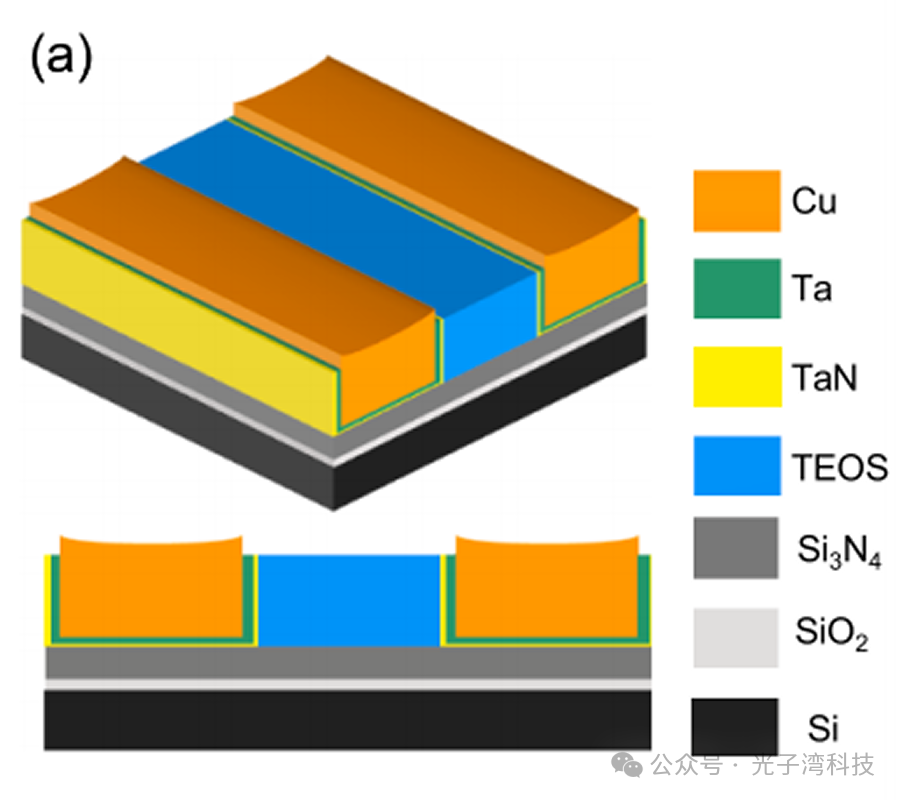 样品#2结构:无Ta/TaN层,铜因过度抛光高于TEOS样品#2(过抛光工艺):
样品#2结构:无Ta/TaN层,铜因过度抛光高于TEOS样品#2(过抛光工艺):
- 在样品#1基础上进行二次抛光:
○ 压力提升至35.9 kPa○ 转速增至90 rpm○ 抛光时间20 s○ 添加专用铜腐蚀抑制剂
- 目标形貌:7±2 nm铜凸起(完全去除Ta/TaN阻挡层)
#Photonixbay.02
高分辨率表面形貌测量方法
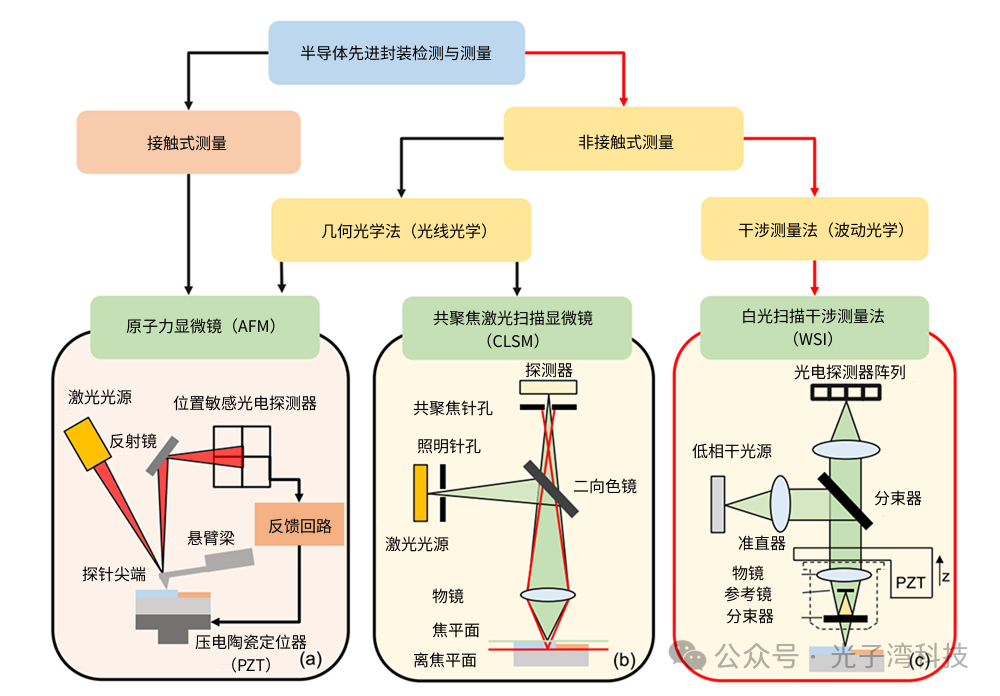 半导体封装异质集成的表面计量方法
半导体封装异质集成的表面计量方法
原子力显微镜 (AFM)
共聚焦显微镜 (CLSM)
- 原理:激光聚焦+针孔过滤,仅捕捉焦平面信号
- 关键组件:共聚焦针孔、二向色镜、物镜、垂直扫描模块
- 用途:亚微米级三维成像(如TSV孔深测量)
白光干涉仪 (WSI)
- 原理:白光干涉条纹分析,消除相位模糊
- 关键组件:低相干光源、参考镜、压电Z轴扫描、分束器
- 用途:毫米级表面全场测量(如凸块高度一致性)
#Photonixbay.03
高度测量结果对比
 样品#1(左)样品#2(右)AFM测量的表面重建与截面图
样品#1(左)样品#2(右)AFM测量的表面重建与截面图 样品#1(左)样品#2(右)(c)(d) WSI在10×和20×放大倍率下的表面重建与截面图
样品#1(左)样品#2(右)(c)(d) WSI在10×和20×放大倍率下的表面重建与截面图 样品#1(左)样品#2(右)(e)(f) CLSM在10×和20×下的表面重建与截面图三种测量方法的表面高度测量结果对比
样品#1(左)样品#2(右)(e)(f) CLSM在10×和20×下的表面重建与截面图三种测量方法的表面高度测量结果对比 AFM、WSI和CLSM对两个混合键合样品进行了测量和分析。AFM记录的样品#1和样品#2的高度分别为100 nm和7 nm。WSI测量的样品#1和样品#2的高度分别为128.1 nm和334.2 nm,而CLSM的结果分别为132.5 nm和128.1 nm。CLSM的结果与AFM参考值存在显著差异,表明薄膜去除对测量结果有强烈影响。
AFM、WSI和CLSM对两个混合键合样品进行了测量和分析。AFM记录的样品#1和样品#2的高度分别为100 nm和7 nm。WSI测量的样品#1和样品#2的高度分别为128.1 nm和334.2 nm,而CLSM的结果分别为132.5 nm和128.1 nm。CLSM的结果与AFM参考值存在显著差异,表明薄膜去除对测量结果有强烈影响。
#Photonixbay.04
测量方法重复性评估
测量方法重复性评估(20次连续测量) WSI在20次连续测量中表现出显著的稳定性,标准差分别为0.97 nm和0.79 nm。CLSM的重复性较差,样品#1和样品#2的标准差分别为9.15 nm和13.07 nm。Allan偏差分析显示,WSI系统在32次平均测量后对非平稳噪声的影响较小,噪声幅度为0.34 nm。
WSI在20次连续测量中表现出显著的稳定性,标准差分别为0.97 nm和0.79 nm。CLSM的重复性较差,样品#1和样品#2的标准差分别为9.15 nm和13.07 nm。Allan偏差分析显示,WSI系统在32次平均测量后对非平稳噪声的影响较小,噪声幅度为0.34 nm。
#Photonixbay.05
相位变化效应的理论与补偿
 WSI在20×放大倍率下(a) 样品#1的100次连续测量结果及艾伦偏差;(b) 样品#2的100次连续测量结果及艾伦偏差
WSI在20×放大倍率下(a) 样品#1的100次连续测量结果及艾伦偏差;(b) 样品#2的100次连续测量结果及艾伦偏差
通过FDTD模拟分析了WSI测量中的复杂相位变化行为,并进行了补偿。补偿后,样品#1的高度误差从28.1 nm降低到0.52 nm,接近AFM测量结果。本文评估了WSI和CLSM作为非接触方法在混合键合样品表面轮廓测量中的技术优势。结果表明,WSI在精度和重复性方面表现出色,经过相位变化效应补偿后,测量精度显著提高。基于这些理论和模拟,验证了光学计量方法的普遍性和亚纳米级精度。
-
半导体封装
+关注
关注
4文章
297浏览量
14578 -
测量
+关注
关注
10文章
5298浏览量
113964 -
干涉仪
+关注
关注
0文章
126浏览量
10464
发布评论请先 登录
半导体晶片键合的对准方法

混合键合在先进封装领域取得进展
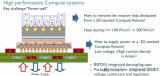





 白光扫描干涉法在先进半导体封装混合键合表面测量中的应用研究
白光扫描干涉法在先进半导体封装混合键合表面测量中的应用研究


















评论