LED 芯片作为半导体照明核心部件,其结构设计直接影响性能与应用。目前主流的正装、倒装和垂直三类芯片各有技术特点,以下展开解析。
正装 LED 芯片:传统主流之选
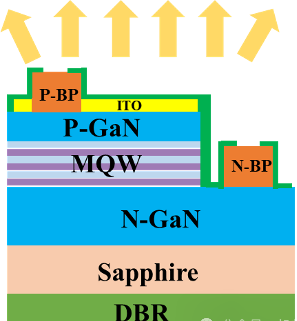
正装 LED 是最早出现的结构,从上至下依次为电极、P 型半导体层、发光层、N 型半导体层和蓝宝石衬底。其核心问题在于散热:PN 结热量需经蓝宝石衬底传导至热沉,而蓝宝石导热性差(约 20 W/(m?K)),易导致效率下降和可靠性降低。
性能上,正装芯片结构简单、工艺成熟、成本较低,适合大规模量产。但短板明显:P、N 电极同侧导致电流横向流动时出现拥挤,限制驱动电流;蓝宝石衬底阻碍散热;温湿度变化可能引发电极金属迁移,小尺寸芯片短路风险增加。
按功率可分为三类:小功率芯片采用 MESA、ITO、PAD 三次光刻;中功率芯片增加 CBL 和 PV 光刻共五次制程,背镀 DBR 提升亮度;大功率芯片沿用五次光刻,背镀层改为 ODR。目前,蓝宝石衬底正装芯片因成本优势,仍是室内照明、指示灯等中低功率场景的主流选择。
倒装 LED 芯片:高效散热新方案
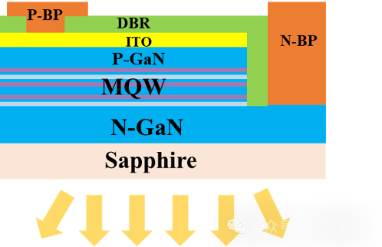
倒装芯片结构倒置,从上至下为蓝宝石衬底、N 型层、P 型层和电极。革新点在于热量无需经蓝宝石,直接通过电极传导至 Si 热沉(Si 导热系数约 150 W/(m?K)),散热效率大幅提升;底面电极设计避免遮光,光提取效率更高。
其优势显著:支持大电流驱动,适合高功率场景;芯片可小型化、高密度化,电极间距远减少短路风险;散热优化延长寿命,抗静电能力增强,还简化后续封装。但制造设备要求高、成本较高,目前厂商参与度低,市场应用尚未普及,不过在汽车大灯、高端显示等领域前景广阔。
垂直 LED 芯片:衬底革新突破

垂直芯片用 Si、Ge、Cu 等高导热衬底替代蓝宝石,从根本解决散热问题。采用通孔垂直结构,无需金线连接,显著降低封装厚度。
性能亮点包括:兼容红、绿、蓝及紫外全色系;所有工艺在晶圆水平完成,一致性好;抗静电能力强,可通过大直径或多数量通孔进一步提升散热。但工艺复杂,激光剥离、衬底键合等步骤技术要求高,导致合格率较低。
制备需经表面处理、台面蚀刻等步骤,核心是实现外延层与高热导率衬底的稳定键合。虽解决了散热痛点,但因成本和工艺问题,目前发展平缓,主要应用于特种照明等高端场景。
-
led
+关注
关注
242文章
23875浏览量
675412 -
LED芯片
+关注
关注
40文章
628浏览量
85392 -
LED工艺
+关注
关注
0文章
3浏览量
6352
发布评论请先 登录
LED灯技术的发展及三种主流灯光优缺点对比
三种主流LED背光源技术解析
三种主流投影仪技术类型
三种最常用的MEMS制造技术解析
芯片制造的艺术与科学:三种主流键合技术的综述

继电保护的三种状态解析
深入解析三种锂电池封装形状背后的技术路线与工艺奥秘






 三种主流 LED 芯片技术解析
三种主流 LED 芯片技术解析


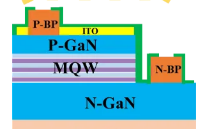
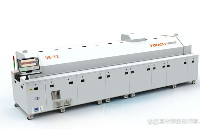










评论