在微电子制造与光伏产业中,大面积薄膜的均匀性与质量直接影响产品性能。传统薄膜表征方法(如溅射深度剖析、横截面显微镜观察)虽能提供高精度数据,但测量范围有限且效率较低,难以满足工业级大面积表面的快速检测需求。本文聚焦光学表征技术的革新,重点阐述椭偏仪等光学方法在大面积薄膜映射与成像中的突破性应用。其中,Flexfilm全光谱椭偏仪以其独特的技术优势,在大面积薄膜表征中展现出显著的应用潜力。
1
薄膜表征方法
flexfilm
根据测量原理与适用场景,薄膜表征方法可分为:深度剖析技术
- 溅射深度剖面分析(如二次离子质谱[SIMS]、X射线光电子能谱[XPS]):需通过物理溅射逐层剥离样品,虽精度高但破坏性强,且无法实现实时监测。
- 非破坏性技术(如光谱椭偏仪[SE]、卢瑟福背散射谱[RBS]):通过光学或粒子束与物质相互作用获取信息,单点测量耗时较长,但部分光学配置可将单点测量时间缩短至秒级。
- 横截面微纳尺度映射(如扫描透射电子显微镜[TEM]):依赖精细样品制备,分辨率可达纳米级,但仅适用于微观区域分析,难以扩展至宏观尺度。
涂层厚度测定方法
- 传统方法(库仑法、X射线荧光[XRF]):需离线操作,适用于实验室级精密分析。
- 离线方法(原子力显微镜[AFM]):可提供纳米级形貌信息,但测量速度较慢。
- 在线方法(反射率测量、干涉测量法、椭偏仪):反射率测量与干涉测量法适用于简单结构,而椭偏仪因其非破坏性、高速潜力及对复杂层状结构的适应性,成为在线检测的首选。
2
光学映射技术
flexfilm
- 椭圆偏振光谱法(SE)
椭偏仪通过测量光在薄膜表面的反射特性(振幅比与相位差),实现薄膜厚度、折射率等参数的快速测定。其在大面积映射中的优势如下:逐点扫描:通过移动光源与检测器单元,覆盖米级面积。例如,在太阳能电池板检测中,单点光谱测量仅需数秒,但数千点测量仍需数小时。卷对卷(RtR)配置:利用衬底移动实现光斑扫描,适用于柔性衬底的在线检测。例如,在光伏多层结构(如CdS/CdSe/CdTe)的均匀性优化中,可实时调整工艺参数。

室温沉积CdSe薄膜的65mm×65mm区域制图
- 反射、透射光谱与散射测量
高光谱成像(HSIM):提供表面区域的空间与光谱信息,用于二维材料(如石墨烯、MoS?)的厚度和激子行为分析,在生命科学和钙钛矿材料中亦有应用。共聚焦显微镜:适用于数百微米厚度的透明双层膜检测,空间分辨率达纳米级,可在线监测柔性衬底上的多层涂层。散射测量:通过衍射图案重建复杂光栅结构,暗场配置可成像亚波长等离子体纳米颗粒。
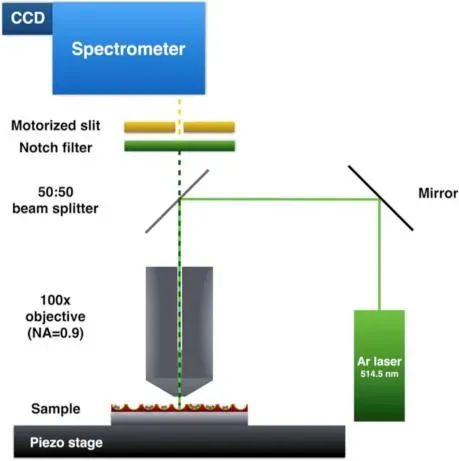
单颗粒制图光谱仪示意图
- 其他方法
毛细管桥法量化超低接触角(精度达0.1°),汞探针肖特基电容-电压法(MCV)用于硅外延层载流子密度的大面积剖面分析。
3
成像技术
flexfilm
- 椭圆偏振成像

发散光源椭圆偏振术装置示意图
发散光源配置:利用球面镜和针孔相机,实现大面积表面的多角度、多波长椭圆偏振参数成像,单次测量可覆盖 1000 mm×500 mm 区域,速度比传统逐点扫描快 10 倍以上。光谱分析:结合光栅色散,可在一维方向实现连续光谱测量,适用于卷对卷工艺中的实时监控。例如,在柔性电子制造中,发散光源椭偏仪可实时监测透明导电氧化物(TCO)层的厚度均匀性。

卷对卷压印纳米结构尺寸分析在线散射仪
- 反射与散射成像
实时散射成像:用于纳米压印结构的在线计量,结合光谱散射法实现纳米级结构深度测量,误差仅数纳米。斑点干涉法:通过激光反射产生的颗粒图案变化,监测生物组织(如大鼠血管)中的血流动力学参数。
4
应用案例
flexfilm
- 300mm晶圆厚度测量

机械臂移动过程中测量的a-NiSi厚度图与商业椭偏仪参考测量结果
配置:机械臂搭载椭偏仪,在晶圆移动过程中完成厚度映射。结果:与商业仪器对比,误差小于1nm,满足半导体制造需求。
- 扩展光束椭偏仪的性能验证

由九个不同氧化处理的4英寸硅片组成的大面积映射结果
数据:发散光束椭偏仪在2分钟内完成300mm晶圆厚度映射,分辨率达10nm。对比:传统点扫描需15分钟以上,效率提升显著。本文系统总结了大表面薄膜的光学映射与成像技术,重点分析了椭圆偏振法的进展与优势。为工业级大面积薄膜检测提供了高效解决方案,推动大表面薄膜技术的工业化应用。推动了光伏、半导体等领域的质量控制革新。
Flexfilm全光谱椭偏仪
flexfilm

全光谱椭偏仪拥有高灵敏度探测单元和光谱椭偏仪分析软件,专门用于测量和分析光伏领域中单层或多层纳米薄膜的层构参数(如厚度)和物理参数(如折射率n、消光系数k)
- 先进的旋转补偿器测量技术:无测量死角问题。
- 粗糙绒面纳米薄膜的高灵敏测量:先进的光能量增强技术,高信噪比的探测技术。
- 秒级的全光谱测量速度:全光谱测量典型5-10秒。
- 原子层量级的检测灵敏度:测量精度可达0.05nm。
Flexfilm全光谱椭偏仪凭借其高灵敏度探测单元和秒级全光谱测量速度,进一步推动了大规模薄膜技术的工业化应用。原文出处:《Mapping and Imaging of Thin Films on Large Surfaces》
*特别声明:本公众号所发布的原创及转载文章,仅用于学术分享和传递行业相关信息。未经授权,不得抄袭、篡改、引用、转载等侵犯本公众号相关权益的行为。内容仅供参考,如涉及版权问题,敬请联系,我们将在第一时间核实并处理。
-
测量
+关注
关注
10文章
5277浏览量
113648 -
薄膜光伏
+关注
关注
0文章
6浏览量
9578
发布评论请先 登录
大面积白光OLED器件
大面积均匀电子束产生实验研究
薄膜光学实时成像仪的设计概念
教授研究组在大面积制备钙钛矿LED领域取得重要进展
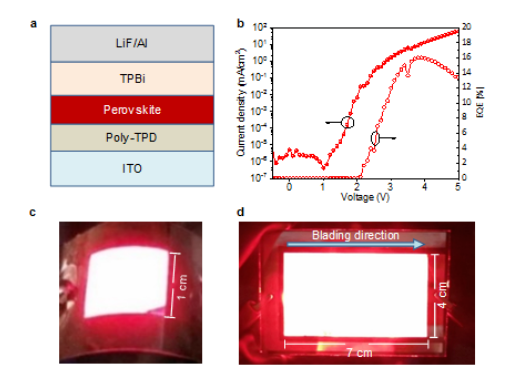
大面积甲脒铯基钙钛矿薄膜与高效稳定模组

全光谱椭偏仪测量:金属/半导体TMDs薄膜光学常数与高折射率特性

椭偏仪原理和应用 | 精准测量不同基底光学薄膜TiO?/SiO?的光学常数

大面积太阳光模拟器 | 设计组成与多领域应用






 大面积薄膜光学映射与成像技术综述:全光谱椭偏技术
大面积薄膜光学映射与成像技术综述:全光谱椭偏技术













评论