文章来源:学习那些事
原文作者:前路漫漫
本文主要讲述为什么外延生长技术是半导体制造的核心工艺。
外延生长技术:半导体制造的核心工艺
随着半导体器件特征尺寸不断微缩,对高质量薄膜材料的需求愈发迫切。外延技术作为一种在半导体工艺制造中常用的单晶薄膜生长方法,能够在单晶衬底上按衬底晶向生长新的单晶薄膜,为提升器件性能发挥了关键作用。本文将对外延技术的定义、分类、原理、常用技术及其应用进行探讨。
在半导体工艺制造领域,随着CMOS器件特征尺寸持续减小,高质量薄膜材料对于提升器件性能的重要性日益凸显。外延技术作为生长高质量单晶薄膜的关键手段,为半导体产业的发展提供了强大支撑。通过在单晶衬底上生长外延层,不仅能够精确控制薄膜的厚度、掺杂浓度等参数,还能有效改善器件的性能,如提高双极型晶体管的高频性能、解决CMOS器件的闩锁效应等。因此,深入研究外延技术对于推动半导体制造工艺的进步具有重要意义。
外延的基本概念
1.定义
外延指的是在单晶衬底上,按照衬底晶向生长一层新的单晶薄膜的工艺。生长出的单晶层被称为外延层,带有外延层的衬底则被称作外延片。这种生长方式能够使外延层与衬底在晶体结构和晶向上保持良好的一致性,从而为半导体器件的制造提供高质量的材料基础。
2.分类
按照外延生长材料的类型,外延可分为同质外延和异质外延。同质外延是指外延层与衬底材料相同的外延工艺,例如在Si衬底上外延Si,在GaAs衬底上外延GaAs等。这种外延方式能够充分利用衬底的特性,生长出与衬底晶格匹配良好的外延层,减少晶格缺陷,提高外延层的质量。异质外延则是外延层与衬底材料不同的外延工艺,如Si上外延SiGe,GaAs上外延GaAlAs等。异质外延为实现不同材料之间的优势互补提供了可能,通过合理选择外延层和衬底材料,可以获得具有特殊性能的半导体结构,满足不同器件的需求。
按照工艺划分,外延可分为气相外延(VPE)、液相外延(LPE)、固相外延(SPE)和分子束外延(MBE)等。不同的外延工艺具有各自的特点和适用范围,在半导体制造中发挥着不同的作用。
按照电阻率高低划分,外延可分为正向外延和反向外延。正向外延是在低阻衬底上外延高阻层(重衬底上外延生长轻掺杂层),而反向外延则是在高阻衬底上外延低阻层(轻掺杂衬底上外延生长重掺杂层)。这种分类方式主要是根据外延层和衬底的电阻率差异来进行的,不同的电阻率分布会对器件的性能产生重要影响。
按照压力划分,可分为常压外延(100kPa)和低压(减压)外延(5 - 20kPa)。压力对外延生长过程中的气体传输、化学反应以及薄膜质量等方面都有着显著的影响,选择合适的压力条件能够优化外延工艺,提高外延层的质量和均匀性。
按照温度划分,可分为反应温度在1000℃以上的高温外延和1000℃以下的低温外延。温度是外延生长过程中的一个关键参数,它直接影响着化学反应速率、原子扩散速率以及外延层的晶体结构和质量。不同的外延工艺和材料对温度的要求各不相同,需要根据具体情况进行精确控制。
外延在半导体器件中的重要性
在早期半导体工艺制造中,外延被用于改善双极型晶体管的高频性能。为了实现高频大功率,双极型晶体管的集电极需要具备高击穿电压和低串联电阻,然而这两个要求对集电极材料的电阻率有着相互矛盾的需求。外延技术通过在电阻极低的衬底上生长一层高电阻率外延层(正向外延),成功地解决了这一矛盾。将双极型晶体管制作在外延层上,高电阻率的外延层保证了晶体管有高的击穿电压,而低电阻的衬底又降低了串联电阻,从而显著提升了高频双极型器件的性能。
在CMOS器件中,外延同样发挥着关键作用。CMOS器件中电源和地之间由于寄生PNP和NPN双极型晶体管相互影响,可能会产生低阻抗通路,导致“闩锁效应”(Latch - Up),使器件损坏。通过在CMOS器件中增加低电阻率的外延层,可以避开双极型晶体管的发射极,使其不能“开启”,从而有效地解决了“闩锁效应”。此外,在先进CMOS工艺制造中,广泛采用SiGe源漏选择性外延工艺给PMOS器件沟道施加压应力,能够提高器件的空穴迁移率,进而提升器件性能。
硅气相外延基本原理
一、外延设备的构成
典型的外延设备由多个关键部分组成,包括气体分布系统、反应腔、支撑并加热硅片的基座、控制系统以及尾气系统。气体分布系统中,气体质量流量控制器(MFC)和真空阀用于严格控制气体流动到反应腔,确保反应气体能够精确、稳定地输送到反应区域。基座一般由石墨或者覆盖着碳化硅或氮化硅的多晶硅组成,它需要具备足够的强度,并且不能与反应物和反应产物发生反应,以保证在高温、复杂化学反应环境下能够稳定支撑硅片并均匀加热。
二、反应源
硅气相外延常用的反应源有四氯化硅(SiCl?)、三氯硅烷(SiHCl?,TCS)、二氯硅烷(SiH?Cl?,DCS)、硅烷(SiH?)以及其他硅烷。早期集成电路制造常采用四氯化硅(SiCl?)作为反应源,但由于其外延生长Si的热预算很高,会带来诸多不利影响,而现今集成电路制造工艺对热预算要求尽可能低,所以目前SiCl?主要应用在传统的外延工艺中。三氯硅烷与SiCl?特性相似,但其所需的热预算比SiCl?低很多,且生长速率较高,适合用于生长厚的外延层。二氯硅烷则广泛应用于在更低温度下生长高质量的薄外延层,其生长的外延层缺陷密度低,是选择性外延常用的一种反应源。硅烷的热分解反应是硅外延生长中较为简单的化学反应,其化学方程式为SiH?→Si(s) + 2H?(g),这种工艺常用于多晶硅的淀积,也可在低于900℃的温度下外延生长很薄的外延层,且淀积速率很快。此外,像乙硅烷(Si?H?)或者丙硅烷(Si?H?)等其他硅烷,因其外延生长温度更低,适合淀积很薄的外延层,且淀积速率快。
三、外延生长模型
为了更好地理解外延的生长过程,建立了详细的外延生长模型。在这个模型中,外延生长可划分为六个具体步骤:
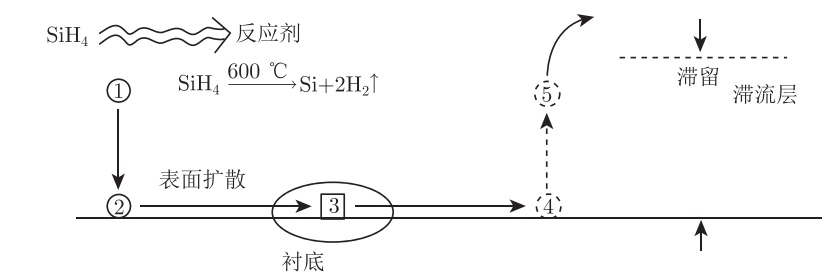
传输:反应物气体经过气相质量输运转移到Si表面。在这一步骤中,反应气体在气流的带动下,通过复杂的气体动力学过程,从气体分布系统输送到硅片表面,为后续的反应提供物质基础。
吸附:反应物吸附在Si表面。当反应气体分子到达硅片表面后,会与硅片表面的原子发生相互作用,通过物理吸附或化学吸附的方式附着在硅片表面,为进一步的化学反应做准备。
化学反应:反应物在Si表面进行化学反应,生长Si外延层及副产物。吸附在硅片表面的反应物分子在高温等条件下发生化学反应,硅原子逐渐结合形成外延层,同时产生相应的副产物。
脱吸:副产物脱离衬底。反应产生的副产物需要从硅片表面脱离,以便为新的反应腾出空间,保证外延生长过程的持续进行。
逸出:脱吸的副产物逸出反应室。脱离硅片表面的副产物在气流的作用下,从反应腔中排出,避免副产物在反应腔内积累对反应产生不利影响。
加接:生成的Si原子加接到Si衬底晶格点阵上,延续Si衬底晶向。新生成的硅原子会按照硅衬底的晶向,有序地加入到晶格点阵中,从而实现外延层的生长,保持与衬底晶向的一致性。

在外延生长进程中,外延层展现出横向二维逐层生长的特性,这一特性与晶面独特的“平台 - 台阶 - 扭转位置”构造紧密相连。晶面的微观结构可看作由平整的原子平台、平台边缘的台阶以及台阶拐角处的扭转位置共同构成。当吸附原子(如硅原子)抵达平台区域的A位置时,若能量较低而保持静止,后续吸附的原子会在其周围无序堆积,逐步形成短链状的硅串或岛状结构。随着硅串或硅岛数量增多并相互连接,极易在晶面内引入大量晶格缺陷(如位错、层错),严重破坏外延层的单晶质量。
当吸附原子具备较高能量时,会借助表面扩散机制向能量更低的稳定位置迁移。其中,台阶边缘的B位置因存在未完全饱和的Si - Si键,能与迁移原子形成部分共价键作用,其能量状态比平台中央的A位置更低,成为原子迁移的优先选择。而位于台阶拐角处的扭转位置C,原子在此处可同时与两个方向的晶格原子形成键合(约完成50%的Si - Si键),能量状态最为稳定。因此,当原子迁移至扭转位置时,几乎不再发生二次迁移,而是直接作为生长节点,推动外延层沿衬底晶向有序延伸。这种“平台吸附 - 台阶迁移 - 扭转固定”的生长模式,是确保外延层保持单晶特性的核心机制。
注意,若原子迁移过程受到动力学因素抑制(如低温或高速生长),将导致生长模式偏离理想的逐层外延。具体表现为:
淀积速率的阈值效应:在特定温度下,存在一个临界淀积速率值。当实际生长速率超过该阈值时,气相中源源不断供给的原子会使平台表面迅速饱和,大量原子因来不及迁移至扭转位置而直接在平台上无序堆积,最终形成多晶或亚微晶结构;反之,当生长速率低于阈值时,原子有充足时间完成表面扩散,从而实现单晶外延。
温度对迁移能力的调控:在固定淀积速率条件下,温度通过影响原子表面迁移率发挥关键作用。高温环境能显著提升原子动能,使其扩散系数增大(如硅原子在1000℃时的表面迁移距离是800℃时的10倍以上),从而快速定位至扭转位置完成有序生长;而低温会导致原子“冻结”在初始吸附位置,被迫以岛状模式生长,最终形成多晶薄膜。这种温度 - 速率的协同作用,构成了外延工艺窗口优化的核心依据。
外延生长速率的影响因素
反应源
不同硅源的热分解行为和表面反应活性直接决定生长速率排序。以常见硅源为例:
硅烷(SiH?):在低温(600 - 900℃)下即可发生热分解(反应式:SiH? → Si + 2H?),其气相扩散系数大(约0.1 cm?/s),且分解后产生的Si*活性基团能快速吸附于衬底表面,因此生长速率最高(可达数μm/min)。
卤代硅烷(如SiCl?、SiHCl?):需更高温度(1100 - 1200℃)才能通过氢还原反应释放硅原子(如SiCl? + 2H? → Si + 4HCl),且反应过程伴随HCl副产物的刻蚀效应,导致实际生长速率低于硅烷。
速率排序规律:SiH? > SiH?Cl?> SiHCl?> SiCl?,这一顺序与硅源中Si - Cl键的键能呈负相关(SiCl?键能3.8 eV > SiHCl?键能3.3 eV),键能越高,需更多能量打破化学键,导致反应速率降低。
温度
温度通过控制反应速率的限速步骤,使外延生长呈现双区域特性:
高温区(质量输运控制区):
此时表面化学反应速率极快,硅源分子的气相扩散成为限速步骤。生长速率主要取决于反应气体穿过边界层(厚度δ≈0.1 - 1 mm)的扩散通量,可由菲克定律描述:

其中,D为扩散系数,C?为气相主体浓度。由于扩散系数对温度的依赖较弱(D ∝ T^(3/2)),高温区生长速率对温度波动不敏感,但对反应腔几何结构(如气体入口设计、衬底间距)和气流速度(雷诺数Re)高度敏感。
低温区(表面反应控制区):
硅源分子的热分解效率下降,表面化学反应成为限速步骤。生长速率遵循阿伦尼乌斯定律:

其中,活化能E?(如SiCl?氢还原反应E?≈2.3 eV)决定温度敏感性。
制备厚外延层(如功率器件的高阻漂移层)时,优先选择高温区工艺,利用质量输运控制的稳定性实现均匀生长;
生长纳米级超薄外延层(如FinFET源漏应变层)时,采用低温区工艺,通过精确控温实现原子级厚度控制,但需注意抑制多晶化倾向。
3.反应剂浓度
以 SiCl?为例,外延工艺主要分成两个过程,第一过程为氢气还原 SiCl?,第二过程是 Si 外延层的生长。硅外延生长速率由这两个过程中较慢的一个决定。当 SiCl?浓度较小时,氢气还原 SiCl?受限,氧化 - 还原反应释放硅原子的速率远远小于硅原子在衬底上有序排列生长单晶硅的速率,表面的氧化 - 还原反应速率控制了外延层的生长速率,此时属于表面化学反应控制类型的生长。随着 SiCl?浓度的增加,氧化 - 还原反应速率加快,外延生长速率也相应增加,当浓度大到一定程度时,氧化 - 还原反应释放出硅原子的速率会超过硅原子在衬底上有序排列生长单晶硅的速率,此时由氧化 - 还原反应速率控制转变为由硅原子有序排列生长单晶的速率控制,在这种情况下易生成多晶硅。当增大 SiCl?浓度大于0.1 时,外延生长速率会逐渐减小,这是因为生长的硅膜在高温下被副产物 HCl 刻蚀,发生了 “逆向反应”。当 SiCl?浓度大于0.27 时,只存在 HCl 对硅膜的腐蚀反应。
气流速率
与CVD工艺类似,在外延腔体中的气流速率对淀积速率也有影响。气体流速越大,边界层越薄,腔体中反应剂更容易扩散穿过边界层到达衬底表面,外延生长速率也越快。但当气流大到一定程度时,边界层变得很薄,气相质量输运到衬底表面的反应剂数量超过外延温度下的表面化学反应需要的数量,此时外延生长转变为表面化学反应速率控制,外延层的生长速率基本不随气体流量增大而加快。
晶面
不同晶面的共价键密度不同,其成键结合能力存在差别,也会对生长速率产生一定影响。在共价键密度小的晶面,比如(111)晶面,其成键结合能力差,外延生长速率较慢;反过来,在共价键密度大的晶面,比如(100)晶面,其成键结合能力强,外延生长速率则快。
常用外延技术
1.减压(低压)化学气相淀积(RPCVD)
常压外延作为相对成熟的外延工艺,在半导体工艺制造水平不断提高的背景下,逐渐暴露出一些问题,如外延图形漂移过大,掩埋层中杂质向外延层扩散等。而RPCVD作为一种低压外延技术(1x10? - 2x10?Pa),能够有效解决这些问题。采用低压外延技术可减小自掺杂效应,因为在低压情况下,分子平均自由程增大,加快了杂质的扩散速率,使衬底逸出的杂质能快速地穿过边界层被排出反应腔,重新进入外延层的机会减小,有效降低了自掺杂效应对外延层中杂质浓度和分布的影响,可以实现陡峭的杂质分布。另外,RPCVD还可改善外延层电阻率的均匀性,减小埋层图形的漂移和畸变。与常压外延相比,低压外延的生长速率只下降了15% - 17%,但其外延生长温度可以降低100 - 150℃,显著提高了图形转移和掩埋层的质量。
2.选择性外延(SEG)
硅选择性外延利用了硅在绝缘体上很难成核并继续生长成薄膜的特性,可以选择性地在硅表面特定区域生长外延层而其他区域不生长。硅在SiO?上成核的可能性最小,而在Si上的可能性最大,这是因为Si晶核/SiO?界面会产生较大的晶格失配,与Si晶核/Si衬底的同质成核相比,在SiO?上生成晶核的能量增加。此外,要进行外延生长的地方通常是窗口内或者硅表面的凹陷处,这些地方成核能较低,因此,落在SiO?上的原子因不易成核而迁移到更易成核的硅表面凹陷处。在先进CMOS制造中,选择性外延可用于导电沟道的应变工程,通过在器件源漏区域外延生长锗硅(SiGe)以增加导电沟道的压应力来提高PMOS的空穴迁移率,或者在沟槽中选择性外延生长高迁移率沟道材料,比如Ge、InGaAs等。
3.横向超速外延(ELO)
横向超速外延是基于选择性外延工艺发展而来的一种外延技术。当硅选择外延生长的外延层厚度超过SiO?岛的台阶高度时,除了沿着垂直硅衬底表面的纵向层生长以外,也会沿横向生长,这种外延技术称为横向超速外延(ELO)。横向与纵向生长速率之比受到窗口或台阶的高度以及衬底晶向等因素的影响。通过控制这些因素,可以实现对横向和纵向生长速率的调控,从而获得具有特定结构和性能的外延层。
4.分子束外延(MBE)
分子束外延是在超高真空下,使外延层组分元素受热蒸发(电阻加热或电子束加热)形成原子或分子蒸气流,然后到达加热的衬底表面,进而形成外延层。分子束外延能够生长元素半导体单晶,如Si和Ge,以及化合物半导体SiGe、GaAs和GaN单晶等。一个典型的分子束外延系统由超高真空系统、生长系统、测量、分析、监控系统等组成。与其他外延技术相比,分子束外延具有生长速率较慢且可控、表面及界面平整、外延温度相对低等特点。较低的生长速率使得分子或原子有充分的时间到达成核点,从而制备出高质量的薄膜。外延温度相对较低,减少了系统的放气,降低了扩散效应和自掺杂效应的影响,降低了来自衬底杂质的再分布以及热缺陷的产生。其中固态分子束外延采用固态源超高真空蒸发技术,与普通热蒸发技术相比,对薄膜的化学组成及掺杂浓度精确可控,并且可实现厚度原子级的精确控制。基于这些优点,分子束外延被广泛用于生长组分及掺杂分布陡峻的突变异质结和复杂的多层结构,包括量子阱器件、超晶格、激光器等,所有这些都得益于外延生长过程中对成分的精确控制。例如,利用分子束外延技术可以产生许多由GaAs和AlGa???As交替组成的超晶格外延层结构,其厚度低至10?。分子束外延不仅在半导体领域有着重要应用,在光学等其他领域也有用武之地,如公交车上的车站预告板、体育场内的超大显示屏,其发光元件往往由分子束外延制造。
金属有机化学气相淀积(MOCVD)
金属有机化学气相淀积是以Ⅲ族、Ⅱ族元素的有机化合物和Ⅴ、Ⅵ族元素的氢化物等作为外延层生长的反应源,以热分解反应方式在衬底上进行气相外延生长各种Ⅲ-Ⅴ族、Ⅱ-Ⅵ族化合物半导体以及它们的多元固溶体的外延层。其组分和掺杂可通过反应源的流量进行精确控制。通常MOCVD系统中的晶体生长都是在常压或低压(10 - 100 Torr)下通H?的冷壁石英(或不锈钢)反应腔中进行,衬底温度为500 - 1200℃,用直流加热石墨基座(衬底基片在石墨基座上方),H?通过温度可控的液体源鼓泡携带金属有机物到外延生长区。金属有机化学气相淀积能实现外延层生长界面成分的突变,实现陡峭的界面,适用于各种异质结外延层的生长。MOCVD技术已广泛应用于光学器件、超导薄膜材料、半导体器件、高介电材料等薄膜材料的制备中。在光电器件领域,如发光二极管(LED)、激光二极管(Laser Diode)及太阳能电池(Solar Cells)的制造中,MOCVD发挥着关键作用,通过精确控制反应源流量和生长条件,能够制备出高质量的化合物半导体薄膜,满足光电器件对材料性能的严格要求。同时,在新型微电子器件的研发中,MOCVD也为探索新的材料体系和器件结构提供了有力的技术支持。
总结
外延技术作为半导体制造中的核心工艺,在提升半导体器件性能方面发挥着不可替代的作用。通过在单晶衬底上生长高质量的外延层,能够精确控制薄膜的各项参数,解决半导体器件制造中的诸多难题,如改善双极型晶体管的高频性能、克服CMOS器件的闩锁效应等。随着半导体技术的不断发展,对高质量薄膜材料的需求日益增长,外延技术也在不断创新和进步。外延层缺陷仍然是影响半导体器件性能的重要因素,在后续的文章中我们也还会对外延层缺陷进行探讨。未来,外延技术将继续在半导体制造领域发挥关键作用,为推动半导体产业的持续发展提供强大动力,同时也将在其他相关领域,如光学、传感器等,展现出更广阔的应用前景,促进多学科的交叉融合和协同发展。
-
CMOS
+关注
关注
58文章
6035浏览量
239158 -
半导体
+关注
关注
335文章
29026浏览量
240059 -
晶体管
+关注
关注
77文章
10029浏览量
142163 -
制造工艺
+关注
关注
2文章
205浏览量
20432
原文标题:外延生长技术:半导体制造的核心工艺
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
GaN外延生长方法及生长模式
SiGe外延工艺及其在外延生长、应变硅应用及GAA结构中的作用

8英寸单片高温碳化硅外延生长室结构

钟罩式热壁碳化硅高温外延片生长装置






 一文详解外延生长技术
一文详解外延生长技术

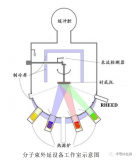
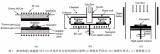
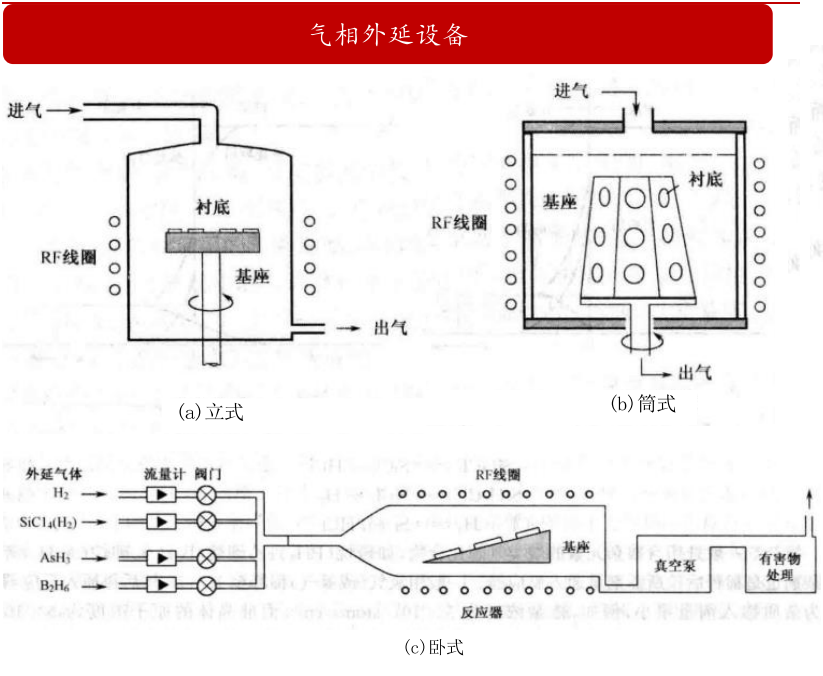

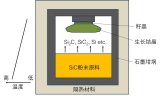










评论