文章来源:老虎说芯
原文作者:老虎说芯
本文介绍了封装中打线键合的概念、流程、关键点与可靠性等。
一、什么是打线键合(Wire Bonding)?
打线键合就是将芯片上的电信号从芯片内部“引出来”的关键步骤。我们要用极细的金属线(多为金线、铝线或铜线)将芯片的焊盘(bond pad)和支架(如引线框架或基板)之间做电连接。
可以理解为:
“芯片是大脑,但得靠血管(引线)把信号输送出去,不然再聪明也干不了事。”
二、打线键合的核心目的:
建立电连接:芯片内部与封装外部间的信号通道
提供可靠性:满足电性能、机械稳定性要求
保证生产良率:为后续封装打好基础
三、打线键合的类型
虽然有多种方式(例如热压键合、超声键合、热超声复合键合等),这里我们主要讲的是热超声金线球焊(Ball Bonding),这是最常见的一种,特别适合铝焊盘+金线的组合。
四、打线键合的完整9步流程
步骤 1:准备金线
金线从打线机线轴中牵出,经过打线劈刀(Capillary)底部,露出短短的线尾。
步骤 2:形成“自由空气球”(FAB)
打线机会用“放电”的方式,在金线尾部打出一个金球。这个球是在空气中自然形成的,因此叫自由空气球(Free Air Ball)。就像是用电火花把金线的尾端熔掉形成一个金珠。
步骤 3:压球到芯片焊盘
劈刀带着金球对准芯片上的焊盘(bond pad),缓缓向下压,让金球和焊盘贴合。
步骤 4:完成第一个键合点(金球键合)
压好后,打线机会开始施加:一定的压力、一定量的超声波振动能量、控制作用时间。这样做的目的是让金球与芯片焊盘之间的金属发生塑性变形+微观摩擦焊接,最终牢牢焊在一起。
步骤 5:拉金线
劈刀抬起,同时拉动金线,从芯片焊盘开始画出一段弧形线,将线带到目标点:支架的焊盘(lead/frame pad 或 PCB pad)。
步骤 6:压线到支架焊盘
劈刀移动到支架焊盘位置,再次往下压线。
步骤 7:形成第二个键合点(鱼尾键合)
再次施加:压力、超声能量、时间控制。这次不是压球,而是将金线压成“鱼尾”状贴附到支架焊盘上,完成第二端焊接。
步骤 8:切线并保留线尾
劈刀继续抬起,并在移动中切断金线,在支架焊盘上留下“鱼尾”,同时在劈刀口留下新的线尾,为下一根线准备。
步骤 9:循环进行下一根线的键合
回到第1步,周而复始,直到所有焊盘都连线完成。
五、打线工艺的四大核心参数
| 温度(Bond Temp) | 提高金属塑性,改善焊接效果 | 一般为100~150°C |
| 压力(Bond Force) | 保证足够接触和变形 | 太小焊不牢,太大会压坏焊盘 |
| 超声能量(Ultrasonic Power) | 引发金属分子间摩擦/扩散 | 控制能量大小避免“虚焊”或“飞线” |
| 超声时间(Bond Time) | 决定超声作用时长 | 配合能量使用,不能太短或太长 |
| 参数 | 作用 | 举例说明 |
|---|
六、打线质量的关键控制点
金球尺寸控制:
金球直径通常为60μm
厚度约20μm
太大易短路,太小焊接不牢
接合强度测试:
剪切力(Shear/Push Force):芯片端金球推力 >20克
拉力(Pull Force):整条线拉断前应 >109克力
这些测试是验证焊点强度是否达标的标准动作,不能忽略。
七、环境和工艺注意事项
1. 湿气控制:
若打线作业延迟超72小时,要进行低温烘焙,把吸附的湿气烤掉。否则在封装注塑(Molding)时,水汽膨胀会导致封装开裂或界面脱层
2. 表面洁净性:
焊盘若有污染或氧化层,会直接导致打线失败(金球脱落、鱼尾不粘)
必要时可使用等离子清洗机进行表面活化处理,恢复焊接性
八、打线后的可靠性隐患有哪些?
| 金球脱落 | 焊盘氧化、温度低、超声不足 | 表面清洁、调整参数 |
| 金线断裂 | 金线受损、弧度过大 | 优化拉线路径、换线材 |
| 鱼尾翘起 | 压力不足、支架氧化 | 加压、清洗支架表面 |
| 接触电阻大 | 焊点不饱满、焊接不牢 | 调整球径、超声能量 |
| 问题现象 | 可能原因 | 解决办法 |
|---|
九、打线在整个封装流程的位置
1. 晶圆切割 → 2. 芯片贴片 → 3. 银胶烘焙 → 4. 打线键合 → 5. 封装成型 → 6. 电性测试 → 7. 成品分选
总结
打线键合是芯片封装中最细致、最关键的工序之一,涉及机械精度、材料性能、热/超声参数控制等多方面的综合考量。金线虽细如发丝,但却承担着整个芯片与外部世界沟通的重任。
-
芯片封装
+关注
关注
12文章
579浏览量
31531 -
焊盘
+关注
关注
6文章
593浏览量
38956 -
键合
+关注
关注
0文章
83浏览量
8122
原文标题:芯片封装中的打线键合(Wire Bonding)
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
介绍芯片键合(die bonding)工艺
芯片封装中铜丝键合技术

优化封装以满足SerDes应用键合线封装规范






 芯片封装中的打线键合介绍
芯片封装中的打线键合介绍

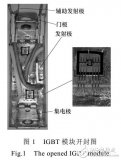
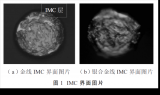















评论