文章来源:学习那些事
原文作者:前路漫漫
本文介绍了球栅阵列封装的结构、分类、应用和发展趋势。
概述
在集成电路封装技术的演进历程中,球栅阵列封装(Ball Grid Array,BGA)凭借卓越性能与显著优势脱颖而出,成为当今高集成度芯片的主流封装形式,广泛应用于各类高端IC产品。自20世纪90年代初问世以来,BGA封装快速发展,极大地推动了电子产业的变革。
球栅阵列(BGA)封装是在PGA和OFP的基础上发展而来的,融合了PGA(针栅阵列封装)与QFP(四边扁平封装)的技术优势:借鉴PGA的阵列布局理念,将传统针脚替换为用于键合的微球;采用QFP成熟的SMT(表面贴装技术)工艺,通过回流焊实现可靠连接。这种创新设计使BGA封装具备占用空间小、对引脚间距要求灵活的特点,能够轻松实现高密度封装,同时拥有出色的电学与机械性能。
作为高引脚数、高性能IC的理想封装方案,BGA广泛应用于芯片组、图形处理芯片、专用集成电路(ASIC)、微处理器等核心器件。其核心特征在于芯片I/O端以球形凸点呈面阵分布,凸点材料可选用Sn-Pb焊料或有机导电树脂,这一技术革新为集成电路封装带来了重大突破,显著提升了芯片的集成度与可靠性 。

BGA结构图
BGA封装的结构与分类
一、结构组成
BGA封装主要由芯片、封装基板、焊球阵列三部分组成。芯片作为核心器件,承载着电路功能;封装基板通常采用陶瓷、有机材料(如BT树脂/玻璃层压板)或柔性材料(如聚酰亚胺),起到电气互连和机械支撑的作用;焊球阵列由锡、铅或其他金属合金制成,作为芯片与印刷电路板(PCB)之间的连接桥梁。在芯片与基板的连接方式上,主要有引线键合和倒装焊两种。引线键合是通过金属丝将芯片引脚与基板上的焊盘连接起来;倒装焊则是将芯片有源面朝下,通过芯片表面的导电凸点直接与基板相连,省略了长金属键合线,进一步缩短了信号传输路径 。
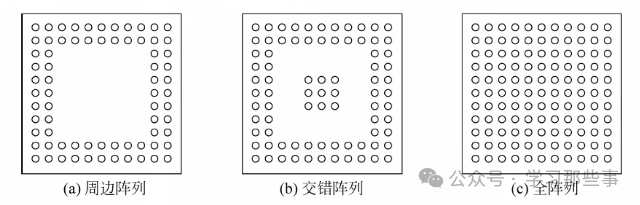
BGA的焊球分布方式
二、分类及特点
根据不同的标准,BGA封装可进行多种分类:
1. 按基板材料分类
塑料球栅阵列封装(PBGA,Plastic Ball Grid Array):PBGA采用塑料材料与塑封工艺,是应用最广泛的BGA封装类型,也称整体模塑阵列载体(OMPAC)封装。它以BT树脂/玻璃层压板作为PCB基板,先通过芯片键合固定裸芯片,经引线键合连接焊盘与基板焊区,再注塑成型,最后在基板底面制作焊球阵列作为外引脚。早期焊球使用63Sn - 37Pb低熔点共晶合金,直径约1mm,间距1.27 - 2.54mm,与封装体连接无需额外焊料。PBGA成本低、电性能好,对焊球共面度要求宽松,但对潮气敏感,回流焊时易因受潮出现“爆米花”现象导致器件失效。
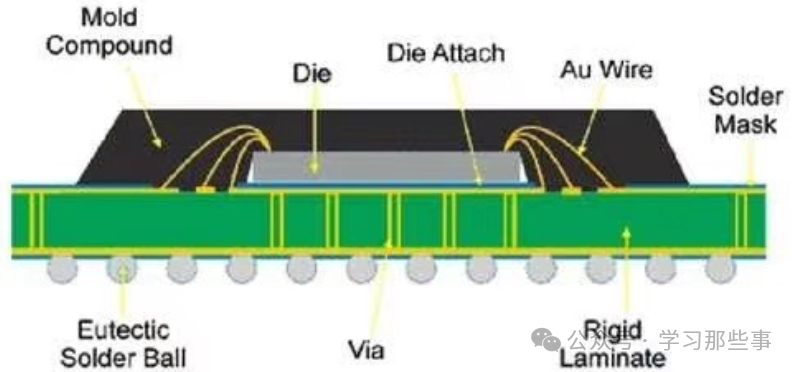
PBGA结构图
陶瓷球栅阵列封装(CBGA,Ceramic Ball Grid Array):CBGA将裸芯片安装在多层陶瓷布线基板上,通过倒装或引线键合实现电气连接,再用金属盖板密封焊接保护内部结构,玻璃封接或焊料焊接的封盖工艺可实现气密封装。其焊球采用90Pb - 10Sn等高熔点焊料,与封装体底部连接使用63Sn - 37Pb低温共晶焊料。CBGA具有抗潮性强、可靠性高、散热与电性能优良等优势,且适合倒装芯片技术提升互连密度,但封装成本较高,与塑料基板热膨胀系数匹配性较差。陶瓷柱栅阵列封装(CCGA)作为CBGA的延伸技术,以焊球柱替代焊球,在器件面积大于32mm? 时可提供更好的可靠性与抗疲劳性能。
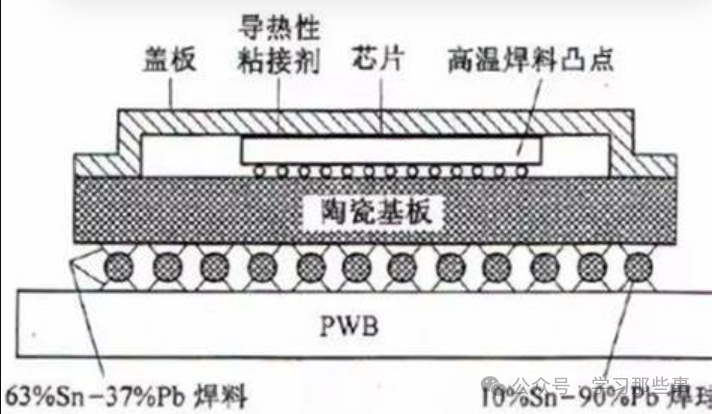
CBGA

PBGA与CBGA焊点对比
载带BGA(TBGA,Tape Ball Grid Array):包含铜/聚酰亚胺挠性载带和与载带电性连接的芯片,具有密封盖板,芯片贴合在密封盖板的空腔中,芯片外围盖板下方的载带底部设置有焊球阵列。载带两侧通常有金属层,顶部金属层为统一接地层,底部金属层为铜线路,可制成双层或多层线路载带,通过铜线路将芯片与焊球阵列连接。引线键合、回流焊或载带自动焊(热压/热超声内引脚键合)均可用于芯片与铜线路的连接。TBGA热阻低,散热性能好,载带与环氧树脂等塑料基板CTE匹配性好,电性能比PBGA优良,封装更薄,但不是气密封装,对湿气敏感,成本高于PBGA。
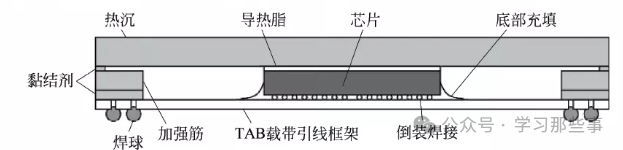
一种采用倒装芯片的TBGA
金属BGA(MBGA,Metal Ball Grid Array):不使用独立的柔性层或载带层,以铝圆片或铝面板作为基板。铝表面生长18mm的阳极氧化铝层作为介电层,沉积由铜、镍和金组成的薄膜金属并图形化,特征尺寸精细。传统阻焊设置在金属薄膜表面定义焊盘位置,电介质也可采用聚酰亚胺或苯并环丁烯(BCB)等聚合物材料,利于多层设计及使用低介电常数材料。芯片键合、引线键合以及塑封在铝圆片或面板上进行,封装完成后分离成单个封装。MBGA同TBGA一样具有良好的散热性和电性能,随着薄膜加工技术进步,成本不断降低 。
2.按气密性分类:陶瓷BGA可分为气密BGA和非气密BGA,除陶瓷BGA外,其他类型均为非气密BGA 。
3.按芯片与基板互连方式分类:主要分为引线键合和倒装焊。目前,采用引线键合的BGA的I/O数常为50 - 540个,采用倒装焊方式的I/O数常大于540个。PBGA互连常用引线键合方式,CBGA常用倒装焊方式,TBGA两种互连方式均有使用 。当I/O数小于600个时,引线键合成本低于倒装焊,但倒装焊更适宜大批量生产,若圆片成品率提高,可降低单个器件成本,且能进一步缩小封装体体积。
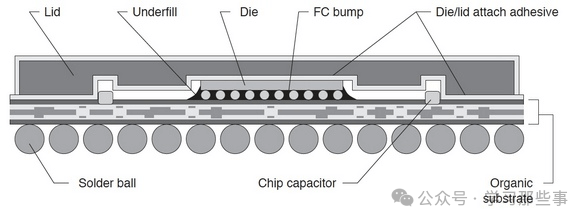
FCBGA
此外,根据结构特点,还有一些特殊类型的BGA,如FBGA(细间距球栅阵列)、FCBGA(倒装BGA)、EBGA(散热增强BGA)等 。
BGA封装的技术优势
一、高引脚密度与空间利用率
BGA封装利用芯片的整个底部面积来布置I/O端口,相较于传统封装形式,极大地提高了芯片的引脚密度和空间利用率。在相同的芯片面积和引出端数目情况下,BGA封装能够提供更大的焊盘,减少了焊点间短路搭桥的故障,提高了引出电极的载流量和焊接可靠性 。例如,一些高端处理器的BGA封装可以容纳数千个引脚,满足了大规模集成电路对信号传输的需求。
二、优异的电气性能
BGA封装的引出端短,芯片和基板的互连路径短,产生的寄生参数小。其寄生电感小,使得器件能够获得很高的工作频率,同时降低了噪声。与传统引线键合封装相比,BGA封装的电阻降低了75%,信号传输延迟和失真大幅减少,能够有效避免信号间的串扰,保证了信号传输的完整性和稳定性,非常适合高频、高速信号的传输 。
三、良好的散热性能
焊料凸点作为BGA封装的热量导出路径,有利于提高功率密度。BGA封装与单板之间的连接点呈二维分布,连接面更广,相当于增大了传热面积,因此结板热阻相对较低。此外,还可以通过在基板上施加热过孔,或在基板底侧正对芯片结处施加铜片等方式进一步降低热阻 。裸Die封装的BGA芯片,其结直接暴露在外,最大程度地降低了结壳热阻,为芯片提供了良好的散热条件 。
四、小型化与轻薄化
BGA封装器件尺寸小、体薄,占用基板面积小。以BGA封装MOSFET为例,其封装比达到60% - 70%,而小型表面贴装器件的封装比通常为25% - 30%,部分仅接近15% 。这种小型化和轻薄化的特点,使得BGA封装非常适合应用于对体积和重量要求苛刻的便携式电子设备,如智能手机、平板电脑等 。
五、生产制造优势
BGA封装具有自对准效应,对贴片精度要求相对较低,降低了生产过程中的难度和成本 。同时,BGA封装广泛应用于微电子封装的倒装芯片技术和表面贴装技术,使用回流焊接可实现多个焊点的一次性贴装,大大提高了生产效率 。
BGA封装的应用领域
计算机领域:常用于CPU、GPU、芯片组等核心部件的封装。例如,Intel和AMD的主流处理器均采用BGA封装,以满足高性能计算对引脚密度、电气性能和散热性能的严格要求 。
通信领域:应用于高速通信芯片、网络处理器等,确保信号的高速、稳定传输,支持5G、数据中心等通信基础设施的建设 。
消费电子领域:在智能手机、平板电脑、智能手表等设备中,BGA封装帮助实现了产品的小型化和高性能化,提升了用户体验 。
航空航天领域:CBGA等气密型BGA封装由于可靠性高,常用于对环境适应性和稳定性要求极高的航空航天电子设备 。
其他领域:还广泛应用于FPGA(现场可编程门阵列)、ASIC(专用集成电路)等高性能集成电路,以及汽车电子、工业控制等领域 。
挑战与发展
尽管BGA封装具有诸多优势,但在实际应用中也面临一些挑战:
焊接与检测难度大:BGA焊点位于封装底部,难以直接观察和检测焊接质量,需要借助X射线检测等特殊手段 。焊接过程中,对工艺控制要求严格,一旦出现焊接不良,返修难度大,成本高 。
热管理问题:随着芯片集成度和功率密度不断提高,BGA封装的散热需求日益增加。虽然其本身具有一定的散热优势,但在一些极端工况下,仍需进一步优化散热设计,以防止芯片过热 。
成本问题:部分BGA封装类型,如CBGA,由于采用陶瓷基板和复杂的制造工艺,成本较高,限制了其在一些对成本敏感领域的应用 。
未来,BGA封装技术将朝着更高引脚密度、更低成本、更优散热性能和更高可靠性的方向发展。例如,进一步缩小焊球间距,开发新型封装材料和工艺,以满足不断增长的集成电路封装需求 。同时,与其他先进封装技术(如3D封装、系统级封装等)的融合也将成为重要趋势,为电子产业的发展提供更强大的技术支持 。
-
集成电路
+关注
关注
5430文章
12139浏览量
368967 -
封装技术
+关注
关注
12文章
580浏览量
68652 -
BGA
+关注
关注
5文章
574浏览量
49169 -
BGA封装
+关注
关注
4文章
121浏览量
18728
原文标题:球栅阵列封装介绍
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
7个步骤教你如何快速从pcb板中移除塑封球栅阵列封装 (PBGA)
印刷电路板 (PCB) 移除塑封球栅阵列封装 (PBGA) 的建议程序






 一文详解球栅阵列封装技术
一文详解球栅阵列封装技术

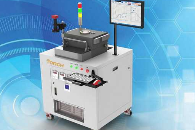










评论