沟道有效迁移率(?eff)是CMOS器件性能的关键参数。传统测量方法在高k介质、漏电介质与高速应用中易出现误差。本文介绍了UFSP(Ultra-Fast Single Pulse)技术如何准确提取迁移率,克服这些挑战。
传统移动性测量及其挑战
我们以栅极长度为L、宽度为W的p沟道器件为例。当沟道电荷在线性区域中从源极到漏极相当均匀时,沟道有效迁移率 (?eff) 可写为

(1)
其中Vd是施加在器件漏极上的小偏压,Qi是移动沟道电荷密度 (C/cm2),Ich是流经沟道的传导电流。
传统上,Ich是在器件的漏极端子处测量的,其配置如图1(a)所示。Qi是通过对测量的栅极 - 沟道电容 Cgc相对于Vg进行积分得出的,即

(2)
使用图1(b)所示的连接配置。
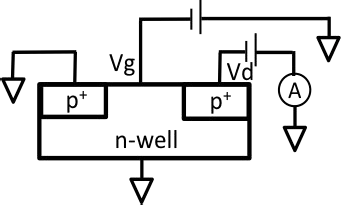
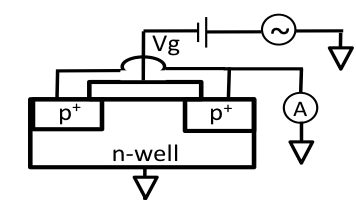
图1. (a) 传导电流测量和 (b) 栅极至沟道电容Cgc测量的配置。
传统迁移率测量的原理看似简单,但这种测试存在许多挑战和陷阱。过去,人们常常忽略一些误差源。
Vd依赖性:传统技术对Ich测量应用不为0的Vd( 通常为50mV–100mV),但对Q测量应用零V。用于测量Ich的V之间的这种差异两次测量可能导致在评估薄氧化物迁移率时出现严重错误,尤其是在低电场区域。图2给出了一个例子,其中较高的 |Vd| 导致峰值附近的迁移率大幅降低。这是因为 |Vg– Vd| 在高 |Vd| 时会降低,因此Ich的实际电荷载流子密度小于在Vd= 0 时测得的Qi。

图2. 通过传统技术测量的有效沟道迁移率。Ich是在各种非零漏极偏压VDS下测量的,但Qi是在 Vd= 0 下测量的。提取的迁移率随着 |Vd| 的升高而明显降低。插图显示了载流子分布在沟道。
电荷捕获:传统技术采用慢速测量,典型测量时间以秒为单位。快速电荷捕获对于薄SiON和高k电介质都很重要。对于慢速测量,捕获可以在测量过程中做出响应,并导致Cgc–Vg曲线的滞后和延伸,以及Ich。这导致对流动性的低估。
漏电介质:随着栅极氧化物的缩小,高栅极漏电流成为迁移率提取的主要挑战。它会影响Ich和Qi测量,进而影响迁移率。为了最大限度地减少其对Cgc测量的影响,已经使用了高达千兆赫的频率,这需要具有RF结构的设备。RF结构需要更多的处理和芯片空间,而且并不总是可用的。
电缆切换:传统技术涉及在Ich和Qi测量之间切换电缆。这会减慢测量速度,并可能导致被测设备发生故障。
超快速单脉冲技术(UFSP技术)
为了克服上述挑战,我们开发了一种称为超快速单脉冲技术 (UFSP) 的新技术,如下所述。
如图3所示。n沟道器件的考虑因素类似。要进行UFSP测量,在器件的栅极端施加一个边缘时间为几微秒的单脉冲。栅极电压在测量期间向负方向扫描脉冲下降沿并打开器件。瞬态电流记录在器件的源极和漏极端子处。然后在栅极电压向正方向扫描的后续上升沿期间关闭器件。相应的瞬态电流也将被记录。可以从在几个测量周期内测量的这四个瞬态电流中提取沟道有效迁移率微秒。
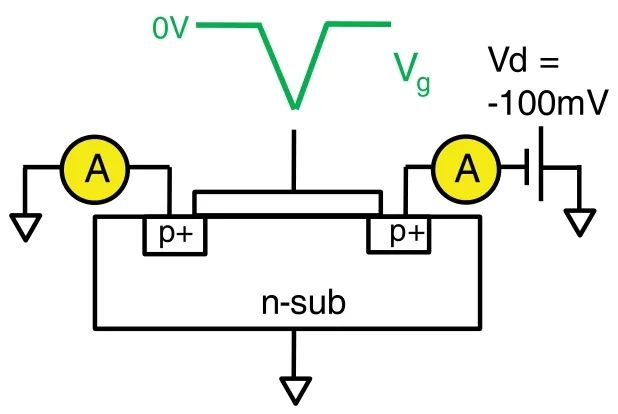
图3. UFSP技术工作原理图。
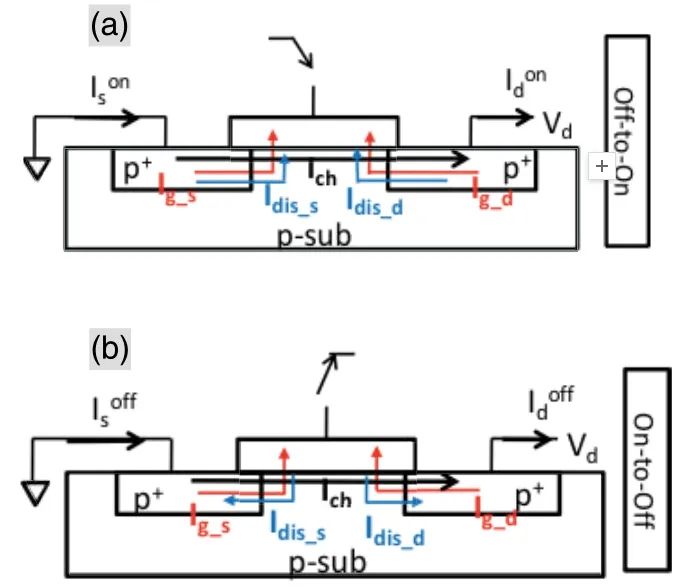
图4. 瞬态测量过程中电流流动的示意图。
为了便于分析,我们将器件开启和关闭时在漏极和源
极端子处测得的电流定义为 Idon、Ison、Idoff和Isoff。瞬态测量过程中沟道中的电流如图4(a)和(b)所示。存在三种类型的电流:沟道传导电流Ich、栅极与源极/漏极之间的位移电流Idis_s和Idis_d以及栅极与源极 /漏极之间的漏电流 Ig_s和Ig_d。当器件从关闭切换到开启时,Idis_s和Idis_d的方向朝向沟道中心; Idis_s与源极处的Ich方向相同,但Idis_d与漏极处的Ich方向相反。当器件从开启切换到关闭时,Idis_s和Idis_d会发生变化方向,但Ich则不然。Ig_s和Ig_d与Vg扫描无关g下始终从源极和漏极流向栅极。基于上述分析,沟道电流Ich、栅极电流Ig和位移电流Idis可利用公式(2)- (4) 分离。Cgc可利用公式 (5) 计算。

(1)

(2)

(3)
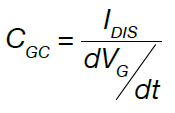
(4)
为了校准UFSP技术,使用具有厚氧化物的p沟道MOSFET,其 IG电流可忽略不计。测量时间(=边缘时间)设置为3?s。图5显示了测量的四个电流。Ich、 克和使用公式(2)至(5)提取的Cgc显示在图6(a).准确评估Cgc和Ich后,即可通过对Cgc和Vg进行积分来获得Qi,并通过公式 (1) 计算出沟道有效迁移率?eff,如图6(b)所示。
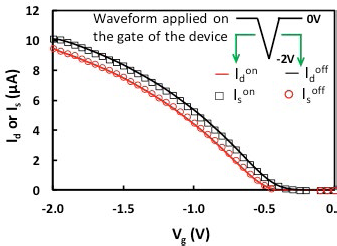
图5. 对应于关断至开和开至关Vg扫描的源极和漏极测量的四个电流。插图中显示了Vg波形示意图。
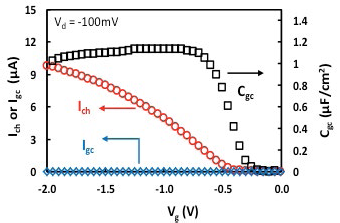
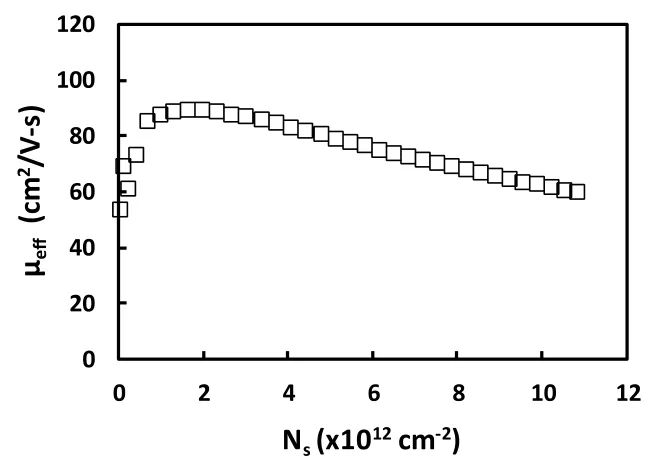
图6.(a). 利用公式(2)-(5)从图5中的电流中同时提取Ich、Ig和Cgc。(b) 从Ich提取的通道有效迁移率,从(a)中提取的Cgc。
由于UFSP在相同的Vd下测量了Ich和Cgc,?eff应与Vd无关。图7比较了在三种不同的Vd偏置下评估的?eff。结果一致,证实使用传统技术可以消除Vd引起的误差已删除。

图7. 用UFSP技术在三种不同Vd下提取的有效沟道迁移率?eff。
UFSP在标准结构的漏电栅介质上也能很好地工作。当将其应用于一个EOT为1.28nm的“漏电”n沟道MOSFET时,从源极和漏极端子测量的四个电流对应于图8(a)显示了关断到开和开到关的VG扫描。利用公式 (2)-(5),Ich('n'), Ig('o') and Cgc('x') 提取并绘制在图8(b)中。图8(b)还绘制了直流测量的Ig以供比较。结果一致。图8(c)表明,对于Ig高达 45A/cm2的漏电器件,可以可靠地测量电子迁移率。由于UFSP 可以容忍高栅极漏电,因此不需要使用用于移动性评估的特殊RF结构。
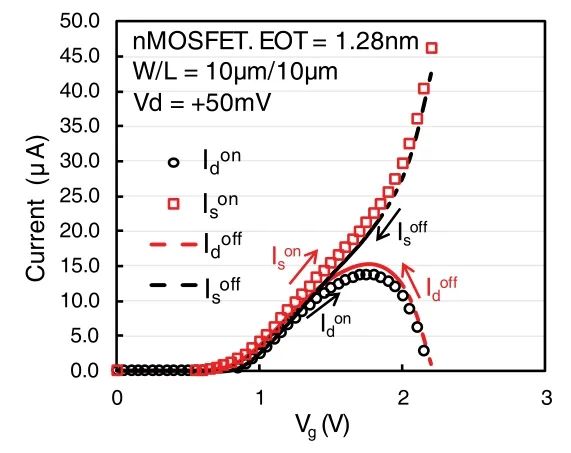
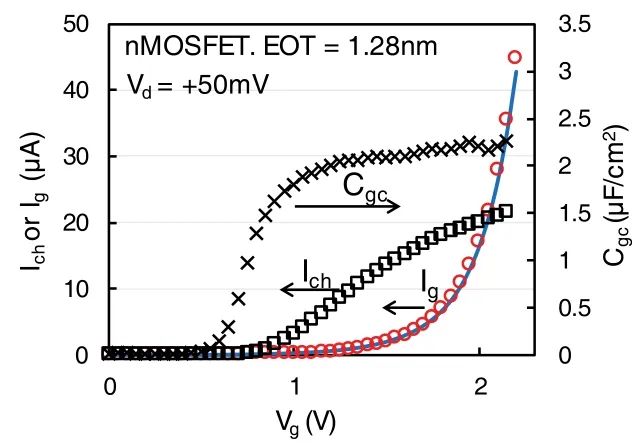
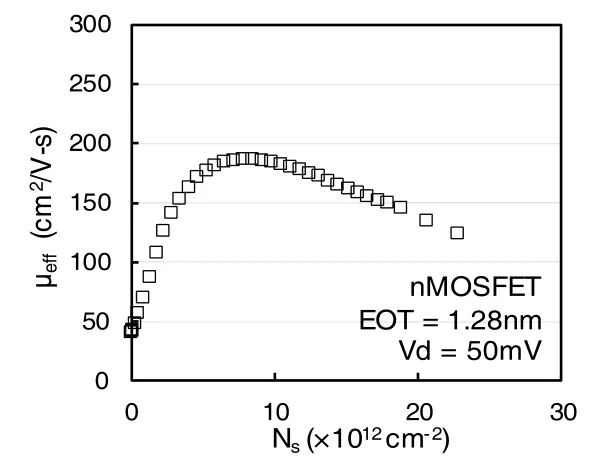
图8.(a) 从source和drain测量的四个电流,对应于在EOT为1.28nm的nMOSFET上通过UFSP技术进行的off-on-on和on-off Vg扫描。
(b) Ich('n'), Ig('o') 和Cgc('x')由公式(2) - (5)从(a)中的电流中提取。蓝线是通过直流测量获得的泄漏电流。
(c) 通道有效迁移率?eff是通过使用提取的Ich和Cgc与 Eqn(1)来计算的。
为了证明UFSP对具有显著电荷捕获的器件的适用性,我们使用了一个具有HfO2/SiO2堆栈的 pMOSFET。大量陷阱位于此介电堆栈中 Si/SiO2界面附近,它们可以快速与基板交换电荷。传统技术需要几秒钟,因此无法将它们与沟道移动电荷区分开来。
因此,反转电荷 将要电荷捕获效应会被高估,反过来,沟道有效迁移率会被低估。UFSP技术只需要几微秒的时间,最大限度地减少了电荷捕获效应。图9比较了这两种技术提取的迁移率。很明显,在抑制电荷捕获后,UFSP提取的迁移率比传统技术高得多技术。
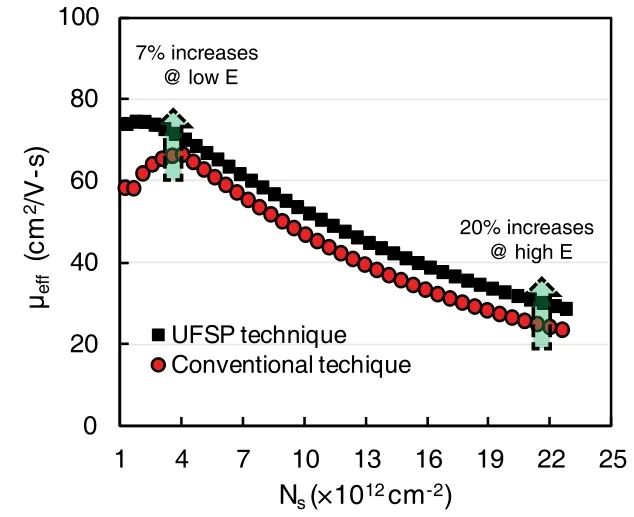
图9. 通过UFSP和常规技术提取的具有相当快速捕获的HfO2/SiON电介质器件的迁移率比较。
UFSP测量所需的硬件
选择合适的测量设备对于成功实施超快速单脉冲方法至关重要。需要以下硬件:
■一台4200A-SCS型参数分析仪
■ 两个超快IV模块(4225-PMU)
■四个远程放大器/开关(4225-RPM)
■ 4 高性能三轴电缆套件(4210-MMPC-C)
图10显示了测试的布线配置照片。4225-PMU是4200A-SCS参数分析仪的仪器选项范围不断扩大。该模块集成了超快速电压波形生成和信号观察功能且融入了4200A-SCS已经很强大的测试环境,提供前所未有的IV测试性能。它使超快速IV源和测量变得与使用传统高分辨率源测量单元(SMU)仪器进行直流测量一样简单。每个插入式4225-PMU模块提供两个集成源和测量沟道测量。每个渠道的这4225-PMU结合高速电压输出(脉冲宽度范围从60ns到DC),同时测量电流和电压。4225-RPM远程放大器/开关通过提供超低电流测量(低于100nA)和降低电缆电容,进一步扩展了4225-PMU的功能 效果。

图10.UFSP技术硬件设置
设备连接
如图11所示。设备的每个端子都使用两根11英寸三轴电缆(电缆套件4210-MMPC-C中提供)连接到一个 4225-RPM。 然后,每个4225-RPM都使用两根三轴电缆连接到PMU的一个沟道。所有测量均由Clarius 控制软件。

图11. 超快速单脉冲 (UFSP) 技术的实验连接。两个Keithley双沟道4225-PMU用于执行瞬态测量。四个Keithley 4225-RPM用于降低电缆电容效应并实现低于100nA的精确测量。

图12. Clarius软件中用于UFSP测量的示例项目。该设备的四个端子分别连接到PMU的一个沟道。
使用Clarius软件进行UFSP测量
使用4200A-SCS系统执行UFSP进行沟道有效迁移率测量非常简单。系统附带一个示例项目。如图12所示,设备的每个端子连接到一个沟道PMU。用户可以在定义选项卡中修改每个PMU沟道的参数。表1列出了一组p沟道MOSFET的用户定义参数。
在Test Setings面板中,用户可以输入想要的测量速度,也就是脉冲的边沿时间,推荐值如表2所示。
表1. PMU 各个沟道定义选项卡中的推荐设置。

表2. 时间选项卡中的推荐设置。

执行测试后,源极和漏极端子打开和关闭期间的瞬态电流将被记录并存储在工作表中,并可保存为.xls文件。这些电流也可以绘制在图形选项卡上。从这些电流中,可以根据公式(2)提取沟道有效迁移率(5)。
结论
UFSP技术通过创新的脉冲测量方法,在微秒级内实现精确迁移率提取。特别适用于CMOS工艺开发、材料评估与器件建模,是现代半导体测试的重要利器。
-
CMOS
+关注
关注
58文章
6035浏览量
239183 -
MOSFET
+关注
关注
150文章
8688浏览量
221142 -
半导体
+关注
关注
335文章
29024浏览量
240162 -
源极
+关注
关注
1文章
55浏览量
8394 -
单脉冲
+关注
关注
0文章
28浏览量
12911
原文标题:从慢测到快取:如何精准提取MOSFET沟道迁移率?
文章出处:【微信号:泰克科技,微信公众号:泰克科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
N沟道和P沟道MOSFET的区别是什么
载流子迁移率测量方法总结

载流子输运现象之散射率、迁移率、电阻率、砷化镓

MXene范德华接触在氮化镓高电子迁移率晶体管中的应用
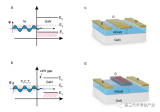
8.2.10.3 4H-SiC反型层迁移率的实验结果∈《碳化硅技术基本原理——生长、表征、器件和应用》

8.2.10.1 影响反型层迁移率的机理∈《碳化硅技术基本原理——生长、表征、器件和应用》

8.2.10.2 反型层迁移率的器件相关定义∈《碳化硅技术基本原理——生长、表征、器件和应用》

如何通过霍尔效应测量半导体中电子和空穴的迁移率?

高电子迁移率晶体管介绍






 如何精准提取MOSFET沟道迁移率
如何精准提取MOSFET沟道迁移率















评论