文章来源:学习那些事
原文作者:前路漫漫
本文对传统封装形式做了简单的介绍。
概述
微电子封装技术每15年左右更新迭代一次。1955年起,晶体管外形(TO)封装成为主流,主要用于封装晶体管和小规模集成电路,引脚数3 - 12个。1965年,双列直插式封装兴起,引脚数增至6 - 64个,间距2.54mm。1980年,表面贴装技术取代通孔插装技术,小外形封装、四边引脚扁平封装等形式涌现,引脚数扩展到3 - 300个,间距1.27 - 0.4mm 。1995年后,BGA封装成为主流。2010年起,晶圆级封装等先进封装技术蓬勃发展。
本文将简单介绍在 BGA 封装技术普及之前,传统封装技术的典型代表形式及其技术特点。
晶体管外形封装
晶体管外形封装是早期晶体管及小规模集成电路的直插式封装形式,按外壳材质分为金属、陶瓷和塑料三类,能满足器件基本电气和保护需求。
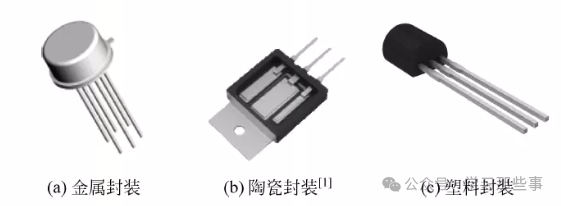
单列直插式封装
单列直插式封装适用于引脚少的场景,引脚从一侧引出排成直线,中心距为2.54mm或1.27mm ,便于电路板设计制造。

双列直插式封装
双列直插式封装(DIP)诞生于20世纪60年代,是中小规模IC芯片常用封装。引脚数4 - 64个,分为陶瓷(CDIP)和塑料(PDIP)两种材质,I/O引脚节距1.78mm或2.54mm。它适配PCB通孔插装,利于布线,可直接焊接或通过插座连接。
1.陶瓷熔封双列直插式封装(CerDIP)
由日立公司在1967年左右开发,采用低熔点玻璃密封,引线节距2.54mm。通过陶瓷制备、玻璃印刷、引线框架嵌入、芯片键合、焊线、密封和引脚处理完成封装。该工艺成本低,曾占据市场主导,但因体积大已逐渐被替代。
2.多层陶瓷双列直插式封装
生瓷片采用流延法制备,经裁切、通孔加工、金属化、层压、热切等工序,再经排胶、高温烧制和表面处理完成外壳制作。相比CerDIP,它可通过优化布线提升电性能,如降低电感、减少串扰和控制阻抗。
3.塑料双列直插式封装
塑料双列直插式封装(PDIP)是以环氧树脂模塑料作为包封材料的DIP封装形式,属于典型的传统塑料封装工艺。其制造流程通常包含芯片固晶、引线键合、注塑成型、去飞边、后固化等多个环节。通过将芯片固定在引线框架上,利用金属丝键合实现芯片与引脚的电气连接,再经过模塑料注塑完成整体封装。这种封装形式凭借成本低、工艺成熟、良品率高的特点,在20世纪80 - 90年代广泛应用于计算器、家电控制板等中小规模集成电路产品中。不过随着电子产品向小型化、轻薄化发展,PDIP因体积较大、引脚间距宽等局限性,逐渐被表面贴装封装形式所取代,但在一些对成本敏感、性能要求不高的低端电子产品中仍有应用。

针栅阵列封装
针栅阵列封装(PGA)是为应对高I/O数量与有限封装面积之间矛盾而诞生的插装型引脚阵列封装技术,与之类似的还有球栅阵列封装(BGA)和触点阵列封装(LGA)。
PGA主要分为陶瓷PGA(CPGA)和塑料PGA(PPGA)两种类型,CPGA常用于对可靠性、散热性能和电气性能要求较高的高端处理器、服务器芯片等领域。例如,一些早期的大型计算机、高端工作站的处理器常采用 CPGA 封装。PPGA则更多地应用于普通个人电脑的处理器、消费类电子产品的芯片等领域。这些领域对成本较为敏感,同时对散热性能和电气性能的要求也相对较低。PGA外形一般呈方形或长方形,在封装体底面以阵列形式排布插针型引脚,常见的引脚中心距规格为2.54mm和1.27mm。在实际应用中,PGA可通过通孔插装方式直接焊接到电路板上,也可以插入专用的PGA插座实现与电路系统的连接。自Intel 80486芯片开始,配套出现了ZIF(Zero Insertion Force Socket,零插拔力插座),这种插座允许PGA封装的CPU在无压力状态下插入和拔出,极大地提高了安装的便利性和可靠性。PGA的引脚数量根据不同应用需求,从64个到上千个不等,例如AMD公司的Ryzen系列处理器采用的AM4接口PGA封装,能够容纳多达1331个引脚,有效满足了高性能芯片复杂的信号传输需求 。

小外形晶体管封装
小外形晶体管(SOT)封装作为最早一批实现商业化应用的表面贴装有源器件封装形式,采用塑料材质进行封装,一般具有3 - 5个引脚,具有体积小、重量轻、安装便捷等特点,广泛应用于手机、数码相机、便携式播放器等消费类电子产品的电源管理、信号放大等电路模块中。最常见的SOT封装类型为SOT23,其外形呈扁平状,三个引脚分布在封装体两侧;此外,还衍生出SOT89、SOT143等多种类型。SOT89封装通常用于功率晶体管,具有更大的散热面积;SOT143则适用于高频信号处理,具备更好的电气性能。值得注意的是,在实际生产和应用过程中,TO - 92封装有时也会被部分厂商归为SOT54,这主要是因为两者在外形尺寸和引脚布局上存在一定相似性,体现了封装命名在实际使用中的灵活性和交叉性。

小外形封装
随着电子技术对封装密度和集成度要求的不断提高,表面贴装技术(SMT)逐渐兴起,小外形封装(SOP)便是早期SMT封装的典型代表。SOP封装是在双列直插式封装(DIP)基础上发展而来,为适应SMT工艺对引脚结构和间距的要求,将引脚向外弯曲成海鸥翼形状,并缩小引脚间距和封装尺寸。为进一步提高电路板组装密度,在SOP基础上又发展出了SOJ(Small Outline J - lead)封装,其将引脚向内弯曲成J形,使得封装在印刷电路板(PWB)上占用的面积更小。SOP与SOJ封装的引脚节距常见规格有1.27mm、1.0mm、0.65mm等,引脚数量范围通常在8 - 86个之间。在引线框架材料选择上,早期多采用可伐合金、42铁镍合金,这些材料与芯片的热膨胀系数较为匹配,能够有效降低因热失配产生的应力;而随着技术发展,Cu合金凭借其优异的导电导热性能和良好的柔韧性,逐渐成为SOP和SOJ引线框架的主流材料。此外,SOP还衍生出窄节距SSOP、薄型TSOP等多种变种,以满足不同应用场景对封装尺寸和性能的需求,部分厂商也会使用SOIC这一别名来指代SOP类型封装。

四边扁平封装
20世纪80年代,为满足大规模集成电路高引脚数需求,日本研发出四边扁平封装(QFP)。作为表面贴装型封装,它将双排引脚扩展为四边布局,显著提升引脚数量与布线密度。QFP主要分为塑料QFP(PQFP)和陶瓷QFP(CQFP),其引脚多为海鸥翼形;若引脚改为J形,则演变为QFJ封装,典型代表是PLCC(塑料有引线片式载体)。
PQFP因工艺简单、成本低应用广泛,引脚节距常见1.0mm、0.8mm、0.65mm;薄型TQFP进一步降低厚度,引脚节距更精细。CQFP常用于军事、航空航天等对可靠性要求极高的领域,用于气密型封装 。PLCC引脚间距1.27mm,引脚数20 - 84个,可直接焊接或通过插座安装。

QFP

QFJ
无引脚封装
四边扁平无引脚封装(QFN)是新型表面贴装封装,外形呈方形或长方形,侧边设导电焊盘,无传统引脚。底部中央的大面积裸焊盘用于高效散热,分为塑料PQFN和陶瓷CQFN(又称陶瓷无引脚片式载体LCC)。
QFN的外引脚和散热焊盘通过半刻蚀形成,相比QFP,它封装紧凑、引脚不易损坏,电性能优异且散热良好,成本也较低。以32引脚的QFN与28引脚PLCC对比,QFN在面积、厚度、质量和寄生效应等方面均有显著优化,广泛应用于智能手机、物联网等小型高性能电子产品 。
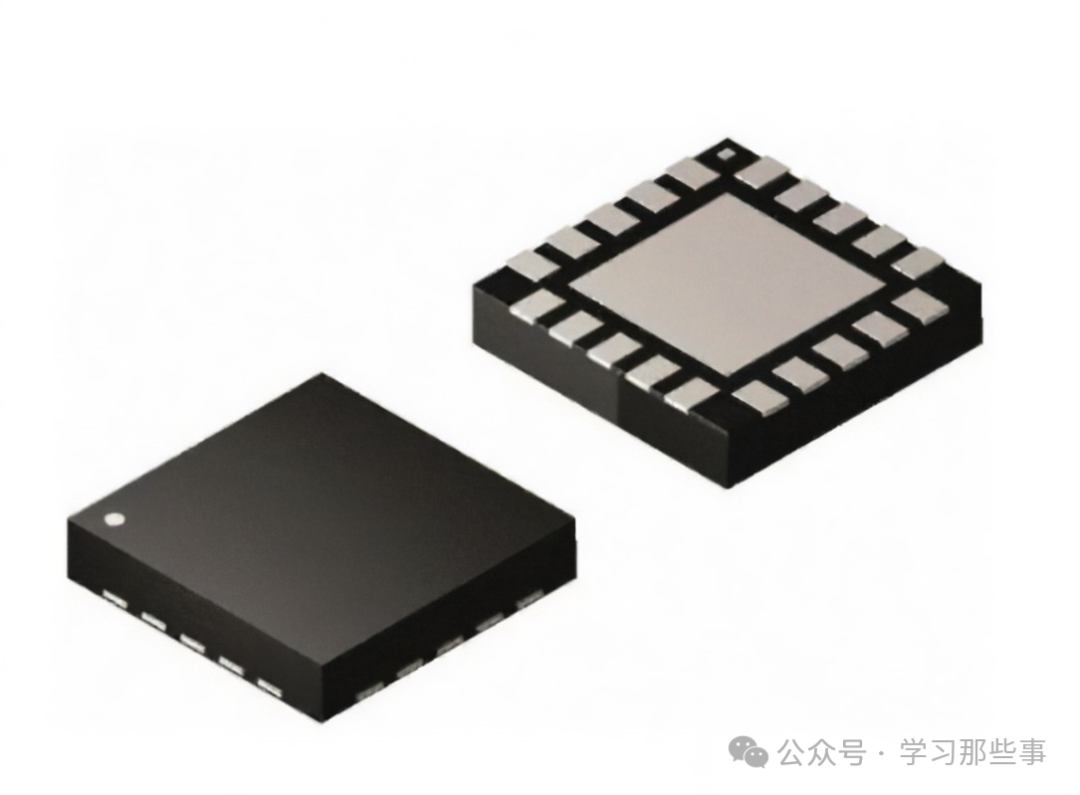
载带自动焊封装
载带自动焊(TAB,Tape Automated Bonding)封装是一种先进的集成电路封装技术,采用专用工艺将芯片精准安置于经金属化处理的特制载带上。此类载带多以聚酰亚胺等高分子材料为基底,通过光刻、刻蚀等工艺在表面形成与芯片引脚匹配的金属布线图案。在实际封装作业时,借助热压焊、超声焊或热超声焊等技术,实现芯片电极与载带金属布线间的稳固电气连接。与传统封装方式相比,TAB封装具备独特优势:其一,能够实现极小的引脚间距,充分满足高密度互连的技术要求;其二,高度适配自动化生产流程,可达成芯片的高速组装,显著提高生产效率;其三,封装成品轻薄,契合便携式电子设备对轻量化、小型化的严苛设计标准。凭借这些技术优势,TAB封装在液晶显示驱动芯片、5G通信芯片等对性能和空间要求较高的领域中。
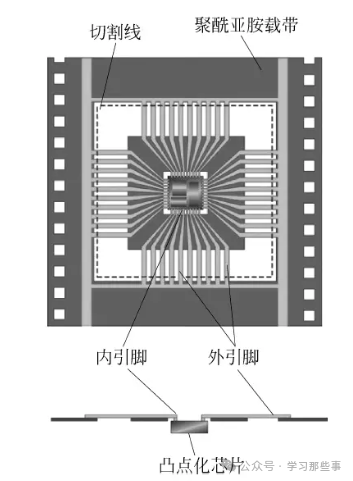
TAB封装示意图
-
集成电路
+关注
关注
5430文章
12139浏览量
368967 -
封装技术
+关注
关注
12文章
580浏览量
68652 -
晶体管
+关注
关注
77文章
10029浏览量
142177 -
BGA
+关注
关注
5文章
574浏览量
49169
原文标题:芯片传统封装形式介绍
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录






 芯片传统封装形式介绍
芯片传统封装形式介绍













评论