随着时间的推移,采用 BGA 封装的器件密度不断提高,焊球数量也越来越多。由于器件之间的间距较小,焊球数量庞大且间距缩小,如今即使是一些简单的器件,也需要采用盘中孔的 HDI 工艺。为了确保良率,在组装时需要特别注意这些器件,并通过有针对性的 X 射线检查,确保成功焊接。
进入大批量生产阶段后,通常会面临降低成本的压力。为此,人们往往从高焊球数器件上的焊膏印刷入手。更换材料后,最常见的一种降本措施是减少耗材使用,而焊料是 PCB 组装过程中消耗量最大的材料。

BGA 组装良率
BGA 的焊接通常需要额外在裸 PCB 的焊盘图案上涂覆一些焊膏。虽然不同的组装厂可能采用不同的指南,但基本原则不变:涂覆焊膏是确保标准焊盘尺寸上有足够焊料的唯一方法。在 CAD 工具默认应用的助焊层数据中,焊膏将涂覆在整个 BGA footprint 上,包括功能性和非功能性 BGA 焊盘。
功能性与非功能性 BGA 焊盘
在 BGA 焊膏印刷中,“非功能性焊盘”并非指通孔焊盘,而是BGA 上没有任何功能的焊盘(或焊球)。它们可能是保留的引脚或明确未连接的引脚,或者具有功能但当前未被使用的引脚。焊接流程通常包括印刷焊膏(选择性印刷)或使用模板将焊膏沉积在焊盘图案上,然后通过回流焊炉。
对于许多器件(如涂覆处理器),大多数焊盘都是功能性的,未连接或保留的可能只有不到 10%。而在采用 BGA footprint 的 FPGA 中,开发人员可以自由分配引脚和接口,因此在生产环境中,可能存在更多未引出的非功能性焊盘。
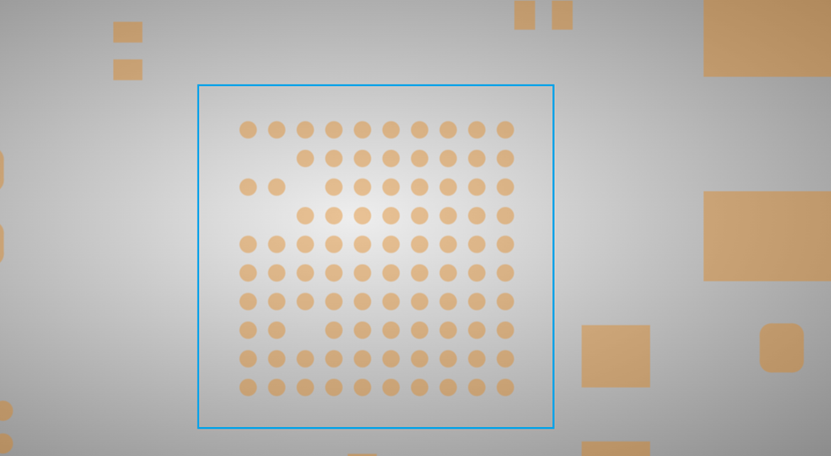
0.4 mm 间距 BGA 上的助焊层开口。
取消焊膏印刷会影响成本吗?
减少组装材料确实可以降低成本,但从产品开发和整体生产成本来看,这种降低可能微不足道。因为除了未使用的焊膏成本,我们还要考虑数量和返修问题。在焊盘图案中印刷焊膏时,仅需使用少量焊膏,但当大批量生产时,这部分成本就会增加到不可忽略的程度。
为了降低大批量涂覆成本,通常会选择去除非功能性焊盘上的焊膏。为此,需要从焊膏模板上移除相应焊盘的开口。此操作可以在相关器件的 PCB footprint 中完成,或在 Gerber 数据中直接删除助焊层上的掩模开口。
BGA 焊盘上的焊膏不可去除
尽管在大批量生产时出于成本考虑,会试图去除部分焊盘上的焊膏,但非功能性焊盘仍与功能性焊盘一样印刷焊膏。虽然这会带来额外的焊膏成本,但与回流焊过程中因组装失败而产生的返修成本相比,这点投入微不足道。更糟糕的是,一旦产品在使用过程中出现故障,不仅会引发昂贵的召回,还可能对品牌信誉造成重大打击。
保留 BGA footprint 中所有焊盘上的焊膏,主要有以下两点原因:
1
电气功能与热传导功能
尽管 BGA 封装中的焊盘可能不具备电气功能,但它们仍具有热传导功能。根据封装类型,这些焊盘可能直接与封装(如晶圆级芯片规模封装)的裸片连接。它们仍具有热传导性,可以将裸片上的热量传导至 PCB 基板。使用焊膏进行充分的焊接,可确保提供一条低热阻路径,实现从裸片到 PCB 基板的热量传导。
2
应力集中
如果器件承受应力,无论是因电路板加热还是器件本身受到冲击,应力都会集中在焊点上。去除助焊层会导致焊料量不足,非功能性 BGA 焊盘上的焊点物理尺寸会变小,焊点强度也会变弱。如此一来,在经历反复的振动应力、机械冲击或温度循环后,应力集中程度加剧,从而显著增加故障的风险。在所有焊盘上涂覆焊料,有助于将应力均匀分布在 BGA 中的所有焊点上。
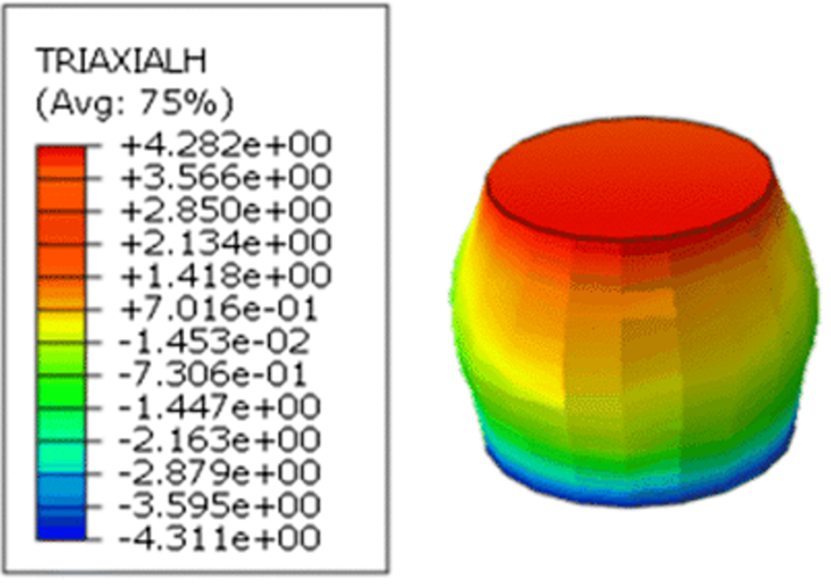
应力集中在 BGA 上焊球最薄弱的部分。如果焊球颈部较为薄弱,应力集中会导致疲劳累积,造成焊点断裂。
总结
简言之,如果在 BGA 的 PCB footprint 中应用了 IPC 标准化焊盘尺寸指南,应在所有焊盘上涂覆焊膏,以提升组装的可靠性。确保 footprint 中包含充足的助焊层开口,以便在 PCB 组装过程中,在 BGA 中形成牢固可靠的焊点。
在 Allegro X PCB Designer 中,可以使用规则管理器对 BGA 焊盘进行规则设置。报名参加报名参加五月直播课程:规则设置,让每一块 PCB 都有望成为可靠性与性能的标杆,解锁高效高质量设计新维度。
-
BGA
+关注
关注
5文章
574浏览量
49163 -
器件
+关注
关注
4文章
339浏览量
28386 -
焊膏
+关注
关注
0文章
50浏览量
10571
发布评论请先 登录


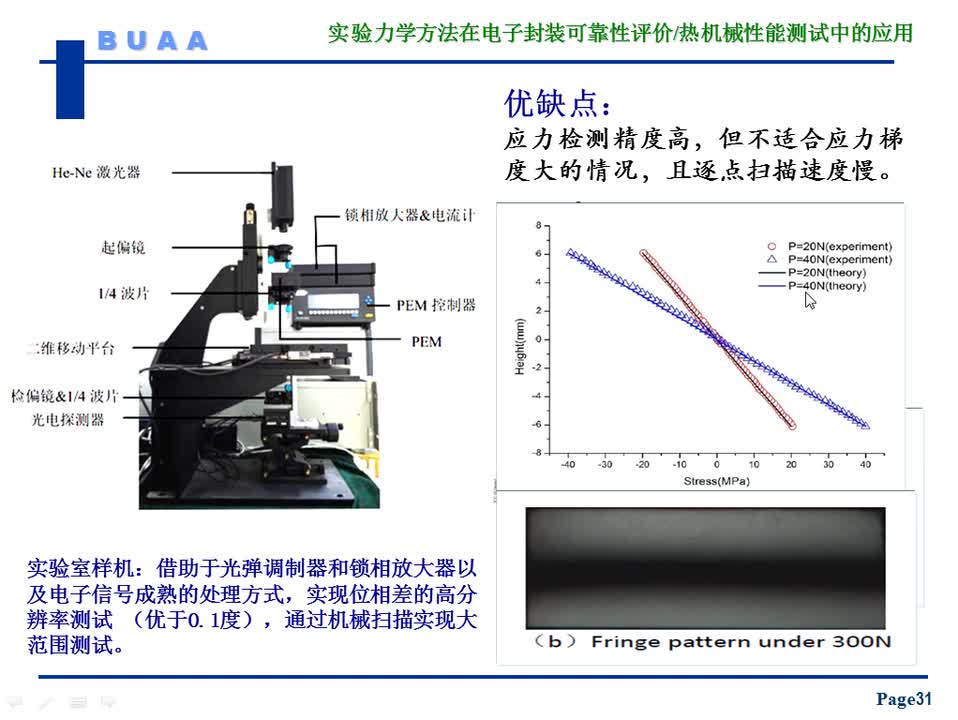
PCB选择性焊接技术介绍
PCB选择性焊接技术详细
PCB选择性焊接技术详细
【转】PCB选择性焊接技术
BGA焊接工艺及可靠性分析
什么是高可靠性?
单片机应用系统的可靠性与可靠性设计
BGA封装的PCB布线可靠性
PCB选择性焊接技术详解
BGA封装焊球推力测试解析:评估焊点可靠性的原理与实操指南






 技术资讯 | 选择性 BGA 焊膏的可靠性
技术资讯 | 选择性 BGA 焊膏的可靠性












评论