在SMT贴片加工的流水线上,焊点缺陷就像隐藏的“地雷”,轻则导致设备故障,重则引发批量返工。这些缺陷中,超过六成与锡膏的选择和使用紧密相关。从焊点间的“非法牵手”到焊盘上的“粮食短缺”,每一种问题都有其独特的诱因和解决之道。接下来傲牛科技的工程师带大家来逐一解析,看看锡膏在其中扮演了怎样的角色,如何构建安全防线,防患于未然。
一、焊点缺陷中的“锡膏印记”:五大典型现象及成因解析
1、桥连短路:焊点间的“非法牵手”
在显微镜下,桥连短路的焊点就像焊盘间多出的“连接线”。这往往是因为锡膏的粘度太低,像稀汤一样在印刷后自然扩散,或是钢网开孔过大、下锡量超标,多余的焊料在高温下流淌到相邻焊盘。
2、虚焊/假焊:焊点的“表面功夫”
虚焊和假焊则更具迷惑性,焊点表面看似完好,内部却因助焊剂活性不足、焊盘氧化层未被清除,或是锡膏粘度太高导致上锡量不足,形成“表面功夫”,导致焊点外观完整但内部未完全熔合,或轻轻触碰即脱落。
3、漏印/缺锡:焊盘的“粮食短缺”
漏印缺锡在小焊盘上尤为明显,可能是锡膏颗粒太粗无法通过细网孔,或是粘度过高堵塞钢网,导致焊盘“吃不饱”。助焊剂中触变剂失效,也可能导致锡膏在钢网中形成“结团”。
4、焊点空洞:焊点内的“隐形气泡”
焊点空洞则是隐藏的“杀手”,会导致降低机械强度和散热能力。X射线才能发现的内部气泡,多因锡膏吸湿受潮,或是助焊剂溶剂在预热阶段爆沸,将空气包裹进焊点。钢网开孔内壁粗糙(Ra>1μm),脱模时卷入空气也可导致焊点空洞。
5、锡球/焊料飞溅:焊盘外的“多余焊点”
焊盘周围的锡球,可引发短路或绝缘失效。一般是由于助焊剂活性过强,焊接时反应剧烈而导致旱涝飞溅。焊粉表面氧化膜破裂,熔融时内部气体突然“炸开”。还有可能是回流焊升温速率过快(>3℃/s),助焊剂爆沸推动焊料溅出。
二、从源头到过程:构建锡膏管控的 “三道防线”
1、要避免锡膏成为缺陷源头,材料选型是第一道关。
不同焊点间距对锡膏颗粒度有严格要求:常规焊盘适合T5级(15-25μm)颗粒,细间距需T6级(5-15μm)确保网孔填充,超细间距则要用T7级(2-11μm)搭配超薄钢网。
助焊剂活性也要按需选择,普通消费电子用中等活性的RA级即可,汽车医疗等高端领域则需低残留的RMA级,卤素含量必须严格控制。验厂时一定要核对 MSDS 报告,确保粘度、氧化度等关键指标达标。
2、工艺优化是第二道防线,让锡膏在印刷和焊接中“乖乖听话”。
印刷环节的刮刀压力和速度至关重要,5-8N/mm的压力既能填满网孔又不致锡膏外溢,细间距焊接速度需降至20mm/s,给锡膏充足的填充时间。回流焊的温度曲线就像锡膏的“成长轨迹”:预热阶段以不超过2℃/s 的速率升温,让助焊剂匀速挥发;回流段峰值温度控制在锡膏熔点加15-20℃,确保充分熔合;冷却段以2-3℃/s 快速固化,减少焊料流动风险。
3、过程管控则是贯穿始终的“守护者”。
锡膏的存储和使用需要“精准呵护”:未开封的锡膏应在5-10℃的冷藏环境中存放,避免温度波动;开封后要标注时间,4小时内用完,剩余锡膏密封冷藏并在24小时内回用,回温时需静置3小时,防止冷凝水影响活性。生产中还要建立实时检测闭环,首件用3D SPI扫描锡膏厚度,过程中每2 小时用显微镜观察焊点截面,每周用X射线检测空洞率,确保每个环节都在掌控之中。
三、跳出锡膏看缺陷:多维度排查保良率
当然,锡膏不能背下所有的锅。元件偏移可能是贴片机吸嘴磨损或视觉定位偏差,需要每日校准精度至±10μm。焊盘氧化多因存储湿度太高,可通过等离子清洗预处理。助焊剂残留腐蚀则可能是清洗工艺不到位,高可靠性产品建议直接选用免洗无卤锡膏。只有将锡膏管控与设备维护、环境控制结合起来,才能形成完整的质量防线。
SMT加工中的焊点缺陷排查,本质上是对材料、工艺、管理的全面考验。锡膏虽小,却串联起从印刷到焊接的关键环节。通过精准匹配焊点需求选择合适的锡膏,辅以严格的制程管控和实时检测,就能将锡膏相关缺陷率大幅降低。记住,没有完美的锡膏,只有最适配的选择——从颗粒度到活性,从存储到焊接,每一个细节的用心,最终都会转化为焊点的可靠与产品的稳定。
-
smt
+关注
关注
43文章
3058浏览量
72437 -
锡膏
+关注
关注
1文章
950浏览量
17521 -
焊盘
+关注
关注
6文章
593浏览量
38960 -
助焊剂
+关注
关注
3文章
138浏览量
11646 -
焊点
+关注
关注
0文章
137浏览量
13107
发布评论请先 登录





 SMT贴片加工常见缺陷排查:哪些是锡膏“惹的祸”,如何精准解决?
SMT贴片加工常见缺陷排查:哪些是锡膏“惹的祸”,如何精准解决?

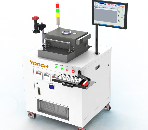






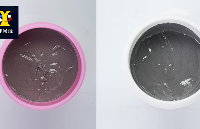

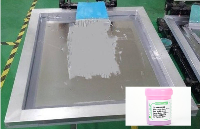













评论