文章来源:半导体与物理
原文作者:jjfly686
本文主要介绍芯片制造中的多晶硅。
多晶硅(Poly- Si)
多晶硅(Polycrystalline Silicon,简称Poly)是由无数微小硅晶粒组成的非单晶硅材料。与单晶硅(如硅衬底)不同,多晶硅的晶粒尺寸通常在几十到几百纳米之间,晶粒间存在晶界。

多晶硅的合成方法:LPCVD工艺
低压化学气相沉积是制备多晶硅的主流技术,其核心是通过硅烷(SiH?)热分解生成硅原子并沉积成膜。
SiH4→Si+2H2↑
低温(<600℃)生成非晶硅,高温(>600℃)形成多晶硅。反应腔压力维持在0.1-1 Torr(低压环境提升薄膜均匀性)。
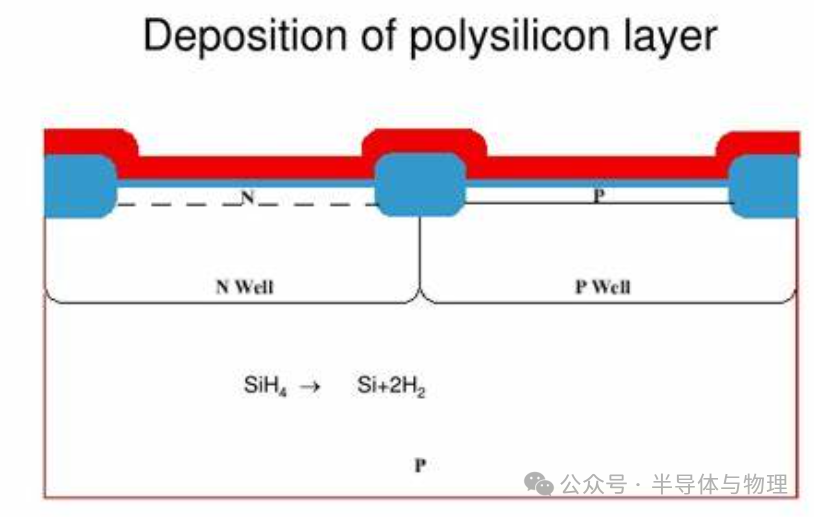
P型与N型多晶硅的合成
多晶硅的导电类型通过掺杂实现,分为P型(掺硼)和N型(掺磷/砷),工艺方法包括离子注入和原位掺杂:
离子注入(主流技术)
N型掺杂:注入磷(P?)或砷(As?),剂量1×10??–1×10?? cm??,能量10-50 keV;
P型掺杂:注入硼(B?),剂量与能量类似;
退火激活:快速热退火(RTA,900-1000℃)修复晶格损伤,激活杂质原子。
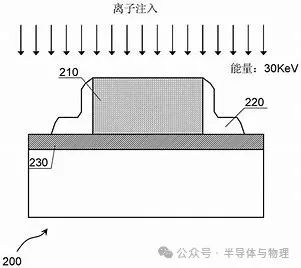
原位掺杂(LPCVD中同步掺杂)
气体掺杂:在SiH?中混入PH?(N型)或B?H?(P型),直接沉积掺杂多晶硅;
优势:避免注入损伤,但掺杂均匀性控制难度较高。
多晶硅在芯片制造中的核心作用
晶体管栅极材料
在栅绝缘介质上沉积多晶硅→掺杂→刻蚀成形→高温退火。掺杂后电阻率低至10?? Ω·cm,传递控制信号;通过N/P型掺杂调节功函数(N-Poly用于NMOS,P-Poly用于PMOS)。

图案转移硬掩膜层
在刻蚀深槽或高深宽比结构时,多晶硅的硬度(莫氏硬度6.5)可保护底层材料。沉积500 nm多晶硅层;光刻定义图案;干法刻蚀多晶硅(Cl?/HBr等离子体);以多晶硅为掩膜刻蚀下层介质/金属。
中段工艺(MEOL)接触连接点
在多晶硅与金属(如钨、钴)之间形成低阻接触。在接触孔中沉积掺杂多晶硅,作为金属与硅衬底的过渡层,减少肖特基势垒;在浅沟槽隔离(STI)区域用多晶硅连接相邻器件。
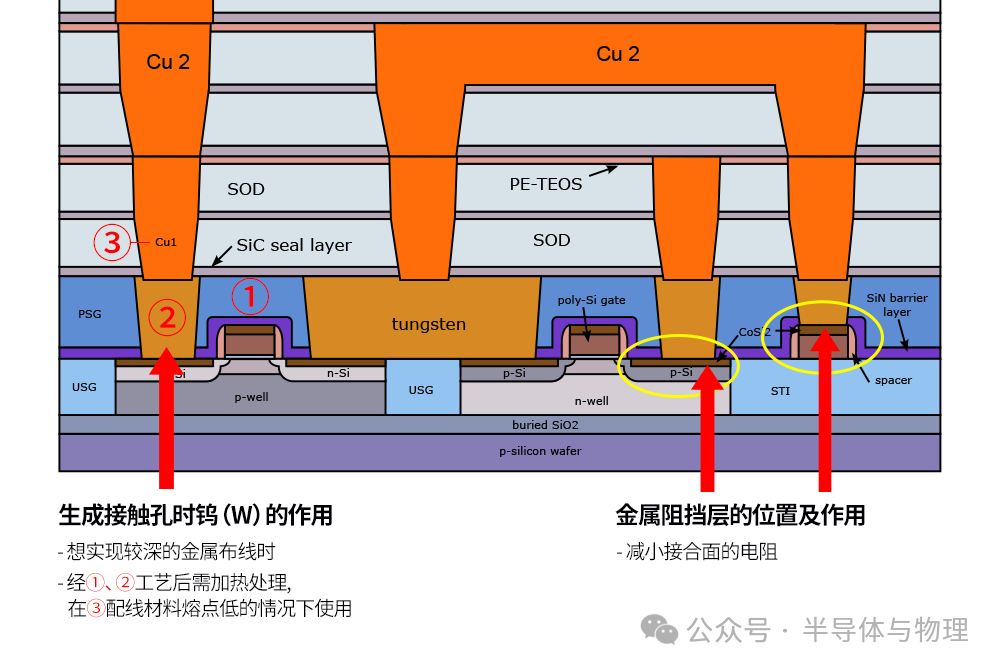
导电层与功函数调控
在FinFET中,多晶硅与High-K介质(如HfO?)结合,通过掺杂类型和浓度调节阈值电压。N型多晶硅功函数≈4.1 eV,匹配NMOS沟道;P型多晶硅功函数≈5.2 eV,适配PMOS需求。
-
多晶硅
+关注
关注
3文章
249浏览量
29967 -
工艺
+关注
关注
4文章
690浏览量
29523 -
芯片制造
+关注
关注
11文章
695浏览量
29815
原文标题:芯片制造中的多晶硅(Poly-Si)
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
低温多晶硅的工作原理是什么?
多晶硅产业发展浅析
低温多晶硅,低温多晶硅是什么意思
多晶硅太阳能电池结构_多晶硅太阳能电池原理
多晶硅是什么东西_多晶硅属于什么行业
多晶硅的用途包括哪些
多晶硅在芯片制造中的作用
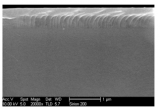





 芯片制造中的多晶硅介绍
芯片制造中的多晶硅介绍












评论