文章来源:学习那些事
原文作者:赵先生
本文介绍了如何进行晶圆检测。
在关键尺寸的在线量测环节,所运用的设备主要涵盖 CD-SEM 以及 OCD(optical critical dimention,光学关键尺寸)量测设备。其中,CD-SEM 借助电子束成像技术,其量测精度颇高,能够敏锐探测局部区域的尺寸变化情况,故而成为量测线宽的关键手段。不过,电子束在照射光刻胶时,会致使光刻胶线宽出现约 4nm 的缩小现象,就光刻胶而言,这属于破坏性检测方式。鉴于此,通常不会针对产品区域开展检测,而是选择对切割道中的监测图形进行量测操作。反观 OCD,它是依靠光学计算来获取线宽数据。该设备的检测光斑尺寸较大,需要针对尺寸大致为 50um 的监测 OCD 图形区域实施量测,并通过计算得出平均线宽数值。OCD 设备的显著优势在于,检测过程无需真空环境,且采用可见光检测,不会受到电荷累计效应的干扰,更为关键的是,量测过程不会对光刻胶的线宽造成任何影响。然而,其缺点也较为明显,仅能检测光栅形式的测试图形,对于其他形式的图形则无能为力。而在线下量测线宽时,所采用的透射电子显微镜,不仅能够提供更高的量测精度,还能获取图形截面信息。凭借其超高分辨率,能够实现对原子排布以及界面镜像的细致观察,并且结合能谱分析,还可开展元素分布分析工作,因此成为失效分析所倚重的主要设备之一。但需要注意的是,其制样过程会对硅片造成破坏。

图1:用于硅片量测的CD-SEM结构
CD-SEM 的结构如图1所示,它借助二次电子信号成像原理来观测样品的表面形态。具体而言,是运用极狭窄的电子束对样品进行扫描,电子束与样品相互作用会引发多种效应,进而激发出各类物理信息。通过对这些信息进行接收、放大以及显示成像处理,最终获取测试样品的表面形貌信息。扫描电子显微镜主要由真空系统、电子束系统以及成像系统这三大部分构成。当一束极为纤细的高能入射电子对扫描样品表面进行轰击时,被激发的区域将会产生二次电子、俄歇电子、特征 X 射线、连续谱 X 射线、背散射电子、透射电子,同时还会在可见光、紫外光、红外光区域产生电磁辐射,并且能够产生电子 - 空穴对、晶格振动(声子)以及电子振荡(等离子体)。由于边缘效应的存在,电子在尖细、粗糙的表面区域,其功函数相对较小,所释放出的二次电子数量较多。在图形的侧面位置,由于倾斜角度较大,侧面积也较大,所以放出的电子数量同样较多。如此一来,硅片表面不同形貌位置所发射的二次电子数量存在差异,进而形成对比度。探测器利用二次电子信号的对比度进行成像,软件则通过计算边缘之间的距离,从而得出线宽、周期、孔径等相关信息,量测结果如图2所示。当下,CD-SEM 的精度能够达到 1.35nm 以下。
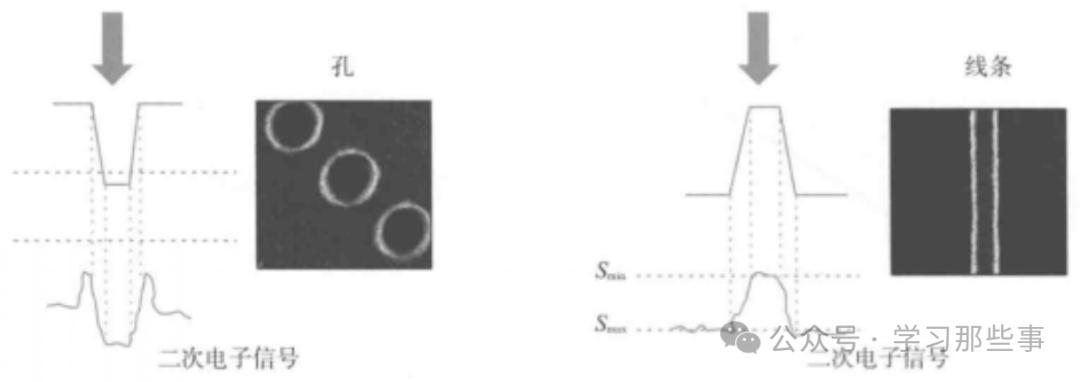
图2:用于硅片量测的CD-SEM对孔和线条量测结果
OCD 的基本工作原理是,借助内部的偏振式反射测量仪,使宽波段的偏振光垂直入射到晶圆表面的 OCD 检测区域 [见图3(a),该区域为周期排布的线条],随后收集散射光信息 [见图3(b),这些信息涵盖光强、传播方向、偏振状态以及相位信息等],通过严格耦合波分析(rigorous coupled wave analysis,RCWA)方法,获取线条的线宽、高度、周期等截面轮廓信息 [见图3(c)]。OCD 检测区域的设计一般包含三种类型,分别是设计规则所规定的最密集图形、半密集图形(周期约为最小周期的 1.8 倍)以及孤立图形(周期为最小周期的 5 倍以上,但小于约 4um 周期,需保证至少存在 10 个周期)。OCD 的主要应用领域包括量测薄膜厚度、线条 CD、沟槽深度、Cu 的高度和 CD、侧墙厚度等。
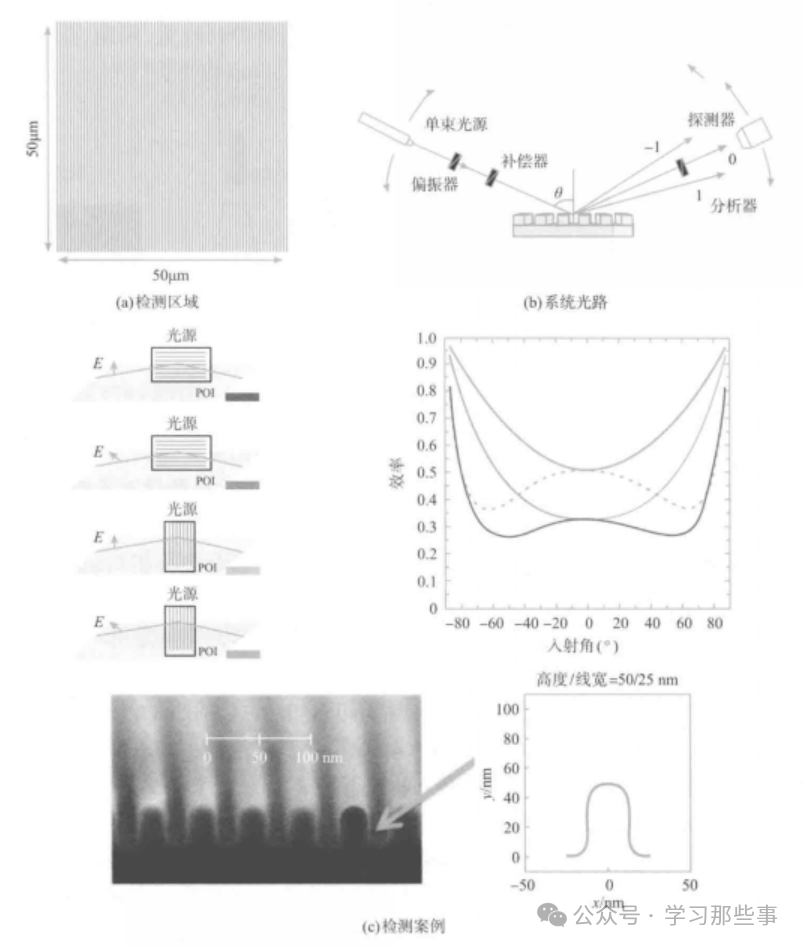
图3:OCD量测
标准 SEM 设备的分辨率范围处于 20 - 30 之间,难以满足高精度量测的需求。而透射电子显微镜(TEM)的量测分辨率提升至 2,属于一种高精度的离线量测方式。TEM 的工作原理是,将经过加速和聚集的电子束投射到极其薄的样品上,电子与样品中的原子发生碰撞后改变方向,从而产生立体角散射。散射角的大小与样品的密度、厚度密切相关,基于此能够形成明暗各异的影像,该影像在经过放大、聚焦处理后,会在成像器件上显示出来。大型透射电镜一般采用 80 - 300kV 的电子束加速电压,不同型号对应不同的电子束加速电压,其分辨率与电子束加速电压相关,可达 0.2 - 0.1nm,高端机型更是能够实现原子级分辨。鉴于电子束的穿透力极为微弱,用于电镜检测的标本必须制成厚度约为 50nm 的超薄切片。TEM 样品制样一般采用聚焦离子束设备,通过 Ga 或者 Xe 离子束进行切割操作,定点提取样品并将其减薄至 100nm 以下,方可用于 TEM 观察,具体流程如图4所示。
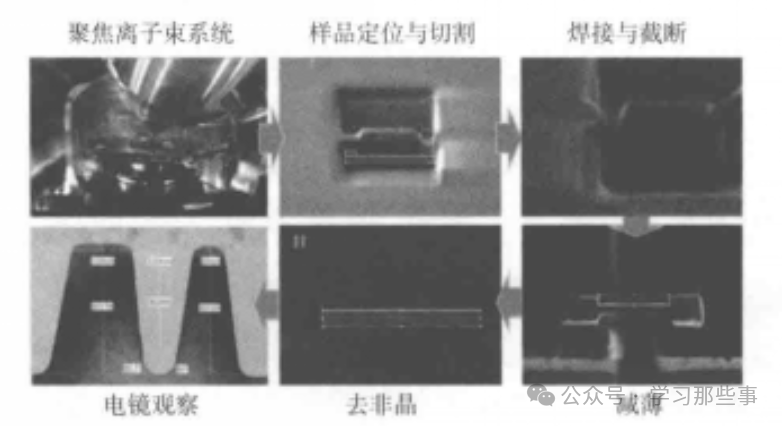
图4:TEM制样及观察流程
缺陷检测
在集成电路制造工艺,特别是先进工艺制造进程里,若晶圆上存在的微小缺陷未被及时察觉,便进入后续工艺环节,极有可能致使数批晶圆的工艺需重新操作,情形严重时甚至会使晶圆直接报废。所以,面对复杂图案,对精细的缺陷检测技术的需求愈发迫切。缺陷检测主要涵盖晶圆的缺陷检测以及检测之后借助扫描电子显微镜开展的观察回看(SEM review)。其中,缺陷检测又分为明场检测与暗场检测这两种类型。
明场缺陷检测(BFI)是一种极为严谨的检测方式。它能够尽早发现问题,并及时采取改进措施,有效避免因缺陷致使晶圆报废或者返工的状况,进而防止成本的浪费以及时间的损耗。BFI 的检测原理如图5所示,它通过将激光直接照射至晶圆表面,利用探测器收集表面的反射光并加以分析。由于反射光信号较为强烈,所以该检测方式具备很高的灵敏度。检测机台通过对比左右芯片单元图像(die to die comparison),依据两者间的差异来判定是否存在缺陷。与基于散射光的暗场缺陷检测(DFI)设备相比,BFI 检测设备处理的数据量较大,这导致机台的检测速度相对较低,不过它通常应用于制程中的关键层检测。
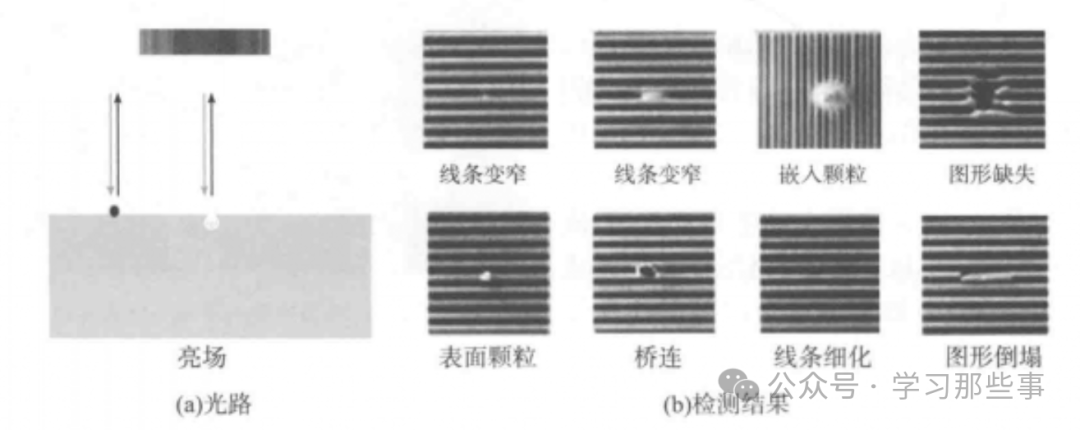
图5:明场缺陷检测
DFI 是一种借助散射光实施检测的技术,其检测原理见图6。该技术通过激光照射晶圆表面,使用探测器收集表面的散射光,因而 DFI 主要针对晶圆表面的缺陷展开分析,同样也是通过对比左右芯片单元图像及差异来确定是否存在缺陷。DFI 处理的光数据量较少,在检测灵敏度方面与 BFI 相比存在一定差距,然而其机台的检测速度更快,能够达到 BFI 的 3 至 4 倍。
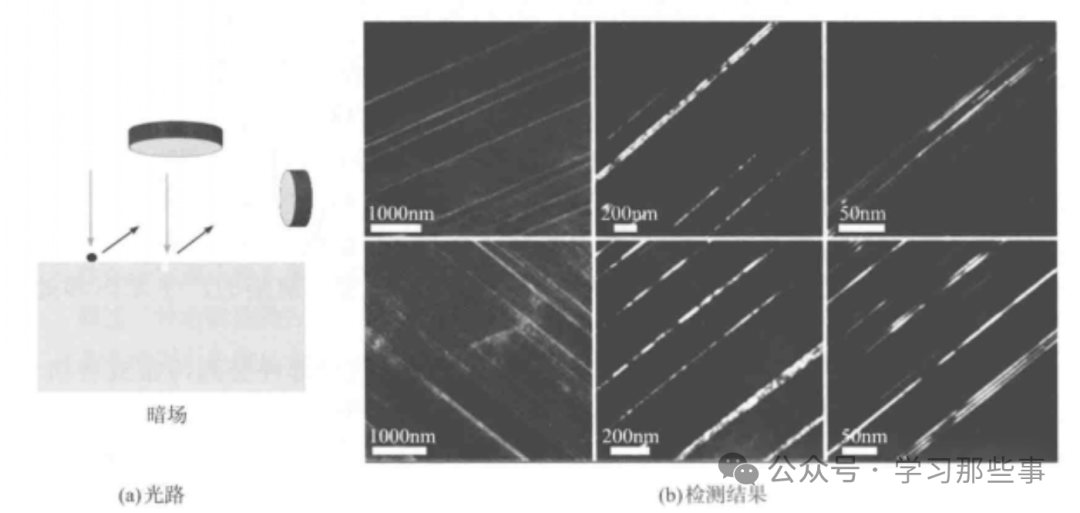
图6:暗场缺陷检测
最新的光学检测技术,已不再单纯依靠解析晶圆上的图案来捕捉缺陷,而是借助复杂的信号处理以及软件算法等手段,在图像对比过程中搜寻 “异常” 情况。检测结果也从以往的晶圆图案,转变为如今的 “亮斑” 和 “暗斑”。尽管这些方法在 20nm 及以上工艺中仍具有一定效果,但在当下的工艺环境里,已不像过去那般可靠。相较于真正的缺陷,噪声在检测结果中所占比例急剧上升,部分情况甚至能超过 90%。并且,仅仅通过观察结果中的光斑,难以判断所捕捉到的信号是否为真实缺陷。基于此,对 BFI 和 DFI 检测出的缺陷进行高精度的 SEM review 回看,并开展人工分类,便成为另一个必不可少的步骤,具体流程见图7。SEM review 具有电子波长短、成像分辨率高的优势,能够对形貌、材质以及元素成分进行检测,还可通过旋转或多角度倾斜来检测缺陷,为探究缺陷的形成原因提供直接依据。
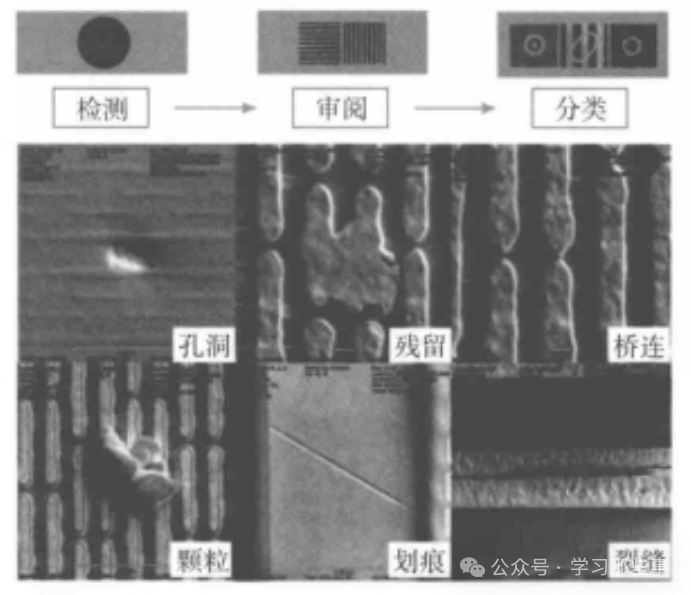
图7:缺陷检测-审阅-分类流程
-
集成电路
+关注
关注
5430文章
12139浏览量
368966 -
晶圆
+关注
关注
53文章
5181浏览量
130122 -
硅片
+关注
关注
13文章
384浏览量
35201 -
缺陷检测
+关注
关注
2文章
154浏览量
12647
原文标题:晶圆检测
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录

什么是晶圆测试?怎样进行晶圆测试?
晶圆切割目的是什么?晶圆切割机原理是什么?
浅谈晶圆检测整体流程及检测目的
多通道晶圆缺陷检测方法
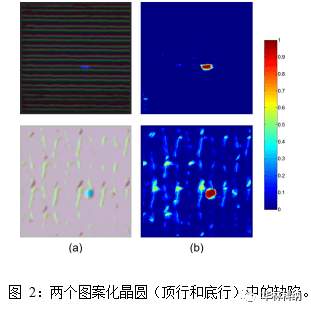





 如何进行晶圆检测
如何进行晶圆检测













评论